壓力主要控制刻蝕均勻性和刻蝕輪廓,同時也能影響刻蝕速率和選擇性。改變壓力會改變電子和離子的平均自由程(MFP),進(jìn)而影響等離子體和刻蝕速率的均勻性。通過增加壓力縮短MFP,此舉也表示增加了離子間的碰撞。隨著離子能量的降低,離子的碰撞散射就會增加,從而可以提高RIE中的化學(xué)刻蝕成分。如果刻蝕主要以化學(xué)方式為主,增加壓力就會提高刻蝕速率;但如果刻蝕以物理方式為主,則增加壓力將會降低刻蝕速率。
增加磁場有助于提高等離子體密度,進(jìn)而增強(qiáng)離子轟擊流量及物理刻蝕成分,也會造成鞘層偏壓降低使得離子能量減少,增加自由基的濃度可使刻蝕更具化學(xué)性。低壓狀態(tài)下當(dāng)磁場微弱時,改善物理刻蝕比化學(xué)刻蝕更重要。當(dāng)磁場強(qiáng)度增加時,刻蝕將變得更具物理性。而當(dāng)磁場強(qiáng)度達(dá)到某個特定數(shù)值時,由于離子能量隨著直流偏壓減少,所以刻蝕將變得更具化學(xué)性。下圖顯示了當(dāng)射頻功率、壓力和磁場強(qiáng)度增加時的刻蝕發(fā)展趨勢圖。
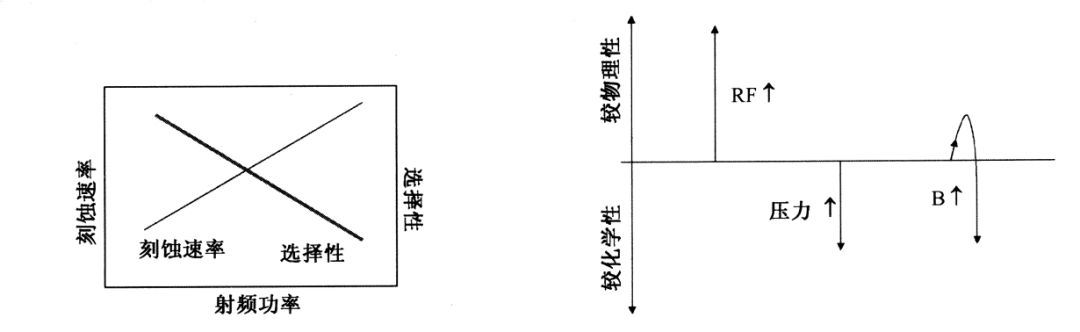
如果刻蝕反應(yīng)室產(chǎn)生漏氣,則光刻膠的刻蝕速率會因等離子體中岀現(xiàn)氧氣而相對提高。光刻膠的選擇性降低,微粒數(shù)會增加。光刻技術(shù)中,如果光刻膠硬式烘烤不足,刻蝕過程中將導(dǎo)致過高的光刻膠刻蝕速率和過多的光刻膠損失。
因為每種刻蝕所需的反應(yīng)室設(shè)計、化學(xué)品和操作環(huán)境不同,所以發(fā)展趨勢也可能各不相同。一般來說,工具供應(yīng)商提供工具時也會附上包括工藝參數(shù)條件和工具檢修指南等信息。
刻蝕工藝未來發(fā)展趨勢
為了獲得更好的非等向性刻蝕輪廓并減少CD損失,需要在較低壓力下進(jìn)行刻蝕過程,因為低壓環(huán)境能夠增加平均自由程并減少離子散射。增加等離子體密度能增加離子的轟擊流量。為了達(dá)到一定的離子轟擊,增加離子轟擊流量可減少所需的離子能量,這也是通常用來減少器件損傷的方法。低壓、高密度的等離子體反應(yīng)室是未來刻蝕反應(yīng)室的設(shè)計方向,ICP和ECR刻蝕反應(yīng)室就能滿足這種情況。這兩種刻蝕反應(yīng)室都能在低壓狀態(tài)下產(chǎn)生高密度等離子體,并能獨立控制等離子體密度和離子轟擊能量,而這些對刻蝕的控制很重要。對于ICP和ECR等離子體源,離子化速率不高,為1%~5%。螺旋波等離子體源可在數(shù)毫托的低壓下達(dá)到近乎100%的離化速率,這也是未來刻蝕反應(yīng)室設(shè)計的方向之一(見下圖)。
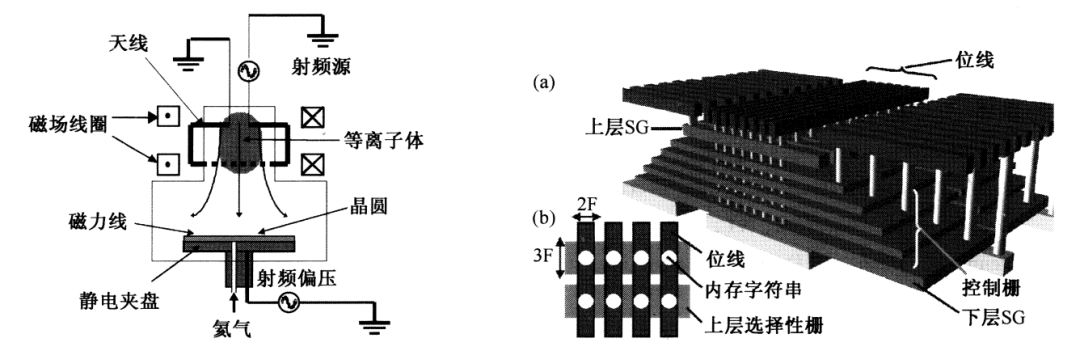
另外需要關(guān)注的問題是等離子體的均勻性控制,特別是對于較大的晶圓尺寸。等離子體均勻性和等離子體位置的控制在未來更加重要。對于成熟的技術(shù)節(jié)點,高的產(chǎn)量、低的成本是與現(xiàn)有生產(chǎn)系統(tǒng)競爭的關(guān)鍵因素。如果可以制造低成本的可靠的刻蝕系統(tǒng),從長遠(yuǎn)來看,可以為客戶節(jié)省大量費用,有可能促使IC制造商取代現(xiàn)有系統(tǒng)發(fā)展低成本的新系統(tǒng)。最關(guān)鍵的是成品率,正常運行時間應(yīng)相同或高于現(xiàn)在的系統(tǒng),而且產(chǎn)量更高,耗材更低,使生產(chǎn)商可以相信通過一年的系統(tǒng)更新,節(jié)省的運作成本可以還清設(shè)備成本。
審核編輯:劉清
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28916瀏覽量
237876 -
IC設(shè)計
+關(guān)注
關(guān)注
38文章
1360瀏覽量
105764 -
刻蝕工藝
+關(guān)注
關(guān)注
2文章
40瀏覽量
8607
原文標(biāo)題:半導(dǎo)體行業(yè)(一百六十九)之刻蝕工藝(二十)
文章出處:【微信號:FindRF,微信公眾號:FindRF】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
半導(dǎo)體行業(yè)之刻蝕工藝
半導(dǎo)體前端工藝之刻蝕工藝
最全最詳盡的半導(dǎo)體制造技術(shù)資料,涵蓋晶圓工藝到后端封測
6英寸半導(dǎo)體工藝代工服務(wù)
【新加坡】知名半導(dǎo)體晶圓代工廠招聘資深刻蝕工藝工程師和刻蝕設(shè)備主管!
振奮!中微半導(dǎo)體國產(chǎn)5納米刻蝕機(jī)助力中國芯
《炬豐科技-半導(dǎo)體工藝》半導(dǎo)體行業(yè)的濕化學(xué)分析——總覽
半導(dǎo)體行業(yè)之刻蝕工藝技術(shù)
半導(dǎo)體行業(yè)之刻蝕工藝介紹
半導(dǎo)體工藝之金屬布線工藝介紹
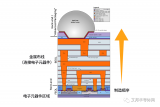
半導(dǎo)體前端工藝:刻蝕——有選擇性地刻蝕材料,以創(chuàng)建所需圖形






 半導(dǎo)體行業(yè)之刻蝕工藝介紹
半導(dǎo)體行業(yè)之刻蝕工藝介紹












評論