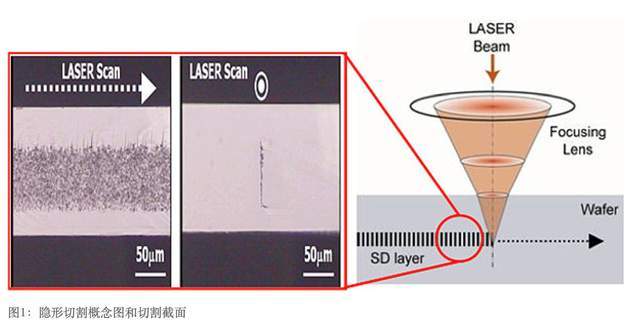
一、究竟什么是隱形切割?
導體制造中,使用大晶片是一個趨勢。但是晶片本身就非常薄,切割工藝涉及到一系列問題,比如一片晶片能夠切割出多少芯片、或者怎樣在不導致缺點的情況下切割出復雜集成電路芯片等。由于芯片產品在具有更多功能的同時變得越來越小,所以切割過程需工作在越來越嚴格的條件下。隱形切割就是一種滿足這種嚴苛條件的技術。隱形切割只是半導體制造工藝的一部分,但是這一部分的改變卻可以給整個工藝造成巨大影響。隨著半導體產品需使用薄晶片,時代需要呼喚著更小、更高性能的半導體器件。說市場需求是推動隱形切割在半導體制造領域獲得目前地位的推動力量,一點也不夸張。
二、隱形切割過程
隱形切割過程中,波長可以透過半導體晶片的激光束經過物鏡聚焦到半導體晶片的一個點上,然后該光束沿著切割線進行掃描。
此處使用的光學系統具有高的聚焦性能,能夠把光壓縮到衍射限界。因此高重復、短脈沖的激光束在時間上和空間上被壓縮到焦點附近非常小的區域,具有非常高的峰值功率密度。當可透過半導體晶片的激光束在壓縮過程中,峰值光能密度超過某個閾值的時候,激光束開始出現高吸收率。優化光學系統以及激光束特性可以更好地控制光密度閾值,以達到只在半導體晶片內部、焦點附近超過閾值的目的。這樣便可以用激光束選擇性地對晶體內部特定地點進行加工,而不會破壞晶體表面及邊緣。在激光處理的區域,改性層形成,改性層作為一個裂縫起點,裂縫垂直變長,在芯片前后表面上下延伸。隱形切割從內部把目標材料分割,與普通激光切割從晶片外部切割材料是不一樣的。
審核編輯黃宇
-
激光
+關注
關注
20文章
3462瀏覽量
67089 -
晶片
+關注
關注
1文章
408瀏覽量
32033
發布評論請先 登錄
自動對刀技術對碳化硅襯底切割起始位置精度的提升及厚度均勻性優化

基于進給量梯度調節的碳化硅襯底切割厚度均勻性提升技術

光模塊芯片(COC/COB)切割采用國產精密劃片機的技術能力與產業應用

從開槽到分層切割:劃片機階梯式進刀技術對刀具磨損的影響分析

劃片機技術:在鍍膜玻璃精密切割領域的深度應用與優勢解析
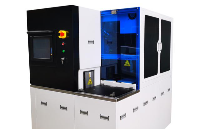
你知道LED全息隱形屏是什么嗎?
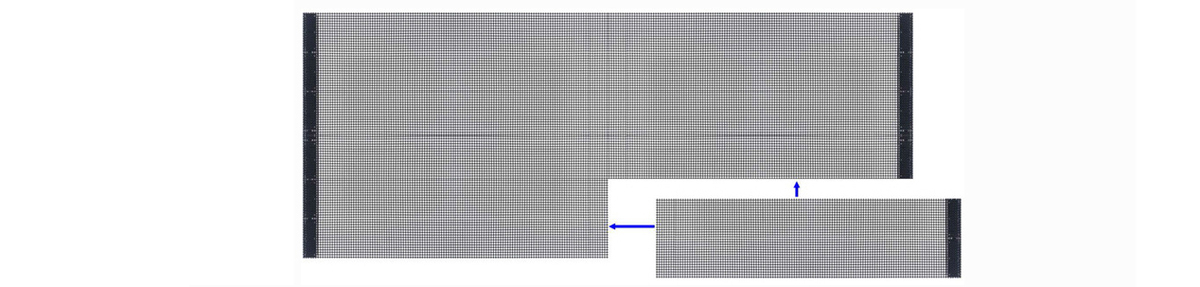





 東方閃光----隱形切割技術簡介
東方閃光----隱形切割技術簡介













評論