光刻工藝后,在硅片或晶圓上形成了光刻膠的圖形,下一步就是刻蝕 。刻蝕就是利用光刻膠或其它材料做掩蔽層,對沒有保護的區域進行腐蝕,最終實現將掩膜版上的圖形變成硅片(或晶圓)上的圖形,實現圖形轉移。
通俗來說, 刻蝕就是光刻后利用化學或物理的手段,對硅片本體精雕細琢的過程。刻蝕后在硅片上呈現出邏輯電路結構。 在本篇文章中,將重點闡述濕法刻蝕。(下圖中,Photoresist Mask光刻膠保護的部分,沒有被刻蝕掉。)
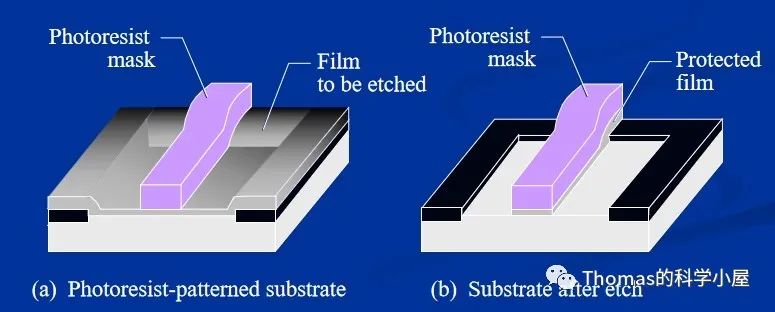
濕法刻蝕
在IC制造工藝中,刻蝕主要分為兩類, 干法刻蝕和濕法刻蝕 。濕法刻蝕使用液態化學品,讓硅片在強酸強堿溶液中刻蝕。干法刻蝕,利用氣體等離子體,讓硅片在化學氣體的離子轟擊下局部刻蝕。按照其反應的本質,可以分為化學方法,物理方法,化學與物理結合的方法。
首先,濕法刻蝕是純粹的化學反應,它是利用化學試劑,與被刻蝕材料發生化學反應生成可溶性物質或揮發性物質。濕法刻蝕的技能,在古代就得到了很多應用。比如在中世紀的時候,歐洲人會用酸性溶液在金屬盔甲上蝕刻雕花。在早期集成電路時代,工程師用強酸強堿來大規模刻出芯片。(下圖中,各種刻蝕方法呈現的溝槽效果)

芯片上還有硅、氧化硅、碳化硅、氮化鎵等各種介質。濕法刻蝕需要使用各種不同的強酸強堿去去除這些雜質。 比如硅比金屬穩定,需要使用濃硝酸和氫氟酸去溶解,外加乙酸調和,簡稱HNA溶劑 。其中氫氟酸非常危險,接觸皮膚后,會迅速滲入組織,侵蝕骨骼,俗稱化骨水。
HNO3+6HF+Si-->H2SiF6+HNO2+H2O+H2
不同的晶向的硅,腐蝕速率也不同,一般常用KOH腐蝕單晶硅。對于二氧化硅,常用NH4F作為緩沖液,防止HF對二氧化硅腐蝕太快。
SiO2+6HF-->H2SiF6+2H2O
關鍵指標
針對刻蝕的最終要求,圖形轉移時的保真度,選擇比,均勻性和刻蝕的清潔。刻蝕有幾個關鍵指標,刻蝕速率,選擇比,方向性。
刻蝕速率,是指單位時間內硅片表面被刻蝕的材料去除量 。通常是刻蝕厚度除以刻蝕時長,每分鐘損失多少微米的厚度,或者是每秒鐘損失多少納米的厚度。在濕法刻蝕中,刻蝕深度是使用刻蝕時長來控制。

選擇比,對不同的材料的刻蝕速率的比值 。比如硅和光刻膠的選擇比是10:1,那每刻蝕掉10微米的硅,就會損失1微米的光刻膠。所以選擇比越高,刻蝕越安全。

一般的濕法刻蝕沒有方向, 朝各個方向均勻腐蝕,簡稱為各向同性 。在業內,各向同性會導致鉆蝕,挖穿本應被光刻膠保護的區域,導致器件短路或開路。在芯片設計中,理 想情況是沒有橫向刻蝕,只有縱向刻蝕,這叫各向異性 。
現實情況中,橫向刻蝕無法避免,只能是減少。比如利用單晶硅在不同晶向上對氫氧化鉀的耐腐蝕性不同,溶液在底部平面的腐蝕速度,要比在側面斜面強數百倍。

總結
在21世紀初,集成電路開始進入幾十納米階段。濕法刻蝕因為其存在的局限性,退出了許多工藝制程。干法刻蝕,得到了工程師和設備商的青睞。
-
集成電路
+關注
關注
5420文章
11975瀏覽量
367426 -
邏輯電路
+關注
關注
13文章
502瀏覽量
43209 -
晶圓
+關注
關注
52文章
5130瀏覽量
129250 -
IC設計
+關注
關注
38文章
1351瀏覽量
105338 -
光刻膠
+關注
關注
10文章
334瀏覽量
30820
發布評論請先 登錄
一文詳解濕法刻蝕工藝






 重點闡述濕法刻蝕
重點闡述濕法刻蝕

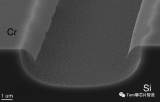










評論