隨著功率MOSFET和IGBT的出現(xiàn),雙極型晶體管的發(fā)展受到一定影響。但在更高電壓、更大電流的應用中,隨著外延層(或單晶)厚度、電阻率的的增加,MOSFET、IGBT導通壓降隨之大幅上升。而雙極型晶體管、晶閘管及其衍生器件由于其具有電導調(diào)制效應,可改善大電流情況下的導通壓降,因此,在高壓、低頻應用領域有著廣泛的需求。在結構方面,MCT多晶硅柵電極下具有雙溝道,分別為開通溝道和關斷溝道。MCT將晶閘管的大電流容量、高阻斷電壓、低飽和壓降特點和MOS場控器件的柵極控制能力結合在一起,降低了低頻應用中晶閘管驅(qū)動功率和驅(qū)動電路的復雜性。由于MCT芯片結構較復雜、制備難度較大、工作條件較嚴苛,因此為了改善MCT的電學特性,需要在深刻理解器件導通機理的基礎上,對器件結構參數(shù)和工藝條件進行精細的設計和優(yōu)化。
1 MCT單胞結構及物理模型選擇
圖1為MCT半單胞結構。為了使得仿真結果具有實際參考意義,根據(jù)電參數(shù)指標要求,利用TCAD半導體器件仿真軟件對MCT單胞橫向、縱向結構參數(shù)進行了設計,后續(xù)的仿真研究以此為基礎。表1為MCT電參數(shù)指標。設計得到的MCT結構參數(shù)和工藝參數(shù)為:溝道寬度為4×106μm;單胞半寬度為15μm,窗口區(qū)半寬度為5μm,多晶硅區(qū)半寬度為10μm;P+襯底厚度和摻雜濃度分別為150μm和1×1019cm-3,襯底晶向為<100>;N-外延層厚度和摻雜濃度分別為160μm和7×1013cm-3(外延層電阻率為63Ω.cm)柵氧化層厚度為60nm,注入過程中犧牲氧化層厚度為20nm;P-體區(qū)注入劑量和能量分別為3.5×1014cm-2和60KeV,P-體區(qū)退火時間和溫度分別為70min和1150℃;N+體區(qū)窗口區(qū)寬度為0.5μm,N+體區(qū)磷注入劑量和能量分別為8×1014cm-2和60KeV;N-體區(qū)磷注入劑量和能量分別為5×1014cm-2和60KeV, N-體區(qū)退火時間和溫度分別為130min和1150℃;P+陰極區(qū)窗口寬度為2μm,P+陰極區(qū)硼注入劑量和能量分別為2×1015cm-2和50KeV, P+陰極區(qū)退火時間和溫度分別為1min和1000℃;開通溝道長度和關斷溝道長度分別為2.7μm和0.8μm;側(cè)墻氧化層厚度為0.5μm;硅材料原始少子壽命為10μs;P+陽極區(qū)與N-外延層之間采用N+緩沖層結構,N+緩沖層為均勻摻雜,摻雜濃度和厚度為變量。縱向結構采用傳統(tǒng)的晶閘管工藝實現(xiàn),橫向采用DMOS硅柵工藝,終端采用終端結擴展結構。
工藝流程為:擴散P+區(qū)→光刻(一次光刻)擴散P-體區(qū)→光刻(二次光刻)擴散N+區(qū)→生長柵氧化層→生長多晶硅→光刻(三次光刻)擴散N-阱→自對準擴散P+→生長SiO2和Si3N4→光刻(四次光刻)引線孔→蒸鋁→反刻(五次光刻)→鈍化→鈍化光刻(六次光刻)。圖2為設計得到MCT輸出特性曲線,由圖2可知,設計得到的MCT電學性能滿足電參數(shù)指標要求,表明結構參數(shù)設計和工藝條件選擇較合理。
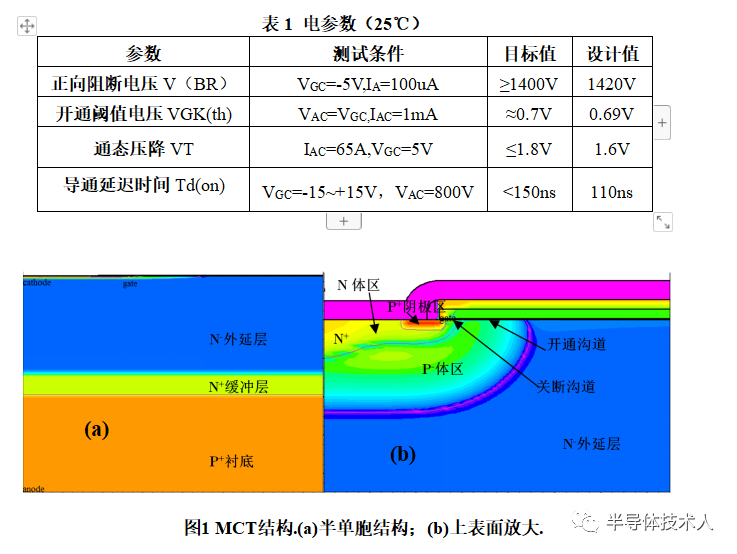
2、N+緩沖層結構對MCT瞬態(tài)特性(TLP)的影響
vgate=5V,vanode=800V;IApeak=150A,上升時間10ns,脈寬6μs,下降時間150ns,周期150μs
2.1 N+緩沖層摻雜濃度的影響,N+緩沖層厚度35μm
(1)1E17cm-3

(2)3E17cm-3
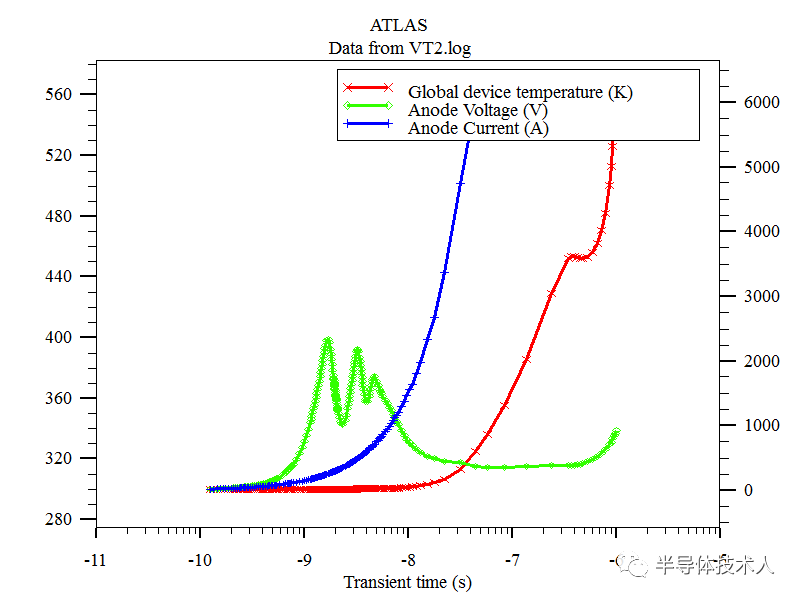
(3)5E17cm-3


(4)7E17cm-3
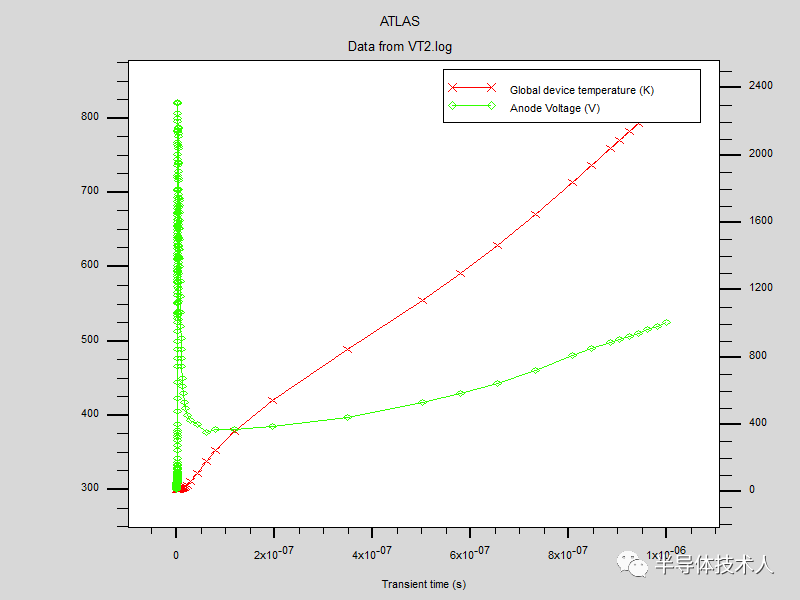
(5)9E17cm-3

2.2 N+緩沖層厚度的影響
(1)25μm

(2)30μm
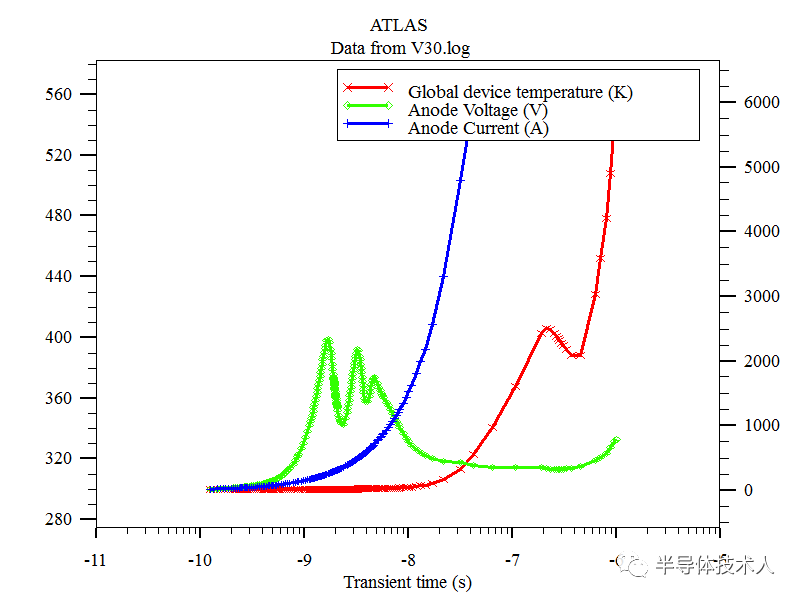
(3)35μm

-
MOSFET
+關注
關注
150文章
8474瀏覽量
219606 -
晶閘管
+關注
關注
35文章
1109瀏覽量
78446 -
IGBT
+關注
關注
1278文章
4055瀏覽量
254132 -
MCT
+關注
關注
0文章
16瀏覽量
5735
發(fā)布評論請先 登錄
labview 瞬態(tài)特性測量
N溝道增強型MOS場效應管的結構與原理
解讀太陽能電池的基本特性
超級結MOSFET的優(yōu)勢
如何改良SiC器件結構
雷達目標空頻域瞬態(tài)極化特性及其在幾何結構反演中的應用
新型功率器件MCT關斷模型的研究
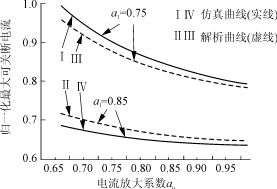
MOS控制晶閘管(MCT),MOS控制晶閘管(MCT)是什么
n埋層PSOI結構射頻功率LDMOS的輸出特性
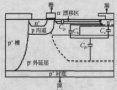
高頻通過特性小型光繼電器:TLP3375,TLP3275

N+緩沖層對PT-IGBT通態(tài)壓降影響的研究






 N+緩沖層結構對MCT瞬態(tài)特性(TLP)的影響
N+緩沖層結構對MCT瞬態(tài)特性(TLP)的影響


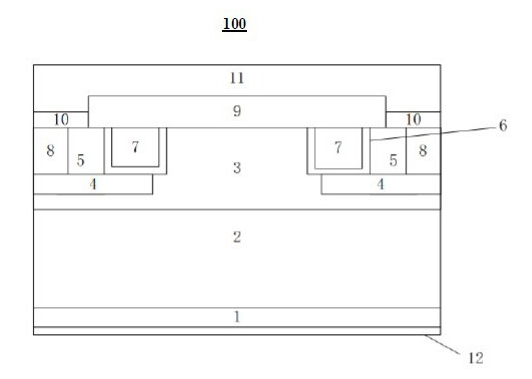










評論