作品概述
相對于傳統平面型的金絲鍵合焊接的MMIC應用,三維(3D)多芯片互連封裝MMIC以其高集成度、低損耗、高可靠性等性能優勢,正逐步在先進電路與系統中得到應用。而3D封裝引入的復雜電磁耦合效應,在傳統MMIC仿真設計上并未包含。本設計基于HFSS,充分考慮實際封裝寄生效應,建立了完整的3D多芯片互連精準模型,并給出了封裝前后仿真結果對比分析。
仿真應用背景
平面型互連向3D集成互連發展
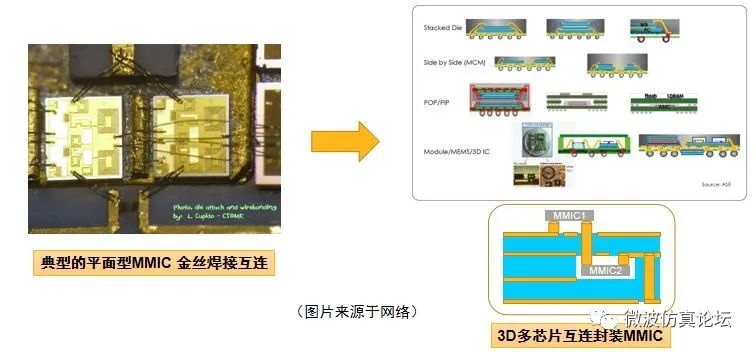
仿真結果分析、展示
本設計用兩個MMIC 互連展示
考慮兩種連接情形分別建模與仿真
Case1:平面型金絲鍵合仿真模型
Chip1和Chip2為兩個濾波器芯片;
Chip1和Chip2通過金絲鍵合;
輸入和輸出微帶線采用陶瓷基板。
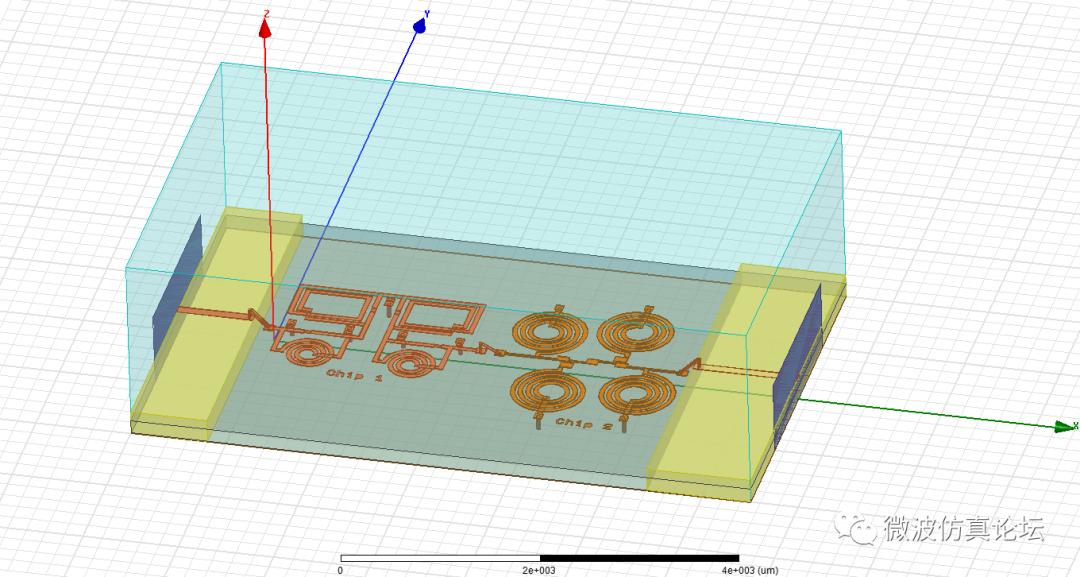
平面型金絲互連仿真模型
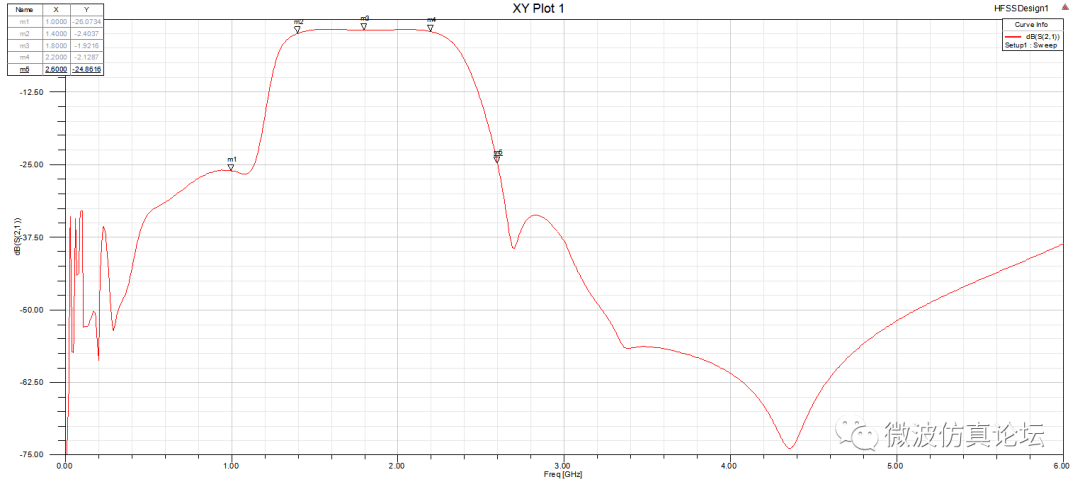
平面型金絲互連仿真結果
Case2:3D集成互連仿真模型
Chip1和Chip2,與Case1相同的兩個濾波器芯片;
Chip1和Chip2通過通孔、銅柱或金球實現信號互連;
采用同樣的陶瓷基板作為芯片的載體。
此處的空氣腔高度設為100 μm。
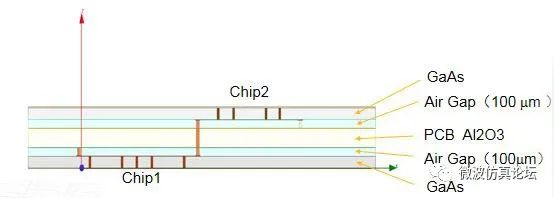
截面圖
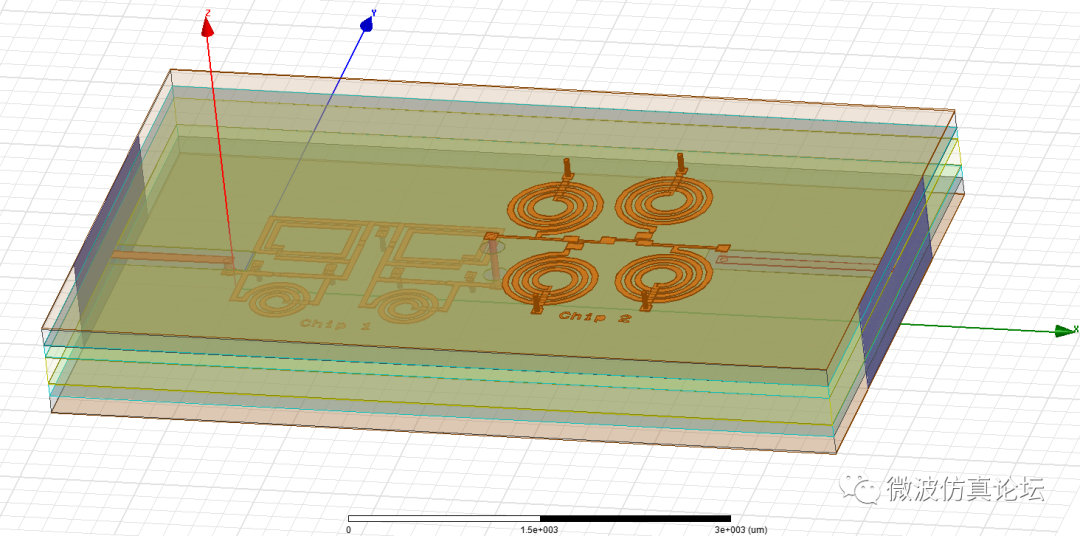
3D集成互連仿真模型
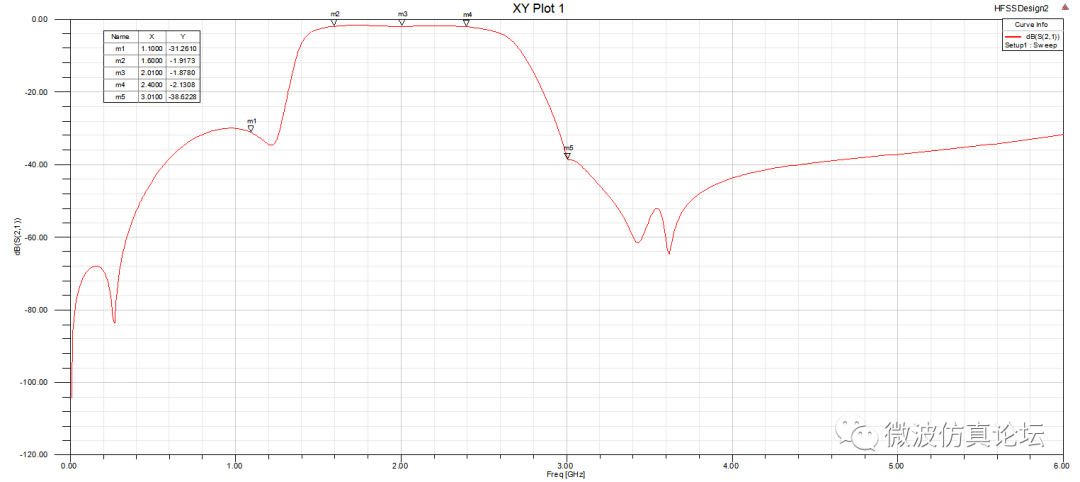
3D集成互連仿真結果
通帶變為:1.6GHz~2.4GHz
原設計通帶(Case1):1.4GHz~2.2GHz
頻段偏移約10%。
小結
1,相較于平面型金絲互連,兩個MMIC芯片3D集成互連之后,發生一定頻偏,頻帶向高偏移約10%。
2,引起頻偏可能的原因:
1) 3D集成的互連結構(通孔、銅柱、金球等)的寄生效應引起頻偏,但相較于芯片中元器件如電感電容而言,該寄生參數相對較小,與金絲的寄生參數量級相當,故影響作用微小。
2) 3D集成引入了較小的空氣腔,本設計空氣腔高度為100μm(工程實踐中會比這高度更低),帶來了新的寄生效應,經分析,當空氣腔高度為芯片基板3倍左右時,頻偏現象可忽略。
3,通過本設計可以看出,應用于3D集成封裝的芯片電路,若單純采用傳統平面型MMIC設計,3D封裝后會造成一定的性能偏差。因此,需有針對性的做完整的3D集成封裝MMIC優化設計,確保3D封裝后滿足電路指標要求。
審核編輯:湯梓紅
-
芯片
+關注
關注
459文章
52192瀏覽量
436253 -
封裝
+關注
關注
128文章
8509瀏覽量
144799 -
仿真設計
+關注
關注
3文章
97瀏覽量
17048 -
MMIC
+關注
關注
3文章
733瀏覽量
25084
原文標題:【案例分享】基于HFSS的3D多芯片互連封裝MMIC仿真設計
文章出處:【微信號:微波仿真論壇,微信公眾號:微波仿真論壇】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄

HFSS高頻電磁場仿真應用
芯片的3D化歷程
3D封裝技術及其發展
英特爾邏輯芯片3D堆疊技術“Foveros” 將實現世界一流性能
利用HFSS軟件進行3D可視化建模

2.5D/3D芯片-封裝-系統協同仿真技術研究
分享一下小芯片集成的2.5D/3D IC封裝技術
3D封裝結構與2.5D封裝有何不同?3D IC封裝主流產品介紹






 基于HFSS的3D多芯片互連封裝MMIC仿真設計
基于HFSS的3D多芯片互連封裝MMIC仿真設計











評論