在上一節計算光學小講堂中,我們學習了光源掩模協同優化(source mask co-optimization, SMO)的相關知識。這一節我們將主要探索光學鄰近效應修正(Optical Proximity Correction,OPC)技術是如何用來提升光刻工藝窗口,為芯片生產保駕護航的。
通過之前兩節課的學習,想必大家對于光學鄰近效應修正已經有了大致的了解。由于***光學系統的不完善性及光路中的衍射光學效應,曝光在晶圓上的最終圖形會和掩模版上的原始圖形產生偏差。
為什么需要光學鄰近效應修正?
隨著線寬尺寸的不斷微縮,這種效應會愈發嚴重,嚴重影響曝光顯影過程的良率。因此需要人為對掩模版上的圖形進行修正抵消這些誤差,使曝光后獲得的圖形滿足設計要求,對于掩模版圖形的修正過程就是光學鄰近效應修正技術。

光學鄰近效應修正技術是什么?
劃重點
這個過程可以類比成射擊打靶,如果我們瞄準靶心,那么由于風向重力等外因往往會導致射偏。在下一次我們需要對瞄準方向相應地向相反方向調整,將誤差考慮進來,通過若干次調整之后,最后正中目標。

基于規則的光學鄰近效應修正技術
在光學鄰近效應修正技術發展的早期,由于圖形尺寸較大,處理流程相對比較簡單直接。光學鄰近效應修正(OPC)軟件可以自動的檢查設計圖形,找出需要修正的部分,并按照事先規定的修正規則查表作出相應的修正,這就是基于規則的光學鄰近效應修正。
下圖是一個一維圖形修正規則表示例,我們可以看當一維圖形的寬度為在150nm到180nm之間,與相鄰圖形的空間距離為185nm到210nm時,圖形需要向外擴11nm來實現對目標圖形的修正。

圖示:一維圖形修正規則表示例
(點擊圖片查看大圖)
隨著圖形尺寸的不斷變小,需要修正的圖形結構越來越多,修正規則也變得越來越復雜,但修正的效果往往卻難以讓人滿意,因此基于模型的光學鄰近效應修正技術在更先進的技術節點被廣泛采用。
基于模型的光學鄰近效應修正
那么基于模型的光學鄰近效應修正是如何對掩模版進行修正的呢?下面是一個簡單的流程演示。
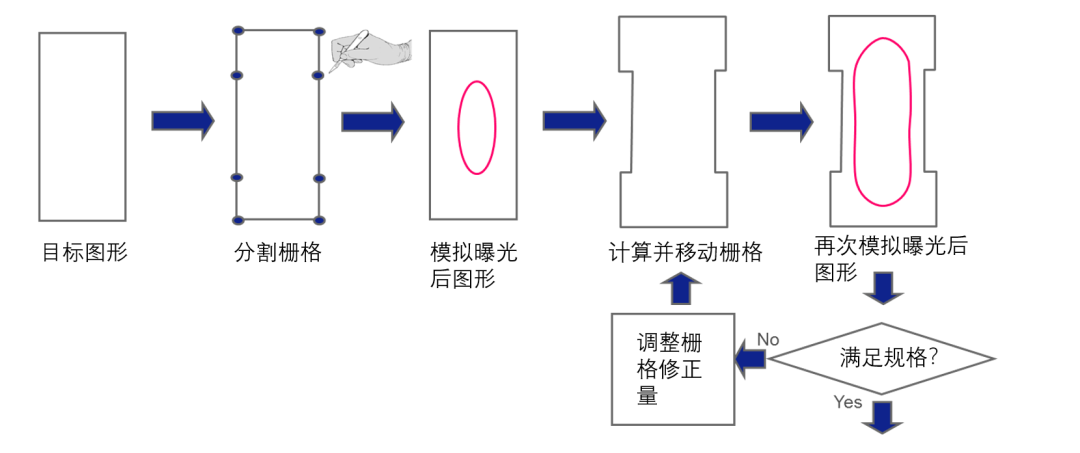
圖示.基于模型的光學鄰近效應修正流程演示
對掩模版進行修正的流程說明
漲知識
01在開始光學鄰近效應修正之前,首先需要通過試驗數據獲得精確的光刻模型,可以對給定掩模版預測出曝光后圖形。
02接下來將待修正圖形分割成一系列短柵格,每條短柵格可以在修正過程中自由移動。
03在每一次的修正過程中,光學鄰近效應修正軟件需要預測出當前掩模版曝光后的圖形并與目標圖形進行對比,計算出兩者之間的差距及短柵格所需修正值,我們把當前結果與目標圖形之間的差距叫做邊緣放置誤差(edge placement error, EPE)。
EPE數值越小,表明我們的修正解與目標越接近,這個過程不斷迭代,直到計算出的邊緣放置誤差達到我們設定的規格范圍內時,我們認為修正效果已經達到,整個光學鄰近效應修正流程完成。
顯然,分割的短柵格數目越多,修正的精細度也越高,但是同時所需的計算量也越大。與此同時過于細碎的柵格分割長度也會使得掩模版的制造更為困難。
以上是一個基本的光學鄰近效應修正應用示例。在實際應用中,根據不同的應用場景與要求,我們還可以在其基礎上拓展其他功能,滿足特定的需要。
拓展的其他功能
對于某些特定的圖形,由于相鄰柵格之間存在很強的相互影響,我們進行校正時不能僅僅只考慮當前柵格,而是需要進行全局優化,尋求更精確的解。
有些情況下我們在進行光學鄰近效應修正時需要考慮光刻設備的工藝參數波動,我們提供的光學鄰近效應修正解決方案不僅需要在理想情況下達到規格要求,而且需要保證在設備工藝參數波動時修正誤差也處在一個可接受的范圍內,避免在實際曝光顯影過程中出現缺陷。
此外有時我們還需要將光刻與后續刻蝕工藝結合起來,考慮刻蝕后圖形線寬的變化狀況,提前對刻蝕偏差進行補償后,再進行光學鄰近效應修正。
曝光輔助圖形
在光學鄰近效應修正中,還有一種常用的工藝窗口增強武器叫做曝光輔助圖形(Sub-Resolution Assist Feature,SRAF)。工程師發現密集圖形與稀疏圖形的光刻工藝窗口是不一樣的,適用于密集圖形曝光的光照條件并不適合稀疏圖形的曝光,這就導致了公共的工藝窗口偏小。
為了解決這一問題,工程師們會在光學鄰近效應修正過程給稀疏圖形旁邊加上曝光輔助圖形。
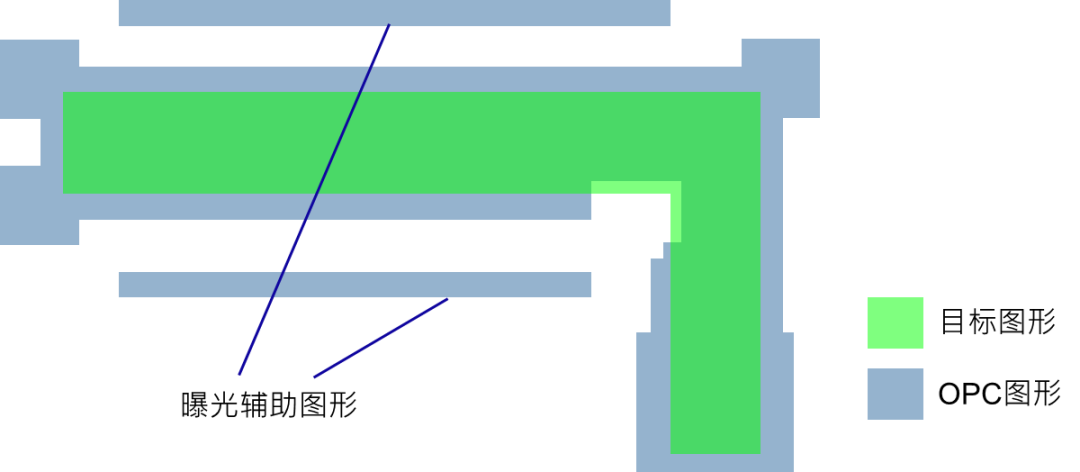
圖示.在設計中添加曝光輔助圖形
曝光輔助圖形
漲知識
所謂曝光輔助圖形是一些很細小的圖形,它們被放置在稀疏圖形的周圍,“偽裝”成密集圖形的樣子。通過這樣的方式可以使稀疏圖形的光刻工藝窗口接近密集圖形的工藝窗口,從而增加整體的公共工藝窗口。在曝光時,它們只對光線起散射作用,而不會在晶圓上形成圖形。因此它的大小必須小于***的分辨率,它和主圖形的距離也必須進行精細控制。
本節講堂主要帶大家學習了光學鄰近效應修正技術的基本知識。從它的基本原理,發展歷史,以及常用的工具幾方面做了簡單介紹。光學鄰近效應修正技術的強大功能,為芯片生產提供了堅實的保障,推動著芯片制造技術不斷向前邁進。
審核編輯:湯梓紅
-
OPC
+關注
關注
7文章
358瀏覽量
47144 -
光學系統
+關注
關注
5文章
250瀏覽量
18669 -
光刻機
+關注
關注
31文章
1163瀏覽量
48101 -
光刻工藝
+關注
關注
1文章
35瀏覽量
1960
原文標題:光刻小講堂|詳解光學鄰近效應修正技術(OPC)
文章出處:【微信號:ASML阿斯麥光刻,微信公眾號:ASML阿斯麥光刻】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 光學鄰近效應修正技術的基本知識
光學鄰近效應修正技術的基本知識


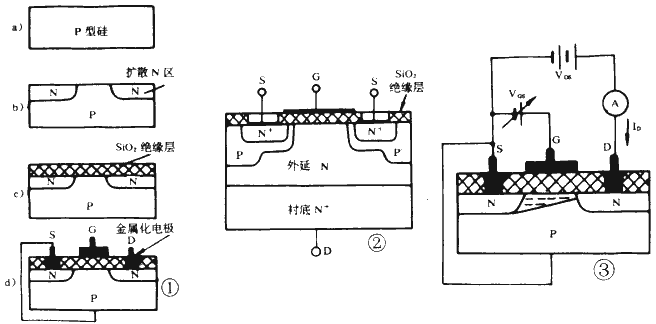


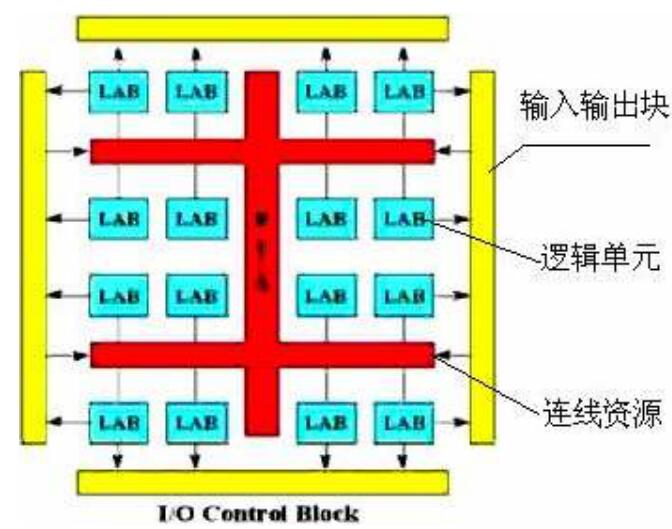












評論