先進封裝競爭不斷向細分領域發展。
昨天(18日),英特爾宣布推出業界首款用于下一代先進封裝的玻璃基板,計劃于2026~2030年量產,憑借單一封裝納入更多的晶體管,預計這將實現更強大的算力(HashRate),持續推進摩爾定律極限,這也是英特爾從封裝測試下手,迎戰臺積電的新策略。
英特爾稱該基板材料是一項重大突破,可解決有機材質基板用于芯片封裝產生的翹曲問題,突破了現有傳統基板的限制,讓半導體封裝晶體管數量極限最大化,同時更省電、更具散熱優勢,將用于更高速、更先進的數據中心、AI、繪圖處理等高端芯片封裝。
英特爾指出,該玻璃基板可以承受更高的溫度,圖案變形減少50%,并具有超低平坦度,可改善曝光深焦,并具有極其緊密的層間互連覆蓋所需的尺寸穩定性。
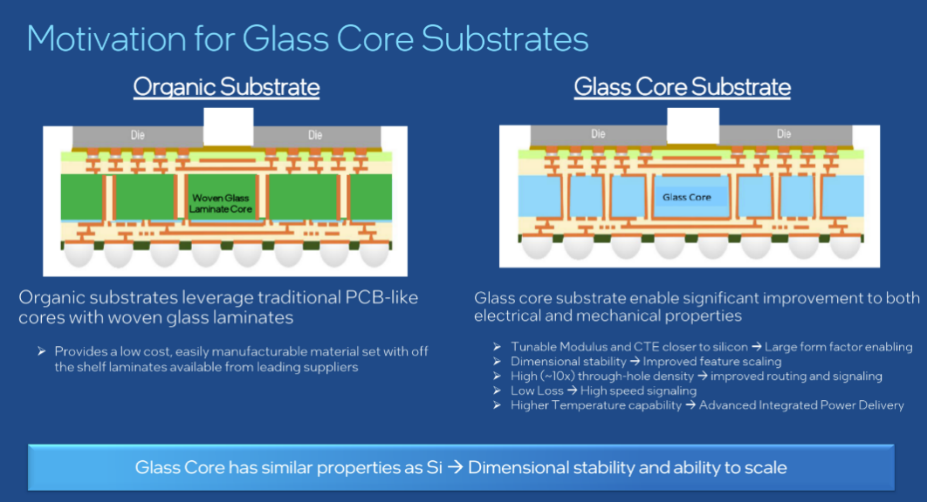
業者指出,玻璃材質的芯片基板,受惠于低間距及更小的膨脹系數,生產制程具優勢,預計相關芯片最早可在2024年年底前生產,搶攻大型數據中心GPU及加速器市場。
英特爾以先進封裝延續摩爾定律至2030年,從系統級單芯片(SoC)轉向系統級封裝(system-in-package),導入嵌入式多芯片互連橋接(EMIB)封裝技術、邏輯芯片3D堆疊封裝技術(Foveros),此外,新開發的3D封裝技術Foveros Omni、Foveros Direct也準備投入量產。
英特爾開發先進封裝技術,一方面能夠提升芯片密度,目標到2030年在一個封裝中,實現1兆個晶體管。另一方面,可以滿足自家產品、代工客戶產品的異質整合需求,提高晶粒(Chiplet)靈活性、并降低成本和功耗。
該公司看好玻璃材質的剛性以及較低的熱膨脹系數,英特爾院士暨組裝與測試總監Pooya Tadayon指出,玻璃基板有很大優勢,用來降低連接線路的間距,適用于大尺寸封裝。
Pooya Tadayon表示,使用玻璃材料能夠提高芯片供電效率,互連密度可以提高10倍,將帶寬近翻倍提升至448G。他強調,玻璃基板將逐漸普及,并與有機材質基板共存。
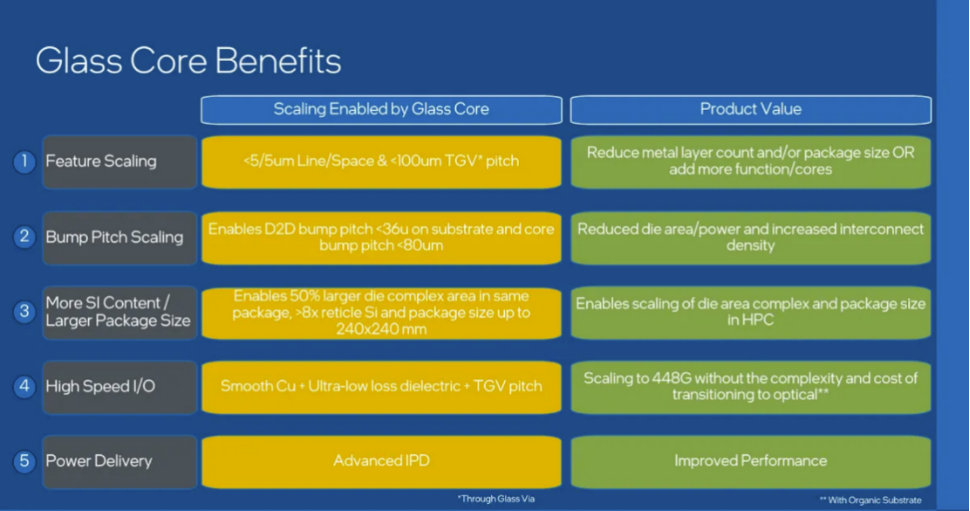
英特爾計劃于2026~2030年進入量產階段,相關業者表示,目前處在實驗、送樣階段,加工穩定性仍有待改善。不過法人就先進封裝市場依舊保持樂觀,并認為市場將快速增長。目前,先進封裝多數應用在包括英特爾、AMD和英偉達的數據中心芯片,估計2023年合計出貨量900萬個。
英特爾已規劃2024年主流NB用CPU平臺Meteor Lake,導入先進封裝Foveros技術,在interposer(中間層)上使用4個芯片,預估2024年使用先進封裝芯片將10倍數增長至9000萬個。
未來,在低延遲和線下使用需求推動下,更可能進一步使用在手機端推理芯片,大量參數的LLM模型需要手機端裝上更大面積先進封裝的芯片,最快2025年可能導入5.5億支高端機種,市場需求充滿想象。
對攻臺積電
這一突破性成果是英特爾為其美國晶圓代工廠增強先進封裝能力的另一個跡象,也是英特爾迎戰臺積電的新策略。
臺積電的亞利桑那州晶圓廠計劃生產4nm和3nm芯片,但目前并無在亞利桑那州或美國境內打造封裝廠的計劃,主要卡關因素是成本高昂,因此,這些先進芯片不會在美國完成封裝。
英特爾先進封裝資深經理Mark Gardner于今年5月份指出,英特爾芯片制造工廠和組裝、測試、封裝站點分布在世界各地,而臺積電大部分芯片制造設施都在臺灣地區,英特爾的優勢在于提供安全供應鏈、分散地緣風險,也可提供客戶部分IDM流程,彈性選擇。
Gardner 稱:“英特爾晶圓制造服務愿意讓客戶只使用服務的一部分,也就是說,他們可以委托其它晶圓代工廠生產芯片,英特爾只做封測。”
業界分析,英特爾下一代玻璃基板先進封裝解決方案,可提供更大面積、更具效能的封裝服務,此舉將掀起全球半導體封裝新一波革命,與日月光、安靠等專業封測廠一較高下。
雖然沒有透露合作的供應鏈名單,但英特爾表示,其投入玻璃基板相關研發,并與材料及設備廠緊密合作,希望建構相關生態系。也認為即使有了玻璃基板方案,未來也會跟有機基板方案持續共存,并非完全取代。
業界:量產技術仍不成熟
對于英特爾的玻璃基板,PCB載板廠商表示,量產技術仍不成熟,該技術是否有出海口仍需觀察。
載板先前市場已有耳語玻璃基板,目前核心層本來就有特殊玻璃材料且內含在PCB載板,但相關技術仍不成熟,仍在實驗室技術開發中。
業界預期,相關技術將在成熟后才能搭配ABF載板或硬板,而且,如果是涉及玻璃基板的封裝段則是硅中間層或其它材質的變化,實際和PCB載板廠商生產制程較無關,而是封裝部分的材質流程變化。
-
英特爾
+關注
關注
61文章
10183瀏覽量
174156 -
封裝
+關注
關注
128文章
8598瀏覽量
144990 -
玻璃基板
+關注
關注
1文章
100瀏覽量
10730 -
先進封裝
+關注
關注
2文章
465瀏覽量
549
原文標題:英特爾推出下一代先進封裝用玻璃基板,業界提出質疑
文章出處:【微信號:ICViews,微信公眾號:半導體產業縱橫】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
英特爾先進封裝,新突破
英特爾與面壁智能宣布建立戰略合作伙伴關系,共同研發端側原生智能座艙,定義下一代車載AI

英特爾先進封裝:助力AI芯片高效集成的技術力量

英特爾下一代桌面測試處理器 Nova Lake 現身
英特爾Intel 18A制程芯片2025年量產計劃公布
10月29日英特爾將發布新一代酷睿Ultra Series 2處理器及圖形產品線
淺談英特爾在先進封裝領域的探索
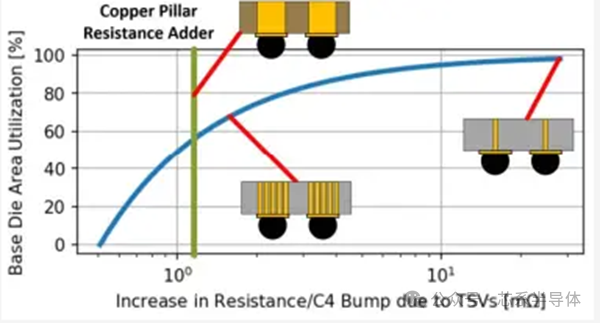





 英特爾推出下一代先進封裝用玻璃基板,業界提出質疑
英特爾推出下一代先進封裝用玻璃基板,業界提出質疑














評論