英特爾近期宣布推出一種新型處理器技術,使用玻璃基板替代傳統的有機基板,有望徹底改變處理器和芯片的制造方式。相較于有機基板,玻璃基板具備更高的互連密度、更高效的輸入/輸出、更快速的信號傳輸、更低的功耗,并且可以實現類似硅的熱膨脹,有助于制造更大的封裝。
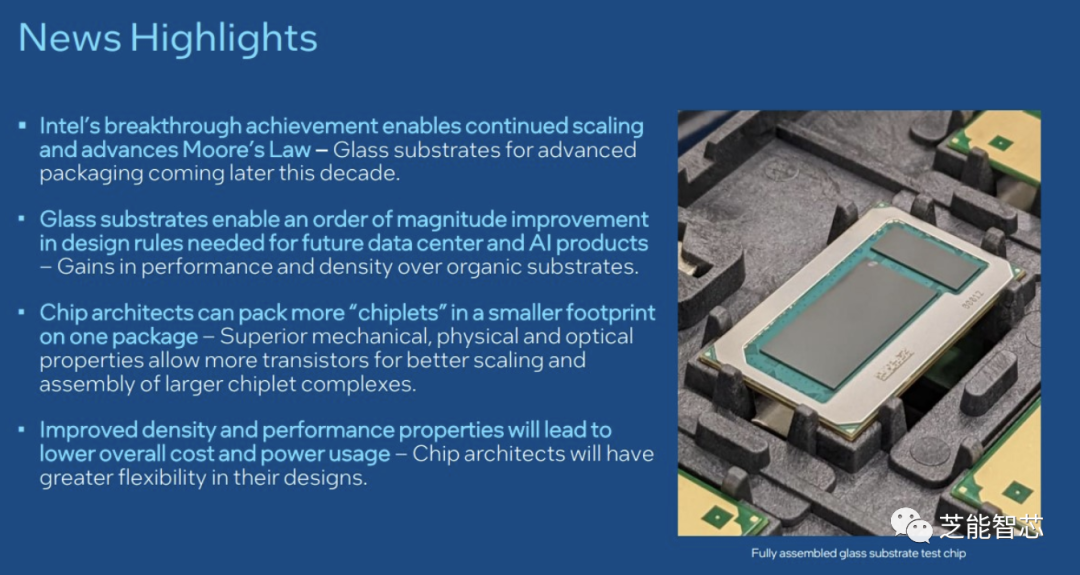
英特爾還計劃引入玻璃通孔技術(TGV),將類似于硅通孔的技術應用于玻璃基板,還推出了Foveros Direct,這是一種具有直接銅對銅鍵合功能的高級封裝技術。計劃為可插拔共封裝光學器件設計一種基于玻璃的耦合技術。這些創新將使處理器和芯片在性能、功耗和功能方面取得巨大進展,為未來計算技術的發展鋪平了道路。
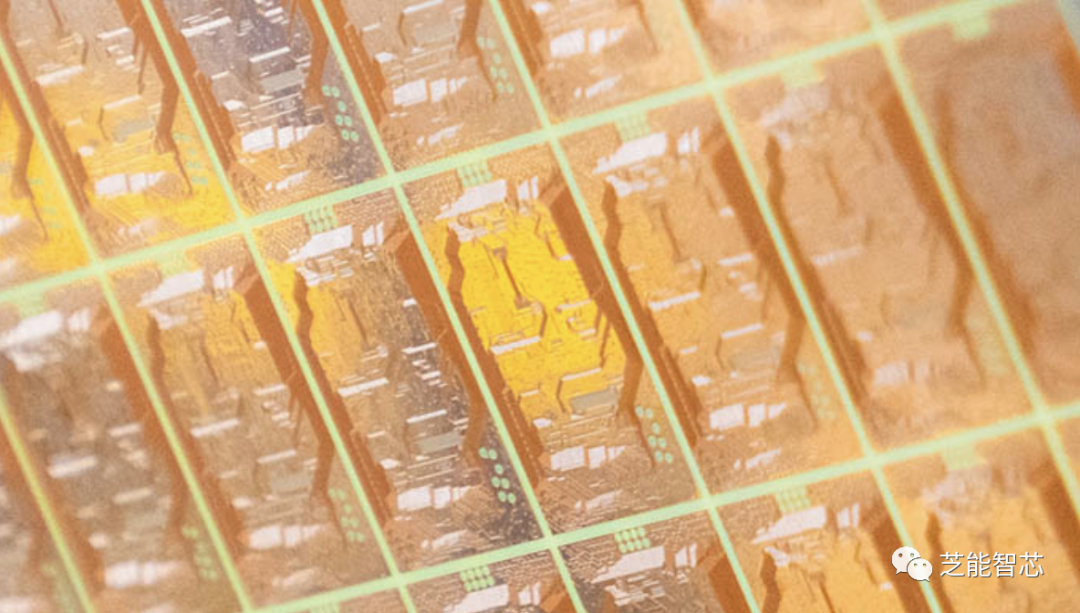
玻璃基板封裝技術:處理器制造的差異化:英特爾最近宣布了一項令人振奮的技術突破,將引入一種創新的處理器技術,采用玻璃基板替代傳統的有機基板

高密度互連與光學互連的實現
玻璃基板技術將帶來更高的互連密度和集成光學互連的能力,為處理器的性能提升提供了新的可能性。相較于傳統有機基板,玻璃基板不僅功耗更低,而且信號傳輸速度更快,為計算設備的高效運行提供了關鍵支持。
先進封裝選項
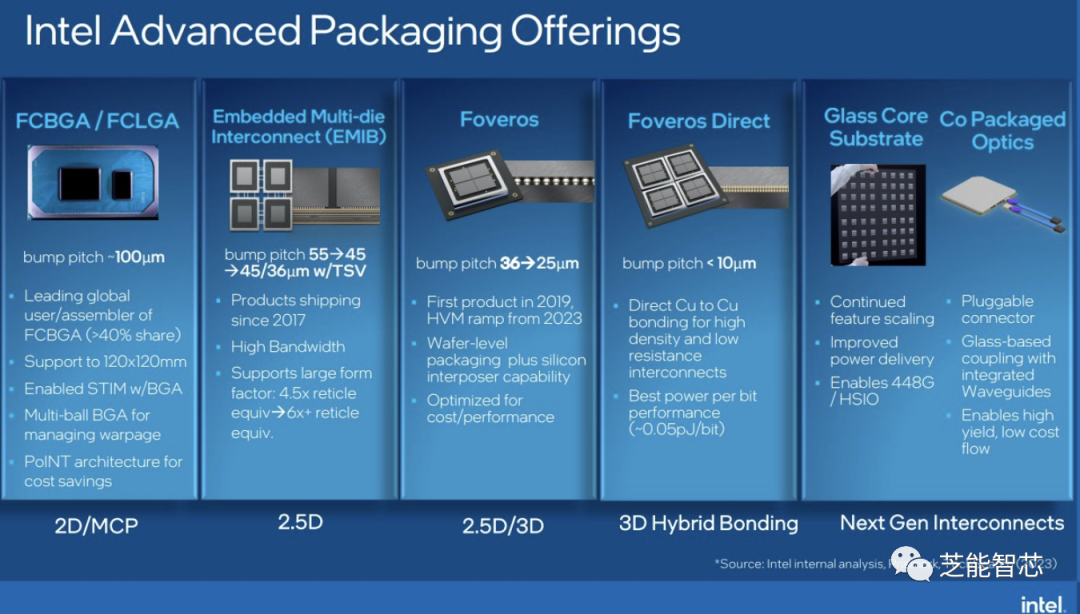
英特爾的新技術不僅僅停留在玻璃基板的層面,還引入了Foveros Direct,這是一種具有直接銅對銅鍵合功能的高級封裝技術,計劃為可插拔共封裝光學器件設計一種基于玻璃的耦合技術,已在英特爾創新 2022 上展示,為處理器的未來功能拓展奠定了基礎。

相較于有機基板,玻璃基板的制造具備更高的靈活性,可以調整為具有類似于硅的熱膨脹特性,這有助于制造更大封裝的處理器。英特爾預測,相較于有機基板,玻璃基板可以獲得10倍甚至更多的通孔密度,實現更低的能耗和更高速度的信號傳輸(高達448G)。
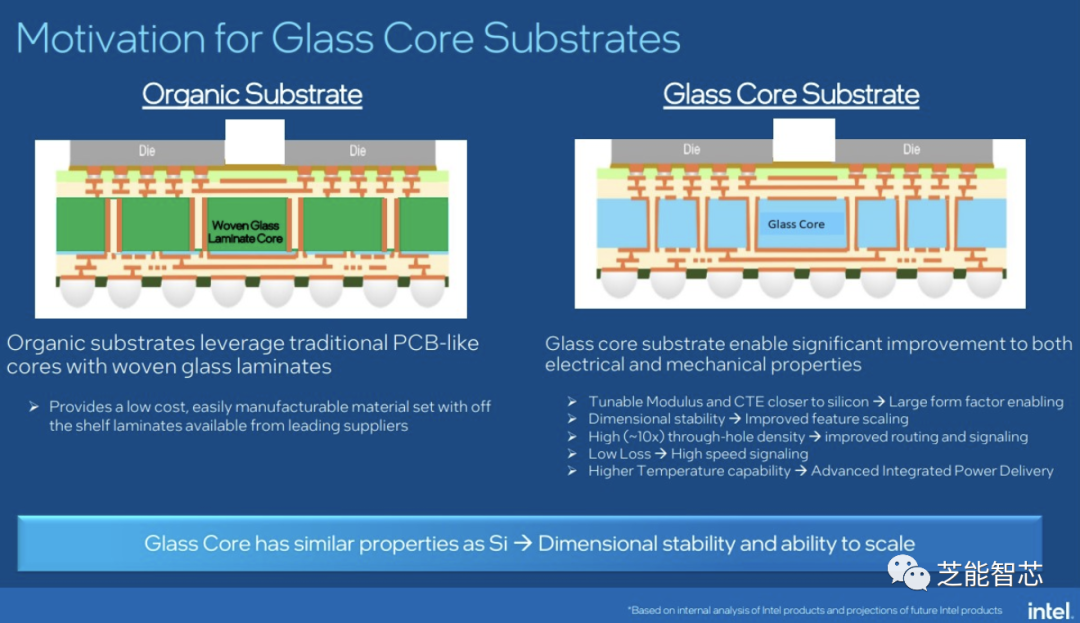
玻璃通孔技術的應用
硅通孔技術(TSV)現在正被成功應用于玻璃基板上,與以往相比,新一代處理器將在更小的體積內實現更多的組件,從而提高了設備的緊湊性和性能。
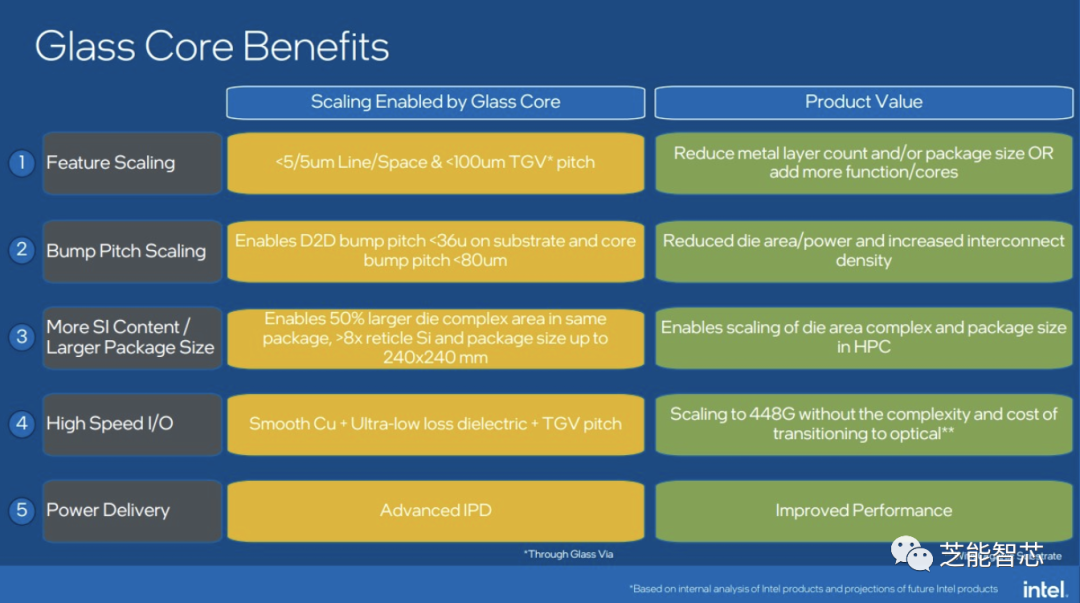
展望未來
英特爾明確表示,這項突破性的技術披露為未來的計算設備和人工智能提供了嶄新的可能性。
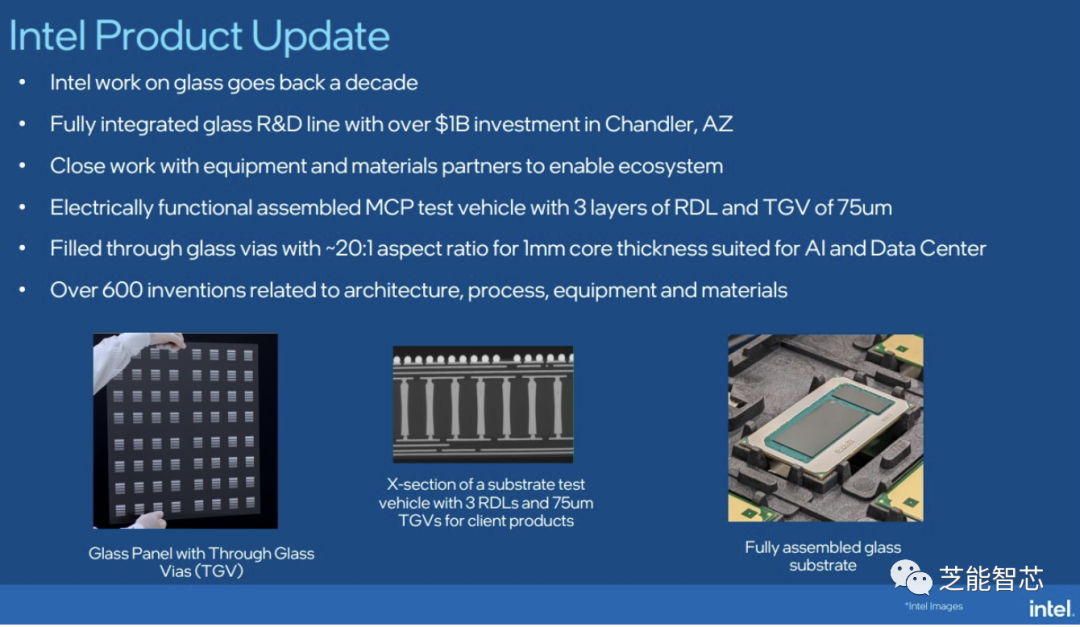
-
英特爾
+關注
關注
61文章
10196瀏覽量
174709 -
封裝
+關注
關注
128文章
8685瀏覽量
145516 -
玻璃基板
+關注
關注
1文章
100瀏覽量
10779
原文標題:下一代英特爾玻璃基板封裝轉型概述
文章出處:【微信號:QCDZSJ,微信公眾號:汽車電子設計】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
英特爾與面壁智能宣布建立戰略合作伙伴關系,共同研發端側原生智能座艙,定義下一代車載AI

英特爾下一代桌面測試處理器 Nova Lake 現身
下一代FOPLP基板,三星續用塑料,臺積青睞玻璃
英特爾Intel 18A制程芯片2025年量產計劃公布
英特爾聯合中科創達構建下一代智能座艙平臺
10月29日英特爾將發布新一代酷睿Ultra Series 2處理器及圖形產品線
淺談英特爾在先進封裝領域的探索
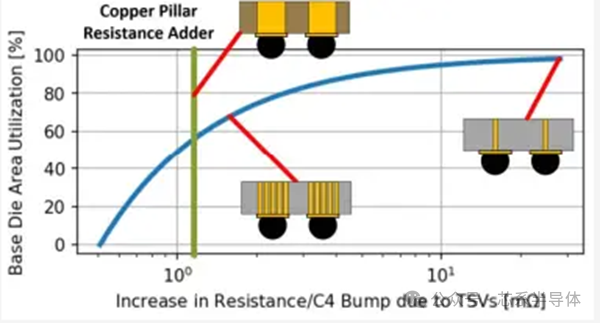
龍芯中科胡偉武:3B6600 八核桌面 CPU 性能將達到英特爾中高端酷睿 12~13 代水平
英特爾正式推出第一代車載獨立顯卡






 下一代英特爾玻璃基板封裝轉型概述
下一代英特爾玻璃基板封裝轉型概述















評論