本文轉(zhuǎn)載自: TechInsights微信公眾號(hào)
2021年10月12日,三星宣布“三星新的五層EUV工藝實(shí)現(xiàn)了業(yè)界最高的DRAM位密度,將生產(chǎn)率提高了約20%”[1]。TechInsights在2023年2月17日發(fā)布的三星Galaxy S23 plus智能手機(jī)中獲得了三星D1a LPDDR5X DRAM器件[2]。經(jīng)過深入的SEM和TEM成像,并結(jié)合TEM EDS/EELS元素分析,TechInsights即將發(fā)布三星D1a nm 16 Gb LPDDR5X器件的分析報(bào)告。基于結(jié)構(gòu)和材料逆向工程分析數(shù)據(jù),TechInsights發(fā)現(xiàn)了四種EUV光刻(EUVL)工藝,用于陣列有源切割/外圍有源(有源修剪)、位線接觸(BLC)、存儲(chǔ)節(jié)點(diǎn)接觸墊(SNLP)/外圍第一金屬層 (M1)和存儲(chǔ)節(jié)點(diǎn)(SN)管圖形化。通過逆向工程分析沒有明顯的證據(jù)來確定EUVL工藝的第五層圖形化層。
下表列出了三星D1y nm、D1z nm和D1a nm工藝器件的陣列有源切割、BLC、SNLP、SN管的最小寬度和節(jié)距,以及用于每層制模的光刻工藝。

下圖包含了三星D1a nm(圖a)、D1z nm(圖b)和D1y nm(圖c)器件在存儲(chǔ)陣列有源層的TEM平面視圖。存儲(chǔ)器陣列中的有源切口具有交錯(cuò)孔布局。三星D1y nm器件的陣列有源切割間距為68 nm,達(dá)到了193i光刻的分辨率極限。單193i光刻工藝用于圖形化陣列有源切割/外圍有源。三星D1z nm器件的陣列有源切割間距為63 nm。雙圖形化工藝可能用于圖形陣列有源切割/外圍有源。三星D1a nm器件的陣列有源切割間距為56 nm。
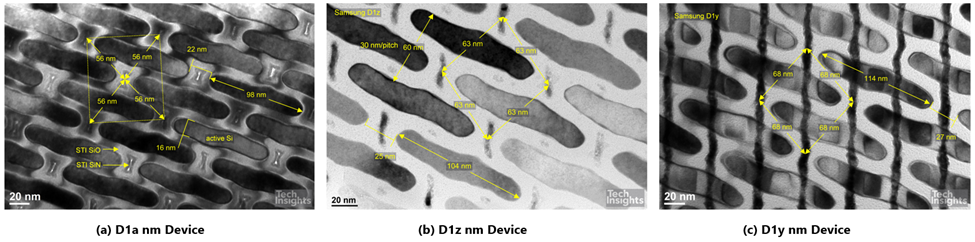
圖1:在DRAM陣列有源層上的TEM平面視圖
圖2是三星D1a nm (a)、D1z nm (b)和D1z nm (c)器件在外圍有源層的SEM平面視圖圖像。WL有源驅(qū)動(dòng)中間的T型STI有一個(gè)尖角,如圖2(a)所示;而WL有源驅(qū)動(dòng)中間的T型STI有一個(gè)相對(duì)光滑的角,如圖2(b)和圖2(c)所示。這清楚地表明,存儲(chǔ)陣列中的有源切口和外圍的有源切口采用的是單一EUVL工藝,而不是193i雙重圖形化工藝。
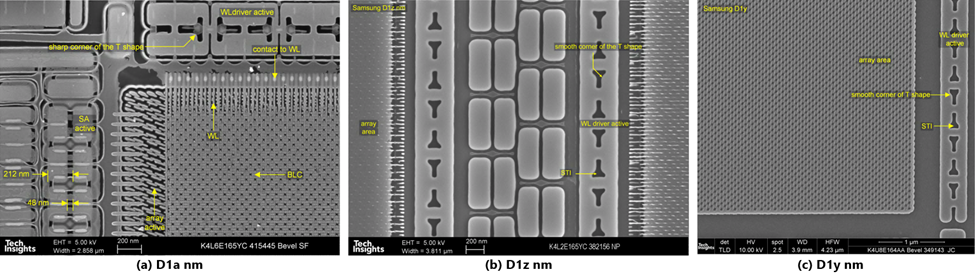
圖2:外圍有源層SEM平面圖
圖3為三星D1y nm (a)、D1z nm (b)和D1a nm (c)在DRAM位線接觸(BLC)層的TEM平面視圖圖像。BLC具有如下圖所示的交錯(cuò)孔布局。三星D1y nm器件的BLC間距為70 nm(圖a),這是193i光刻的分辨率極限。因此,采用單一的193i光刻工藝對(duì)BLC進(jìn)行圖形化。如圖3 (b)所示,三星D1z nm器件的BLC間距為64 nm;由于在BLC特殊區(qū)域(如藍(lán)點(diǎn)所示)使用掩膜的負(fù)色調(diào)顯影(NTD)光刻工藝來對(duì)BLC進(jìn)行圖形化設(shè)計(jì),因此可以觀察到連續(xù)的SiN間隔(參見有關(guān)三星12 Gb 1z EUV LPDDR5 Advanced Memory Essentials, AME2102 -801的更多詳細(xì)信息)。如圖3(c)所示,三星D1a nm器件的BLC間距為56 nm;如圖3 (a)所示,BLC SiN間隔片不是連續(xù)的,這與三星D1y nm器件中的BLC SiN間隔片相同。單個(gè)EUVL工藝可能用于三星D1a nm器件中的BLC圖形化。
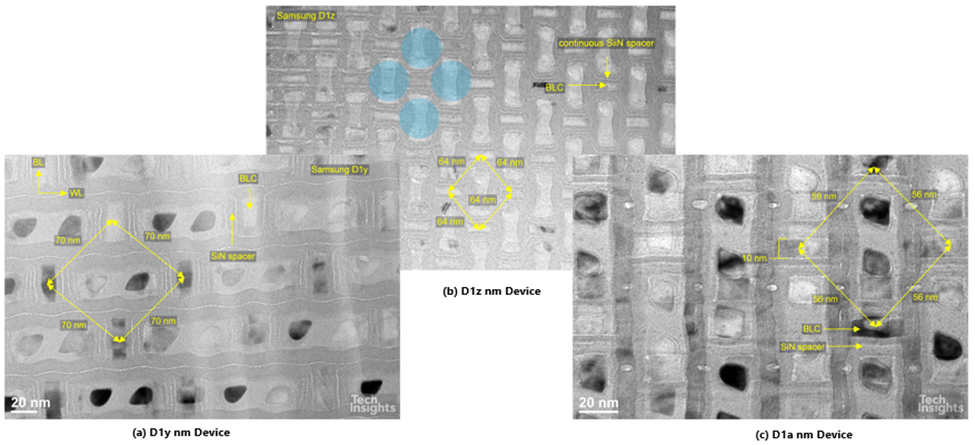
圖3:陣列BLC層TEM平面視圖
圖4包括了三星D1a nm器件SNLP層的SEM (a)和TEM (b)平面視圖圖像。與三星D1z nm制程器件相同,圓形SNLP和陣列邊緣的連續(xù)M1線表明使用單個(gè)EUVL制程對(duì)存儲(chǔ)節(jié)點(diǎn)接觸墊(SNLP)和外圍M1進(jìn)行了圖形化。
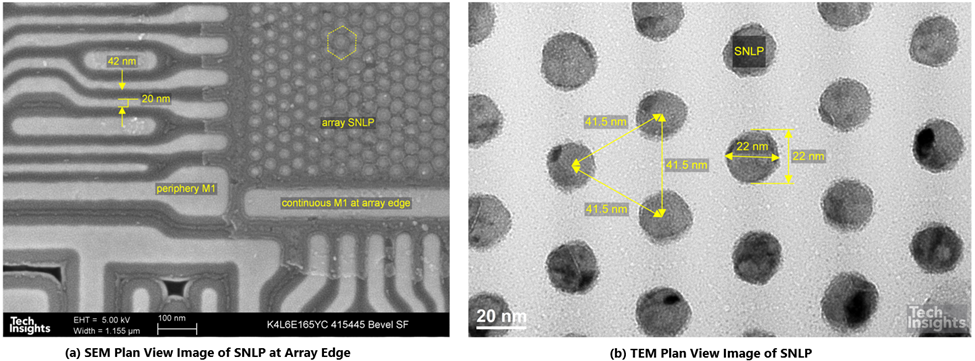
圖4:三星D1a nm器件陣列SNPL層的SEM和TEM平面視圖
圖5為三星D1z nm (a)和D1a nm (b)器件電容層的TEM平面視圖圖像。D1z nm器件的電容存儲(chǔ)節(jié)點(diǎn)(SN)管間距為46.0 nm, D1a nm器件的SN管間距為41.5 nm。在三星D1z器件中,采用雙向自對(duì)準(zhǔn)雙圖像化工藝對(duì)SN管進(jìn)行圖像化(詳見三星12Gb 1z EUV LPDDR5 process Flow Full, PFF-2102-801)。如圖5 (a)所示,由于雙向自對(duì)準(zhǔn)圖像化工藝的偏移和工藝均勻性問題,部分SN管在一個(gè)方向上比另一個(gè)方向略微拉長(zhǎng)。D1a nm器件中的SN管在TEM斜角水平呈圓形,直徑為23 nm(圖5 (b))。因此,單一EUVL工藝可能用于三星D1a nm器件的SN管圖案。
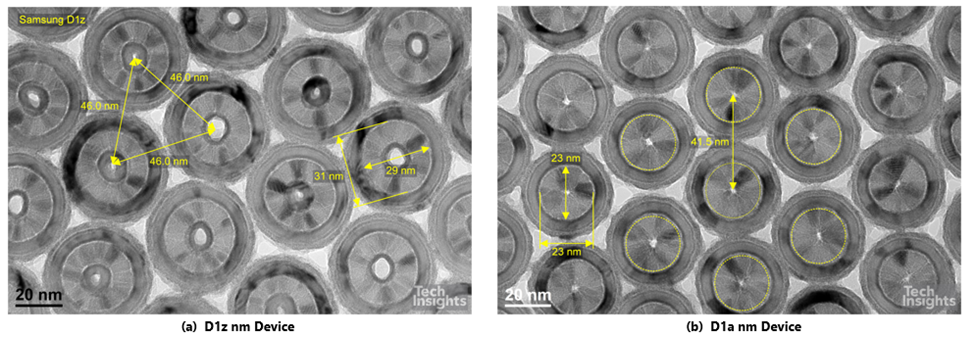
圖5:在陣列電容層的TEM平面視圖
References:
[1] Samsung Starts Mass Production of Most Advanced 14nm EUV DDR5 DRAM
[2] Samsung Announces Global Launch of the Galaxy S23 Series
審核編輯 黃宇
-
DRAM
+關(guān)注
關(guān)注
40文章
2343瀏覽量
185282 -
光刻
+關(guān)注
關(guān)注
8文章
344瀏覽量
30618 -
EUV
+關(guān)注
關(guān)注
8文章
609瀏覽量
87009 -
LPDDR5
+關(guān)注
關(guān)注
2文章
90瀏覽量
12500 -
三星
+關(guān)注
關(guān)注
1文章
1687瀏覽量
32455
發(fā)布評(píng)論請(qǐng)先 登錄
LPDDR5X更輕薄了!明年旗艦機(jī)型或?qū)⒉捎?/a>
三星在4nm邏輯芯片上實(shí)現(xiàn)40%以上的測(cè)試良率
LPDDR5X:面向高性能與能效的增強(qiáng)型移動(dòng)內(nèi)存
LPDDR5X速率刷新記錄,LPDDR5-Ultra-Pro DRAM來了
三星Galaxy S25系列搭載美光LPDDR5X內(nèi)存和UFS 4.0
三星LPDDR5X榮獲CES 2025創(chuàng)新獎(jiǎng)
佰維存儲(chǔ)發(fā)布LPDDR5X高效能內(nèi)存
今日看點(diǎn)丨 2011億元!比亞迪單季營(yíng)收首次超過特斯拉;三星將于2025年初引進(jìn)High NA EUV光刻機(jī)
簡(jiǎn)述光刻工藝的三個(gè)主要步驟
光刻工藝的基本知識(shí)






 三星D1a nm LPDDR5X器件的EUV光刻工藝
三星D1a nm LPDDR5X器件的EUV光刻工藝










評(píng)論