半導(dǎo)體行業(yè)的發(fā)展離不開行業(yè)的共識,而行業(yè)的共識往往體現(xiàn)在行業(yè)所公認(rèn)的路線圖里面。在上世紀(jì)末,美國的半導(dǎo)體工業(yè)協(xié)會SIA聯(lián)合歐洲和亞洲的半導(dǎo)體行業(yè),開始發(fā)布大名鼎鼎的國際半導(dǎo)體技術(shù)路線圖(ITRS)。ITRS主要的貢獻(xiàn)是通過協(xié)調(diào)全球的半導(dǎo)體行業(yè),發(fā)布了在21世紀(jì)初十多年中的芯片技術(shù)路線圖,包括特征尺寸,功率密度,邏輯門密度等等。到了2015年,隨著傳統(tǒng)基于2D CMOS特征尺寸縮小的摩爾定律的發(fā)展到了尾聲,ITRS也不再更新,因此2015年版本就是ITRS的最后一個版本。在當(dāng)時,作為ITRS的牽頭方之一,SIA發(fā)表聲明將會在未來合適的時候發(fā)布新的半導(dǎo)體路線圖。而在上周,SIA和SRC聯(lián)合發(fā)布了微電子和高級封裝路線圖,作為ITRS的后繼者。

MAPT路線圖分析了未來十年內(nèi)預(yù)期對于半導(dǎo)體行業(yè)最重要的驅(qū)動應(yīng)用,其中最重要的包括:
- l數(shù)據(jù)中心和高性能計算
- l汽車電子
- l物聯(lián)網(wǎng)和邊緣計算
- l移動通信
- l生物計算
數(shù)字芯片向來是半導(dǎo)體芯片中最核心的品類,其出貨量大,對于半導(dǎo)體芯片工藝的依賴度高,往往是驅(qū)動整個半導(dǎo)體行業(yè)發(fā)展的核心芯片品類;因此在在MAPT路線圖中,對于數(shù)字芯片相關(guān)的路線圖分析也是最詳實的。
在MAPT中,數(shù)字邏輯未來的進(jìn)步主要靠架構(gòu)上的進(jìn)步。MAPT提出主要的進(jìn)步方向包括:
進(jìn)一步提升集成度:由于半導(dǎo)體工藝進(jìn)步在未來十年中對于邏輯密度的提升貢獻(xiàn)有限,為了進(jìn)一步提升集成度,主要需要依靠高級封裝技術(shù)。高級封裝技術(shù)可以用不同的堆疊方式(2.5D以及3D)把不同的芯片粒(chiplet)集成在同一個封裝里并且可以解決先進(jìn)工藝的良率問題,因此可望在未來中高端芯片中得到更廣泛的應(yīng)用。
降低數(shù)據(jù)移動開銷:隨著未來芯片集成度越來愈高(即邏輯越來越復(fù)雜),數(shù)據(jù)互聯(lián)的開銷將會成為芯片性能和能效比的主要瓶頸;例如,根據(jù)之前的研究,在10nm節(jié)點,高復(fù)雜度的SoC中數(shù)據(jù)互聯(lián)的功耗開銷已經(jīng)占到整個芯片功耗的90%左右,而未來隨著復(fù)雜度和集成度進(jìn)一步提升,數(shù)據(jù)互聯(lián)將會越來越成為瓶頸。為了解決這個問題,一方面需要使用高級封裝技術(shù)——例如,通過3D堆疊,互聯(lián)的物理距離會大大降低(因為可以垂直走線),從而降低功耗;另一個重點則是通過新的架構(gòu),例如近內(nèi)存計算和存內(nèi)計算,來降低開銷;最后,模擬和混合信號電路的創(chuàng)新也能降低數(shù)據(jù)移動的開銷。
正如MAPT在數(shù)字邏輯章節(jié)的分析,高級封裝將成為未來半導(dǎo)體的主旋律。
例如,在未來五年中,一個系統(tǒng)中芯片粒的數(shù)量將從今天的4-10提升到10-30(提升3倍),預(yù)計在十年的時間內(nèi)芯片粒數(shù)量會提升更多;在內(nèi)存角度,芯片粒將會實現(xiàn)新的內(nèi)存架構(gòu),從而改善內(nèi)存墻問題,到時候希望內(nèi)存的容量、速度和功耗將不再成為整個系統(tǒng)的瓶頸;在互聯(lián)方面,未來10年高級封裝的互聯(lián)線數(shù)量將從今天的1000-2000上升到8000,另外使用新的IO接口技術(shù)(例如PAM8,以及高密度WDM光學(xué)互聯(lián))來進(jìn)一步提升數(shù)據(jù)帶寬并降低數(shù)據(jù)移動開銷。
這些需求具體對應(yīng)到高級封裝的技術(shù)演進(jìn),MAPT在高級封裝章節(jié)提出了未來十年的技術(shù)演進(jìn)方向。
我們認(rèn)為,在高級封裝未來十年中,最關(guān)鍵的技術(shù)演進(jìn)包括:
進(jìn)一步提升IO密度:將芯片粒之間的bump(焊球)間距從100微米降低到25微米,從而將IO密度提升16倍。
進(jìn)一步提升IO互聯(lián)線密度:這里的互聯(lián)線密度包括在晶圓正面將今天的2-3層線間距大于1微米的頂層銅互聯(lián)發(fā)展到7層線間距小于1微米的銅互聯(lián),晶圓背面的RDL層互聯(lián)從一層上升到三層互聯(lián)并且將線間距從10微米降低到2微米;以及在晶圓間的互聯(lián)線間距從5微米降低到1微米,即互聯(lián)線密度提升25倍。
革新集成鍵合技術(shù):從目前基于焊接(solder)的鍵合集成技術(shù)逐漸改進(jìn)到die-to-wafer以及die-to-die的鍵合。新的集成鍵合技術(shù)將是實現(xiàn)高密度IO的核心技術(shù)。
模擬和混合信號電路在未來十年的半導(dǎo)體路線圖中也扮演了重要角色,因為模擬和混合信號電路仍將是重要應(yīng)用的賦能技術(shù)。
在半導(dǎo)體設(shè)計端,EDA/IP和芯片是利潤核心環(huán)節(jié)。EDA/IP市場規(guī)模隨工藝制程演進(jìn)而提升,全球市場預(yù)計將達(dá)到215億美元左右。同時,全球半導(dǎo)體IP市場也將持續(xù)增長,預(yù)計到2027年將達(dá)到101億美元。在芯片類型方面,模擬、功率、存儲等因應(yīng)用不同體現(xiàn)出不同的增長表象。模擬芯片因應(yīng)用分散而穩(wěn)步增長,功率芯片因新能源爆發(fā)式增長而供不應(yīng)求,存儲芯片因算力需求而前景廣闊。
下游半導(dǎo)體終端客戶的需求變化直接影響封測行業(yè)的技術(shù)路線和稼動率。隨著智能手機(jī)、數(shù)據(jù)中心、高性能服務(wù)器等應(yīng)用領(lǐng)域?qū)啥鹊囊笤絹碓礁撸统杀尽⒌凸摹⑿⌒突纫髮⒊掷m(xù)催動Chiplet市場增加。
在路線圖中,我們可以看到GaN和SiC功率電子芯片都會得到長足的發(fā)展。對于SiC來說,預(yù)計未來10-15年,支持的電壓將從今天的3.3kV拓展到15-25kV,從而為新能源應(yīng)用提供支持,同時也進(jìn)一步增加器件載流子移動速率以提升器件的性能(支持更高的開關(guān)頻率);而GaN也在提供高器件性能和開關(guān)頻率的同時增加對于高電壓的支持,從今天的650V提升到3.3kV,而除此之外另一個重要的演進(jìn)方向是進(jìn)一步提升GaN對于硅基底(GaN on Silicon)的支持,在10年后預(yù)計200mm GaN-on-silicon晶圓將成為標(biāo)準(zhǔn)配置,從而進(jìn)一步降低GaN的成本并且有機(jī)會支持更方便的高級封裝集成。
半導(dǎo)體行業(yè)于未來依舊延續(xù)著廣大的發(fā)展舞臺與機(jī)緣,以下為數(shù)種或許之趨勢:
人工智能和機(jī)器學(xué)習(xí)的廣泛普及將為半導(dǎo)體需求帶來推動。此類技術(shù)所需之更為高效、迅疾和穩(wěn)定之半導(dǎo)體產(chǎn)物,如GPU、TPU等,皆將持續(xù)受用。
物聯(lián)網(wǎng)之興起將推動半導(dǎo)體需求之蓬勃增長。物聯(lián)網(wǎng)所須之各式傳感器、芯片、處理器和通訊設(shè)備等半導(dǎo)體產(chǎn)品,隨著其在各領(lǐng)域應(yīng)用愈趨廣泛,其對半導(dǎo)體之渴求更將擴(kuò)展。
5G技術(shù)之廣泛傳播將引發(fā)新的需求與機(jī)遇。5G所需之高性能、低功耗、寬帶之芯片和通訊設(shè)備,將使半導(dǎo)體行業(yè)面對新的成長契機(jī)。
可穿戴設(shè)備和智能家居市場之?dāng)U張將推動半導(dǎo)體需求之蓬勃增加。此類設(shè)備所需之微小、低耗、高效半導(dǎo)體產(chǎn)物,如傳感器、微控制器等,皆將因之受益。
環(huán)保與可持續(xù)發(fā)展之要求將引導(dǎo)半導(dǎo)體行業(yè)朝著更為綠色、高效之方向前進(jìn)。綠色半導(dǎo)體技術(shù)、新能源材料和可持續(xù)制造技術(shù),將為未來半導(dǎo)體行業(yè)之重要方向。
總之,半導(dǎo)體行業(yè)于未來仍然懷揣著廣大的發(fā)展前景,技術(shù)創(chuàng)新、市場需求以及環(huán)保的可持續(xù)性,將共同成為其發(fā)展道路上的重要引擎。
審核編輯:黃飛
-
物聯(lián)網(wǎng)
+關(guān)注
關(guān)注
2927文章
46015瀏覽量
389303 -
人工智能
+關(guān)注
關(guān)注
1805文章
48833瀏覽量
247315 -
機(jī)器學(xué)習(xí)
+關(guān)注
關(guān)注
66文章
8496瀏覽量
134217 -
5G
+關(guān)注
關(guān)注
1360文章
48772瀏覽量
570973 -
半導(dǎo)體行業(yè)
+關(guān)注
關(guān)注
9文章
403瀏覽量
41056
原文標(biāo)題:半導(dǎo)體產(chǎn)業(yè)的發(fā)展趨勢。
文章出處:【微信號:wcdz8888,微信公眾號:威臣電子有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
全球唯一?IBM更新量子計算路線圖:2029年交付!
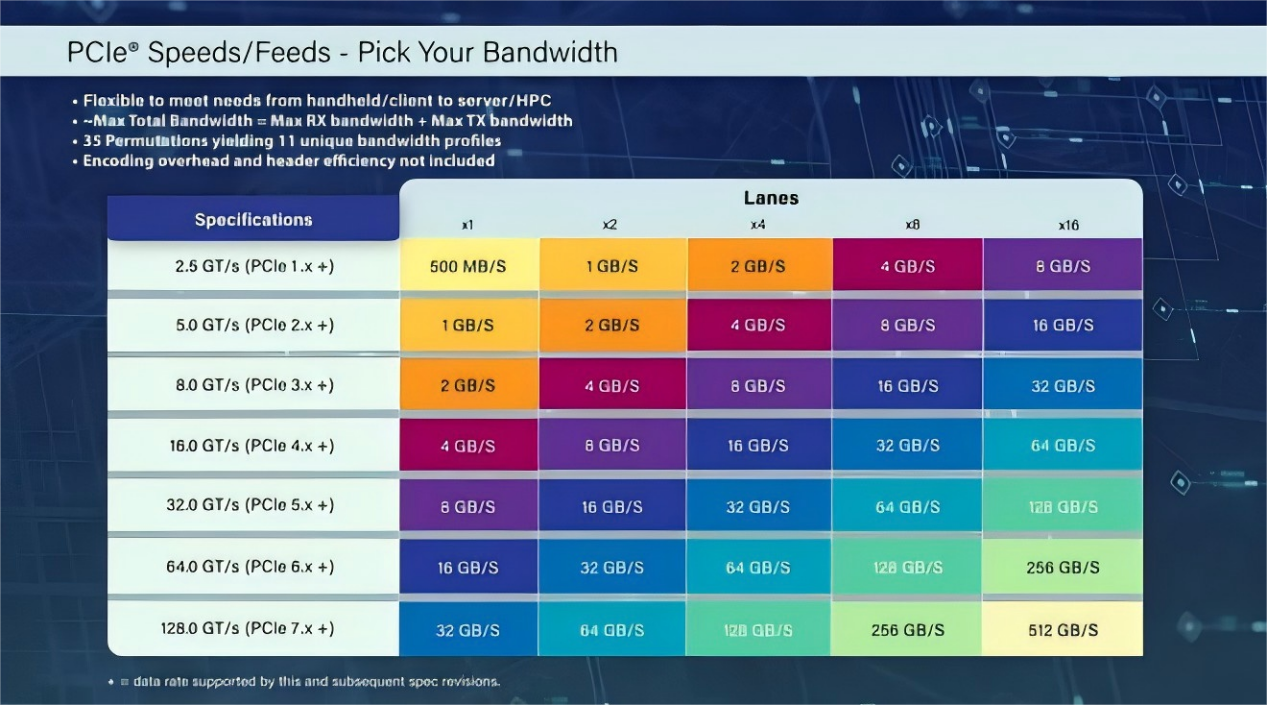
蘇州芯矽科技:半導(dǎo)體清洗機(jī)的堅實力量
砥礪創(chuàng)新 芯耀未來——武漢芯源半導(dǎo)體榮膺21ic電子網(wǎng)2024年度“創(chuàng)新驅(qū)動獎”
芯和半導(dǎo)體將參加重慶半導(dǎo)體制造與先進(jìn)封測產(chǎn)業(yè)發(fā)展論壇
OpenAI簡化大模型選擇:薩姆·奧特曼制定路線圖
TI視角下的科技前沿:半導(dǎo)體產(chǎn)業(yè)新動向
第三代半導(dǎo)體產(chǎn)業(yè)高速發(fā)展
關(guān)于RISC-V學(xué)習(xí)路線圖推薦
碳化硅在半導(dǎo)體產(chǎn)業(yè)中的發(fā)展
未來10年智能傳感器怎么發(fā)展?美國發(fā)布最新MEMS路線圖

行芯受邀出席2024求是緣半導(dǎo)體產(chǎn)業(yè)峰會
想了解半導(dǎo)體芯片的設(shè)計和生產(chǎn)制造
中國半導(dǎo)體的鏡鑒之路
越南定半導(dǎo)體路線圖:2030年建1芯片廠10封測廠
2024學(xué)習(xí)生成式AI的最佳路線圖






 半導(dǎo)體產(chǎn)業(yè)的發(fā)展路線圖
半導(dǎo)體產(chǎn)業(yè)的發(fā)展路線圖










評論