通過實驗進行大面陣碲鎘汞芯片的熱應力分析不僅耗時長、成本高,而且對于微米尺度的陣列單元分析難度高。近年來,利用基于數值計算的模擬仿真方法進行碲鎘汞芯片的熱應力分析受到了人們廣泛的關注及研究。近年來,利用基于數值計算的模擬仿真方法進行碲鎘汞芯片的熱應力分析受到了人們廣泛的關注及研究。
據麥姆斯咨詢報道,近期,北京工業大學、新型功能材料教育部重點實驗室和新型功能材料教育部重點實驗室的科研團隊在《紅外》期刊上發表了以“大面陣碲鎘汞芯片的耦合熱應力模型與結構優化”為主題的文章。該文章第一作者為王晗,主要從事紅外表面材料、光電材料與器件方面的研究工作;通訊作者為王如志。
針對大面陣碲鎘汞芯片熱應力仿真分析過程中計算量與準確性不能兼容的問題,本文基于常規的碲鎘汞芯片建模方式,對模型銦柱連接層進行細化處理:在其中局部引入小規模(10 × 8)銦柱陣列,在其余位置仍采用常規的近似處理。通過將小規模陣列布置于不同的位置,最后利用仿真結果擬合出其整體的熱應力分布。對大規模碲鎘汞芯片的整體及局部熱應力進行了更細致、更準確的分析。在此優化模型的基礎上,對其結構進行了優化,為大規模碲鎘汞芯片的設計及加工提供了理論指導。
模型建立
物理模型描述
紅外焦平面探測器模塊結構如圖1所示,主要包括三個部分:紅外探測器芯片、讀出電路和陶瓷基板。其中位于結構最頂端的是碲鎘汞芯片,它由碲鋅鎘襯底和碲鎘汞外延層兩部分組成,是用來接收入射的紅外輻射并將該信號轉換為電信號輸出的器件。碲鎘汞芯片的下方是硅讀出電路,兩者之間通過銦柱互聯;陶瓷基板在最底部。
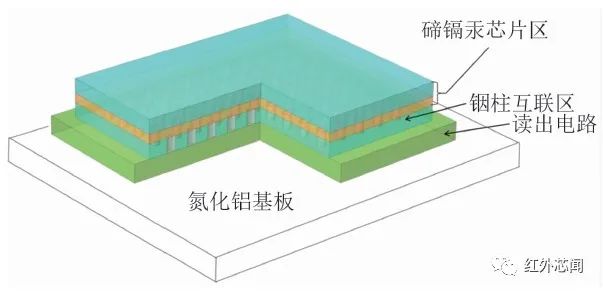
圖1 探測器混成芯片的示意圖
本文借助有限元分析/數值計算方法對640 × 512碲鎘汞芯片進行熱應力分析。隨著焦平面陣列規模的增大,在數值分析軟件中建立完整的細化1:1大規模碲鎘汞芯片仿真模型具有較高的難度,同時在計算過程中需要龐大的計算量支撐,因此常規計算機及服務器難以滿足其熱應力的計算需求。常規的大規模碲鎘汞芯片仿真分析方法通常對模型進行簡化處理,將銦柱以及底充膠層簡化成由單一材料構成的整體,不做銦柱具體結構的建模處理(見圖2(b))。本文基于常規的碲鎘汞芯片建模方式,對模型銦柱連接層進行細化處理:在其中局部引入小規模(10 × 8)銦柱陣列,在其余位置仍采用常規的近似處理。通過將小規模陣列布置于不同的位置,最后利用仿真結果擬合出其整體的熱應力分布。所建立的仿真優化模型如圖2(a)及圖2(c)所示,其具體尺寸見表1。
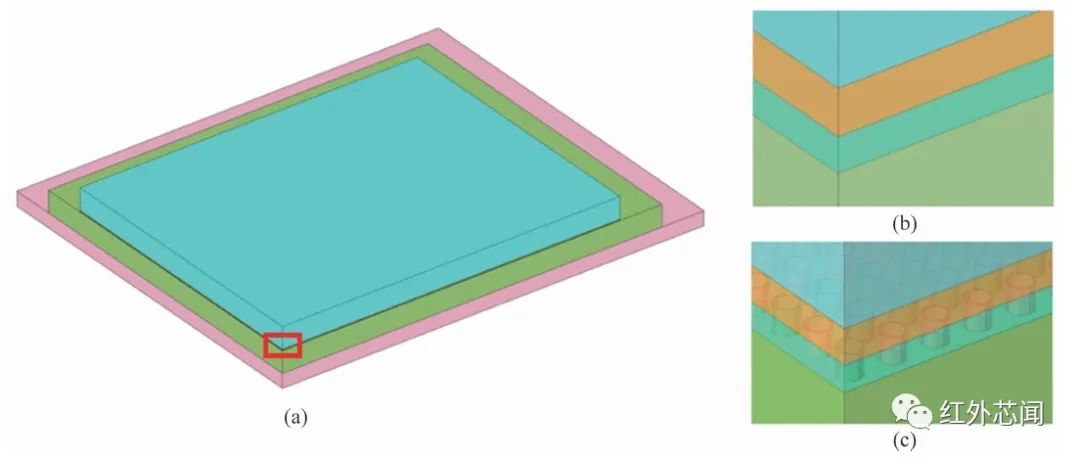
圖2 近似及優化仿真模型的建立:(a)探測器芯片的整體示意圖;(b)近似仿真模型的局部示意圖;(c)優化仿真模型的局部示意圖
表1 640 × 512探測器的各組件尺寸

數值模型建立
本文建立了固體傳熱模型、熱應力耦合模型。根據模型,在有限元數值仿真軟件中建立了圖3所示的有限元模型,并對物理模型進行了相應的網格劃分。為保證計算的準確性,采用六面體網格進行劃分,并對包含銦柱附近的區域進行網格的加密處理。

圖3 有限元網格模型:(a)整體網格模型;(b)銦柱局部網格模型
仿真計算與結果分析
近似模型的熱應力分析
圖4所示為傳統近似模型的熱應力仿真分析結果。在77K低溫作用下,碲鎘汞芯片的不同位置因熱膨脹系數不同而產生了不同程度的收縮。由于各個組件間的約束及牽制作用,器件的不同位置會產生形變及熱應力。探測器的應變分布仿真結果如圖4(a)及圖4(c)所示。芯片整體將產生一個中間凹陷、四周向上翹曲的形變。形變最大值產生在芯片的角落處,達到5.82 μm。此外,近似模型中的最大應力為162 MPa,產生于碲鎘汞芯片與銦柱互聯區域的交界面的邊緣處,如圖4(d)所示。由于對銦柱互聯區進行了較大程度的簡化,此仿真結果顯然是不準確的,同時也難以通過結構及材料的設計對其銦柱互聯區的熱應力進行優化,導致參考價值及指導意義較低。
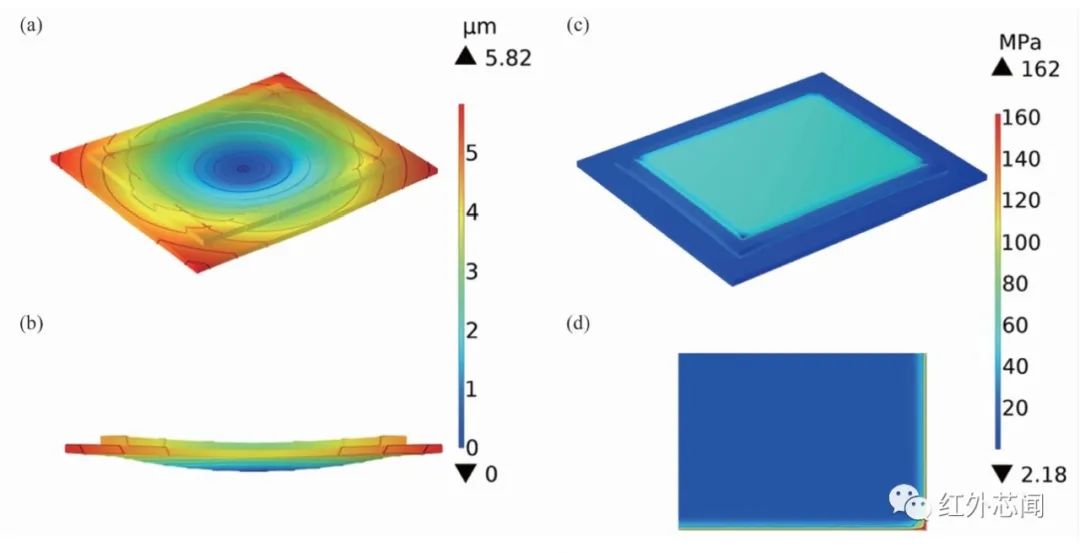
圖4 近似模型形變、應力仿真結果:(a)芯片整體形變分布;(b)芯片整體形變分布側視圖;(c)芯片整體應力分布;(d)銦柱互聯層熱應力分布
優化模型的熱應力分析
使用優化模型對碲鎘汞芯片進行了熱應力仿真分析。其中將小規模銦柱陣列布置于具有較大形變的芯片角落位置。其形變及熱應力仿真計算結果如圖5所示;熱應力及形變計算結果比傳統近似模型結果大。最大應力出現于最角落銦柱的下表面處,這是在以前的仿真結果中觀察不到的。其銦柱的熱應力分布云圖如圖5(b)所示,最大值為224.19 MPa。這是由銦柱與相連接的下層讀出電路之間較大的熱膨脹系數差異導致的。在制冷收縮過程中,讀出電路起到阻礙銦柱收縮的作用。過大的熱應力將造成焊點破裂、連接處斷裂等問題,從而導致碲鎘汞芯片與下層讀出電路之間的電連接失效。

圖5 優化模型的熱應力仿真結果:(a)各層應力及形變分布;(b)銦柱熱應力分布云圖
進一步地將小型銦柱陣列布置于大規模碲鎘汞芯片銦柱互聯區的不同位置,分析銦柱位置與其內部產生的最大熱應力之間的關系。對仿真結果進行擬合,繪制出的銦柱互聯層整體熱應力分布云圖如圖6(b)所示。可以發現,由于銦柱的存在,整體互聯層均出現了160 MPa以上的熱應力,且不同位置的銦柱所受到的熱應力沖擊并不相同。處于非邊緣位置的陣列單元在降溫后產生的熱應力較小,邊緣及角落位置的銦柱在其下表面處產生了更大的熱應力,這是由降溫收縮過程中的邊緣效應導致的。
由以上分析可以發現,相比于傳統的大面陣碲鎘汞芯片熱應力仿真模型,的優化仿真模型不僅可以對其銦柱互聯區內所產生的應力集中區域進行仿真分析,而且還可以進一步擬合出其各個位置所產生的熱應力大小。模型的優化使仿真結果更準確有效,為器件的進一步優化奠定了基礎。
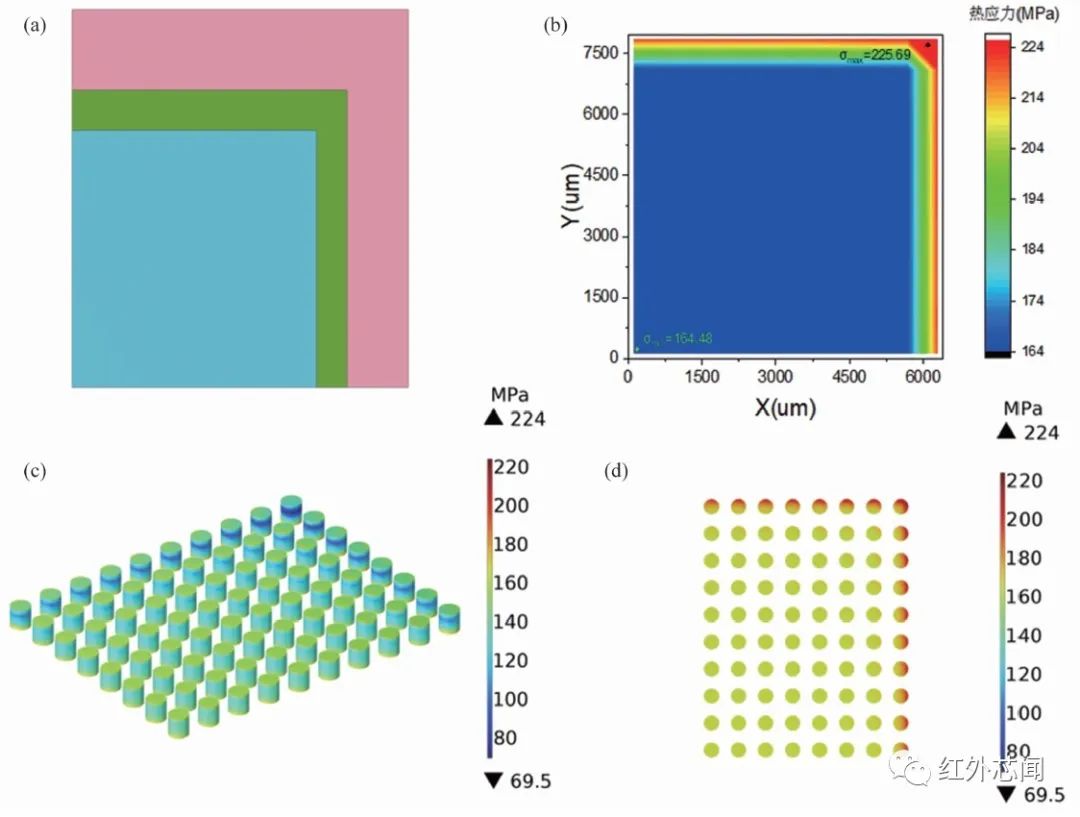
圖6 熱應力與位置之間的關系:(a)模型俯視圖;(b)銦柱互聯層熱應力擬合結果;(c)銦柱陣列熱應力分布;(d)銦柱陣列底面熱應力分布
器件結構的優化設計
基于大面陣碲鎘汞芯片的熱應力仿真優化模型及相關仿真結果,對讀出電路層以及碲鋅鎘襯底的層厚進行了優化。仿真結果如圖7所示。隨著讀出電路層加厚,芯片內部所產生的最大熱應力呈現出先減小后增大的趨勢。這是由于讀出電路層具有較小的熱膨脹系數,在制冷收縮的過程中將對與其相連接的上下層組件起到阻礙收縮的作用。在其厚度較薄時,固定約束對互聯層的影響較大,此時最大熱應力出現在銦柱與讀出電路的連接位置。增加厚度時,約束對互聯層的固定能力減弱,熱應力下降。厚度超過500 μm后,低熱膨脹系數的讀出電路阻礙收縮的能力增強,讀出電路層與陶瓷基板的連接面成為了最大熱應力的出現位置。此時最大熱應力由二者間的熱適配主導,且隨著其厚度的增加,熱應力增大。此外,如圖7(b)所示,更厚的碲鋅鎘襯底將導致更大熱應力的產生。這是由于碲鋅鎘材料的熱膨脹系數較大,意味著其在降溫過程中相比于上下兩層將產生更大程度的收縮。碲鋅鎘襯底越厚,收縮能力越強,所以在上下交界的表面處會產生更大的熱應力。在其他條件一致時,10 μm厚的碲鋅鎘襯底比 500 μm厚時所導致的器件內部的最大熱應力低135 MPa左右。綜上所述,讀出電路層厚度為500 μm時器件內部所產生的熱應力最小,同時減薄碲鋅鎘襯底能較大程度地減小其內部所產生的熱應力。
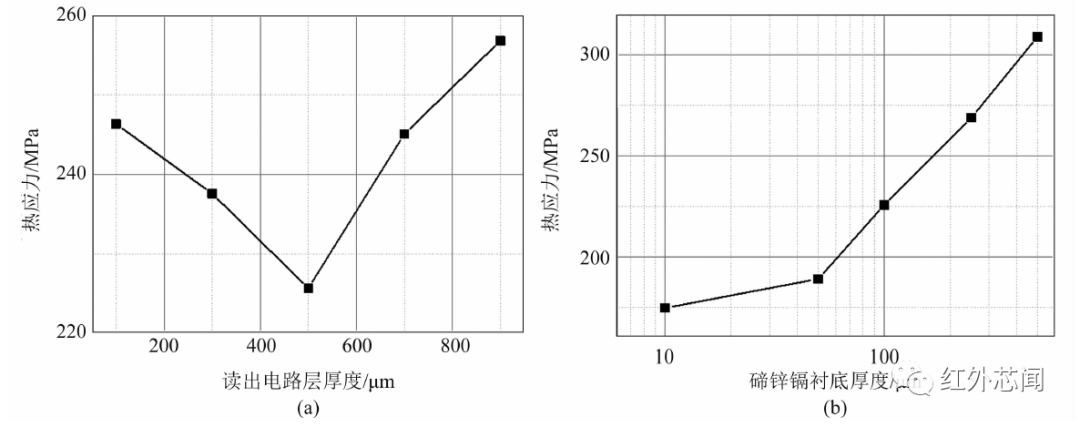
圖7 層厚與器件內部所產生的最大熱應力之間的關系:(a)讀出電路層厚度與熱應力之間的關系;(b)碲鋅鎘襯底厚度與熱應力之間的關系
此外,借助碲鎘汞芯片優化模型對銦柱結構進行了優化。將理想的圓柱體、單面銦以及雙面銦三種常見結構進行了熱應力仿真的對比分析。仿真結構如圖8(a)~圖8(c)所示。從圖8(d)中可以看到器件內部所產生的最大熱應力與銦柱(最大)半徑之間的關系。三種結構的器件內部所產生的熱應力均隨半徑的增加而增大,且單面銦在三種結構中展現出了最低的熱應力;當(最大)半徑為7 μm時,單面銦對應的最大熱應力比雙面銦小6 MPa,比理想圓柱體小16 MPa左右。所以,單面銦是三種結構中最優的熱應力結構,同時在制備過程中減小銦柱的半徑可以進一步減小其內部的熱應力。
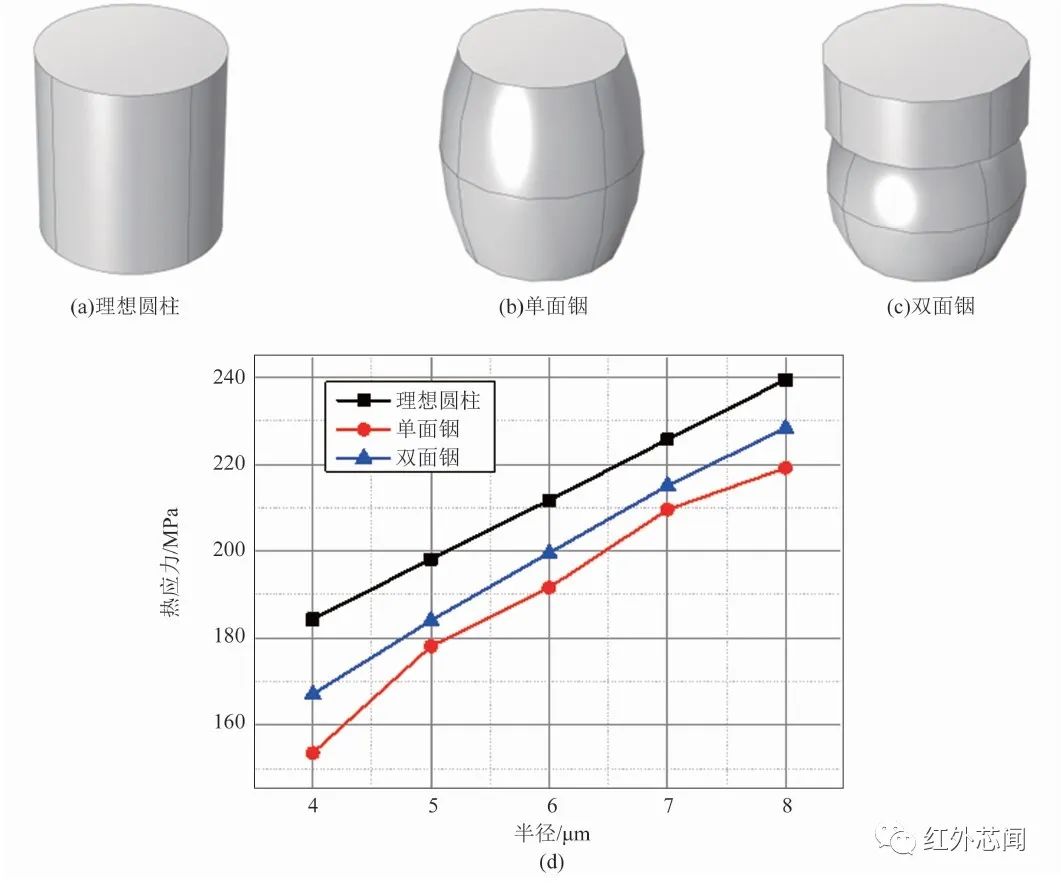
圖8 銦柱結構與熱應力之間的關系:(a)理想圓柱結構;(b)單面銦結構;(c)雙面銦結構
結束語
通過在傳統近似仿真模型中的不同位置引入小規模銦柱陣列,建立大面陣碲鎘汞芯片熱應力耦合優化仿真模型,可對碲鎘汞芯片內由制冷產生的熱應力進行更加準確有效的分析。研究了熱應力的集中區域并擬合出了位置與熱應力之間的對應關系。根據仿真結果對其組件進行了優化設計,具體結論如下:
(1)由于熱失配在銦柱的上下表面附近區域內產生了較大的熱應力,同時相比于內部單元銦柱,邊緣及角落處的陣列單元內部所產生的熱應力更大,角落處的最大熱應力達到225.69 MPa。過大的熱應力將導致器件存在破裂失效的風險。
(2)碲鎘汞芯片中各個組件的厚度對其內部產生的熱應力有直接的影響。仿真結果顯示,讀出電路層厚度為500 μm時,器件內部產生的熱應力最小,同時減薄碲鋅鎘襯底能較大程度地減小其內部產生的熱應力。
(3)借助優化模型對比了三種常見的銦柱結構。仿真結果表明,單面銦是三種結構中最優的熱應力結構,同時在制備過程中減小銦柱的半徑可以進一步減小其內部的熱應力。
本文所提出的熱應力仿真模型為大面陣碲鎘汞芯片內部的熱應力分析提供了更準確有效的分析方法,仿真優化結果可為器件的加工設計提供理論指導。此外,將輻射傳熱、焦耳熱等多物理場引入模型,建立更準確逼真的探測器芯片仿真模型將是下一階段的研究重點。
審核編輯:彭菁
-
芯片
+關注
關注
460文章
52511瀏覽量
440859 -
電路
+關注
關注
173文章
6027瀏覽量
175050 -
模型
+關注
關注
1文章
3521瀏覽量
50421 -
模擬仿真
+關注
關注
0文章
17瀏覽量
8724
原文標題:大面陣碲鎘汞芯片的耦合熱應力模型與結構優化
文章出處:【微信號:MEMSensor,微信公眾號:MEMS】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
封裝中的界面熱應力分析
基于分子束外延的短/中波雙色碲鎘汞材料及器件的最新研究進展
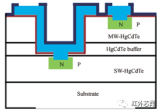





 基于數值計算的模擬仿真方法進行碲鎘汞芯片的熱應力分析
基于數值計算的模擬仿真方法進行碲鎘汞芯片的熱應力分析







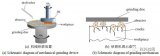










評論