自從IBM于20世紀60年代開發出可控塌陷芯片連接(Controlled Collapse Chip Connect,C4)技術,或稱倒裝芯片技術,凸點鍵合在微電子封裝領域特別是芯片與封裝基板的鍵合中得到了廣泛的應用。隨著3D封裝技術的發展,凸點鍵合技術也被應用于芯片-芯片、芯片-圓片鍵合及封裝體的3D疊層封裝。凸點鍵合技術的主要特征包括:
(1)凸點鍵合技術通常使用焊料(如Sn或SnAg)或其他低熔點共晶組合作為凸點材料,并在加熱過程中使其熔化或相互擴散以達到鍵合的目的;
(2)凸點鍵合過程經常涉及金屬間化合物(Intermetallic Compounds,IMC)的形成;
(3)在凸點鍵合技術中,一般需要制作凸點下金屬(Under Bump Metal,UBM)層,以增加凸點的黏附性,并限制低熔點金屬向芯片金屬布線層的擴散,以及過多IMC的形成。
隨著近年來高密度互連的需求,凸點鍵合技術向著超小節距(Ulltra-Fine Pitch)方向發展出了銅柱和固態鍵合等技術。如圖1所示,隨著凸點節距的縮小,要求凸點中所使用的焊料量也減少,甚至無焊料鍵合(Solder-Less Bonding)或無凸點鍵合(Bump-Less Bonding),以避免在焊料熔化過程中產生鍵合凸點之間的橋接等風險。表1列舉了幾種金屬鍵合方法及其鍵合溫度。
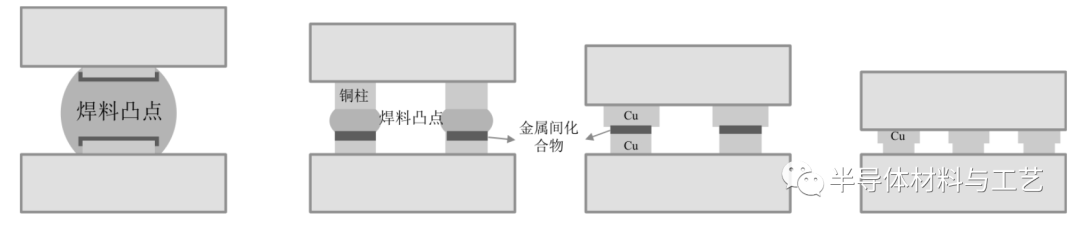
圖1焊料凸點、銅柱微凸點、微凸點固態鍵合及無凸點鍵合結構示意圖
表1幾種金屬鍵合方法及其鍵合溫度

無凸點金屬鍵合可采用的金屬包括鋁、金、銅、銀等。與其他金屬鍵合相比,銅-銅鍵合可實現更小的電阻、更小的功率損耗、更好的抗電遷移特性、更好的散熱和熱可靠性。因此,銅-銅鍵合是實現高性能高密度3D芯片的理想3D互連技術。隨著IBM在1997年宣布采用銅互連技術,研究人員開始了銅-銅鍵合技術的研究。目前銅-銅鍵合有兩種主要的鍵合方法,即熱壓鍵合(TCB)與表面活化鍵合(Surface Activated Bonding,SAB)。接下來主要介紹銅-銅熱壓鍵合與表面活化鍵合的基本機理。
文章來源:功率半導體生態圈
審核編輯:湯梓紅
-
芯片
+關注
關注
459文章
52252瀏覽量
436913 -
封裝
+關注
關注
128文章
8561瀏覽量
144874 -
鍵合
+關注
關注
0文章
78瀏覽量
8062 -
倒裝芯片
+關注
關注
1文章
103瀏覽量
16535
原文標題:金屬直接鍵合技術簡介
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 凸點鍵合技術的主要特征
凸點鍵合技術的主要特征











評論