
歡迎了解
邵滋人,李太龍,湯茂友
宏茂微電子(上海)有限公司
摘要:
在存儲技術發展過程中,三維閃存存儲器以其單位面積內存儲容量大、改寫速度快等優點,正逐步取代機械硬盤成為大數據存儲領域中的主角。但是目前市面上的 Nand Flash 產品封裝還是多以傳統金屬線鍵合技術為主,這類傳統方案會在一些特殊應用和需求下存在較難進一步降低封裝體的尺寸、傳輸速度受限等問題。為了應對產品尺寸持續向小、速度和帶寬需求持續增大的趨勢,三維閃存封裝也需要更多的形式,可以結合當前涌現出的多種先進封裝形式尋找新的解決方案。本文通過分析 SiP、Fan-out、3D 和 Chiplet 等先進封裝形式,探討在三維閃存封裝中的可能應用方案,利用重新布線層(RDL)代替基板、TSV,Bumping 代替金線的連接等技術,有效縮小封裝體面積同時,提升產品的運行速度,增強數據處理能力。
0 引言
近年來,隨著人工智能、物聯網和 5G 等技術的蓬勃發展和應用,市場對數據處理以及存儲的需求逐漸增大。根據 IDC 預測,全球數據圈每年被創建、采集或復制的數據量,由 2018 年的 32 ZB 到 2025年將增至 175 ZB。半導體存儲具有存取速度快、功耗低、體積小、可靠性高等優勢,廣泛應用在電子設備中,并且正逐步取代機械硬盤成為主流存儲器。其中閃存不同于 DRAM,因其具有斷電數據不丟失的優點,多用于“數據倉庫”來使用。其技術的發展也是朝著不斷增大單位面積存儲容量的方向發展,由二維到三維,再到不斷地增加堆棧層數,當前業界已經推出 200 層以上堆棧的產品,未來還會向 1000 層發展。閃存因其采用電荷隧穿的方式實現存儲功能,相比 DRAM 的電容方式,存儲速度上大打折扣,封裝方式上也以傳統的封裝形式為主,目前市面上采用先進封裝工藝來實現其存儲功能的產品非常少。隨著數據時代的發展,各領域 AI 應用對數據傳輸及處理的多樣性需求逐步增多,同時伴隨摩爾定律的放緩和各類先進封裝技術的涌現,持續探索新的封裝形式,將處理器、DRAM、閃存采用新的形式結合起來,提升總體運算能力,將會影響未來三維閃存封裝發展方向。
1 三維閃存及當前主要封裝形式簡介
東芝公司于 1989 年開發了 NAND Flash 的結構,主要目的是降低每比特的成本,獲得高性能,并且可以通過接口輕松升級。最初 2D 結構的存儲單元僅僅是布置在平面中,因此想要提高單位存儲密度,唯一方法就是微縮晶體管,不斷減小制程工藝的節點。但是對于 NAND Flash 器件,減小晶體管會帶來電荷存儲空間不足、電荷串擾等問題。在不增大芯片面積的情況下,為了提高存儲密度,NAND Flash廠商紛紛推出 3D 堆疊技術,將存儲單元沿垂直方向進行堆疊,從而提高單位面積的存儲量,如下示意圖 1 所示。目前,NAND Flash 的主要代表公司有三星、鎧俠、西數、海力士、美光,英特爾和國內的長江存儲等。
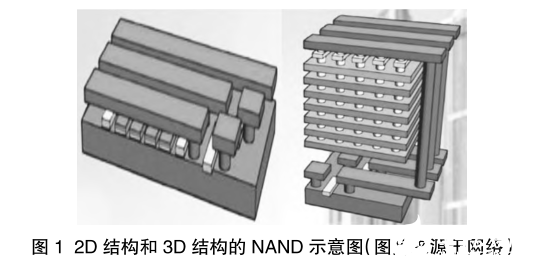
從封裝角度來看,BGA 形式是實現大容量存儲的主要方案,且主要有 3 種,即封裝體內只含有NAND 芯片的 Raw NAND,增加控制芯片的 Managed NAND(eMMC/UFS/NVMe),和增加主控芯片以及LPDDR 芯片的 eMCP,如圖 2 所示。內部實現電連接主要采用 Wire Bonding 形式,對部分高端 Managed NAND 產品中的控制芯片會采用 Flip Chip 形式(圖示為 Flip Chip)。
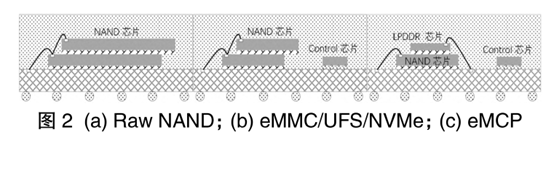
由于 3D NAND 產品目前主要應用在存儲卡、閃存盤和固態硬盤等,以 Wire Bonding 為主的傳統封裝方案可以滿足對高密度數據存儲的需求。未來,隨著物聯網(IoT)、人工智能、自動駕駛和其他數據密集型應用的不斷發展,對數據的存儲和讀寫速度的要求將變得更具挑戰性,因此有必要思考更多封裝形式及技術,來解決相應的需求。
2 先進封裝技術及其在三維閃存中的可能應用
隨著半導體行業進入后摩爾時代,在成本和性能要求的綜合驅動下,涌現出各種先進封裝形式,并已成為行業未來發展的趨勢之一。當前主要的先進封裝形式有 SiP (System in a Package)、Fan in/out、2.5D/3D、Chiplet 等,相關的技術有凸塊(Bumping)、RDL(Redistribution Layer)、TSV(Through Silicon Via)等技術。此類封裝技術的特點是:封裝內部連接擺脫傳統的焊線方式,基板被部分或全部取代,使用凸塊及直接鍵合等方式實現連接,從而在提高集成度、降低封裝尺寸的同時,縮短電流傳導路徑、減少能耗、降低成本,滿足性能需求。
2.1 先進封裝技術及其在三維閃存產品封裝中可能的應用
2.1.1Bumping & RDL
Bumping 和 RDL(Redistribution Layer)的工藝在流程上大體一致,都包含噴涂、曝光、顯影、濺射、電鍍和刻蝕等主要的工藝過程,Bumping 工藝最后流程需要經過回流焊形成凸塊,實現與外界的電性能連接,而 RDL 的最外層線路也需要 Bumping 工藝,實現內外的線路的導通。
RDL 也稱重新布線層,由金屬層和介質層組成,其工藝是在載體或者晶圓的表面沉積金屬層和相應保護的介質層形成金屬布線,對 I/O 的端口進行重新布局,可以根據產品的需求相應地增加端口的數量及布局的位置,形成面排布的過程。目前,RDL 技術主要應用在晶圓級封裝、2.5D/3D 和 Chiplet封裝等,不僅完美地解決了高密度集成芯片的 I/O間距受限的問題,同時也利用 RDL 取代基板實現芯片與外界的電性連接,以此降低封裝體的體積。
2.1.2TSV
TSV(Through Silicon Via)技術是一種穿透硅的通孔技術,簡稱硅通孔技術。該技術利用硅通孔結構,使芯片與芯片之間、芯片與基板之間實現垂直連接,從而有效縮短傳導線路,降低功耗,提高芯片的運行速度。應用在存儲芯片時,可以通過增加芯片堆疊數量,實現高帶寬、大容量存儲;其次,還可以實現不同功能芯片之間的互連,使單個封裝體具有更多的功能。TSV 工藝主要包括通孔刻蝕、通孔薄膜淀積(絕緣層、阻擋層、種子層的沉積)、通孔填充、化學機械拋光(CMP)、晶圓減薄和 RDL 與微凸點制作等關鍵技術。
2.1.3RDL/Bumping,TSV 在三維閃存封裝中的可能應用方案
相比 DRAM 產品,將先進封裝技術應用到NAND 產品上,并實現商用的案例幾乎很少,本文基于 NAND 芯片的功能和先進封裝技術,對其應用做了一些設想,其中一個方案如圖 3 所示。將 NAND芯片以垂直方向堆疊,利用 TSV 技術制作的通孔導電結構代替傳統的 WB 打線,用微 Bumping 來實現芯片與芯片、芯片與 RDL 之間的互連,并利用Molding 工藝對整個封裝體進行第一次塑封。然后將控制芯片以倒裝的形式鍵合在另一 RDL 上,并且通過導電結構實現兩層 RDL 的互連,以此實現內部異質芯片電路的連接。該結構難點主要在于分層的問題,因為 TSV 中導電結構的金屬 Cu 的熱膨脹系數(1.8x10-5℃ -1 )和 Si 的熱膨脹系數(3x10-6℃ -1 )差距較大,當該結構熱量不能及時散出時,金屬層 Cu 和Si 表面可能發生分層,從而導致產品的失效。
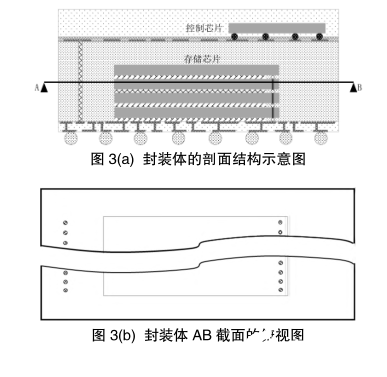
2.2 先進封裝形式及其在三維閃存封裝中的可能應用
2.2.1SiP
SiP 是將不同功能的芯片(例如存儲器、處理器、無源器件等)封裝在同一個塑封體中,以此來實現一個完整功能的封裝形式,具有高集成、低功耗、良好的抗機械和化學腐蝕的能力以及高可靠性等優點,如圖 4 所示。對照此概念,目前 3D NAND 應用中的Managed NAND(eMMC,UFS 等),eMCP 產品較類似且已廣泛應用,即將堆疊的 NAND 芯片、倒裝或金線連接的 Control 芯片、以及電容電阻互連在一個封裝體中,實現系統集成,同時根據產品需求的不同,增加芯片的數量和種類,以此實現異構、異質集成,減少封裝體積,降低系統成本。
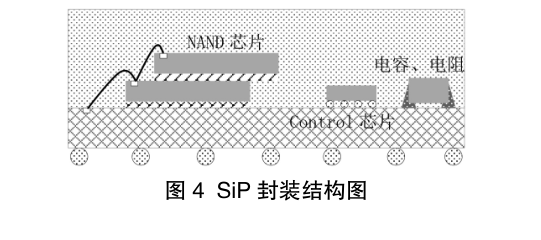
2.2.2Fan-in/Fan-out
Fan-in 封裝是在晶圓上布 RDL,并植球,直接切割后形成單顆芯片。這種形式得到的單顆封裝體的尺寸幾乎與芯片的尺寸相同,且可以多晶圓同時加工,提高封裝的作業效率。但也因其 I/O 局限在單顆芯片尺寸范圍內,導致 I/O 數量被極大限制住,所以應用一般僅限在小型電子器件,并且不需要較多I/O 需求的產品上。Fan-out 封裝技術屬于晶圓重構技術,將晶圓切割成單顆芯片后,重新布置在載體上,然后進行塑封、RDL、植球、切割 ,從而得到面積大于芯片面積的封裝體。這樣可以靈活把控 I/O 的間距及數量不受芯片尺寸的限制。Fan-out 工藝也可分為芯片先上(Die First)和芯片后上(Die Last)兩種,相對于芯片先上,芯片后上具有塑封翹曲小和成品率高等優點,但是制造工藝相對復雜。
當前,市面上的三維閃存芯片封裝的主流還是將芯片通過直接貼裝在封裝基板的表面上,然后采用金屬線鍵合工藝實現芯片焊盤與基板電性能連接。基板作為芯片封裝的核心材料之一,其成本占據整個封裝材料成本的 30%~50%;并且為了應對產品朝著輕薄小的方向發展,基板中的設計會越來越復雜,而且層數也會隨之增加,導致基板的厚度增加,影響了總體的封裝厚度,還致使基板的價格進一步提高。在線寬線徑方面,15/15μm(mSAP 工藝)已經是接近極限,想再進一步下探需要更換制作工藝,同時會帶來成本或其他負面效果,并且也很難低于5μm,單層的 PP 厚度最薄也只能接近 15μm。RDL工藝是晶圓制造端較成熟的工藝,可以達到1.5/1.5μm 的線寬線距;在厚度方面,單層的 RDL厚度可以控制在 5~20μm 的范圍之內,也是低于基板的厚度。
如將 Fan-out 應用在三維閃存芯片封裝上,可起到提升信號速度,減少封裝體厚度的作用。本文設想的結構如圖 5 所示,將 NAND 芯片層錯開堆疊(露出焊盤區),然后利用金屬導電結構代替 WB 打線與外界信號連接,塑封后制作重新布線層和凸塊,以此實現內外的導通結構。該結構的主要難點在于連接的問題,本文針對該難點采用激光打孔和做金屬柱兩種方法,激光打孔是需要在塑封體上進行鉆孔,使孔底落在芯片焊盤上,然后再深孔內形成導電結構,從而連接 RDL 層實現電信號傳輸;金屬柱則是先在芯片 Pad 上形成金屬結構,然后進行塑封,然后打磨塑封體露出金屬柱,實現與 RDL 層連接。
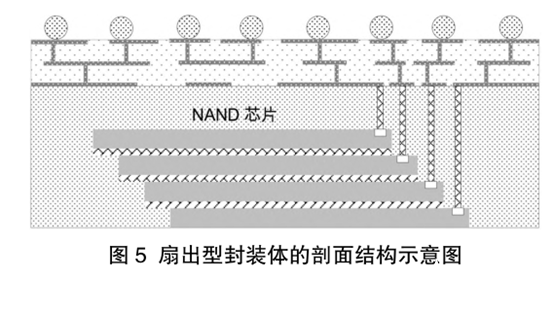
2.2.32.5D/Chiplet
Chiplet 的封裝[6-8]被視為延續摩爾定律的新法寶,是將原 SoC 大尺寸的設計分散在較小的芯片上,將多個芯片通過先進封裝技術重新組合在一個 Si中介板上,形成一種“SiP”封裝形式,以此來滿足產品的需求。應用 Chiplet 的優勢首先在于利用 Si 中介板代替基板,將 NAND 芯片、DRAM 芯片、Logic 芯片和 Control 芯片等異質芯片集成在 Si 中介板上,一是可以有效地解決熱效應導致的異質芯片與基板之間熱膨脹系數不匹配的問題,二是由于 Si 中介板采用的 TSV 技術,可以有效縮短電性傳輸路徑,從而提高其傳輸的速度;其次,Si 中介板的電路設計是可以根據異質芯片的不同需求而采取不同的工藝節點,這正好符合處理器、DRAM、NAND 的不同工藝現狀,從而增加工藝的靈活性,縮短產品更新周期。
本文設想的結構如圖 6 所示,結合 Chiplet 技術在 NAND 中的應用,可采用前文提到的 TSV 技術將DRAM 芯片和 Logic 芯片垂直堆疊連接成 HBM 結構,然后通過 Si interposer 與外界基板實現連接;單個的 Logic 芯片以倒裝(FC)的形式與 Si interposer實現連接,并通過內部布線實現與 HBM 的電信連接;NAND 芯片和 Control 芯片垂直堆疊并通過 Si interposer 實現與內部的 Logic 芯片和外部的基板互連;通過 Si interposer 實現系統內互連,達到高度集成的目的。該結構的難點在于產品還存在散熱等問題,目前,市面上還沒有發現規模化的相關產品應用,因此,未來還是充滿了挑戰。
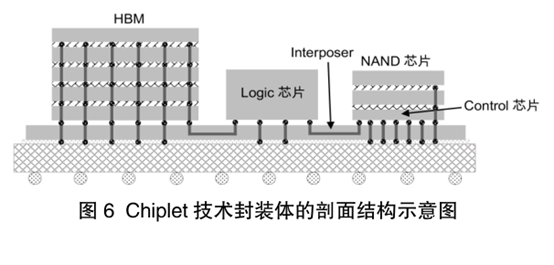
3 結論
隨著數字經濟時代的來臨,數據已經成為了核心的生產要素,爆炸式的數據增長對計算和存儲提出了更高的要求,傳統的三維閃存芯片封裝技術和形式將會面臨更多的技術挑戰。為此,本文重點探討了 Bumping、RDL 和 TSV 等先進封裝技術及 SiP、Fan-in/Fan-out 和 2.5D/Chiplet 等先進封裝形式在3D NAND 中應用的可行性。在 3D NAND 中,先進封裝不僅能提高芯片的集成度,減少封裝的體積,還可以縮短信號的傳播路徑,從而提高數據處理的速度。
國家“十四五”信息化政策提出加快集成電路關鍵技術的攻關,存儲芯片的創新,強調了存儲芯片的重要性。我國已初步完成在存儲芯片領域的戰略布局,雖然起步比較晚,部分核心技術受到封鎖,距離其他國家還有一定的差距,但是由于存儲產品屬于大宗商品,只要性能滿足用戶需求,可替換率很高,這為我國存儲器發展趕超其他國家的行業巨頭提供了機會。先進封裝作為延續摩爾定律的前沿技術,目前在 3D NAND Flash 產品中的應用還處于探索階段,隨著未來市場的不斷需求,以及先進封裝技術的不斷成熟和成本不斷降低,相信在未來必將迎來新的篇章。
審核編輯 黃宇
-
芯片
+關注
關注
459文章
52465瀏覽量
440333 -
閃存
+關注
關注
16文章
1844瀏覽量
115942 -
封裝
+關注
關注
128文章
8651瀏覽量
145393 -
存儲
+關注
關注
13文章
4529瀏覽量
87397
發布評論請先 登錄
三維封裝工藝流程與技術
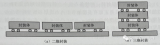
先進封裝技術在三維閃存中的應用
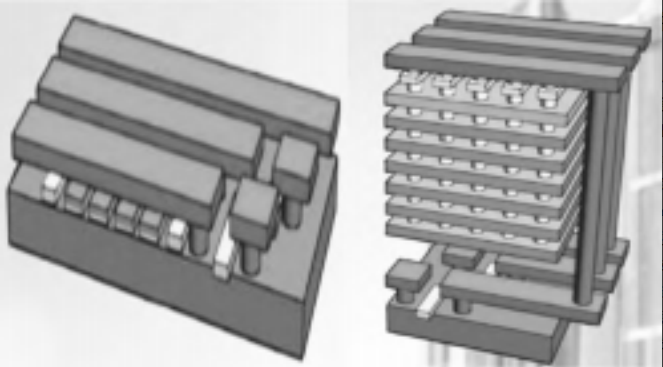





 先進封裝技術在三維閃存產品中的應用探討
先進封裝技術在三維閃存產品中的應用探討












評論