據報道,臺積電在近期舉行的IEDM 2023會議上制定了芯片封裝計劃,其中包括提供擁有萬億晶體管能力的封裝產品,該計劃與早前英特爾所披露的規劃相似。然而,需要注意的是,這個萬億晶體管并非指單個芯片封裝的總量,而是源于多個3D封裝小芯片。盡管如此,臺積電仍在全力以赴提高單片芯片的制造潛能,爭取開發出含有兩千億晶體管的封裝芯片。
為達成此目標,公司正加緊推進N2和N2P級別的2nm制造節點研究,并同步發展A14和A10級別的1.4nm加工工藝,預計到2030年可以實現。此外,臺積電預計封裝技術,如CoWoS、InFO、SoIC等會不斷優化升級,使他們有望在2030年前后打造出超萬億晶體管的大規模封裝解決方案。
值得一提的是,臺積電在本次會議中還透露他們已全面啟動1.4nm級制作流程研發工作。同樣,該公司再次確認,按照原定計劃,2nm級制造流程將從2025年起進入大規模商業化。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
臺積電
+關注
關注
44文章
5687瀏覽量
167006 -
封裝技術
+關注
關注
12文章
553瀏覽量
68039 -
晶體管
+關注
關注
77文章
9746瀏覽量
138917
發布評論請先 登錄
相關推薦
臺積電2025年起調整工藝定價策略
近日,據臺灣媒體報道,隨著AI領域對先進制程與封裝產能的需求日益旺盛,臺積電計劃從2025年1月起,針對其3nm、5nm以及先進的CoWoS
臺積電市值近萬億美元大關,年內股價猛漲近九成
10月14日美股開盤后,臺積電的股價持續攀升,最高觸及194.25美元(折合約1377元人民幣),再度創下股價新高。在交易過程中,臺積
OpenAI CEO提7萬億美元建36座晶圓廠計劃遭臺積電質疑
在2023年的寒冬季節,OpenAI的首席執行官Sam Altman開啟了一場東亞的旋風式訪問,與臺積電、三星及SK海力士等業界巨頭的高管進行了會面。然而,他的初次亮相并未贏得人們的青睞。據傳,
新思科技發布1.6納米背面布線技術,助力萬億晶體管芯片發展
近日,新思科技(Synopsys)宣布了一項重大的技術突破,成功推出了1.6納米背面電源布線項目。這一技術將成為未來萬億晶體管芯片制造過程中的關鍵所在。
臺積電封裝,新規劃
來源:半導體芯聞綜合 臺積電高效能封裝整合處處長侯上勇3 日在Semicon Taiwan 2024 中舉行專題演講,表示被視為是三種CoWoS 產品中,能滿足所有條件的最佳解決方案,
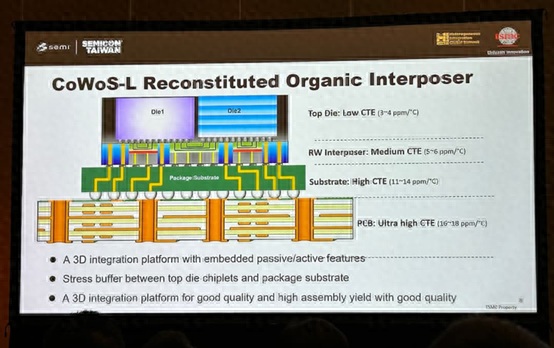
谷歌Tensor G5芯片轉投臺積電3nm與InFO封裝
近日,業界傳出重大消息,谷歌手機的自研芯片Tensor G5計劃轉投臺積電的3nm制程,并引入臺積
臺積電布局FOPLP技術,推動芯片封裝新變革
近日,業界傳來重要消息,臺積電已正式組建專注于扇出型面板級封裝(FOPLP)的團隊,并規劃建立小型試產線(mini line),標志著這家全
臺積電跨制程整合晶體管架構并引入CFET,發布新一代芯片技術
張曉強強調,半導體產業的黃金時代已然來臨,未來AI芯片的發展幾乎99%都依賴于臺積電的先進邏輯技術和先進封裝技術。
臺積電創新推出萬億晶體管封裝平臺,專注于高性能計算和AI芯片應用
臺積電高級研發副總裁張曉強指出,本項新技術主要針對AI芯片性能增強。新型HBM高帶寬存儲器與Chiplet架構小芯片的引入需求大量組件及IC




 臺積電:規劃1萬億晶體管芯片封裝策略
臺積電:規劃1萬億晶體管芯片封裝策略


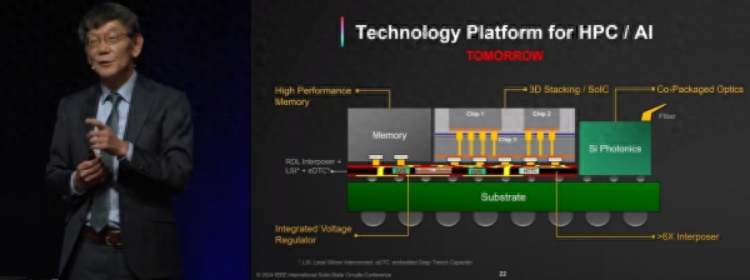











評論