激光植球技術(shù)在BGA芯片封裝工藝中的優(yōu)勢(shì)
芯片是一種電子元器件,由微電子技術(shù)制造,將電路和系統(tǒng)集成在一個(gè)微小的硅片上。它是現(xiàn)代科技的重要組成部分,無處不在,影響著人們的生產(chǎn)生活。芯片的種類、制造工藝和應(yīng)用領(lǐng)域不斷拓展和創(chuàng)新,對(duì)于現(xiàn)代信息社會(huì)的發(fā)展和人類社會(huì)的進(jìn)步具有重要的意義。
什么是bga?
BGA的全稱是Ball Grid Array(球柵陣列結(jié)構(gòu)的PCB),它是集成電路采用有機(jī)載板的一種封裝法。用于永久安裝微處理器等設(shè)備。BGA可以提供比雙列直棰或扁平封裝更多的互連引。可以使用設(shè)備的整個(gè)底面,而不僅僅是周邊。將封裝的引線連接到管芯,封裝的導(dǎo)線或焊球的走線平均也比周邊類型的走線短,從而在高速下具有更好的性能。它的特點(diǎn)有:
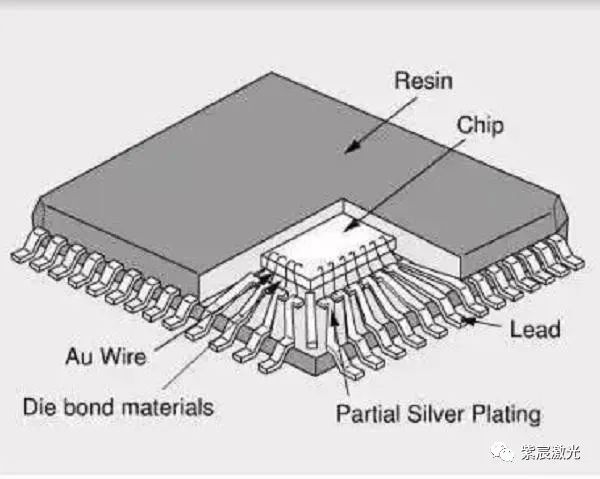
01
①封裝面積減少;
02
②功能加大,引腳數(shù)目增多;
03
③PCB板溶焊時(shí)能自我居中,易上錫;
04
④可靠性高;
05
⑤電性能好,整體成本低。
有BGA的PCB板一般小孔較多,大多數(shù)客戶BGA下過孔設(shè)計(jì)為成品孔直徑8~12mil,BGA處表面貼到孔的距離以規(guī)格為31.5mil為例,一般不小于10.5mil。BGA下過孔需塞孔,BGA焊盤不允許上油墨,BGA焊盤上不鉆孔。

目前,許多芯片封裝都為BGA型,這類封裝的最大優(yōu)點(diǎn)就是能節(jié)約板上空間。最常見的是芯片向上結(jié)構(gòu),對(duì)熱處理要求較高的通常是使用向下的結(jié)構(gòu)。多數(shù)封裝都采用芯片鍵合技術(shù)將芯片與基板連接起來,并實(shí)現(xiàn)芯片與基板之間的電連接。BGA也如此,但更多是采用倒裝芯片互連技術(shù)。采用倒裝芯片設(shè)計(jì)可將散熱片直接與芯片連接起來,達(dá)到更好散熱的目的。
封裝工藝流程
圓片凸點(diǎn)的制備→圓片切割→芯片倒裝及回流焊→底部填充→導(dǎo)熱脂、密封焊料的分配→封蓋→裝配焊料球→回流焊→打標(biāo)→分離最終檢查→測(cè)試→包封。
倒裝焊接克服了引線鍵合焊盤中心距極限的問題,在芯片的電源/地線分布設(shè)計(jì)上提供了更多便利,為高頻率、大功率器件提供更完善的信號(hào)。而BGA器件的焊接需要精確控制,通常通過自動(dòng)化工藝完成,例如計(jì)算機(jī)控制的自動(dòng)激光植球+回流焊爐。
在高密度芯片晶圓封裝技術(shù)領(lǐng)域,在進(jìn)行晶圓芯片上的凸點(diǎn)制作時(shí),晶圓上后續(xù)封裝微焊點(diǎn)主要使用超細(xì)間距和高密度凸點(diǎn)陣列實(shí)現(xiàn),這是高密度芯片晶圓封裝中的一個(gè)重要環(huán)節(jié),對(duì)工藝效果、操作及成本等要求都比較高。
目前,得到凸點(diǎn)主要有三種方式:電鍍、印刷錫膏固化和植球。但是,電鍍方式存在工藝復(fù)雜且成本較高、制造周期長(zhǎng)、環(huán)境污染等缺點(diǎn),而印刷錫膏方式不容易控制凸點(diǎn)高度,難以制作小于 200 μm 的凸點(diǎn)。激光植球方式的優(yōu)勢(shì)便更加凸顯:由于錫球內(nèi)不含助焊劑,激光加熱熔融后不會(huì)造成飛濺,凝固后飽滿圓滑,對(duì)焊盤不存在后續(xù)清洗或表面處理等附加工序。同時(shí),因錫量恒定,分球焊接具有速度快、精度高,已經(jīng)越來越多地應(yīng)用在BGA芯片植球領(lǐng)域。
激光植球工藝優(yōu)勢(shì)
0****1
系統(tǒng)選用光纖激光器作植球熱源,電光轉(zhuǎn)換效率高、能量穩(wěn)定;
0****2
可兼容0.07mm~0.2mm規(guī)格Sn-Ag-Cu、Sn-Bi-Ag等常用材質(zhì)錫料錫球,以應(yīng)對(duì)不同領(lǐng)域工藝需求,同時(shí)配備CCD相機(jī)定位保證植球精度;
0****3
非接觸式噴錫植錫方式,植球速度3~5點(diǎn)/s,凸點(diǎn)錫量穩(wěn)定、一致性好,工藝簡(jiǎn)便,易實(shí)現(xiàn)生產(chǎn)自動(dòng)化,
0****4
工藝無需整體加熱,植球過程中熱影響小,對(duì)預(yù)植凸點(diǎn)周邊晶圓材質(zhì)無影響;
0****5
錫料無助焊劑成分,省去焊后清洗工序,激光植球中激光熔錫噴錫過程可做到零污染生產(chǎn),更符合綠色制造理念。
審核編輯:劉清
-
pcb
+關(guān)注
關(guān)注
4326文章
23161瀏覽量
399987 -
激光技術(shù)
+關(guān)注
關(guān)注
2文章
224瀏覽量
22297 -
BGA封裝
+關(guān)注
關(guān)注
4文章
118瀏覽量
18003 -
光纖激光器
+關(guān)注
關(guān)注
12文章
179瀏覽量
20114 -
BGA芯片
+關(guān)注
關(guān)注
1文章
32瀏覽量
13668
原文標(biāo)題:激光植球技術(shù)在BGA芯片封裝工藝中的優(yōu)勢(shì)
文章出處:【微信號(hào):Vilaser-2014,微信公眾號(hào):紫宸激光】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
晶圓凸起封裝工藝技術(shù)簡(jiǎn)介
專業(yè)BGA植球,BGA返修,BGA焊接。
BGA植球與貼片工藝
【轉(zhuǎn)帖】一文讀懂BGA封裝技術(shù)的特點(diǎn)和工藝
BGA封裝是什么?BGA封裝技術(shù)特點(diǎn)有哪些?
BGA的封裝工藝流程基本知識(shí)簡(jiǎn)介
SMT之植球技術(shù)
如何利用BGA芯片激光錫球進(jìn)行植錫
BGA連接器植球工藝研究

揭秘BGA芯片植球技巧,打造完美電子連接!
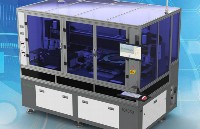
SiP封裝產(chǎn)品錫膏植球工藝





 激光植球技術(shù)在BGA芯片封裝工藝中的優(yōu)勢(shì)有哪些呢?
激光植球技術(shù)在BGA芯片封裝工藝中的優(yōu)勢(shì)有哪些呢?












評(píng)論