功率金屬-氧化物-半導體場效應管 (Power MOSFET) 由于輸入阻抗高、開關速度快,并且具有負溫度系數(溫度上升時電流減少),因此被認為是一種理想的開關器件。功率金屬-氧化物-半導體場效應管有垂直(或縱向)(Vertical DiffusedMOSFET, VDMOS)和橫向(或水平) (Lateral Diffused MOSFET, LDMOS) 兩種類型。
垂直型器件的源極和漏極分別制作在圓片上下和兩側。因為電流垂直流過圓片,垂直型器件不適合做成集成電路,通常封裝成分立器件,可以承受較大的電流。傳統 VDMOS 的結構如圖 2-68 所示。超高壓器件 (600V 以上)需要100μm 左右的外延層厚度,通態電阻較大。溝槽式柵極 MOSFET 的結構如圖2-69所示。溝槽式柵極 MOSFET 有較大的溝道密度,通態電阻較小。采用背面研磨技術(Backside Grinding) 可把圓片厚度研磨至 100μm 以下,有助于降低溝槽式柵極 MOSFET 的內阻。

LDMOS 的結構如圖 2-70 所示。制造工藝若可以提供淺槽隔離 ( ShallowTrench Isolation,STI)結構, 則可以將 STI 加在漂移區靠近溝道處,以增加LDMOS 承受電壓的能力;如圖2-71所示。LDMOS 管可以和集成電路結合。圖2-71所示的器件厚度約 10μm 左右,可以耐電壓 100~200V,結合低壓控制電壓和保護電路可以做成智能功率IC 和顯示器驅動電路。

耐壓 600V 以上的超高壓 LDMOS 需要既厚且長的漂移區(接近 100μm)。1979年,J.A.Appels 和 H. Vaes 提出采用薄外延層并使其完全耗盡 成空間電荷區以降低表面電場 (Reduced Surface Field, RESURF),的概念,可以優化器件的特性。器件漂移區耗盡示意圖如圖 2-72 所示。
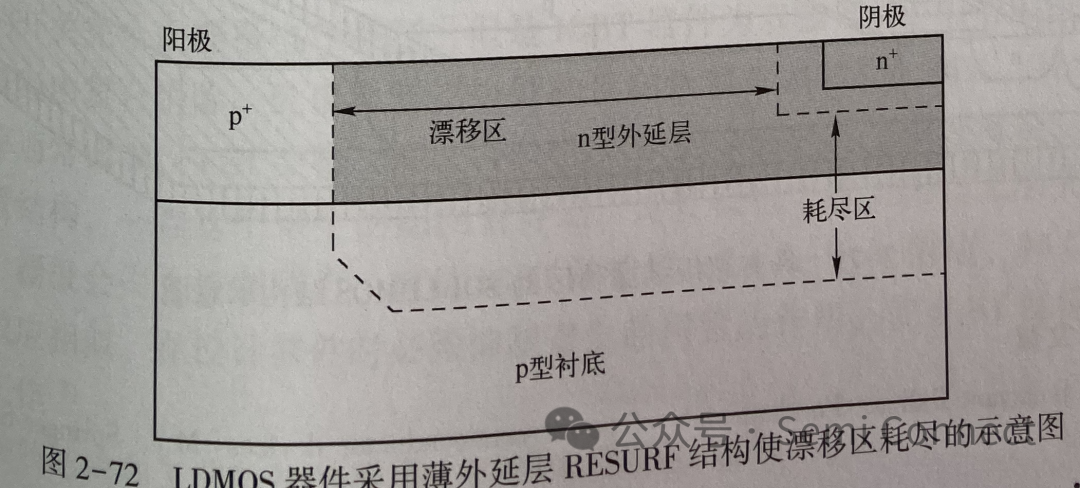
此一觀念后續又發展出多重 RESURF 結構的器件,如圖 2-73及圖2-74所示。

橫向超高壓器件集成在智能功率集成電路內時,其電流上限受到封裝工藝的影響,通常為2A 左右。
超級結(Super Junction)的結構以及溝槽式柵極都可以做在 LDMOS 里,類似的器件結構也都可以用 SOI 工藝制造,如圖 2-75 所示。

審核編輯:湯梓紅
-
MOSFET
+關注
關注
148文章
7770瀏覽量
216832 -
半導體
+關注
關注
335文章
28256瀏覽量
228841 -
場效應管
+關注
關注
47文章
1182瀏覽量
65175 -
晶體管
+關注
關注
77文章
9899瀏覽量
140025
原文標題:功率金屬-氧化物-半導體場效應管,功率金氧半場效電晶體,Power MOSFET
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦





 簡單認識功率金屬-氧化物-半導體場效應管
簡單認識功率金屬-氧化物-半導體場效應管
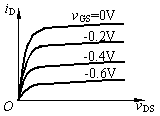

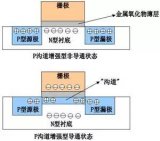
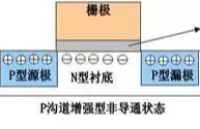
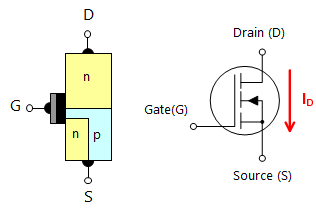










評論