半導體芯片在作為產品發布之前要經過測試以篩選出有缺陷的產品。每個芯片必須通過的 “封裝”工藝才能成為完美的半導體產品。封裝主要作用是電氣連接和保護半導體芯片免受元件影響。
通過前面步驟完成的晶圓被切割成單獨的半導體芯片。這些單獨切割的芯片中的每一個都稱為裸芯片或裸片。但現階段芯片無法與外界交換電信號,容易受到外界沖擊而損壞。對于要安裝在基板或電子設備上的半導體芯片(集成電路),首先需要進行相應的封裝。為半導體芯片與外界交換信號并保護其免受各種外部因素影響而開辟“道路”的過程稱為“封裝”。封裝的目的是將集成電路連接到電子設備,并保護電路免受以下因素的影響:高溫、高濕度、化學試劑、沖擊和振動等。
1)晶圓切割
首先,需要將晶圓分離成單獨的芯片。一個晶圓包含數百個芯片,每個芯片都用劃線標出。石劃片機用于沿著這些劃線切割晶圓。
2)貼片
劃片過的芯片被移動到引線框或印刷電路板 (PCB) 上。引線框架作為保護和支撐芯片的框架,在半導體芯片和外部電路之間傳輸電信號。
3)引線鍵合
使用細線將放置在基板上的半導體芯片的接觸點與基板的接觸點連接以賦予芯片電氣特性稱為引線鍵合。

引線鍵合和倒裝芯片方法的比較
除了傳統的引線鍵合方法外,還有另一種封裝方法,即使用球形凸點連接芯片和基板的電路。這提高了半導體速度。這種技術稱為倒裝芯片封裝,與引線鍵合相比,它具有更低的電阻、更快的速度和更小的外形尺寸。凸點通常由金 (Au) 或焊料(錫、鉛和銀的化合物)制成。
4)注塑成型
引線鍵合步驟完成后,就該進行成型步驟了。注塑完成所需形狀的芯片封裝,并保護半導體集成電路免受熱和濕氣等物理因素的影響。使用環氧樹脂密封引線鍵合芯片,這樣就完成了我們所知道的半導體芯片。
封裝測試:邁向完美半導體芯片的最后一步
終于,半導體芯片完成了。封裝后進行封裝測試,以篩選出有缺陷的半導體芯片。該測試也稱為最終測試,因為它是在成品上進行的。半導體芯片被放置在測試儀中,并經受各種電壓、電信號、溫度和不同的濕度水平,以測試產品的電氣特性、功能特性和運行速度。來自測試儀的數據經過分析并反饋到制造或裝配過程中,進一步提高了產品質量。我們關于生產半導體芯片的八個基本過程的系列文章到此結束。半導體技術的進步有望進一步豐富我們的生活。
來源:祺芯半導體
審核編輯:湯梓紅
-
晶圓
+關注
關注
52文章
5131瀏覽量
129297 -
封裝
+關注
關注
128文章
8598瀏覽量
144994 -
倒裝芯片
+關注
關注
1文章
103瀏覽量
16543 -
半導體芯片
+關注
關注
60文章
930瀏覽量
71286
原文標題:一覽半導體芯片封裝八大工藝
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
招聘半導體封裝工程師
半導體芯片是如何封裝的_半導體芯片封裝工藝流程
半導體生產封裝工藝簡介
半導體封裝工藝之模塑工藝類型

半導體封裝工藝面臨的挑戰






 半導體芯片封裝工藝介紹
半導體芯片封裝工藝介紹
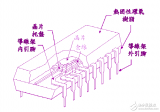



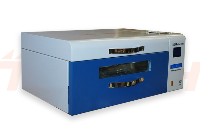











評論