今天我們聊聊半導體產品的封裝工藝,一提到“封裝”,大家不難就會想到“包裝”,但是,封裝可不能簡單的就認為等同于包裝的哦,因為封裝是“升級版”的包裝呢,封裝工藝不僅是將芯片包裹起來,還能制造通路并在外部環境下保護電路而不受外部環境的傷害。下面我們就開始講講半導體封裝工藝(Packaging)的相關知識!
將通過前段工序完成的晶圓半導體芯片—一切割,這些切割后的芯片稱為裸芯片(Bare Chip)或晶粒(Die),但是這種狀態下的芯片不能與外部交換電信號,所以容易受到外部沖擊,造成損壞。為了將半導體芯片或集成電路(IC)安裝在基板或電子設備上,需要對其進行相應的包裝。為使半導體芯片與外部交換信號從而制造通路,并在多種外部環境中保護芯片安全的工藝叫做封裝工藝。
封裝是連接集成電路和電子設備并保護電路免受外部環境(例如高溫,高濕,化學藥品和震動/沖擊等)傷害的工藝。那么,讓我們來了解一下封裝工藝中的有哪些重要步驟吧?
一、晶圓切割
首先,要將晶圓分離成單獨的芯片。一個晶圓上密集地排列著數百個芯片,每個芯片以劃線槽(ScribeLine)為界限被分隔開。然后沿著該劃線槽,用金剛石鋸或激光進行切割晶圓。因為這個工序是切割晶圓,所以晶圓切割作業也稱為“晶圓劃片(WaferSawing)”或“切片(Dicing)”。
二、芯片貼裝(Die attatch)
切割的芯片將被轉移到引線框架(Lead Frame) 或印制電路板(Printed Circuit Board, PCB)上。引線框架在半導體芯片和外部電路之間傳遞電信號,并在外部環境中起到保護和支持芯片的骨架作用。
三、芯片互聯
打線鍵合(Wire Bonding)是為了實現半導體的電特性,使用細金線將基板上的半導體芯片的接點與基板的接點相連的過程。

比較打線鍵合與倒裝芯片鍵合
除了傳統的打線鍵合的方法外,還有一種封裝方法,它是將芯片電路和基板凸點(Bump)相連接,以提高半導體的速度。這種技術被稱為倒裝芯片(Flip Chip)封裝。與引線鍵合相比,它的電阻更小,速度更快,并且實現了小規格(Form Factor)制造。凸點的材料主要是金(Au)或焊料(Solder) (錫/鉛/銀化合物)。
四、成型(Molding) 工藝
當芯片互聯完成時,保護半導體集成電路不受熱和濕氣等物理環境的影響,并將封裝制成理想的形態,這樣的過程叫做成型工藝。互聯完成后的半導體芯片,經過化學樹脂密封,就會成為我們常見的半導體。
完成封裝工藝的半導體芯片。經過最終測試之后制成的半導體用于將我們生活中的各個地方。
封裝工藝完成后,將進行封裝測試以最終篩選半導體產品合格與否。該測試是在成品成型后進行檢查,因此也被稱為"最終測試(Final Test)"。
封裝測試通過將半導體放入檢查設備(Tester)中,在不同條件下(電壓、電信號、溫度、濕度等)測量產品的電特性、功能特性和運行速度等。它還可以通過分析測試數據,反饋給制造過程或組裝過程,來提高產品質量。
到目前為止,我們了解了半導體誕生的8大工藝。從切割硅錠的圓盤形晶片變成尺寸比指甲還小的半導體,經過了復雜細致的過程,最終用于我們的日常生活中。期待無處不在的半導體不斷發展,讓我們的生活更加豐富多彩!
審核編輯:劉清
-
PCB板
+關注
關注
27文章
1472瀏覽量
53152 -
晶圓
+關注
關注
52文章
5130瀏覽量
129277 -
半導體封裝
+關注
關注
4文章
292瀏覽量
14339 -
電信號
+關注
關注
1文章
842瀏覽量
21024
原文標題:半導體產品封裝8大工藝的詳解;
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
半導體封裝工藝流程的主要步驟

招聘半導體封裝工程師
招聘人才 封裝工藝工程師
半導體生產封裝工藝簡介
半導體封裝工藝之模塑工藝類型

半導體封裝工藝面臨的挑戰






 聊聊半導體產品的8大封裝工藝
聊聊半導體產品的8大封裝工藝
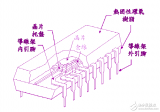



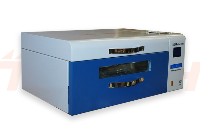











評論