減少HCI和電遷移的測試時間
許多可靠性“磨損”測試監測的是一個性能參數,該參數隨著對數變化的時間長度而穩步下降。在大多數情況下,會測量到10%的退化時間。10%的退化時間是一個基準,因為許多器件在比半導體器件的性能高10%的速度或電壓下進行測試。例如,DRAM可能會在45ns的工作時間內被測試,并且能完全正常工作,但隨后以較慢的50ns的性能出售。這種“guard-banding" 允許關鍵性能參數漂移高達10%,且設備不會超出其指定性能。可靠性測試必須證明設備在預期產品壽命 ( 通常為10年或20年 ) 內不會出現超過10%的關鍵性能參數漂移。
加速應力值可以在較短時間內達到10%的退化時間。然而,需要對失效機制有很好的了解,才能外推出在特定條件下達到10%的退化時間。在大多數情況下,需要在幾種不同的應力條件下進行測試,以提取應力條件和退化速率之間的關系。在使用最低應力條件下,增加了測試成本,在有限的測試時間范圍內提取需要的參數。
最大應力條件通常受到寄生參數的限制,例如焦耳加熱或源極-漏極擊穿電壓。此外競爭失效機制可以在更高的應力條件下導致測試失效機制的變化 ( 例如:對于電遷移測試,在更高溫度下從晶界擴散到體擴散的變化 ) 。這限制了可應用于最高應力條件的加速度。
在了解本期測試技術細節前,我們先來回顧一下今年關于晶圓可靠性測試的云上大講堂
另一種技術是測量在真實使用條件下達到較小退化百分比的時間。一般退化速率在對數時域中通常是線性的,可以在更短的測試時間內測量到退化較小百分比的變化。在這種測試條件下 “真實條件” 壓力水平的使用將只會在一種壓力條件下進行測試,并不需要理解壓力與時間關系。此外,不會擔心較高的應力條件會改變退化速率。然而使用這種技術將需要非常低的儀器噪聲水平和非常短的時間分辨率。
考慮圖1中所示的退化速率。在“真實條件應力” 下的晶體管被發現以每年10%年的速度退化。有了這個斜率,十年內退化率低于10%的要求意味著設備在一年內的退化率必須低于9%。這可以擴展到在1/10年或36.5天內需要低于8%的退化。此外,它必須在 3.65天內表現出小于7%的退化,在0.365天或8.76小時內表現出低于6%的退化。如果測試持續時間為 8.76 小時,則必須在40年內外推結果。為了使這種外推具有意義,我們必須能夠顯示在至少四個數量級的時間內積累的數據。這意味著最小時間分辨率必須為3.15秒。在3.15秒時,我們預計只能測量到2%的退化。準確測量該值需要小于0.2%的測量噪聲。
所有這些聽起來都很有可能。然而,這些要求顯然是退化速率的函數。圖1顯示了幾種不同的退化率,所有這些都導致了十年內10%的退化。表1顯示了在8.76小時的應力下測量和外推這些結果的最小時間和最小儀器分辨率。
表1:更高退化率所需的較低儀器噪聲

表1清楚地表明,退化速率越陡,在固定的測試持續時間內測量退化所需的儀器噪聲就越低。從另一個角度來看,如果給定儀器噪聲,則可以使用這些數據來確定最短測試時間。

圖1. HCI退化=10%/10年
最小時間點可以從圖1中的任何曲線中提取 , 方法是在圖上畫一條線來表示10倍的儀器噪音。該線與曲線相交的點表示儀表噪聲可被視為輕微影響的最短時間。例如,在圖1中,噪聲水平為0.01%的儀器將具有0.1%的10倍噪聲值。在圖上畫一條0.1%的線,很明顯,低的斜率(10%和 20%/十年)的最小應力時間可能非常短。然而,對于200%十年(每十年翻一番),最短時間必須是大約20秒。對于500%的退化斜率,最小應力時間必須為約30000秒或8.3小時。在這一點上,一個無法在十年內達到10%目標設備將顯示出10倍的測量噪聲。能夠很好地預測十年退化的總測試時間必須比這些值長得多。
對于200%/退化斜率,在可以測量退化的第一個精確測量值的點和十年點(3.15億秒)之間大約有七個數量級。這個差值的一半是3.5個數量級,即最小值的3162倍。這將提供63240秒或17.5小時的最短測試時間。這將允許在3.5個數量級上精確測量退化,并3.5個量級上外推斜率。
對于500%/退化斜率,退化第一次精確測量將在 30000秒時發生。從第一個點到十年點之間只有四個數量級的時間。然后,外推必須只覆蓋兩個數量級,以實現在不超過測量范圍的距離上進行外推的目標。這需要大約三百萬秒或 35 天的總測量時間。
較低的儀器噪聲裕度是非常有價值的。如果測量噪聲可以從0.01%下降到0.003%,則測試持續時間可以從35天減少到大約16天。顯然,儀器噪聲、測試持續時間和應用程序壽命之間存在關系。最短測試持續時間為 :

其中 :

公式1.0僅在測試開始后才有用。在測試開始之前,無法知道tnoise的值。該值只能在每個設備的測試過程中測量。測試順序必須為 :
■1. 在測試開始前,通過對性能參數進行多次測量來測量儀器噪聲。噪聲定義為單個測量值與測量值平均值之間的差的平方和除以測量次數的平方根。
■2. 開始應力并監測參數直到監測參數中的測量漂移大于測量噪聲的十倍。
■3. 一旦晶體管偏移量大于10倍的測量噪聲 我們將測量引起這種參數偏移所需的時間。這個“時間到10倍噪聲 " 將允許我們根據等式1.0計算總測試時間。該值將是“十倍噪聲點” 與預期應用壽命之間距離的一半。這將確保漂移不會在比數據范圍更長的范圍內外推。
■4. 繼續監測樣品中的漂移,直到超過計算的測試時間。該點之后的所有點的測量噪聲將小于測量的10%。
■5. 根據參數變化百分比對數與時間對數的最小二乘擬合將時間外推至10%漂移,在測量漂移超過10倍時間之間測量噪聲和測試的最大持續時間。
許多NMOS FET將在短應力時間內顯示出某些測量的性能參數的改善。這使得“真實條件”技術的使用變得復雜。界面空穴陷阱實際上可以增加低柵極場下的溝道遷移率并且在應力的最初幾秒期間VT的小幅度降低和增加Idlin或Idsat 。
為了計算這種影響,建議測量參數的最大值(或最小值)并從該拐點而不是從原始(時間零點)計算參數的變化。
示例 1
Idlin在兩次測量之間沒有應力的情況下,對晶體管的進行了十次測量。記錄值為:10.020、10.013、9.990、10.015、10.003、9.985、9.997、10.010、9.990和10.010毫 安。對 于10mA的平均Idlin這給出了與該晶體管的Idlin測量相關聯的0.1%的測量噪聲。熱載流子應力開始于柵極電壓為2.3V,漏極電壓為 3.7V。以大約3秒、10秒、30秒和100秒的對數時間間隔測量。這些第一個讀數點顯示的Idlin為10.101mA、10.000mA、9.9mA和9.8mA。該產品的使用壽命為一年。這種壓力的最短持續時間是多少 ?
答:測量數據顯示,在3秒時的最大Idlin值為 10.101mA。噪聲測量值為 0.1%,因此從測量值中減去10倍的噪聲將是10.101最大測量值的1%。10秒時的測量值正好比峰值低1%。因此,tnoise是10秒。現在根據公式1.0計算最小試驗持續時間。

繼續測試趨勢開始,測量點為300秒、1000秒,需要3000 秒、10000秒、30000秒和56156秒。如果測量結果與第一次測量中觀察到的0.2%/decade變化一致,則讀數的記錄值為9.7、9.6、9.5、9.4、9.31和9.25mA,用最小二乘法擬合,該數據在十年應力后的Idlin約8.4mA。這將超過十年內10%的目標,該設備將無法通過測試。
自試驗不是在加速應力條件下進行的,不會討論外推模型或異常失效機制。該設備在 “真實條件” 下進行壓力測試的。外推中使用的每個測量點都至少是測量噪聲的十倍,這樣時間外推才是清楚的(圖2)。由于數據不是在大于有效數據范圍的范圍內外推的,因此只要最小二乘擬合良好,時間外推的風險就很低。

圖2. HCI的時間外推
應該非常清楚的是,使用這種技術需要低的測量噪聲。如果測量噪聲約為測量值的1%,則沒有時間與該技術相關的節約。10倍噪聲的時間將是10%退化的時間,因此無需外推測量值,也無需節省時間。
雖然上面的大多數討論都涉及熱載流子壽命外推在使用條件應力的情況下,可以使用相同的技術來最大限度地減少加速試驗的時間電遷移測試。再一次預計該設備在對數時域中表現出線性退化。圖3顯示了金屬線的電阻隨時間的變化進行等溫電遷移測試(JEDEC標準JESD61)。
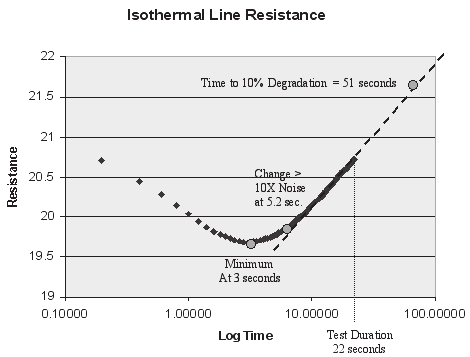
圖3. 等溫線電阻
圖3再次顯示了金屬線電阻最初作為時間的函數而下降。這是由于線在高應力溫度下的退火效應(晶粒生長、沉淀吸收等)。電阻在三秒讀取點達到最小值,然后由于電遷移而開始增加。
本例中的儀器(圖3)的測量噪聲為0.05%。該噪聲的10倍為0.5%。數據顯示,在5.2秒的讀取點上,測得的電阻變化高于最小值0.5%。該讀取點發生在記錄最小電阻2.2秒之后。在這一點之后的所有測量都應該顯示測量噪聲包括小于測量的退化的10%。然后在超過該最小測量點的時間上繼續測試一個數量級。測量信號的時間數量級是測量噪聲應該允許在該應力水平下精確地外推到10%的退化時間。對于這個例子,測試在22秒后終止。如果測試一直持續到可以測量到10%的退化時間,測試將花費51秒。因此,該技術能夠將總測試時間減少2.3倍以上。這對于快速過程控制測試非常重要。
審核編輯:劉清
-
DRAM
+關注
關注
40文章
2343瀏覽量
185282 -
NMOS
+關注
關注
3文章
358瀏覽量
35446 -
晶體管
+關注
關注
77文章
9993瀏覽量
140934 -
半導體器件
+關注
關注
12文章
777瀏覽量
32837 -
載流子
+關注
關注
0文章
134瀏覽量
7844
原文標題:白皮書|可靠性測試中,如何減少HCI和電遷移的測試時間?(附直播回放)
文章出處:【微信號:泰克科技,微信公眾號:泰克科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
提供半導體工藝可靠性測試-WLR晶圓可靠性測試
低功率LED可靠性到底是什么?應該如何測試
可靠性證明測試:高度加速壽命測試
半導體可靠性測試項目有哪些
可靠性測試包括哪些測試和設備?






 可靠性測試中,如何減少HCI和電遷移的測試時間?
可靠性測試中,如何減少HCI和電遷移的測試時間?












評論