晶圓是半導體制造過程中使用的一種圓形硅片,它是制造集成電路(IC)或芯片的基礎材料。晶圓的制造過程非常復雜,涉及到高純度硅的提煉、硅錠的生長、晶圓的切割和拋光等多個步驟。以下是對晶圓及其與芯片區別的詳細解釋。
晶圓的制造過程
- 硅的提煉 :首先從石英砂中提取出高純度的硅,這是制造晶圓的原料。
- 硅錠生長 :通過化學氣相沉積或直拉法將高純度硅熔化并緩慢拉出,形成圓柱形的硅錠。
- 晶圓切割 :將硅錠切割成薄片,這些薄片就是晶圓。晶圓的厚度通常在100微米到750微米之間。
- 晶圓拋光 :對切割后的晶圓進行精密拋光,確保其表面平整光滑,無缺陷。
- 晶圓檢測 :對晶圓進行嚴格的質量檢測,包括表面缺陷、晶格結構、純度等。
晶圓的物理特性
晶圓的物理特性對其在半導體制造中的應用至關重要:
- 純度 :晶圓的硅純度極高,通常達到99.9999%以上。
- 直徑 :晶圓的直徑有多種標準尺寸,如100mm(4英寸)、150mm(6英寸)、200mm(8英寸)和300mm(12英寸)等。
- 平整度 :晶圓表面必須非常平整,以確保后續制造過程的精確性。
- 晶向 :晶圓的晶體生長方向對器件的性能有影響,常見的晶向有<100>和<111>。
芯片的制造過程
芯片是在晶圓上制造出來的集成電路,其制造過程包括以下步驟:
- 光刻 :使用紫外光通過掩模將電路圖案轉移到晶圓表面的光刻膠上。
- 蝕刻 :通過化學或物理方法去除未被光刻膠保護的硅或其它材料層。
- 離子注入 :將摻雜元素注入晶圓,形成N型或P型半導體區域。
- 熱處理 :通過高溫退火處理,修復注入過程中的晶格損傷,激活摻雜元素。
- 金屬化 :在晶圓上形成金屬層,用于連接不同的器件和電路。
- 測試 :對晶圓上的芯片進行電性能測試,篩選出合格的芯片。
- 切割 :將晶圓切割成單獨的芯片。
- 封裝 :將切割后的芯片封裝到塑料或陶瓷外殼中,提供保護和電氣接口。
晶圓和芯片的區別
- 概念 :
- 晶圓是制造芯片的基礎材料,是未經加工的硅片。
- 芯片是在晶圓上經過一系列制造工藝制成的集成電路。
- 形態 :
- 晶圓是圓形的硅片,通常有多種標準直徑。
- 芯片是矩形的,尺寸根據設計和應用需求而定。
- 制造過程 :
- 晶圓的制造過程包括硅的提煉、硅錠生長、晶圓切割和拋光等。
- 芯片的制造過程包括光刻、蝕刻、離子注入、熱處理、金屬化等。
- 應用 :
- 晶圓本身不具有電子功能,它是制造芯片的原材料。
- 芯片是最終產品,具有特定的電子功能,如計算、存儲、放大等。
- 價值 :
- 晶圓的價值主要取決于其質量、純度和直徑。
- 芯片的價值取決于其設計、性能、功能和市場需求。
結論
晶圓和芯片是半導體行業的重要組成部分,但它們在形態、制造過程和應用上存在明顯區別。晶圓是制造芯片的原材料,經過一系列復雜的制造工藝,最終形成具有特定功能的集成電路,即芯片。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
集成電路
+關注
關注
5414文章
11846瀏覽量
365985 -
晶圓
+關注
關注
52文章
5070瀏覽量
128955 -
半導體芯片
+關注
關注
60文章
924瀏覽量
71109
發布評論請先 登錄
相關推薦
晶圓為什么要減薄
,滿足晶圓的翹曲度的要求。但封裝的時候則是薄一點更好,所以要處理到100~200um左右的厚度,就要用到減薄工藝。 ? 滿足封裝要求 降低封裝厚度 在電子設備不斷向小型化、輕薄化發展的趨勢下,對集成電路芯片的厚度有嚴格限制。通過
晶圓的TTV,BOW,WARP,TIR是什么?
晶圓的TTV、BOW、WARP、TIR是評估晶圓質量和加工精度的重要指標,以下是它們的詳細介紹:
TTV(Total Thickness Variation,總厚度偏差)
定義:

為什么晶圓是圓的?芯片是方的?
晶圓為什么是圓的而不是方的?按理說,方型的Die放在圓形的Wafer里總會不可避免有空間浪費,為什么不做成方型的更節省空間。因為制作工藝決定了它是圓形的。提純過后的高純度多晶硅是在一個子晶



碳化硅晶圓和硅晶圓的區別是什么
以下是關于碳化硅晶圓和硅晶圓的區別的分析: 材料特性: 碳化硅(SiC)是一種寬禁帶半導體材料,具有比硅(Si)更高的熱導率、電子遷移率和擊





 晶圓是什么東西 晶圓和芯片的區別
晶圓是什么東西 晶圓和芯片的區別


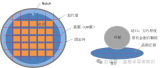

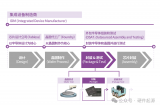










評論