引言
隨著半導體技術(shù)的飛速發(fā)展,摩爾定律逐漸逼近物理極限,傳統(tǒng)依靠縮小晶體管尺寸來提升性能的方法面臨嚴峻挑戰(zhàn)。在此背景下,先進封裝技術(shù)作為超越摩爾定律的重要途徑,正成為半導體行業(yè)新的焦點。晶圓廠和封測廠齊發(fā)力,共同推動先進封裝技術(shù)的創(chuàng)新與應用,為半導體行業(yè)帶來新的增長點。本報告將深入探討先進封裝技術(shù)的現(xiàn)狀、發(fā)展趨勢及其對半導體行業(yè)的影響。
一、先進封裝技術(shù)的重要性日益凸顯
1.1摩爾定律的放緩與封裝技術(shù)的崛起
摩爾定律指出,集成電路上可容納的晶體管數(shù)目大約每18至24個月就會翻一倍,處理器性能大約每兩年翻一倍,同時價格下降為之前的一半。然而,隨著工藝制程進入10nm以下,芯片設計成本快速提高,且越來越接近物理極限,摩爾定律明顯放緩。根據(jù)International Business Strategies (IBS)的數(shù)據(jù),16nm工藝的芯片設計成本為1.06億美元,而5nm則增至5.42億美元。
面對這一挑戰(zhàn),業(yè)界開始將研發(fā)重點從“如何把芯片變得更小”轉(zhuǎn)變?yōu)椤叭绾伟研酒獾酶 薄O冗M封裝技術(shù)通過提高集成度和性能、降低成本,成為延續(xù)摩爾定律的重要途徑。
1.2先進封裝技術(shù)的定義與功能
芯片封裝是用特定材料、工藝技術(shù)對芯片進行安放、固定、密封,保護芯片性能,并將芯片上的接點連接到封裝外殼上,實現(xiàn)芯片內(nèi)部功能的外部延伸。芯片封裝完成后,還需進行芯片測試以確保封裝的芯片符合性能要求。通常認為,集成電路封裝主要有電氣特性的保持、芯片保護、應力緩和及尺寸調(diào)整配合四大功能。
二、先進封裝技術(shù)的演進與發(fā)展現(xiàn)狀
2.1封裝技術(shù)的五個發(fā)展階段
迄今為止,全球集成電路封裝技術(shù)一共經(jīng)歷了五個發(fā)展階段:
通孔插裝時代:以DIP(雙列直插封裝)、SIP(單列直插封裝)技術(shù)為代表。
表面貼裝時代:以LCC(無引線芯片載體)、SOP(小外形封裝)為代表,用引線替代引腳并貼裝在PCB板上。
面積陣列時代:以BGA(球柵陣列封裝)、CSP(芯片尺寸封裝)、FC(倒裝焊封裝)等先進封裝技術(shù)為代表,封裝體積大幅縮減,系統(tǒng)性能顯著提升。
多芯片封裝與系統(tǒng)級封裝時代:MCM(多芯片模塊)、SiP(系統(tǒng)級封裝)、Bumping等技術(shù)快速發(fā)展,封裝技術(shù)從單芯片封裝向多芯片封裝、從封裝元件向封裝系統(tǒng)演變。
立體結(jié)構(gòu)封裝時代:MEMS(微機電機械系統(tǒng)封裝)、TSV(硅通孔)、FO(扇出型封裝)等立體結(jié)構(gòu)型封裝技術(shù)相繼出現(xiàn),封裝產(chǎn)業(yè)鏈進入復雜集成時代。
2.2當前主流技術(shù)與未來趨勢
當前,全球封裝行業(yè)的主流技術(shù)處于以CSP、BGA為主的第三階段,并向以SiP、FC、Bumping為代表的第四階段和第五階段封裝技術(shù)邁進。根據(jù)SemiconductorEngineering預測,全球半導體封裝市場規(guī)模將由2020年的650.4億美元增長至2027年的1186億美元,復合增長率為6.6%。其中,先進封裝復合增長率超過傳統(tǒng)封裝,有望于2027年市場規(guī)模超過傳統(tǒng)封裝,達到616億美元。
先進封裝技術(shù)多樣,包括FO、WLCSP(晶圓級芯片規(guī)模封裝)、FCCSP(倒裝芯片級封裝)、FCBGA、2.5D封裝、3D封裝、SiP等。這些技術(shù)通過提高集成度和性能、降低成本,滿足市場對電子設備小型化、系統(tǒng)化和信息傳遞速度不斷提升的需求。
三、晶圓廠和封測廠在先進封裝中的角色與發(fā)力
3.1晶圓廠的優(yōu)勢與布局
晶圓廠在先進封裝中的地位領(lǐng)先,尤其是高端封裝的實現(xiàn)越來越依賴前道技術(shù)。臺積電、英特爾和三星等晶圓廠憑借先進封裝需求走高,封裝收入在全球市場中占據(jù)重要地位。
臺積電:早在2008年便成立集成互連與封裝技術(shù)整合部門,專門研究先進封裝技術(shù)。目前,臺積電已形成CoWoS、InFO、SoIC技術(shù)陣列,并在2020年宣布將其2.5D和3D封裝產(chǎn)品合并為一個全面的品牌3DFabric技術(shù),進一步加速3D IC生態(tài)系統(tǒng)的創(chuàng)新及完備。
英特爾:同樣在先進封裝領(lǐng)域投入巨資,通過不斷迭代新型封裝技術(shù),提升產(chǎn)品性能和市場競爭力。
三星:在3D封裝技術(shù)方面取得顯著進展,通過TSV等關(guān)鍵技術(shù)實現(xiàn)芯片間的垂直互聯(lián),提高集成度和性能。
3.2封測廠的專業(yè)化與創(chuàng)新
半導體產(chǎn)業(yè)垂直分工造就專業(yè)委外封裝測試企業(yè)(OSAT)。封測廠通過專業(yè)化服務,為晶圓廠提供高質(zhì)量的封裝測試解決方案。在先進封裝領(lǐng)域,頭部OSAT廠商如安靠、日月光、長電科技等憑借技術(shù)創(chuàng)新和規(guī)模效應,不斷推動封裝技術(shù)的進步。
四、先進封裝技術(shù)的市場前景與機遇
4.1市場規(guī)模與增長潛力
根據(jù)Yole的預測,全球先進封裝市場將持續(xù)增長。2023年全球先進封裝營收為378億美元,占半導體封裝市場的44%,預計2024年將增長13%至425億美元,2029年增長至695億美元,CAGR達11%。其中,2.5D/3D封裝增速最快,高端封裝市場規(guī)模將從2023年的43億美元增長至2029年的280億美元,CAGR達37%。
4.2應用領(lǐng)域與市場需求
先進封裝技術(shù)在多個應用領(lǐng)域展現(xiàn)出巨大潛力。在高性能計算領(lǐng)域,先進封裝技術(shù)通過提高集成度和性能,滿足超算和AI芯片對算力和帶寬的極致需求;在消費電子領(lǐng)域,隨著智能手機、可穿戴設備等產(chǎn)品的不斷迭代升級,對芯片封裝技術(shù)的要求也越來越高;在汽車電子和工業(yè)物聯(lián)網(wǎng)領(lǐng)域,先進封裝技術(shù)通過提高系統(tǒng)的可靠性和穩(wěn)定性,保障產(chǎn)品的長期穩(wěn)定運行。
4.3國產(chǎn)替代與全球競爭
面對美國等國家的制裁和技術(shù)封鎖,中國半導體行業(yè)加速國產(chǎn)替代進程。在先進封裝領(lǐng)域,國內(nèi)企業(yè)如長電科技、通富微電、華天科技等憑借技術(shù)創(chuàng)新和市場拓展,逐步縮小與國際領(lǐng)先企業(yè)的差距。未來,隨著全球半導體市場的持續(xù)復蘇和中國市場需求的快速增長,國產(chǎn)先進封裝技術(shù)將迎來更加廣闊的發(fā)展空間。
五、結(jié)論與展望
先進封裝技術(shù)作為超越摩爾定律的重要途徑,正成為半導體行業(yè)新的焦點。晶圓廠和封測廠齊發(fā)力,共同推動先進封裝技術(shù)的創(chuàng)新與應用,為半導體行業(yè)帶來新的增長點。未來,隨著全球半導體市場的持續(xù)復蘇和中國市場需求的快速增長,先進封裝技術(shù)將迎來更加廣闊的發(fā)展空間。同時,國內(nèi)企業(yè)需加強技術(shù)創(chuàng)新和市場拓展,提高國產(chǎn)先進封裝技術(shù)的國際競爭力,為半導體行業(yè)的自主可控貢獻力量。
-
晶圓
+關(guān)注
關(guān)注
52文章
5131瀏覽量
129287 -
晶體管
+關(guān)注
關(guān)注
77文章
9995瀏覽量
140955 -
封測
+關(guān)注
關(guān)注
4文章
363瀏覽量
35444
發(fā)布評論請先 登錄
Arm攜手微軟共筑云計算和PC未來
攜手共塑物料搬運未來,永恒力與EP設備達成戰(zhàn)略合作

臺積電最大先進封裝廠AP8進機
日月光2024年先進封測業(yè)務營收大增
晶圓和封測廠紛紛布局先進封裝(附44頁PPT)
高通攜手谷歌,共筑智能汽車新未來
格創(chuàng)東智受邀出席封測年會,共話先進封裝CIM國產(chǎn)方案

整合為王,先進封裝「面板化」!臺積電、日月光、群創(chuàng)搶攻FOPLP,如何重塑封裝新格局?

賦能創(chuàng)芯,共筑生態(tài):航順芯片HK32MCU新品發(fā)布,強勢打破行業(yè)內(nèi)卷
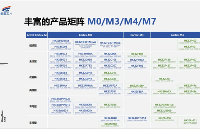
賽美特與某知名12英寸封測廠簽署戰(zhàn)略合作協(xié)議
長飛先進與懷柔實驗室攜手推進碳化硅技術(shù),共筑綠色低碳未來
日月光宣布建設高雄K28廠,擴充先進封裝產(chǎn)能
先進封裝技術(shù)綜述






 晶圓廠與封測廠攜手,共筑先進封裝新未來
晶圓廠與封測廠攜手,共筑先進封裝新未來












評論