動(dòng)態(tài)
-
發(fā)布了文章 2025-06-16 14:07
混合集成電路(HIC)芯片封裝中真空回流爐的選型指南
 混合集成電路(HIC)芯片封裝對(duì)工藝精度和產(chǎn)品質(zhì)量要求極高,真空回流爐作為關(guān)鍵設(shè)備,其選型直接影響封裝效果。本文深入探討了在混合集成電路芯片封裝過(guò)程中選擇真空回流爐時(shí)需要考慮的多個(gè)關(guān)鍵因素,包括溫度控制精度、真空度、加熱均勻性、設(shè)備穩(wěn)定性與可靠性、工藝兼容性、成本效益以及售后服務(wù)等,旨在為相關(guān)企業(yè)和研發(fā)人員提供全面且實(shí)用的選型參考,助力其做出更科學(xué)合理的設(shè)備228瀏覽量
混合集成電路(HIC)芯片封裝對(duì)工藝精度和產(chǎn)品質(zhì)量要求極高,真空回流爐作為關(guān)鍵設(shè)備,其選型直接影響封裝效果。本文深入探討了在混合集成電路芯片封裝過(guò)程中選擇真空回流爐時(shí)需要考慮的多個(gè)關(guān)鍵因素,包括溫度控制精度、真空度、加熱均勻性、設(shè)備穩(wěn)定性與可靠性、工藝兼容性、成本效益以及售后服務(wù)等,旨在為相關(guān)企業(yè)和研發(fā)人員提供全面且實(shí)用的選型參考,助力其做出更科學(xué)合理的設(shè)備228瀏覽量 -
發(fā)布了文章 2025-06-03 15:43
-
發(fā)布了文章 2025-05-30 11:09
半導(dǎo)體硅表面氧化處理:必要性、原理與應(yīng)用
 半導(dǎo)體硅作為現(xiàn)代電子工業(yè)的核心材料,其表面性質(zhì)對(duì)器件性能有著決定性影響。表面氧化處理作為半導(dǎo)體制造工藝中的關(guān)鍵環(huán)節(jié),通過(guò)在硅表面形成高質(zhì)量的二氧化硅(SiO?)層,顯著改善了硅材料的電學(xué)、化學(xué)和物理特性。本文從半導(dǎo)體硅表面氧化的必要性出發(fā),深入探討其原理、方法、優(yōu)勢(shì)以及在集成電路、微電子器件等領(lǐng)域的廣泛應(yīng)用,旨在揭示表面氧化處理在推動(dòng)半導(dǎo)體技術(shù)發(fā)展中的重要作326瀏覽量
半導(dǎo)體硅作為現(xiàn)代電子工業(yè)的核心材料,其表面性質(zhì)對(duì)器件性能有著決定性影響。表面氧化處理作為半導(dǎo)體制造工藝中的關(guān)鍵環(huán)節(jié),通過(guò)在硅表面形成高質(zhì)量的二氧化硅(SiO?)層,顯著改善了硅材料的電學(xué)、化學(xué)和物理特性。本文從半導(dǎo)體硅表面氧化的必要性出發(fā),深入探討其原理、方法、優(yōu)勢(shì)以及在集成電路、微電子器件等領(lǐng)域的廣泛應(yīng)用,旨在揭示表面氧化處理在推動(dòng)半導(dǎo)體技術(shù)發(fā)展中的重要作326瀏覽量 -
發(fā)布了文章 2025-05-29 11:40
芯片制造“鍍”金術(shù):化學(xué)鍍技術(shù)的前沿突破與未來(lái)藍(lán)圖
 隨著芯片技術(shù)的飛速發(fā)展,對(duì)芯片制造中關(guān)鍵工藝的要求日益提高。化學(xué)鍍技術(shù)作為一種重要的表面處理技術(shù),在芯片制造中發(fā)揮著不可或缺的作用。本文深入探討了化學(xué)鍍技術(shù)在芯片制造中的應(yīng)用現(xiàn)狀,分析了其原理、優(yōu)勢(shì)以及面臨的挑戰(zhàn),并對(duì)近年來(lái)該技術(shù)的研究進(jìn)展進(jìn)行了全面梳理,同時(shí)展望了其未來(lái)的發(fā)展方向,旨在為芯片制造領(lǐng)域中化學(xué)鍍技術(shù)的進(jìn)一步優(yōu)化和創(chuàng)新提供參考。398瀏覽量
隨著芯片技術(shù)的飛速發(fā)展,對(duì)芯片制造中關(guān)鍵工藝的要求日益提高。化學(xué)鍍技術(shù)作為一種重要的表面處理技術(shù),在芯片制造中發(fā)揮著不可或缺的作用。本文深入探討了化學(xué)鍍技術(shù)在芯片制造中的應(yīng)用現(xiàn)狀,分析了其原理、優(yōu)勢(shì)以及面臨的挑戰(zhàn),并對(duì)近年來(lái)該技術(shù)的研究進(jìn)展進(jìn)行了全面梳理,同時(shí)展望了其未來(lái)的發(fā)展方向,旨在為芯片制造領(lǐng)域中化學(xué)鍍技術(shù)的進(jìn)一步優(yōu)化和創(chuàng)新提供參考。398瀏覽量 -
發(fā)布了文章 2025-05-28 14:56
甲酸真空共晶焊接工藝:開(kāi)啟精密焊接新時(shí)代
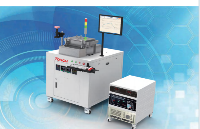 在現(xiàn)代電子制造領(lǐng)域,焊接工藝的優(yōu)劣直接關(guān)乎產(chǎn)品的性能與可靠性。隨著電子器件不斷向小型化、高性能化發(fā)展,傳統(tǒng)焊接技術(shù)逐漸暴露出諸多局限性。在此背景下,甲酸真空共晶焊接工藝憑借其獨(dú)特的優(yōu)勢(shì)脫穎而出,成為眾多高端電子制造領(lǐng)域的關(guān)鍵技術(shù)。369瀏覽量
在現(xiàn)代電子制造領(lǐng)域,焊接工藝的優(yōu)劣直接關(guān)乎產(chǎn)品的性能與可靠性。隨著電子器件不斷向小型化、高性能化發(fā)展,傳統(tǒng)焊接技術(shù)逐漸暴露出諸多局限性。在此背景下,甲酸真空共晶焊接工藝憑借其獨(dú)特的優(yōu)勢(shì)脫穎而出,成為眾多高端電子制造領(lǐng)域的關(guān)鍵技術(shù)。369瀏覽量 -
發(fā)布了文章 2025-04-18 13:39
-
發(fā)布了文章 2025-04-14 13:49
-
發(fā)布了文章 2025-04-11 14:02
芯片封裝中的四種鍵合方式:技術(shù)演進(jìn)與產(chǎn)業(yè)應(yīng)用
 芯片封裝作為半導(dǎo)體制造的核心環(huán)節(jié),承擔(dān)著物理保護(hù)、電氣互連和散熱等關(guān)鍵功能。其中,鍵合技術(shù)作為連接裸芯片與外部材料的橋梁,直接影響芯片的性能與可靠性。當(dāng)前,芯片封裝領(lǐng)域存在引線鍵合、倒裝芯片、載帶自動(dòng)鍵合和混合鍵合四種主流技術(shù),它們?cè)诠に嚵鞒獭⒓夹g(shù)特點(diǎn)和應(yīng)用場(chǎng)景上各具優(yōu)勢(shì)。本文將深入剖析這四種鍵合方式的技術(shù)原理、發(fā)展現(xiàn)狀及未來(lái)趨勢(shì),為產(chǎn)業(yè)界提供技術(shù)參考。859瀏覽量
芯片封裝作為半導(dǎo)體制造的核心環(huán)節(jié),承擔(dān)著物理保護(hù)、電氣互連和散熱等關(guān)鍵功能。其中,鍵合技術(shù)作為連接裸芯片與外部材料的橋梁,直接影響芯片的性能與可靠性。當(dāng)前,芯片封裝領(lǐng)域存在引線鍵合、倒裝芯片、載帶自動(dòng)鍵合和混合鍵合四種主流技術(shù),它們?cè)诠に嚵鞒獭⒓夹g(shù)特點(diǎn)和應(yīng)用場(chǎng)景上各具優(yōu)勢(shì)。本文將深入剖析這四種鍵合方式的技術(shù)原理、發(fā)展現(xiàn)狀及未來(lái)趨勢(shì),為產(chǎn)業(yè)界提供技術(shù)參考。859瀏覽量 -
發(fā)布了文章 2025-04-10 14:36
從焊錫膏到3D堆疊:材料創(chuàng)新如何重塑芯片性能規(guī)則?
 在摩爾定律逼近物理極限的當(dāng)下,先進(jìn)封裝技術(shù)正成為半導(dǎo)體行業(yè)突破性能瓶頸的關(guān)鍵路徑。以系統(tǒng)級(jí)封裝(SiP)、晶圓級(jí)封裝(WLP)、3D堆疊、Chiplet異構(gòu)集成為代表的顛覆性方案,正重新定義芯片性能躍遷的軌跡。隨著AI芯片需求的爆發(fā)式增長(zhǎng)及臺(tái)積電CoWoS產(chǎn)能限制,先進(jìn)封裝材料作為產(chǎn)業(yè)鏈核心上游,其性能直接決定封裝密度、可靠性及功能性,成為推動(dòng)技術(shù)持續(xù)進(jìn)步的479瀏覽量
在摩爾定律逼近物理極限的當(dāng)下,先進(jìn)封裝技術(shù)正成為半導(dǎo)體行業(yè)突破性能瓶頸的關(guān)鍵路徑。以系統(tǒng)級(jí)封裝(SiP)、晶圓級(jí)封裝(WLP)、3D堆疊、Chiplet異構(gòu)集成為代表的顛覆性方案,正重新定義芯片性能躍遷的軌跡。隨著AI芯片需求的爆發(fā)式增長(zhǎng)及臺(tái)積電CoWoS產(chǎn)能限制,先進(jìn)封裝材料作為產(chǎn)業(yè)鏈核心上游,其性能直接決定封裝密度、可靠性及功能性,成為推動(dòng)技術(shù)持續(xù)進(jìn)步的479瀏覽量 -
發(fā)布了文章 2025-04-09 13:35
功率半導(dǎo)體與集成技術(shù):開(kāi)啟能源與智能新紀(jì)元
 本文深入探討了功率半導(dǎo)體器件與功率集成技術(shù)的發(fā)展現(xiàn)狀,分析了其面臨的挑戰(zhàn)與機(jī)遇,并對(duì)未來(lái)發(fā)展趨勢(shì)進(jìn)行了展望。功率半導(dǎo)體器件作為電能轉(zhuǎn)換與電路控制的核心,在新能源、工業(yè)控制、消費(fèi)電子等領(lǐng)域發(fā)揮著關(guān)鍵作用。隨著技術(shù)的不斷進(jìn)步,功率半導(dǎo)體器件正朝著高性能、高集成度、智能化方向發(fā)展,功率集成技術(shù)也日益成熟,為各行業(yè)帶來(lái)了更高的效率和可靠性。566瀏覽量
本文深入探討了功率半導(dǎo)體器件與功率集成技術(shù)的發(fā)展現(xiàn)狀,分析了其面臨的挑戰(zhàn)與機(jī)遇,并對(duì)未來(lái)發(fā)展趨勢(shì)進(jìn)行了展望。功率半導(dǎo)體器件作為電能轉(zhuǎn)換與電路控制的核心,在新能源、工業(yè)控制、消費(fèi)電子等領(lǐng)域發(fā)揮著關(guān)鍵作用。隨著技術(shù)的不斷進(jìn)步,功率半導(dǎo)體器件正朝著高性能、高集成度、智能化方向發(fā)展,功率集成技術(shù)也日益成熟,為各行業(yè)帶來(lái)了更高的效率和可靠性。566瀏覽量