SiO?薄膜的厚度量測(cè)原理主要基于光的干涉現(xiàn)象。具體來說,當(dāng)單色光垂直照射到SiO?薄膜表面時(shí),光波會(huì)在薄膜表面以及薄膜與基底的界面處發(fā)生反射。這兩束反射光在返回的過程中會(huì)發(fā)生干涉,即相互疊加,產(chǎn)生干涉條紋。干涉條紋的形成取決于兩束反射光的光程差。
- 干涉現(xiàn)象 :
- 當(dāng)單色光照射到SiO?薄膜上時(shí),一部分光在薄膜表面反射,另一部分光穿透薄膜在薄膜與基底的界面處反射后再穿回薄膜表面。這兩束反射光在空間中相遇并發(fā)生干涉。
- 光程差與干涉條紋 :
- 干涉條紋的形成與兩束反射光的光程差密切相關(guān)。光程差是兩束反射光所走路徑的長(zhǎng)度差。當(dāng)光程差是半波長(zhǎng)的偶數(shù)倍時(shí),兩束光相位相同,干涉加強(qiáng),形成亮條紋;而當(dāng)光程差是半波長(zhǎng)的奇數(shù)倍時(shí),兩束光相位相反,干涉相消,形成暗條紋。
- 膜厚計(jì)算 :
- 通過觀察和計(jì)數(shù)干涉條紋的數(shù)量,結(jié)合已知的入射光波長(zhǎng)和SiO?的折射率,就可以利用特定的計(jì)算公式來確定SiO?薄膜的厚度。具體來說,膜厚儀會(huì)根據(jù)干涉條紋的數(shù)目、入射光的波長(zhǎng)和SiO?的折射系數(shù)等參數(shù),利用數(shù)學(xué)公式來計(jì)算出薄膜的厚度。
- 高級(jí)技術(shù) :
- 現(xiàn)代SiO?薄膜厚度測(cè)量?jī)x器可能還采用了其他高級(jí)技術(shù)來提高測(cè)量精度和可靠性,如白光干涉原理。這種原理通過測(cè)量不同波長(zhǎng)光在薄膜中的干涉情況,可以進(jìn)一步精確確定薄膜的厚度。
- 影響因素 :
- 膜厚儀的測(cè)量精度受多種因素影響,包括光源的穩(wěn)定性、探測(cè)器的靈敏度以及光路的精確性等。因此,在使用膜厚儀進(jìn)行SiO?薄膜厚度測(cè)量時(shí),需要確保儀器處于良好的工作狀態(tài),并進(jìn)行定期校準(zhǔn),以保證測(cè)量結(jié)果的準(zhǔn)確性和可靠性。
總結(jié):
SiO?薄膜的厚度量測(cè)原理主要基于光的干涉現(xiàn)象,通過測(cè)量反射光波的相位差并利用相關(guān)物理參數(shù)來計(jì)算薄膜的厚度。這種方法在微電子、光學(xué)、材料科學(xué)等領(lǐng)域具有廣泛的應(yīng)用價(jià)值,有助于科研人員和生產(chǎn)人員更好地控制和優(yōu)化SiO?薄膜的性能和質(zhì)量。
-
探測(cè)器
+關(guān)注
關(guān)注
15文章
2706瀏覽量
74393 -
光源
+關(guān)注
關(guān)注
3文章
745瀏覽量
69964 -
SIO
+關(guān)注
關(guān)注
0文章
4瀏覽量
9117
發(fā)布評(píng)論請(qǐng)先 登錄
sio2_sio2是什么意思
一種基于梳狀濾波器的固體腔厚度測(cè)量方法
測(cè)厚儀 ZM100測(cè)透明薄膜的厚度
芯片制作工藝流程 一
ITO玻璃技術(shù)之SiO2阻擋膜層規(guī)格
鍍復(fù)SiO2膜的電容器介質(zhì)膜
基于SiO2薄膜的915nm半導(dǎo)體激光器的無雜質(zhì)空位誘導(dǎo)量子阱混合研究
PECVD沉積SiO2和SiN對(duì)P-GaN有什么影響
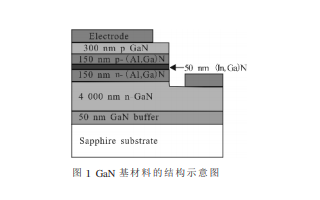
薄膜厚度的檢測(cè)技術(shù)有哪些
二氧化硅薄膜應(yīng)用領(lǐng)域及特性的詳細(xì)資料說明
芯片表面SiO2薄膜

sio2膜層鍍膜如何解決膜裂
sio2薄膜在集成電路中的作用
SiO2薄膜的刻蝕機(jī)理
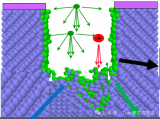





 sio2薄膜的厚度量測(cè)原理
sio2薄膜的厚度量測(cè)原理












評(píng)論