玻璃基板在異質集成技術中被廣泛應用。它與有機基板、硅以及其他陶瓷材料相似,能在2.5D和3D封裝中充當轉接層或中間層,并且在3D封裝技術中,玻璃基板扮演著基礎材料的角色,為產品創新提供了新的可能性。
玻璃基板:
材料與工藝的變革
玻璃基板主要用于替代傳統的硅/有機基板和中介層,其應用范圍覆蓋了面板、IC等泛半導體領域。玻璃材質因其成本低、電學性能優越以及低翹曲率等優勢,能夠有效克服有機物和硅材質的缺陷,實現更穩定、更高效的連接,并降低生產成本。

國際大廠對玻璃基板的布局動態
盡管英特爾已投入超過十年的研發,并計劃在下一代產品中使用玻璃基板,但在中國大陸,玻璃基板仍被視為一項新興技術。這項技術可能面臨的主要問題之一是成本問題。
目前,玻璃基板技術可能首先在高性能計算領域得到應用,因為這一領域的客戶更愿意投資新技術以獲得更高的性能。因此,玻璃基板技術的發展可能會更多地圍繞AI芯片進行突破。
除了高性能GPU和AI產品外,玻璃基板技術本身并不新穎,因為它已在其他產品中得到成熟應用,比如早期的光通信、傳感器、射頻產品,尤其是顯示用LED產品等。但對于先進封裝技術而言,玻璃基板仍是一個相對較新的領域,還需要經歷一個較長的發展過程。
目前,國內從事先進封裝的玻璃基板工廠大多還未進入量產階段,多數仍處于研發階段。他們正在解決玻璃與金屬層的結合力問題、填孔問題,以及未來更高層數的可靠性問題。預計到2025年底或2026年,這些工廠才能達到量產水平。在此之前,大部分工作仍將集中在研發上。
四大關鍵技術挑戰
玻璃基板技術雖然具有巨大的潛力和優勢,但要實現其在先進封裝領域的廣泛應用,仍需克服眾多技術挑戰。
高精度通孔
玻璃通孔成孔技術是制約TGV發展的主要困難之一。
制備要求:
高速、側壁光滑、高精度
垂直度好、窄節距、低成本
目前,TGV的制作工藝包括但不限于噴砂法、聚焦放電法、等離子刻蝕法等。從玻璃基板制造工藝及行業應用來看,激光誘導刻蝕法是目前最主流的TGV制作工藝之一。其主要方法相對簡單,即通過激光對玻璃進行改性處理,然后在青木酸中利用不同的時間控制來制作不同孔徑的孔。

然而,盡管單個或少量孔的制作可能較為簡單,但當數量增加到數十萬個時,難度會以幾何級數增長。這也是許多TGV未能達到預期效果的原因之一。此外,如何測試每個通孔的良率或尺寸精度,也是我們需要考慮的問題。目前來看,除了玻璃基板的先進板廠在研發之外,進程比較快的是那些原本從事光電或玻璃相關工藝的工廠。
高質量金屬填充
目前,金屬填孔TGV主要有兩種工藝:一是銅漿塞孔工藝,二是電鍍工藝。這兩種工藝在應用場景、材料成本和性能上存在差異。選擇何種工藝取決于孔徑、深寬比以及對電阻率和電導率的要求。值得一提的是,銅漿塞孔技術相較于電鍍工藝具有獨特優勢,但可能在電導率方面存在較大劣勢。
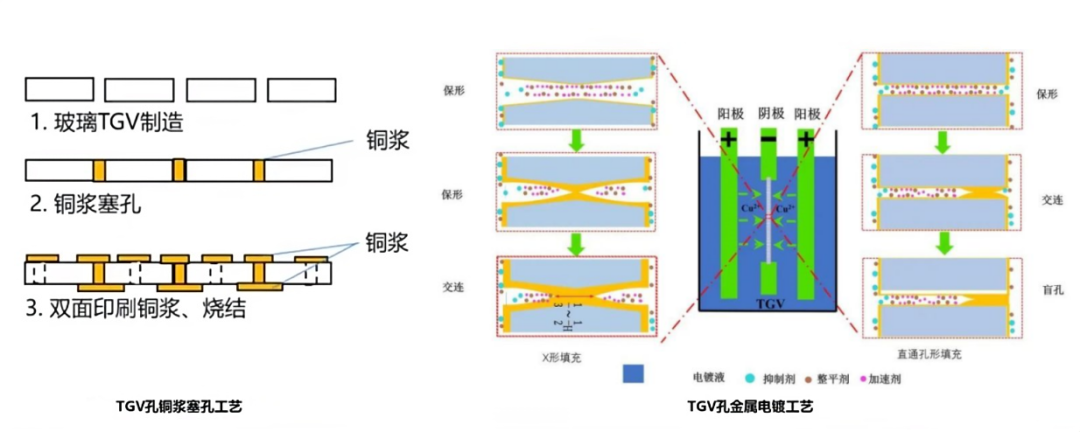
高密度布線
另一個制約玻璃基板技術應用的關鍵因素是高密度布線。盡管有不少公司能夠較好地完成玻璃基板的填孔或TGV工藝,但真正挑戰在于完成玻璃通孔的制備后,如何通過布線來實現電氣連接,將其制成一個完整的玻璃基板或玻璃基interposer,并且在有實際應用場景時實現高密度布線。
傳統的工藝方法可能包括半加成法,以及將現有的有機基板電路制作模式應用到玻璃基板上,即將有機的BT層轉化為玻璃級別的層以提供支撐。其他部分則采用完整的有機基板電鍍層制作方法,最后通過進一步的壓合或其他工藝進行整合,這可能是板廠常用的一些手段。
但由于半加成工藝法在線寬小于5μm的時候會面臨許多挑戰,如在窄間距內刻蝕種子層容易對銅走線造成損傷且窄間距里的種子層殘留易造成漏電。針對表面高密度布線也有不同工藝路線的探索。
至于先前提到的專注于玻璃機的LED場景的公司,它們可能會在玻璃機的TGV和填孔工序完成后,應用晶圓中道工藝,包括RDL工藝和CTT工藝來進行制作。海外還有一種新的技術,即多層RDL直接柵板轉移技術。盡管這一技術目前尚未得到廣泛應用,但也是未來的一個技術方向之一。
此外納米壓印,尤其是在晶圓制造方面,佳能已取得了一定的應用成果。未來,業界期望能夠在玻璃基板電路的制作上找到更多應用場景。
鍵合技術
玻璃基板關鍵技術之四為鍵合技術,目前Chiplet的D2W及Flip Chip鍵合工藝主要分為三大類。
Reflow回流焊鍵合工藝:
回流焊爐可以批量焊接產品,并且隨著技術水平的提升,bump pitch>80μm已不再是難題。但是缺點也很明顯,熱應力導致的翹曲極大,回流焊過程中高溫和低溫的波動可能會導致產品發生較大變形。尤其是當芯片面積接近基本面積時,整個焊盤也會變得極大。這也是為什么在做更大密度的先進封裝芯片集成時,必須使用更大尺寸的封裝,因為有機基板的翹曲極限無法滿足PCB板的間隔要求。因此需要用玻璃基板來代替有機基板。
TCB熱壓焊鍵合工藝:
以100°C/s的升溫速率和-50℃℃/s的降溫速率對焊點進行快速焊接,bump pitch>10μm。
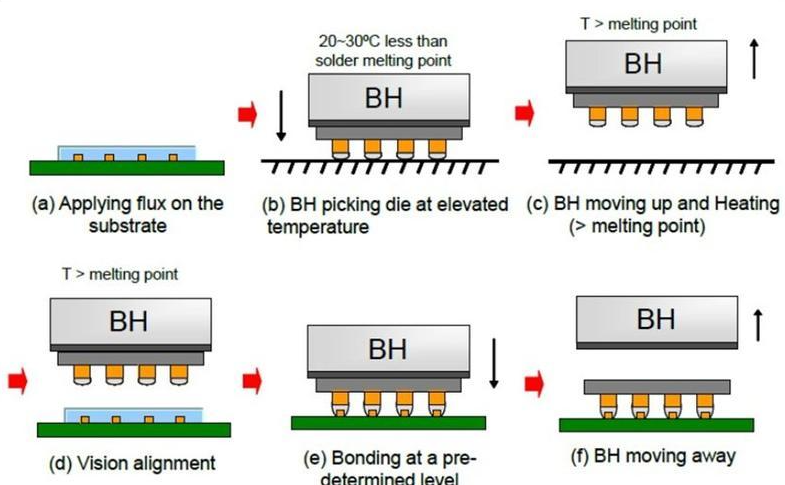
LAB激光輔助鍵合工藝:
產生尖銳且均勻的激光束,能夠以極高的升溫速度選擇性地加熱目標區域,通常焊接時間在1s內。bump pitch>40μm。
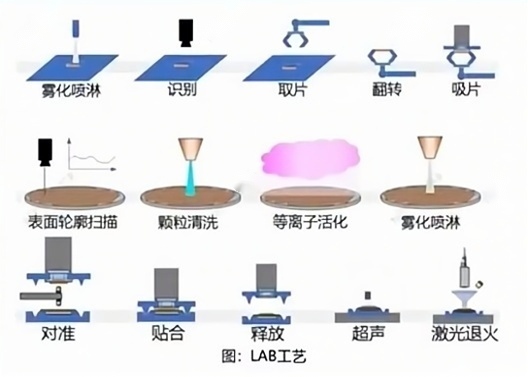
-
玻璃基板
+關注
關注
1文章
95瀏覽量
10627 -
3D封裝
+關注
關注
7文章
139瀏覽量
27548
原文標題:玻璃基板的四大關鍵技術挑戰
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
鴻道Intewell工業操作系統,三大關鍵技術,領跑行業前沿
玻璃基板面臨的四大核心技術攻關難點

Ampere 年度展望:2025年重塑IT格局的四大關鍵趨勢
玻璃基板:半導體封裝領域的“黑馬”選手

玻璃基板的技術優勢有哪些
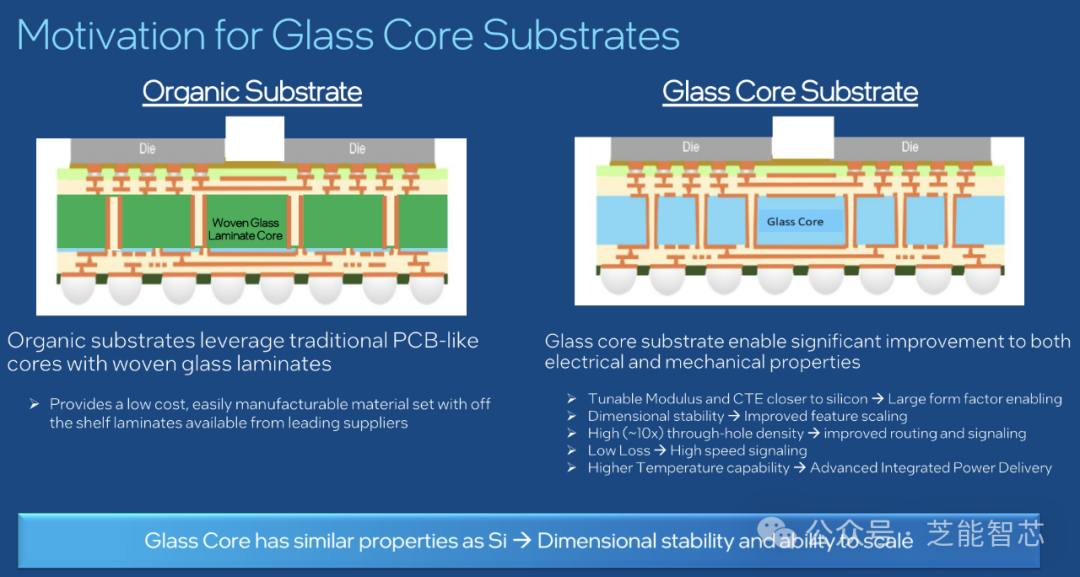
探尋玻璃基板在半導體封裝中的獨特魅力
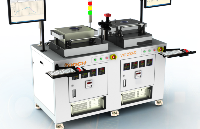
LG進軍半導體玻璃基板市場
玻璃基板時代,TGV技術引領基板封裝
玻璃基板:封裝材料的革新之路
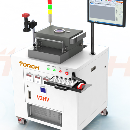





 玻璃基板的四大關鍵技術挑戰
玻璃基板的四大關鍵技術挑戰
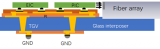














評論