近年來,隨著半導(dǎo)體行業(yè)的迅猛發(fā)展,對高性能、高密度的芯片封裝技術(shù)需求日益增長。在這一背景下,玻璃基板作為一種新興的封裝材料,正逐漸嶄露頭角,被業(yè)界視為未來半導(dǎo)體封裝技術(shù)的“明日之星”。本文將深入探討玻璃基板的技術(shù)優(yōu)勢、市場應(yīng)用前景以及面臨的挑戰(zhàn),為讀者揭示這一領(lǐng)域的無限潛力。
玻璃基板:技術(shù)創(chuàng)新的產(chǎn)物
半導(dǎo)體行業(yè)的每一次進步都離不開封裝技術(shù)的革新。傳統(tǒng)的有機基板,如BT、ABF等,在過去幾十年里發(fā)揮了重要作用,但隨著單個封裝內(nèi)的芯片和連線數(shù)量越來越多,這些材料逐漸逼近物理極限。翹曲、收縮、信號傳輸性能不佳等問題日益凸顯,迫使行業(yè)尋找新的解決方案。
玻璃基板正是在這樣的背景下應(yīng)運而生。與有機基板相比,玻璃基板具有諸多優(yōu)勢。首先,玻璃基板具有更高的熱穩(wěn)定性和機械穩(wěn)定性,能夠更有效地處理高溫環(huán)境,同時有效管理高性能芯片的散熱。其次,玻璃基板可實現(xiàn)更高的互連密度,這對于下一代封裝中的電力傳輸和信號路由至關(guān)重要。此外,玻璃基板更容易變得平坦,這使得封裝和光刻過程變得更容易,有助于提高芯片的良品率和性能。
玻璃基板的應(yīng)用前景
隨著人工智能、高性能計算等領(lǐng)域的快速發(fā)展,對高性能、高密度AI芯片的需求急劇增加。玻璃基板憑借其出色的信號傳輸性能和密集的布線能力,成為這些先進芯片封裝的理想選擇。
英偉達、英特爾、三星、AMD等全球半導(dǎo)體巨頭紛紛布局玻璃基板技術(shù)。英偉達的GB200芯片率先采用了玻璃基板封裝工藝,預(yù)計將于2024年下半年向市場交付約42萬顆,到2025年產(chǎn)量將達到150萬至200萬顆。英特爾也推出了業(yè)界首款用于下一代先進封裝的玻璃基板,并計劃于2026年至2030年實現(xiàn)量產(chǎn)。三星則組建了一個新的跨部門聯(lián)盟,著手聯(lián)合研發(fā)玻璃基板,并計劃于2026年實現(xiàn)量產(chǎn)。
這些大廠的積極布局,不僅推動了玻璃基板技術(shù)的快速發(fā)展,也為整個半導(dǎo)體行業(yè)樹立了新的標(biāo)桿。未來,隨著技術(shù)的不斷成熟和成本的進一步降低,玻璃基板有望在更廣泛的領(lǐng)域得到應(yīng)用,成為半導(dǎo)體封裝技術(shù)的主流選擇。
玻璃基板的技術(shù)優(yōu)勢
玻璃基板之所以受到業(yè)界的青睞,主要得益于其獨特的技術(shù)優(yōu)勢。首先,玻璃基板具有出色的信號傳輸性能和更密集的布線能力。與有機基板相比,玻璃基板能夠減少信號傳輸過程中的衰減和干擾,提高芯片的整體性能。同時,玻璃基板上的布線密度更高,有助于實現(xiàn)更小、更緊湊的封裝設(shè)計。
其次,玻璃基板具有更高的熱穩(wěn)定性和機械穩(wěn)定性。在高性能芯片的封裝過程中,散熱是一個至關(guān)重要的問題。玻璃基板能夠有效地將芯片產(chǎn)生的熱量傳導(dǎo)出去,防止芯片過熱導(dǎo)致的性能下降或損壞。此外,玻璃基板的機械穩(wěn)定性也更強,能夠更好地抵抗封裝過程中的應(yīng)力和變形。
最后,玻璃基板更容易變得平坦,這使得封裝和光刻過程變得更容易。平坦的基板表面有助于提高芯片的良品率和性能,降低生產(chǎn)成本。
玻璃基板面臨的挑戰(zhàn)
盡管玻璃基板具有諸多優(yōu)勢,但其商業(yè)化應(yīng)用仍面臨一些挑戰(zhàn)。首先,玻璃基板的制造成本相對較高。與有機基板相比,玻璃基板的制造過程更為復(fù)雜,需要更多的設(shè)備和人力投入。這導(dǎo)致玻璃基板的價格相對較高,限制了其在一些成本敏感型應(yīng)用中的推廣。
其次,玻璃基板的成孔技術(shù)仍不成熟。在封裝過程中,需要在玻璃基板上打孔以實現(xiàn)芯片與基板之間的電連接。然而,目前主流的玻璃通孔加工成型方法仍存在一些問題,如成本高、良率低等。這些問題需要得到進一步解決,以提高玻璃基板的可靠性和穩(wěn)定性。
此外,玻璃基板與金屬層的結(jié)合力問題也需要關(guān)注。由于玻璃表面平滑,與常用金屬(如銅)的黏附性較差,容易造成玻璃襯底與金屬層之間的分層現(xiàn)象。這會影響芯片的可靠性和穩(wěn)定性,需要尋找新的解決方案來提高玻璃基板與金屬層的結(jié)合力。
玻璃基板的市場競爭格局
目前,玻璃基板市場仍處于起步階段,競爭格局尚未完全形成。然而,一些具有技術(shù)實力和市場影響力的企業(yè)已經(jīng)開始積極布局,試圖搶占這一新興市場的先機。
美國康寧、日本旭硝子等全球知名的玻璃基板供應(yīng)商在TFT-LCD領(lǐng)域具有深厚的技術(shù)積累和市場份額。隨著玻璃基板在半導(dǎo)體封裝領(lǐng)域的應(yīng)用逐漸增多,這些企業(yè)也開始關(guān)注并布局這一新興市場。
同時,一些專注于半導(dǎo)體封裝技術(shù)的企業(yè)也開始涉足玻璃基板領(lǐng)域。這些企業(yè)利用自身在封裝技術(shù)方面的優(yōu)勢,積極研發(fā)玻璃基板相關(guān)的技術(shù)和產(chǎn)品,以滿足市場對高性能、高密度芯片封裝的需求。
未來,隨著技術(shù)的不斷成熟和市場的不斷擴大,玻璃基板市場的競爭格局將更加激烈。那些能夠掌握核心技術(shù)、提供高質(zhì)量產(chǎn)品和服務(wù)的企業(yè)將在競爭中脫穎而出,成為行業(yè)的領(lǐng)軍企業(yè)。
玻璃基板的發(fā)展趨勢
展望未來,玻璃基板在半導(dǎo)體封裝領(lǐng)域的應(yīng)用前景廣闊。隨著技術(shù)的不斷成熟和成本的進一步降低,玻璃基板有望在更廣泛的領(lǐng)域得到應(yīng)用。以下是一些可能的發(fā)展趨勢:
首先,玻璃基板將向更高密度、更高性能的方向發(fā)展。隨著芯片集成度的不斷提高和信號傳輸速度的不斷加快,對封裝材料的性能要求也越來越高。玻璃基板憑借其出色的信號傳輸性能和密集的布線能力,將成為未來高性能、高密度芯片封裝的理想選擇。
其次,玻璃基板將與其他先進封裝技術(shù)相結(jié)合,形成更加完整的封裝解決方案。例如,玻璃基板可以與3D封裝、Chiplet等技術(shù)相結(jié)合,實現(xiàn)更小、更緊湊的封裝設(shè)計,提高芯片的整體性能和可靠性。
最后,玻璃基板的市場規(guī)模將不斷擴大。隨著半導(dǎo)體行業(yè)的快速發(fā)展和市場需求的不斷增長,玻璃基板的市場規(guī)模將不斷擴大。預(yù)計到2026年,全球IC封裝基板行業(yè)規(guī)模將達到214億美元,其中玻璃基板將占據(jù)一定比例的市場份額。
結(jié)語
玻璃基板作為半導(dǎo)體封裝領(lǐng)域的新興材料,正逐漸嶄露頭角,成為業(yè)界關(guān)注的焦點。憑借其出色的信號傳輸性能和密集的布線能力,玻璃基板有望在未來成為高性能、高密度芯片封裝的理想選擇。然而,要實現(xiàn)這一目標(biāo),還需要克服一些技術(shù)挑戰(zhàn)和市場難題。我們有理由相信,隨著技術(shù)的不斷進步和市場的不斷擴大,玻璃基板將在半導(dǎo)體行業(yè)中發(fā)揮越來越重要的作用,成為“明日之星”。”
-
芯片
+關(guān)注
關(guān)注
460文章
52616瀏覽量
442552 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
29024瀏覽量
239887 -
玻璃基板
+關(guān)注
關(guān)注
1文章
100瀏覽量
10831
發(fā)布評論請先 登錄
芯和半導(dǎo)體將參加2025年玻璃基板TGV產(chǎn)業(yè)鏈高峰論壇
迎接玻璃基板時代:TGV技術(shù)引領(lǐng)下一代先進封裝發(fā)展

一文解讀玻璃基板與陶瓷基板、PCB基板的優(yōu)缺點及適用領(lǐng)域
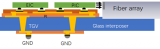
日本電氣玻璃與VIA Mechanics簽署面向下一代半導(dǎo)體封裝的無機芯板開發(fā)協(xié)議
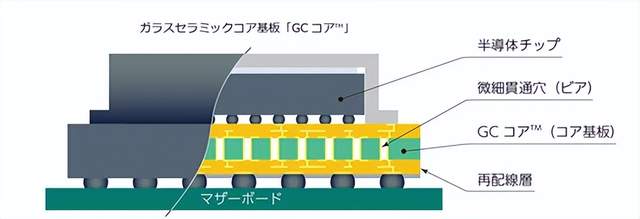
玻璃基板的四大關(guān)鍵技術(shù)挑戰(zhàn)

這一聯(lián)合開發(fā)涉及半導(dǎo)體封裝玻璃陶瓷基板
JNTC 向3家半導(dǎo)體封裝公司提供首批玻璃基板樣品
韓國JNTC為三家芯片封裝企業(yè)供應(yīng)新型TGV玻璃基板
京東方披露玻璃基板及先進封裝技術(shù)新進展
PCB與半導(dǎo)體的橋梁:封裝基板的奧秘與應(yīng)用

探尋玻璃基板在半導(dǎo)體封裝中的獨特魅力
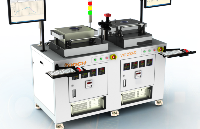





 玻璃基板:半導(dǎo)體封裝領(lǐng)域的“黑馬”選手
玻璃基板:半導(dǎo)體封裝領(lǐng)域的“黑馬”選手














評論