引言
翻轉芯片技術已成為半導體行業中不可或缺的封裝方法,在性能、尺寸減小和功能增加方面具有優勢。本文概述翻轉芯片技術,包括晶圓凸塊制作工藝、組裝方法和進展。
翻轉芯片技術簡介
翻轉芯片技術由IBM在20世紀60年代初引入,涉及將芯片的有源表面直接通過導電凸塊連接到基板上。與傳統的引線鍵合相比,這種方法具有以下優勢:
由于互連更短,電氣性能更好
更高的I/O密度
更小的封裝尺寸
更好的散熱性能
晶圓凸塊制作工藝
晶圓凸塊制作是翻轉芯片技術中的關鍵步驟。兩種常見的方法是模板印刷和電鍍。
模板印刷
模板印刷是一種簡單且具有成本效益的晶圓凸塊制作方法。過程包括:
通過模板將錫膏涂到晶圓焊盤上
回流錫膏形成凸塊
圖1說明了準備進行模板印刷的晶圓:
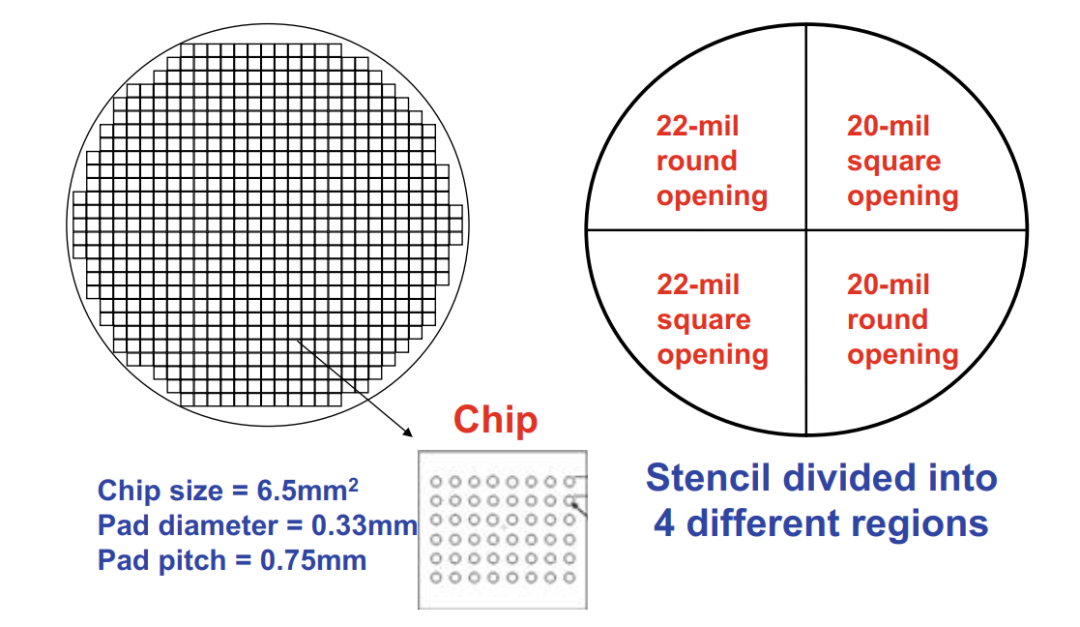
圖1
該圖顯示了一個8英寸晶圓,每個芯片有48個焊盤,焊盤間距為0.75毫米。使用的模板具有不同的開口尺寸和形狀,以優化凸塊形成。
C4(受控塌陷芯片連接)晶圓凸塊制作
C4凸塊制作通常通過電鍍完成,包括以下步驟:
濺射凸塊下金屬層(UBM)
涂布和圖案化光刻膠
電鍍銅和焊料
剝離光刻膠并蝕刻UBM
回流焊料形成球形凸塊
圖2說明了C4晶圓凸塊制作過程:
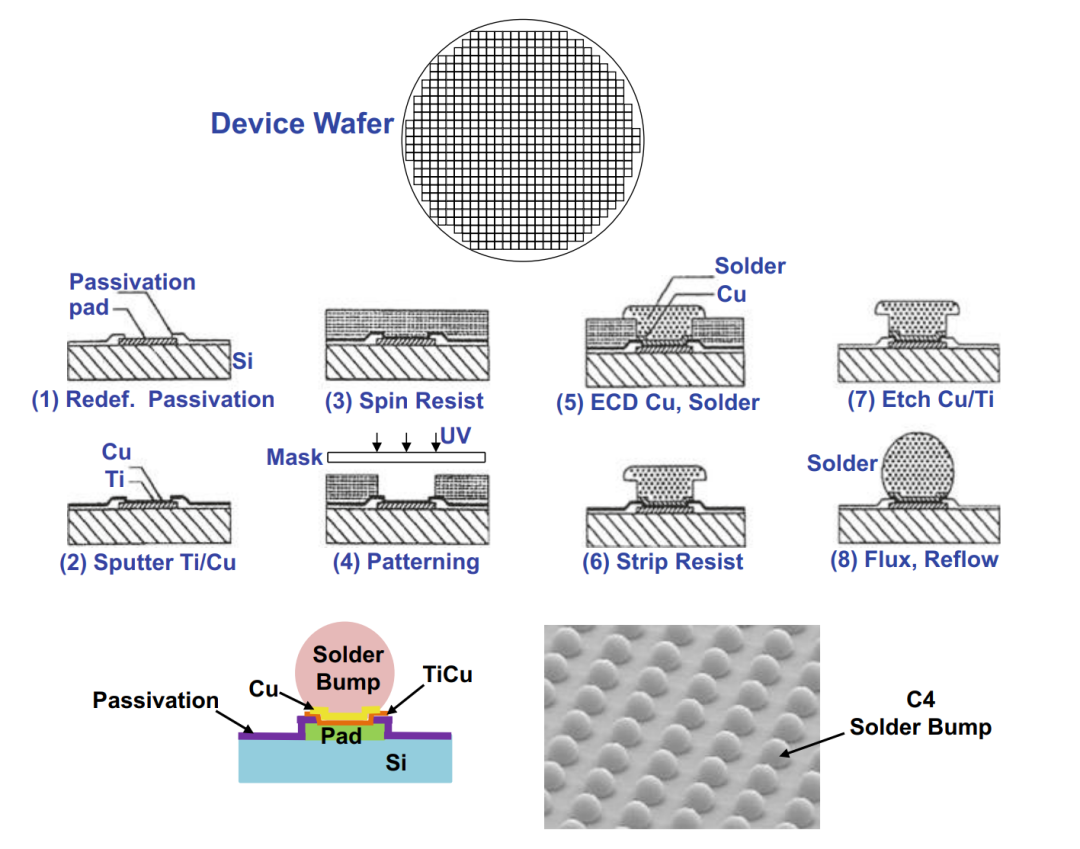
圖2
C2(芯片連接)晶圓凸塊制作
C2凸塊制作是C4的一種變體,使用帶有焊料帽的銅柱。這種方法允許更細的間距和更好的熱電性能。該過程與C4凸塊制作類似,主要區別在于在焊料帽之前電鍍銅柱。
圖3顯示了C2晶圓凸塊制作過程:
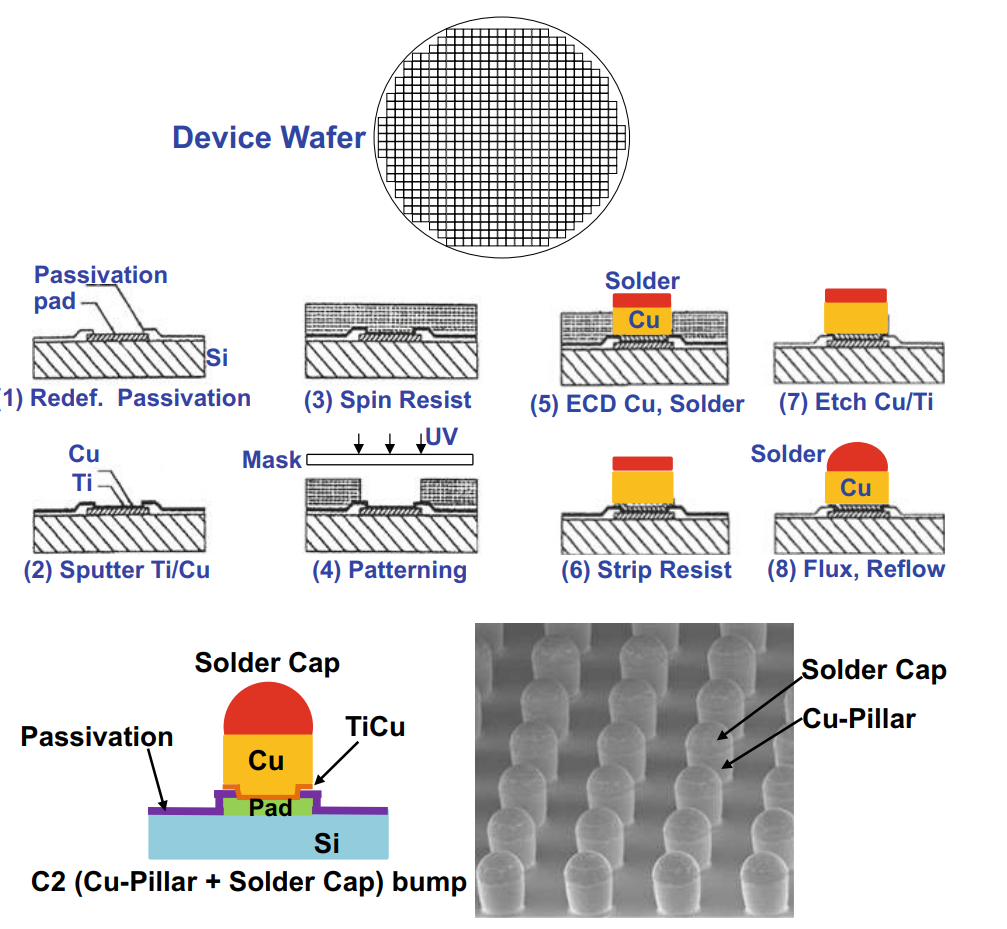
圖3
翻轉芯片組裝方法
有幾種方法可以將翻轉芯片組裝到基板上。選擇取決于凸塊類型、間距和可靠性要求等因素。
C4或C2凸塊的批量回流(CUF)
這是最常見的翻轉芯片組裝方法,包括:
在凸塊或基板上涂助焊劑
將芯片放置在基板上
回流組件形成焊點
為提高可靠性而施加毛細管底填充(CUF)
圖4說明了這個過程:

圖4
低力熱壓鍵合(TCB)(CUF)
對于更高的引腳數和更細的間距,使用低力TCB:
涂助焊劑
將芯片放置在基板上
施加熱量和低壓力形成焊點
施加毛細管底填充
圖5顯示了這個過程:

圖5
高力TCB(NCP/NCF)
對于更細的間距和更薄的封裝,使用高力TCB和預先涂布的底填充:
在基板或芯片上涂布非導電糊料(NCP)或薄膜(NCF)
將芯片放置在基板上
施加熱量和高壓力同時形成互連并固化底填充
圖6和7說明了這些過程:

圖6

圖7
用于可靠性的底填充
底填充對翻轉芯片組件的可靠性非常重要,特別是在有機基板上。它有助于分散應力并保護焊點免受熱疲勞和機械疲勞。
圖8顯示了底填充分配過程:
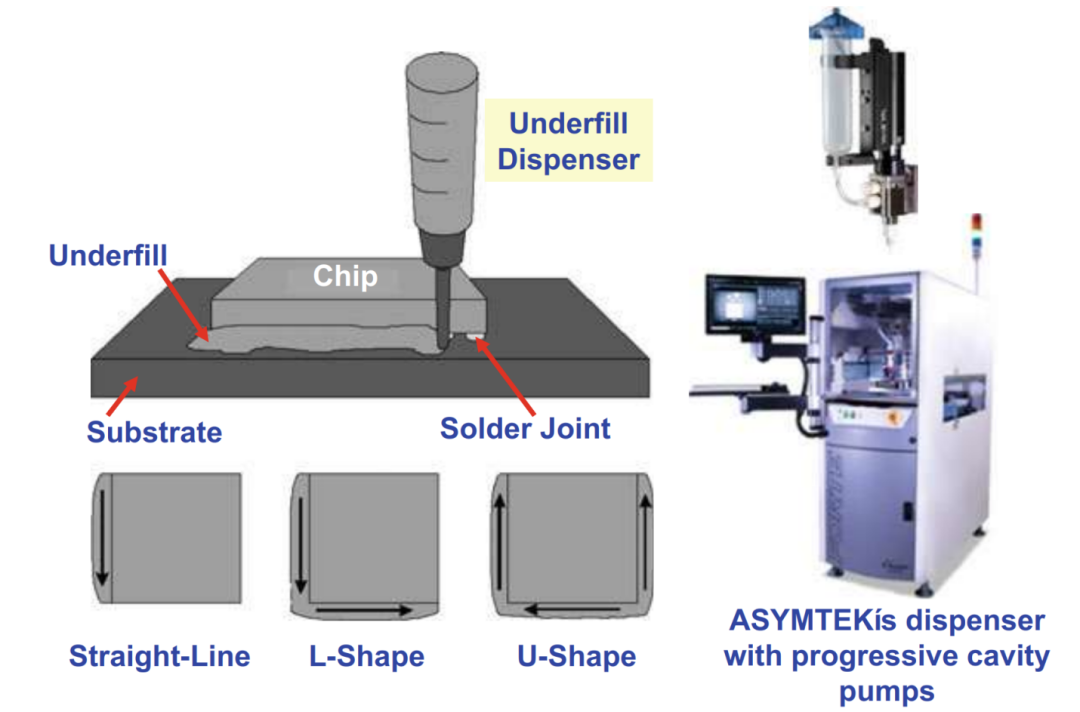
圖8
先進的翻轉芯片組裝:C2凸塊的LPC TCB
翻轉芯片組裝的最新進展是液相接觸(LPC)TCB工藝。這種方法提供更高的產量和更好的焊點高度控制。
LPC TCB的主要特點:
焊料在接觸基板之前熔化
更短的鍵合周期時間(<4秒)
精確控制焊點厚度
圖9說明了LPC TCB過程:
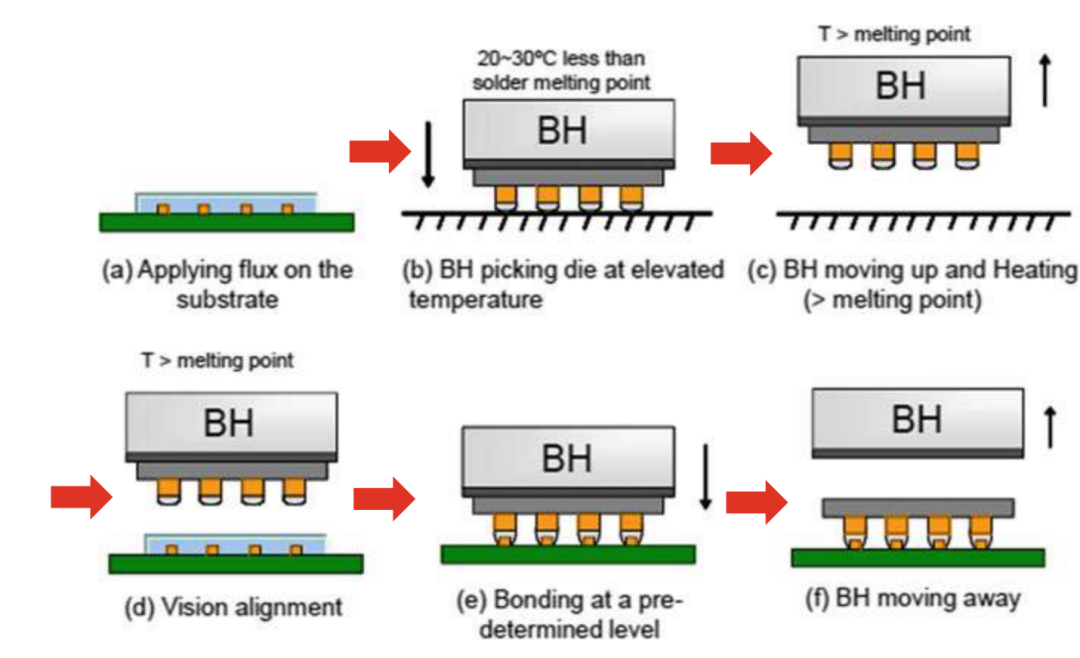
圖9
LPC TCB的優勢:
更高的產量(每小時可達1,200單位)
優秀的焊料潤濕性
精確控制支撐高度
圖10顯示了使用LPC TCB的芯片上基板(CoS)組件的橫截面:
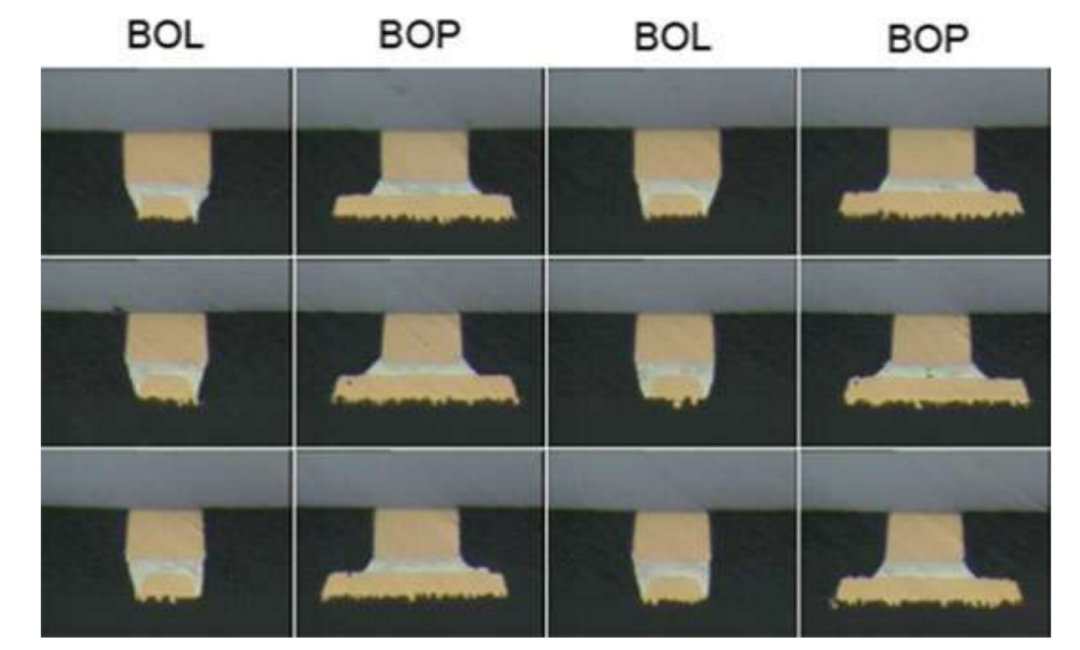
圖10
焊點質量和可靠性
焊點的質量和可靠性對翻轉芯片組件非常重要。影響接頭質量的因素包括:
金屬間化合物(IMC)的形成
焊點支撐高度
熱循環性能
圖11比較了不同工藝形成的焊點的界面微觀結構:
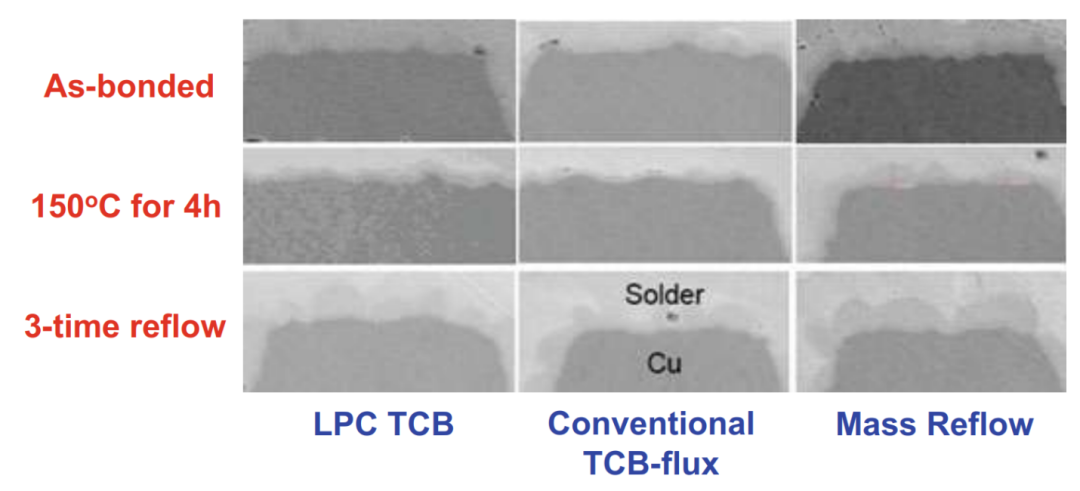
圖11
未來趨勢和建議
隨著半導體行業的不斷發展,翻轉芯片技術正在演變以應對新的挑戰:
增加引腳數(高達10,000個)
減小焊盤間距(低至30μm)
更薄的芯片和基板
圖12總結了不同翻轉芯片組裝方法的當前能力:
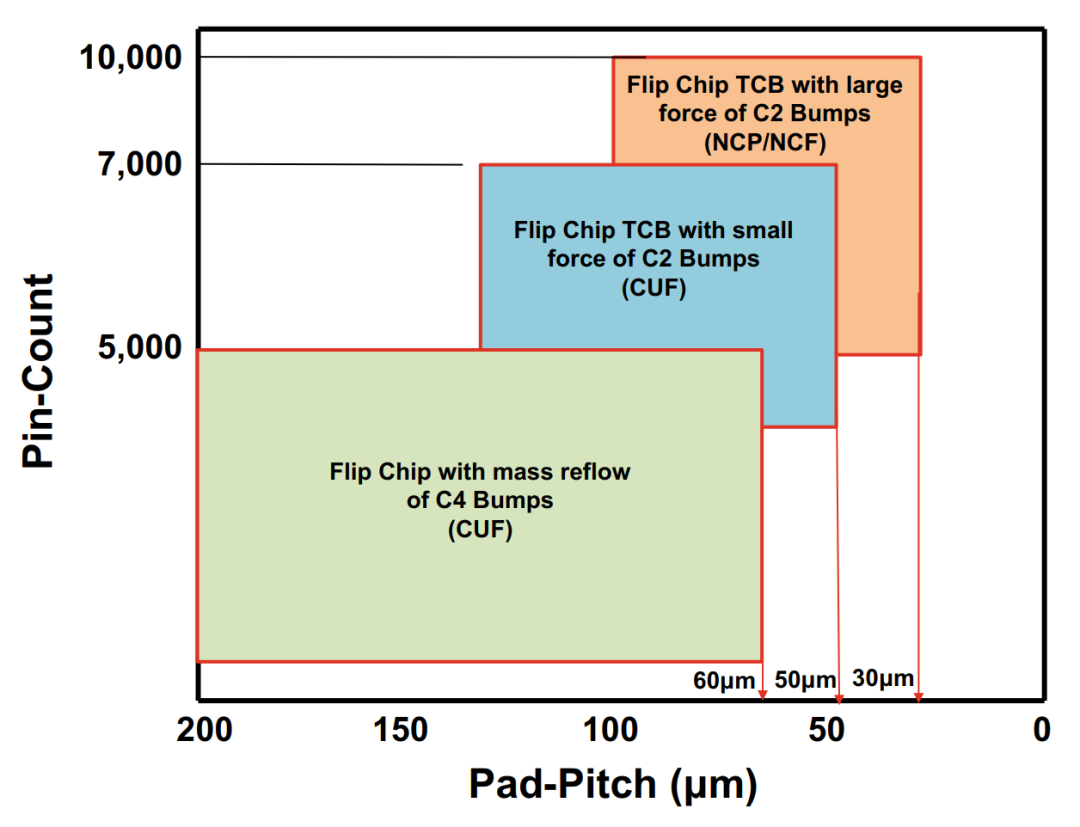
圖12
對翻轉芯片技術的建議:
對于大多數應用,在有機基板上使用C4凸塊的批量回流和CUF仍然是最廣泛使用的方法。
對于更高的引腳數和更細的間距,考慮使用小力TCB和C2凸塊。
對于最高的引腳數和最細的間距,使用大力TCB和帶有NCP/NCF的C2凸塊。
關注LPC TCB等進展,以潛在地提高產量和焊點質量。
結論
翻轉芯片技術繼續成為半導體行業中的重要封裝方法。通過了解各種凸塊制作工藝、組裝方法和最新進展,工程師可以為其特定應用需求選擇最合適的技術。隨著行業向更高集成度和更小的外形因素發展,翻轉芯片技術將在實現電子設備中發揮越來越重要的作用。
-
芯片
+關注
關注
459文章
52308瀏覽量
437887 -
晶圓
+關注
關注
52文章
5131瀏覽量
129297 -
先進封裝
+關注
關注
2文章
465瀏覽量
549
原文標題:先進封裝中的翻轉芯片技術概述
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
盤點先進封裝基本術語






 先進封裝中的翻轉芯片技術概述
先進封裝中的翻轉芯片技術概述















評論