隨著集成電路技術(shù)的飛速發(fā)展,芯片封裝技術(shù)也在不斷進步,以適應日益增長的微型化、多功能化和高集成化的需求。其中,球柵陣列封裝(BGA)作為一種先進的封裝技術(shù),憑借其硅片利用率高、互連路徑短、信號傳輸延時短以及寄生參數(shù)小等優(yōu)點,迅速成為當今中高端芯片封裝領(lǐng)域的主流。在BGA芯片封裝中,凸點制作工藝是至關(guān)重要的一環(huán),它不僅關(guān)系到封裝的可靠性和性能,還直接影響到封裝的生產(chǎn)效率和成本。本文將詳細介紹BGA芯片封裝上的凸點制作工藝,包括其特點、常見方法、工藝流程以及發(fā)展趨勢。
一、凸點制作工藝的特點
凸點制作工藝在BGA芯片封裝中起著電互連、熱傳遞和機械支撐等重要作用。凸點通常位于芯片的有源電極上,與封裝基板上的電極直接連接,形成最短的電路路徑,從而減小電阻、電感,提高信號傳輸速度和質(zhì)量。此外,凸點還可以作為散熱通道,將芯片產(chǎn)生的熱量傳遞到封裝基板或其他組件上,提高芯片的散熱性能。
在BGA芯片封裝中,凸點制作工藝具有以下特點:
高精度:凸點的尺寸和位置精度對封裝的可靠性至關(guān)重要。因此,凸點制作工藝需要具備高精度的設(shè)備和技術(shù),以確保凸點的尺寸和位置符合設(shè)計要求。
高可靠性:凸點作為電互連和機械支撐的關(guān)鍵部分,其可靠性直接影響到封裝的整體性能。凸點制作工藝需要確保凸點與芯片電極、封裝基板電極之間的連接牢固可靠,能夠承受封裝和使用過程中的各種應力和環(huán)境變化。
高效率:隨著電子產(chǎn)品市場的快速發(fā)展,對封裝生產(chǎn)效率的要求也越來越高。凸點制作工藝需要具備高效、自動化程度高的特點,以提高封裝生產(chǎn)線的產(chǎn)能和降低生產(chǎn)成本。
二、常見的凸點制作方法
在BGA芯片封裝中,凸點制作方法多種多樣,主要包括電鍍、印刷、植球、激光重熔等。下面將詳細介紹這些常見的凸點制作方法。
電鍍法
電鍍法是一種通過電化學沉積在芯片電極上形成凸點的方法。其工藝流程通常包括以下幾個步驟:
UBM制備:在芯片電極上沉積一層凸點下金屬化層(UBM),以提高凸點與芯片電極之間的黏附性和防止金屬間化合物的生成。
光刻膠涂覆與曝光:在UBM上涂覆一層光刻膠,并通過曝光和顯影形成凸點的圖形。
電鍍:將芯片放入電鍍槽中,通過控制電鍍電流和時間,在光刻膠開窗圖形的底部開始生長并得到一定厚度的金屬層作為凸點。
光刻膠去除與回流:去除多余的光刻膠,并通過回流工藝使凸點形成球狀。
電鍍法具有成本效益好、良率高、速度快且凸點密度高的優(yōu)點,特別適用于極細節(jié)距凸點的制作。然而,電鍍法也存在設(shè)備投入大、成本高以及工藝復雜等缺點。
印刷法
印刷法是一種通過涂刷器和網(wǎng)板將錫膏涂刷在芯片電極上形成凸點的方法。其工藝流程通常包括以下幾個步驟:
UBM制備:在芯片電極上沉積一層UBM。
錫膏絲網(wǎng)印刷:通過涂刷器和網(wǎng)板將錫膏涂刷在芯片電極上形成凸點圖形。
錫膏回流:對芯片進行加熱回流,使錫膏熔化形成凸點。
焊盤清洗:清洗焊盤上的殘留物。
印刷法具有成本低、效率高的優(yōu)點,特別適用于間距為200~400μm的焊盤。然而,在節(jié)距小于150μm的高密度互連中,印刷法面臨較大的挑戰(zhàn),如助焊劑容易橋接、回流后焊料容易橋接等問題。
植球法
植球法是一種通過專用設(shè)備將預成型精密焊球放置在芯片電極上形成凸點的方法。其工藝流程通常包括以下幾個步驟:
UBM制備:在芯片電極上沉積一層UBM。
助焊劑涂覆:在芯片電極上涂刷黏性助焊劑。
焊球放置:通過專用設(shè)備將預成型精密焊球放置在芯片電極上。
加熱回流:對芯片進行加熱回流,使焊球熔化形成凸點。
植球法具有簡單快捷、生產(chǎn)效率高的優(yōu)點,可靈活應用于不同尺寸和材料的焊球。然而,植球法對焊球的一致性要求較高,且對助焊劑和回流溫度設(shè)定的依賴度較高。
激光重熔法
激光重熔法是一種通過激光束將預置在芯片電極上的釬料合金熔化形成凸點的方法。其工藝流程通常包括以下幾個步驟:
釬料預置:在芯片電極上預置釬料合金。
激光重熔:通過激光束將釬料合金熔化形成凸點。
回流與冷卻:對芯片進行加熱回流和冷卻處理,使凸點形成穩(wěn)定的球狀。
激光重熔法具有局部加熱、熱影響區(qū)小、凸點一致性好等優(yōu)點,特別適用于BGA封裝釬料凸點的補修和精確控制。然而,激光重熔法也存在設(shè)備成本高、工藝復雜等缺點。
三、凸點制作的工藝流程
凸點制作的工藝流程因方法而異,但總體上可以歸納為以下幾個步驟:
芯片準備:對芯片進行清洗、烘干等預處理工作,確保芯片表面干凈無雜質(zhì)。
UBM制備:在芯片電極上沉積一層UBM,以提高凸點與芯片電極之間的黏附性和防止金屬間化合物的生成。UBM的制備方法主要有濺射、蒸鍍、電鍍等。
凸點形成:根據(jù)所選的凸點制作方法,在芯片電極上形成凸點。這一步是凸點制作工藝的核心部分,需要精確控制凸點的尺寸、位置和形狀。
回流與冷卻:對芯片進行加熱回流和冷卻處理,使凸點形成穩(wěn)定的球狀。回流溫度和時間需要根據(jù)所選的釬料合金和芯片材料進行調(diào)整。
檢查與測試:對形成的凸點進行檢查和測試,確保其尺寸、位置和形狀符合設(shè)計要求。同時還需要對凸點的可靠性進行測試,以確保封裝的整體性能。
四、凸點制作工藝的發(fā)展趨勢
隨著電子信息技術(shù)的飛速發(fā)展,芯片封裝技術(shù)也在不斷進步。凸點制作工藝作為芯片封裝中的關(guān)鍵環(huán)節(jié),其發(fā)展趨勢主要體現(xiàn)在以下幾個方面:
高精度與高密度:隨著芯片引腳數(shù)的增加和封裝尺寸的減小,對凸點制作工藝的精度和密度要求也越來越高。未來凸點制作工藝將更加注重高精度和高密度的實現(xiàn)。
綠色制造:隨著環(huán)保意識的增強和法規(guī)政策的推動,綠色制造已成為芯片封裝技術(shù)的重要發(fā)展方向。凸點制作工藝需要采用環(huán)保材料、減少化學污染和廢棄物產(chǎn)生等措施,以實現(xiàn)綠色制造的目標。
自動化與智能化:為了提高生產(chǎn)效率和降低成本,凸點制作工藝將更加注重自動化和智能化的實現(xiàn)。通過引入先進的自動化設(shè)備和智能控制系統(tǒng),可以實現(xiàn)凸點制作過程的自動化控制和智能監(jiān)控。
新材料與新工藝:隨著新材料和新工藝的不斷涌現(xiàn),凸點制作工藝也將不斷創(chuàng)新和發(fā)展。例如,采用新型釬料合金、開發(fā)新型UBM材料、引入先進的激光重熔技術(shù)等,都可以提高凸點制作的質(zhì)量和效率。
五、結(jié)論
凸點制作工藝在BGA芯片封裝中起著至關(guān)重要的作用。通過選擇合適的凸點制作方法和工藝流程,可以確保凸點的尺寸、位置和形狀符合設(shè)計要求,從而提高封裝的可靠性和性能。未來,隨著電子信息技術(shù)的不斷發(fā)展和市場需求的變化,凸點制作工藝將更加注重高精度、高密度、綠色制造、自動化與智能化以及新材料與新工藝的應用和創(chuàng)新發(fā)展。
-
集成電路
+關(guān)注
關(guān)注
5394文章
11633瀏覽量
363443 -
BGA
+關(guān)注
關(guān)注
5文章
549瀏覽量
47084 -
芯片封裝
+關(guān)注
關(guān)注
11文章
515瀏覽量
30762
發(fā)布評論請先 登錄
相關(guān)推薦
BGA芯片的封裝類型 BGA芯片與其他封裝形式的比較
如何進行BGA封裝的焊接工藝
BGA封裝與SMT技術(shù)的關(guān)系
BGA封裝技術(shù)的發(fā)展 BGA封裝的優(yōu)勢與應用
Bumping工藝升級,PVD濺射技術(shù)成關(guān)鍵推手

晶圓上的‘凸’然驚喜:甲酸回流工藝大揭秘

芯片封裝技術(shù)的流程及其優(yōu)勢解析
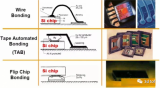
倒裝芯片封裝凸點剪切力測試實例,推拉力測試機應用全解析!
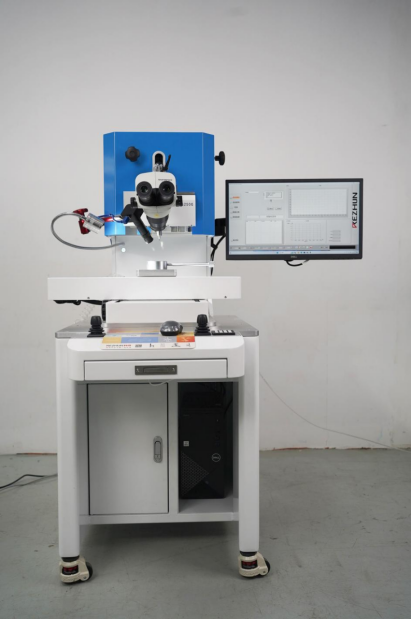
用于不同體態(tài)芯片互連的凸點制備及性能表征
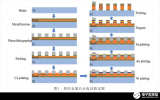




 BGA芯片封裝凸點工藝:技術(shù)詳解與未來趨勢
BGA芯片封裝凸點工藝:技術(shù)詳解與未來趨勢
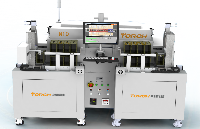
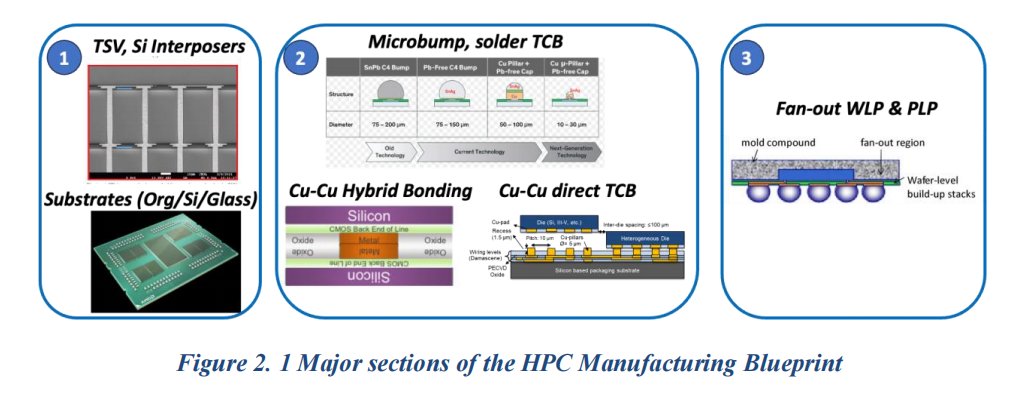












評論