半導體封裝的分類
半導體封裝能夠依據下圖實施分類操作。其主要可被劃分為兩大類別,即傳統封裝與晶圓級封裝。傳統封裝的流程是先把晶圓按照芯片為單位進行切割,隨后針對切割后的芯片開展封裝工藝;而晶圓級封裝則有所不同,它會先在晶圓層面就進行一部分或者全部的封裝工作,待完成相關封裝操作后,才將晶圓切割成單個的器件。


SD NAND的封裝方式
例如米客方德SD NAND的采用基板封裝方式,基板封裝方法使用基板作為媒介。基板封裝在制造時用多層薄膜制作而成,因此也被稱為(Laminated type)封裝。
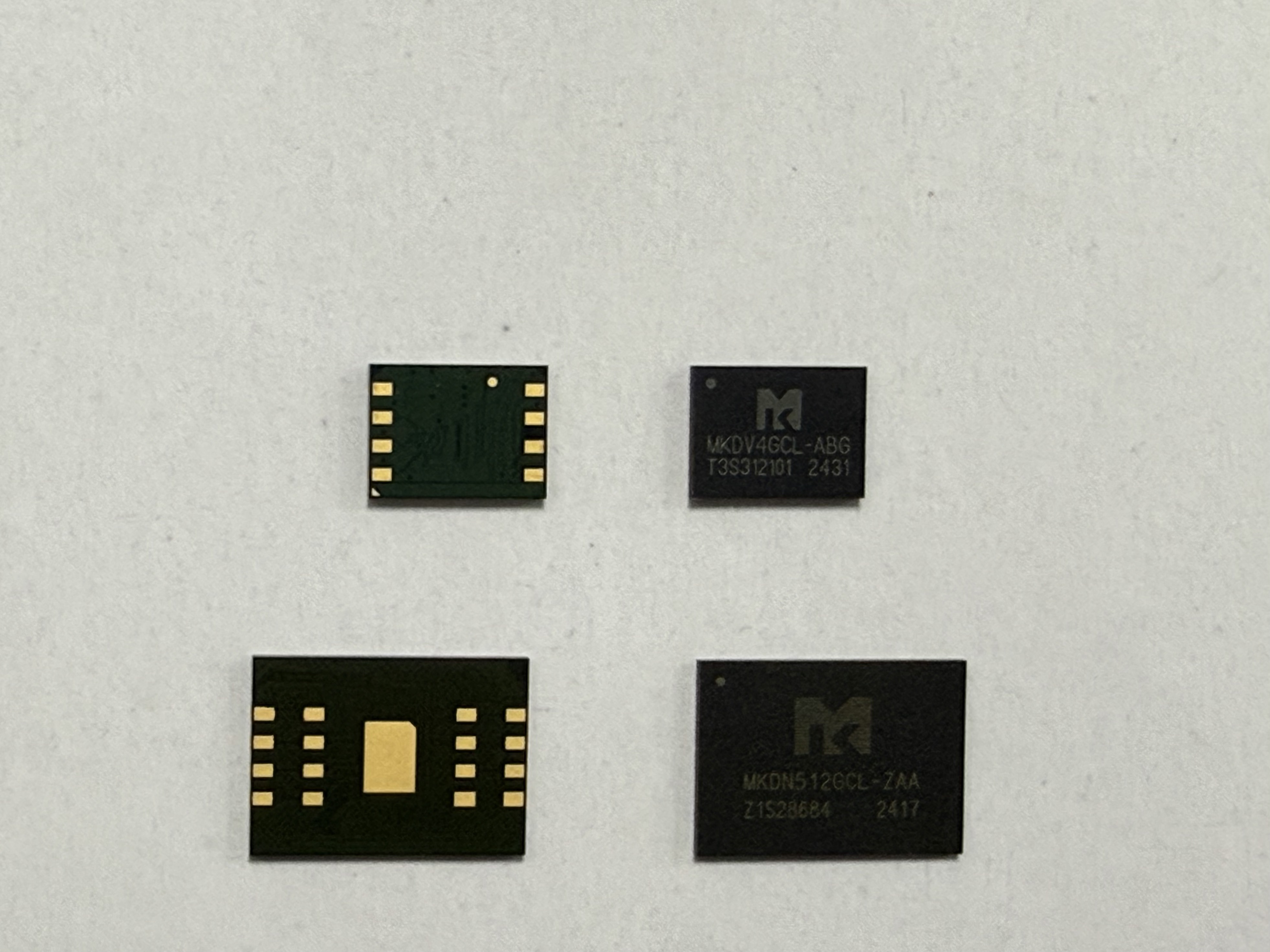
不同于引線框架封裝只有一個金屬布線層(因為引線框架這種金屬板無法形成兩個以上金屬層),基板封裝可以形成若干布線層,因此電氣特性更加優越且封裝尺寸更小。引線框架封裝和基板封裝的另一個主要區別是布線連接工藝。連接芯片和系統的布線必須分別在引線框架和基板上實現。當需要交叉布線時,基板封裝可將導線交叉部署至另一個金屬層;引線框架封裝由于只有一個金屬層,因而無法進行交叉布線。
基板封裝可以將錫球全部排列在一個面作為引腳,由此獲得大量引腳。相比之下,引線框架封裝采用引線作為引腳,而引線只能在一側的邊緣形成。這樣的部署也改善了基板封裝的電氣特性。在封裝尺寸方面,引線框架封裝由主框架和側面引線所占空間構成,因而尺寸通常較大。而基板封裝的引腳位于封裝底部,可有效節省空間,因此尺寸通常較小。由于這些優點現在大多數半導體封裝都是基板封裝類型。
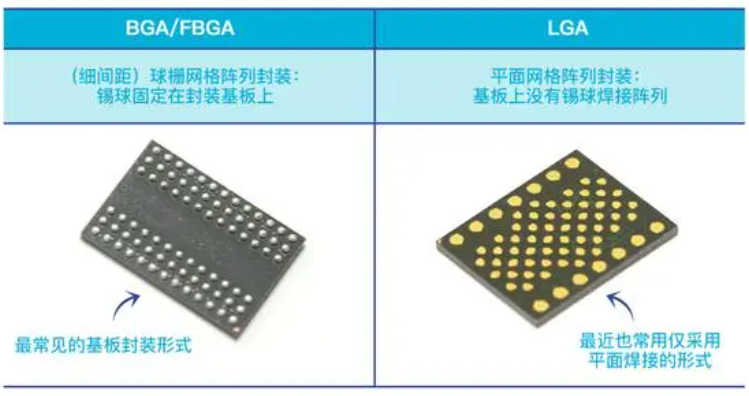
最常見的基板封裝類型是球柵網格陣列(BGA)封裝。但近年來,平面網格陣列(LGA)封裝日益盛行,這種封裝方法采用由扁平觸點構成的網格平面結構替代錫球。
審核編輯 黃宇
-
封裝
+關注
關注
128文章
8598瀏覽量
144994 -
SD NAND
+關注
關注
0文章
91瀏覽量
1466
發布評論請先 登錄
T-BOX應用NXP S32K148控芯片 搭配 貼片式TT卡(SD NAND)存儲的完美結合

[上手體驗]雷龍SD NAND:比TF卡更小更耐用
CS創世SD NAND【貼片式sd卡】的測試使用說明
雷龍SD NAND試用
SD NAND 概述
雷龍CS SD NAND:貼片式TF卡體驗與性能測試

Arduino程序:實現SD NAND(貼片sd卡)的讀寫功能






 淺談SD NAND(貼片式存儲卡)封裝
淺談SD NAND(貼片式存儲卡)封裝


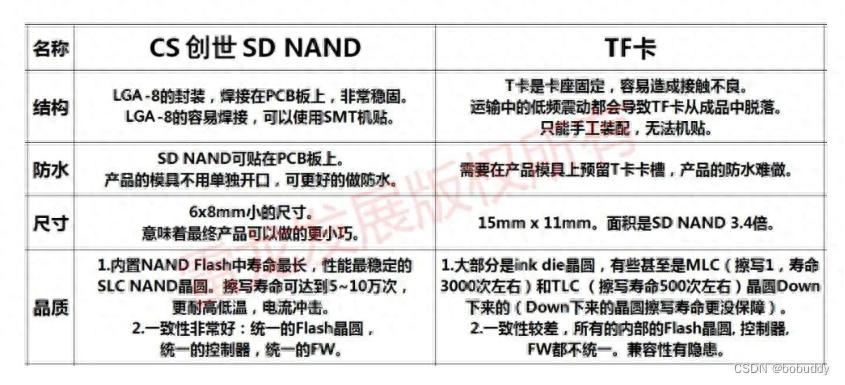











評論