碳化硅(SiC)功率器件作為一種潛在的優越替代品,逐漸取代傳統的硅基組件,為航天器和電動飛機的高功率應用提供了顯著的優勢。然而,SiC技術的成功應用必須克服一個關鍵障礙:在這些極端操作條件下遇到的嚴峻輻射環境。
本文基于最近在德國法蘭克福舉辦的PCIM Europe會議上的講座,分析了SiC技術在航天應用中的潛在限制,并提出了CoolCAD Electronics為高空和太空環境開發的解決方案。
航天電力應用的挑戰
輻射耐受的高壓功率器件是實現航天任務和電動飛機顯著減輕重量和體積的必要條件。這些器件能夠在電力轉換器和配電系統中實現更高的電壓和頻率,這對于下一代航天電力系統至關重要。
國際空間站是目前航天器中功率容量最高的,約為100千瓦,體現了對先進電力分配系統的需求,采用了八個交錯微電網。未來的太空任務,例如月球軌道站Gateway和月球及火星基地,將需要低質量、高效率的模塊化電力調節器。
SiC高壓功率器件通過提高電壓水平提供了一種可行的解決方案,從而提高效率并延長任務壽命。這些器件簡化了設計復雜性,并減少了電力分配損耗,得益于更高的工作電壓和降低的冷卻需求。因此,SiC功率器件可以顯著降低系統重量和成本,為關鍵儀器載荷騰出空間和電力。
目前的航天電力分配技術由于半導體的限制,僅能支持200伏以下的電壓。實現超過300伏的工作電壓需要開發新技術。耐輻射的高壓組件額定電壓超過300伏,可以將電推進系統的功率提升到當前的5千瓦閾值之上,提升系統效率超過92%,并減少載荷重量。
輻射威脅:電子設備的敵對環境
地球大氣層為我們屏蔽了太空輻射,但宇宙射線和太陽粒子的宇宙雨仍然會穿透它。這些宇宙雨產生的次級中子粒子對商業和軍事飛機以及地面車輛中的電子設備構成風險。
主要的宇宙射線主要是質子和α粒子,來源于外太空或被捕獲的質子帶。當它們與大氣氣體碰撞時,會產生高能產物,如中子、π介子和μ子,形成宇宙雨。其中,中子因其質量、大的俘獲截面和穿透能力,對電子設備特別危險。
高能中子可以通過將原子從晶格位置擊出而對半導體器件(如功率MOSFET)造成嚴重損害,導致電離軌跡,從而導致器件失效。SiC器件以其在效率和高溫操作方面的優勢而聞名。然而,還需進一步研究以評估長期可靠性,并確保其集成到節能系統中,從而減輕潛在的可靠性問題。
輻射對功率電子的影響
用于航天應用的功率器件需要耐受以下三種類型的輻射。
總電離劑量
總電離劑量(TID)是指材料因高能電磁波或帶電粒子而發生的電離(電子和空穴對的形成),以單位質量吸收的能量來衡量。在半導體中,TID效應通常使用單位rad來描述,其中1 rad等于每克材料吸收的100 erg能量。
對于功率MOSFET,TID主要影響n通道器件的閾值電壓。與硅基器件相比,SiC功率MOSFET對TID效應表現出更強的耐受性,這得益于在SiC上生長的二氧化硅中較低的空穴捕獲效率。
在商用SiC功率MOSFET中,經過鈷-60伽馬輻射的研究顯示出閾值電壓的輕微偏移。由于新一代MOSFET的柵氧化層厚度有所改進,偏移在新一代器件中不太明顯。在CoolCAD的新一代SiC MOSFET中,閾值電壓隨TID變化而變化不大,即使在最高劑量120 krad(Si)下也是如此。
實驗結果表明,盡管TID增加,閾值電壓的偏移仍然非常小,表明對TID的良好響應。輻射后退火顯示閾值電壓恢復很小或沒有恢復,突顯了SiC器件對輻射效應的抗干擾能力。
位移損傷
位移損傷發生在材料中的晶格原子被入射粒子(如質子)位移時,導致缺陷和捕獲位點的形成。這種位移使原子變為間隙原子,同時留下空位。隨著時間的推移,這些缺陷可能顯著改變材料特性并降低器件的電性能。
對于SiC,位移損傷的閾值超過每平方厘米10^12個質子或中子,這一值高于硅。因此,SiC在粒子通量增加時漏電流的增加幅度較小。
一項在德克薩斯農工大學圓形加速器設施進行的重離子輻照實驗顯示,商用SiC功率設備因離子擊打而導致端子電流降級,在相對較低的電壓下受到影響(見圖2a)。在更高電壓下,SiC功率器件會經歷意外失效。重離子造成的損害在圖2b的左上角可見。
 圖2
圖2重離子單效應
SiC功率MOSFET對重離子的損傷非常敏感,其特征在于其線性能量轉移(LET)。LET以MeV·cm2/mg為單位,量化重離子向材料的能量轉移速率。更重的離子和更密集的材料增加LET,從而由于快速能量損失而減少粒子的范圍。
單事件燒毀和單事件門極擊穿是由輻射引發的高電流狀態導致的SiC器件的災難性失效機制。這些失效發生在重離子電離軌跡誘導自持高電流狀態時,導致器件失效。在高偏置下,從大約三分之一的擊穿電壓開始,單個高LET離子擊打會造成不可逆的損害。在中等偏置下,漏電流和柵電流的變化與重離子通量相關,并在輻照后持續存在。在低偏置下(低于額定電壓的20%),輻照后沒有可測量的影響,從而限制了SiC MOSFET在太空環境中的安全工作電壓。
SiC功率二極管表現出類似的降解機制,災難性故障發生在更高的偏置下。研究表明,存在一個閾值電場,超過該電場會發生災難性損害,主要由電熱效應驅動。在較低電壓下,由于局部熱過程也可能造成永久性損傷。MOSFET中的柵損壞與氧化層電場增加和隨之而來的物理損傷有關,導致柵漏電流增加。
 圖3
圖3由于燒毀和門極擊穿造成的災難性失效在功率器件中是不可接受的,會導致端子電壓短路。典型的1.2 kV SiC功率器件的燒毀閾值約為500 V,在高電壓額定器件中也有類似的閾值。為了提高輻射耐受性和燒毀閾值,研究人員的努力集中在實現至少40 MeV·cm2/mg的LET耐受性和105離子/cm2的通量,直至300 V偏置。初步結果(見圖3)顯示重離子燒毀閾值超過1 kV,LET高達20 MeV·cm2/mg,而對于更高LET值則稍低于1 kV。
飛機的要求
組件的高空適應性由其對大氣中中子的耐受性決定,這些中子會通過位移晶格原子而損壞器件。這種位移類似于低LET離子擊打。大氣中的中子在海平面及更高海拔處會導致SiC功率器件的失效。這種失效是由于中子與晶格原子碰撞引發的小絲快速加熱。這些碰撞在器件內沉積電荷;如果電荷超過特定偏置的臨界值,就會導致失效。
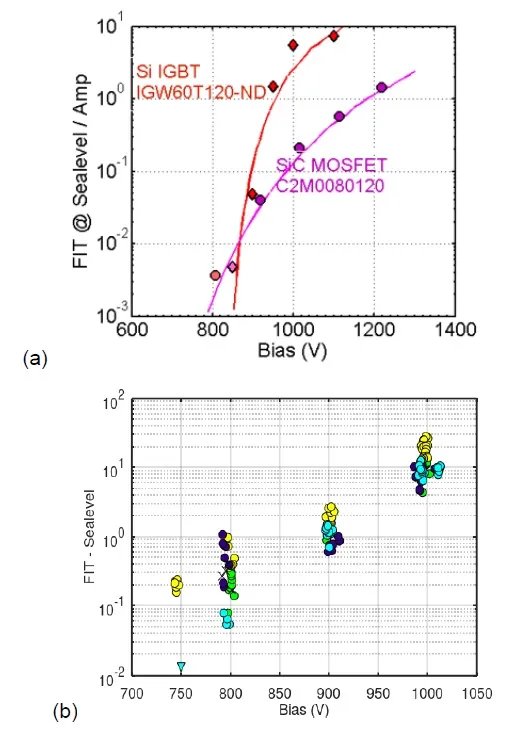 圖4
圖4圖4a顯示了SiC MOSFET與硅MOSFET的失效率比較。在圖4b中,CoolCAD的設計在較低電壓下表現出更好的失效率。圓圈代表失效,而每個三角形顯示失效的上限。
-
航天器
+關注
關注
0文章
200瀏覽量
21254 -
SiC
+關注
關注
31文章
3227瀏覽量
65324 -
飛機
+關注
關注
7文章
1177瀏覽量
40504
發布評論請先 登錄
BASiC基本公司SiC MOSFET碳化硅功率模塊在商空熱泵中的技術應用

基于SiC碳化硅功率模塊的高效、高可靠PCS解決方案

SiC碳化硅功率模塊賦能商用空調與熱泵系統高效升級的技術革新
CAB450M12XM3工業級SiC半橋功率模塊CREE
告別“里程焦慮”,ER-QA-03C ---助力航天器精準“定位”未來!

使用 SiC 功率半導體提升高性能開關轉換器的效率
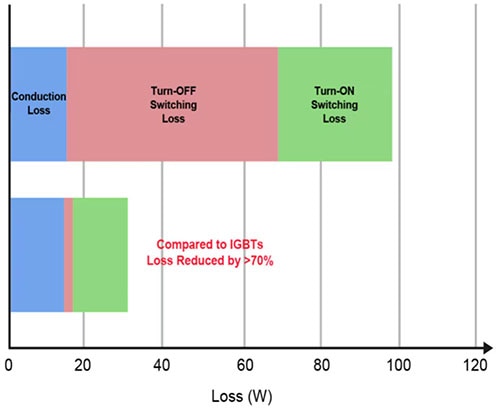
納米銀燒結技術:SiC半橋模塊的性能飛躍






 SiC技術能否滿足航天器和飛機的高功率需求!
SiC技術能否滿足航天器和飛機的高功率需求!




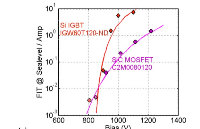











評論