統(tǒng)及原理
雙束聚焦離子束系統(tǒng)可簡單地理解為是單束聚焦離子束和普通SEM之間的耦合。
單束聚焦離子束系統(tǒng)包括離子源,離子光學柱,束描畫系統(tǒng),信號采集系統(tǒng),樣品臺五大部分。
離子束鏡筒頂部為離子源,離子源上施加強大電場提取帶正電荷離子,經(jīng)靜電透鏡和偏轉(zhuǎn)裝置聚焦并偏轉(zhuǎn)后實現(xiàn)樣品可控掃描。樣品加工采用加速離子轟擊試樣使表面原子濺射的方法進行,而生成的二次電子及二次離子則由對應(yīng)探測器進行采集及成像。
常用的雙束設(shè)備有電子束豎直安裝和離子束和電子束呈一定角度安裝兩種,見附圖。人們常把電子束與離子束在焦平面上的交線稱為共心高度位置。使用時試樣位于共心高度位置既可實現(xiàn)電子束成像,又可進行離子束處理,且可通過試樣臺傾轉(zhuǎn)將試樣表面垂直于電子束或者離子束。
典型離子束顯微鏡主要由液態(tài)金屬離子源和離子引出極,預聚焦極,聚焦極使用高壓電源,電對中,消像散電子透鏡,掃描線圈等組成、二次粒子檢測器,活動樣品基座,真空系統(tǒng),抗振動及磁場設(shè)備,電路控制板,電腦等硬件設(shè)備,如圖所示:
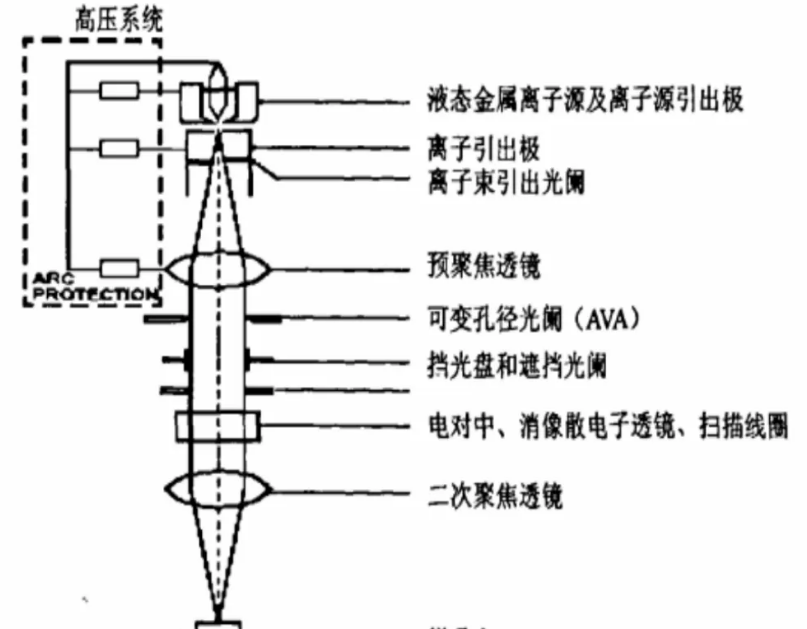
通過電透鏡聚焦和可變孔徑光闌的調(diào)節(jié),可以控制離子束的大小,進而實現(xiàn)對樣品表面的精確加工。在一般工作電壓下,尖端電流密度約為10^-4A/cm^2,離子束到達樣品表面的束斑直徑可達到7納米。
常用的TEM制樣
1、半導體薄膜材料
此類樣品多為在平整的襯底上生長的薄膜材料,多數(shù)為多層膜(每層為不同材料),極少數(shù)為單層材料。多數(shù)的厚度范圍是幾納米-幾百納米。制備樣品是選用的位置較多,無固定局限。
2、半導體器件材料
此類樣品多為在平整的襯底上生長的有各種形狀材料,表面有圖形,制樣范圍有局限。
3、金屬材料
金屬材料,多為表面平整樣品,也有斷口等不規(guī)則樣品,減薄的區(qū)域多為大面積。
4、電池材料
電池材料多為粉末,每個大顆粒會有許多小顆粒組成,形狀多為球形,由于電池材料元素的原子序數(shù)較小,pt原子進入在TEM下會較為明顯,建議保護層采用C保護。
5、二維材料
此類樣品為單層或多層結(jié)構(gòu),如石墨烯等,電子束產(chǎn)生的熱效應(yīng)會對其造成損傷,在制備樣品前需要在表面進行蒸鍍碳的處理,或者提前在表面鍍上保護膜。
6、地質(zhì)、陶瓷材料
此類樣品導電性能差、有些會出現(xiàn)空洞,制備樣品前需要進行噴金處理,材料較硬,制備時間長。
7、原位芯片
用原位芯片代替銅網(wǎng),將提取出來的樣品固定在芯片上,進行減薄。
截面分析
應(yīng)用FIB濺射刻蝕功能可定點切割試樣并觀測橫截面(cross-section)來表征截面形貌大小,還可配備與元素分析(EDS)等相結(jié)合的體系來分析截面成分。
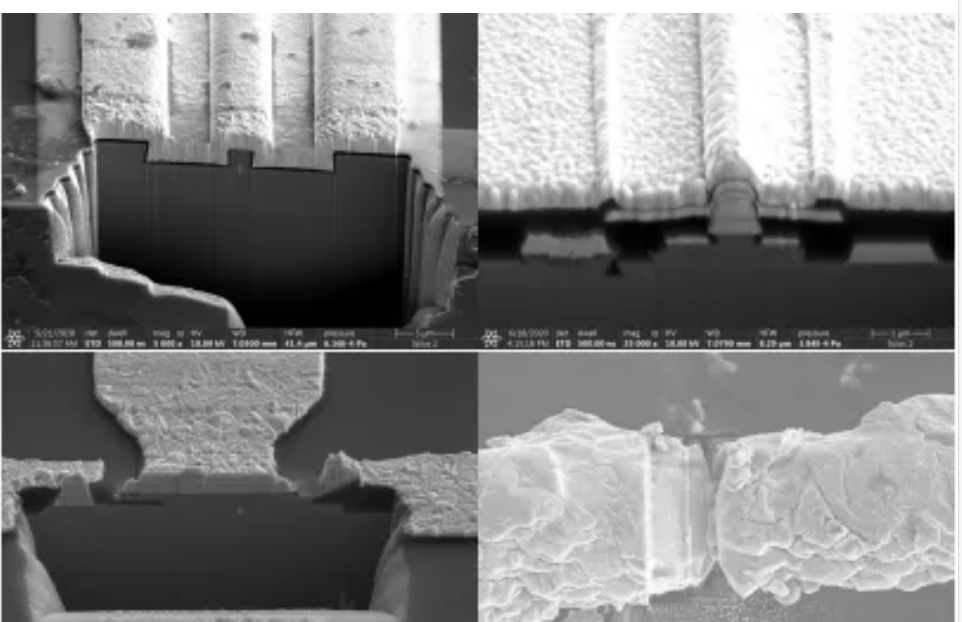
芯片修補與線路編輯
IC設(shè)計時,必須對所形成集成電路進行設(shè)計變更驗證,優(yōu)化與調(diào)試。在檢測出問題之后,對這些缺陷的部位需進行維修。現(xiàn)有集成電路制程正在縮減。線路層數(shù)亦越來越多。應(yīng)用FIB中濺射功能可以使某處連線切斷,也可以用它的沉積功能使某地原先沒有連接的地方連接在一起,使電路連線的方向發(fā)生了變化,可以找到、診斷電路是否存在誤差,并能直接對芯片中的這些誤差進行校正,減少研發(fā)成本并加快研發(fā)進程,由于它節(jié)省原形制備及掩模變更所需的時間及成本。
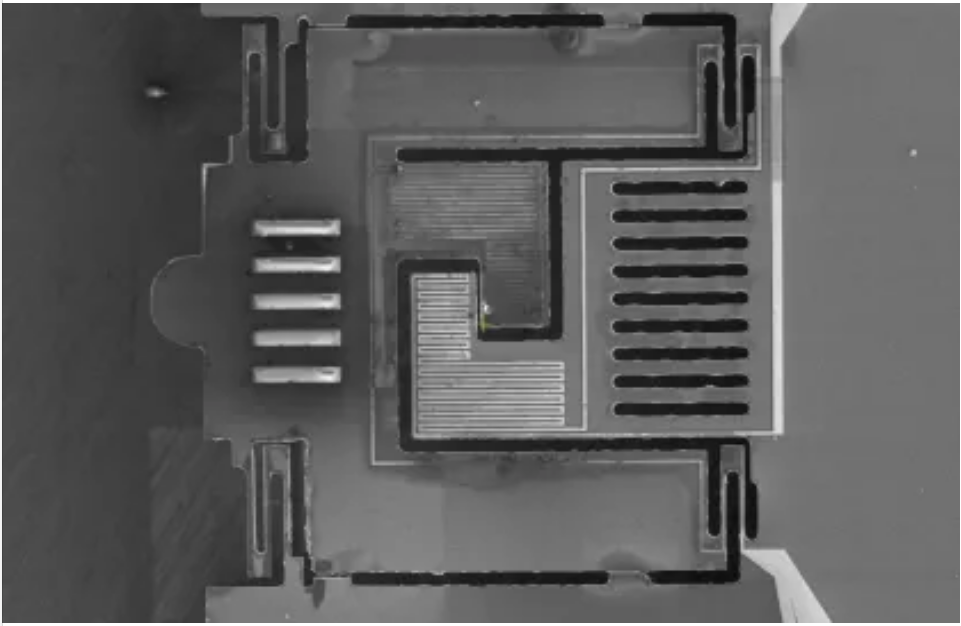
微納結(jié)構(gòu)制備
FIB系統(tǒng)不需要掩膜版就能直接刻畫出或沉積到GIS系統(tǒng)下所需要的圖形,使用FIB系統(tǒng)已能夠在微納米尺度上制備復雜功能性結(jié)構(gòu),內(nèi)容涉及納米量子電子器件、亞波長光學結(jié)構(gòu)、表面等離激元器件和光子晶體結(jié)構(gòu)。采用合理方法,不但能實現(xiàn)二維平面圖形結(jié)構(gòu)的繪制,而且即使在復雜的三維結(jié)構(gòu)中也能進行繪制。

三維重構(gòu)分析
三維重構(gòu)分析目的主要是依靠軟件控制FIB逐層切割和SEM成像交替進行,最后通過軟件進行三維重構(gòu)。FIB三維重構(gòu)技術(shù)與EDS有效結(jié)合使得研究人員能夠在三維空間對材料的結(jié)構(gòu)形貌以及成分等信息進行表征;和EBSD結(jié)合可對多晶體材料進行空間狀態(tài)下的結(jié)構(gòu)、取向、晶粒形貌、大小、分布等信息進行表征。
-
SEM
+關(guān)注
關(guān)注
0文章
257瀏覽量
14813 -
fib
+關(guān)注
關(guān)注
1文章
94瀏覽量
11349 -
離子束
+關(guān)注
關(guān)注
0文章
86瀏覽量
7749
發(fā)布評論請先 登錄
FIB技術(shù)
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構(gòu)
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構(gòu)
當大范圍結(jié)構(gòu)定點分析觀察 Dual-Beam FIB滿足不了時怎么辦?
FIB加工就在你身邊-芯片IC電路修改-芯片IC開封-FIB截面分析
芯片漏電點FIB切片分析
FIB加工就在你身邊-芯片IC電路修改-芯片IC開封-FIB截面分析
FIB技術(shù)在印刷線路板PCB失效分析的應(yīng)用
SEM/FIB雙束系統(tǒng)截面加工:實現(xiàn)離子的成像、注入、刻蝕和沉積

什么是FIB?FIB有哪些應(yīng)用?如何修改線路做FIB?FIB怎么做失效分析?
FIB常見應(yīng)用明細及原理分析

FIB技術(shù):芯片失效分析的關(guān)鍵工具

FIB技術(shù)在芯片失效分析中的應(yīng)用
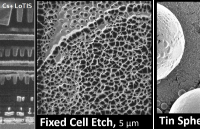
一文帶你了解聚焦離子束(FIB)
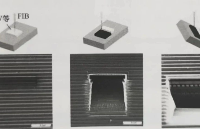
FIB聚焦離子束切片分析






 FIB常見應(yīng)用明細及原理分析
FIB常見應(yīng)用明細及原理分析










評論