半導(dǎo)體濕法清洗工藝
隨著半導(dǎo)體器件尺寸的不斷縮小和精度要求的不斷提高,晶圓清洗工藝的技術(shù)要求也日益嚴(yán)苛。晶圓表面任何微小的顆粒、有機(jī)物、金屬離子或氧化物殘留都可能對(duì)器件性能產(chǎn)生重大影響,進(jìn)而影響半導(dǎo)體器件的成品率和可靠性。
晶圓表面污染物種類繁多,大致可分為顆粒污染、金屬污染、化學(xué)污染(包括有機(jī)和無機(jī)化合物)以及天然氧化物四大類。
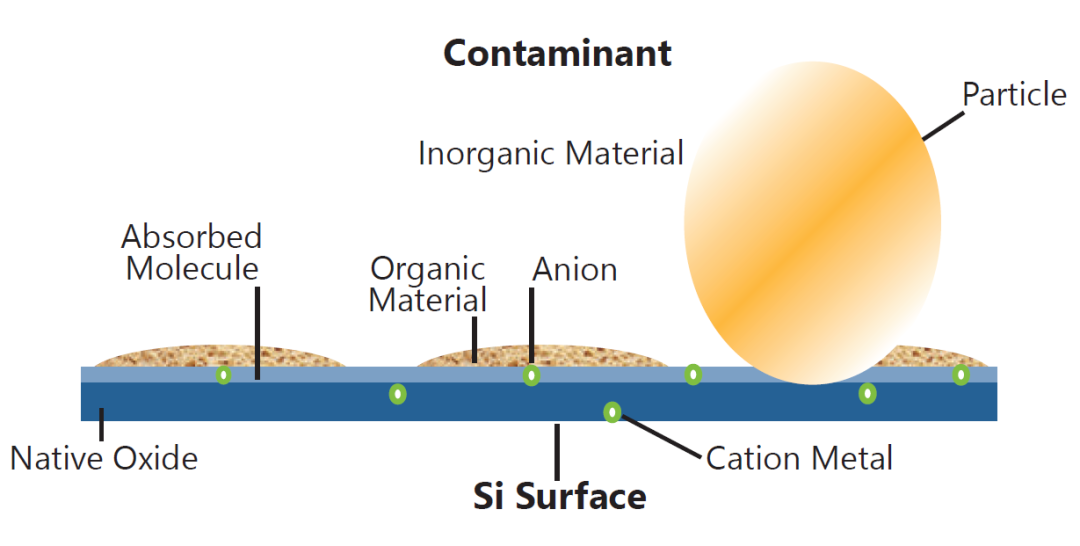
圖1:硅晶圓表面可能存在的污染物
01
顆粒污染
顆粒污染主要來源于空氣中的粉塵、生產(chǎn)設(shè)備磨損、工藝化學(xué)品殘留等。這些微小顆粒可能遮擋關(guān)鍵特征的形成,或在絕緣薄膜中產(chǎn)生局部電弱點(diǎn),導(dǎo)致器件性能下降甚至失效。針對(duì)顆粒污染的清洗策略包括使用強(qiáng)氧化劑如piranha溶液(硫酸與過氧化氫的混合物)進(jìn)行總顆粒物清洗,以及利用SC-1溶液(氨水、過氧化氫和水的混合物)去除強(qiáng)粘附的小顆粒。SC-1通過誘導(dǎo)晶圓表面與顆粒相同的zeta電位,有效防止顆粒再吸附。
02
金屬污染
金屬污染物如金、銅等,在硅晶格中具有高度流動(dòng)性,易從表面遷移到體硅中,導(dǎo)致漏電流增大、擊穿電壓降低等嚴(yán)重后果。酸性清洗劑如SC-2(鹽酸、過氧化氫和水的混合物)、SPM(硫酸與過氧化氫的混合物)等能有效去除金屬污染物,形成可溶的離子化金屬鹽并被沖洗掉。
03
化學(xué)污染
有機(jī)污染物主要來源于光刻膠殘留、揮發(fā)性有機(jī)溶劑及空氣污染。這些污染物在高溫工藝中會(huì)形成碳?xì)埩粑铮绊懥悸省C-1和SPM等清洗液通過氧化及溶劑化作用去除有機(jī)污染物。
無機(jī)污染物包括硼、磷等摻雜元素及酸堿性化合物。這些污染物會(huì)改變電阻率、影響光刻膠性能并產(chǎn)生顆粒和霧霾。通過SC-1和SC-2的聯(lián)合作用可有效去除。
04
天然氧化物
硅表面自然形成的氧化物層會(huì)影響熱氧化物厚度形成及柵極絕緣體電特性。稀氫氟酸(DHF)、氟化銨或BOE(拋光氧化物刻蝕液)能完全去除天然氧化物,留下氫終端的硅表面。

圖2:天然氧化物的去除和氫終端硅表面特性
濕法清洗是指利用化學(xué)反應(yīng)或物理作用將半導(dǎo)體表面的雜質(zhì)、氧化物和有機(jī)物等污染物去除的方法。清洗的目的是為了提高半導(dǎo)體表面的潔凈度,減少雜質(zhì)對(duì)器件性能的影響。在濕法清洗中,常用的化學(xué)反應(yīng)有酸堿中和反應(yīng)、氧化還原反應(yīng)等。物理作用包括溶解擴(kuò)散、吸附等。
常用的濕法清洗有:RCA清洗、臭氧清洗、超聲波清洗和兆聲波清洗等方法。
1
RCA清洗
RCA清洗工藝是半導(dǎo)體行業(yè)中最經(jīng)典的晶圓預(yù)清洗方法,由Werner Kern及其同事在RCA公司開發(fā)。該工藝結(jié)合了SC-1和SC-2溶液,并輔以稀HF或BOE去除天然氧化物。RCA清洗憑借其高效性和可靠性,至今仍被廣泛應(yīng)用于前道工序(FEOL)的晶圓清洗中。SC-1清洗液由 NH4OH、H2O2和H2O 組成,由于H2O2的作用,硅片表面有一層自然氧化膜(SiO2),呈親水性, 硅片表面和粒子之間可用清洗液浸透。SC-2 清洗液由 HCl、H2O2 、和H2O組成,主要用于對(duì)硅片表面金屬沾污的清洗。
硅片表面金屬的存在形式是多種多樣的,它們可以以原子、氧化物、金屬復(fù)合物、硅化物等形式存在于自然氧化膜表面、自然氧化膜內(nèi)部、硅與氧化物的界面或硅內(nèi)部。金屬在溶液中的附著特性與 pH 值、金屬誘生氧化物作用、氧化還原電位、負(fù)電性、金屬致氧化物形成焓以及化學(xué)試劑的氧化性等有關(guān)。在3
在SC-1和SC-2溶液清洗后,利用DHF去除晶圓表面的氧化層。DHF(HF/H2O 20-25℃)是一種由氫氟酸和去離子水組成的混合溶液。由于DHF可以去除硅片表面的自然氧化膜,因此附著在自然氧化膜上的金屬將被溶解到清洗液中,同時(shí) DHF 抑制了氧化膜的形成。因此可以很容易的去除硅片表面的 AL、 Fe、 Zn、 Ni等金屬,DHF也可以去除附著在自然氧化膜上的金屬氫氧化物。隨著自然氧化膜溶解到清洗液中 Cu 等貴金屬(氧化還原電位比 H 高),會(huì)附著在裸硅表面即:
01
如果硅片最外層的硅都以H為終端,硅表面在化學(xué)上將是穩(wěn)定的。即使清洗液中存在貴金屬離子,也很難發(fā)生于 Si的電子交換,因此這些金屬不會(huì)附著在硅片的表面;
01
02
如果清洗液中存在Cl等陰離子,就會(huì)附著在硅表面H終端不完整的地方,附著的陰離子將會(huì)輔助Cu離子與 Si 的電子交換,使Cu離子成為Cu附著在硅片表面。用 DHF 清洗時(shí)將會(huì)把硅片表面的自然氧化膜腐蝕掉,而Si幾乎不被腐蝕。用DHF 清洗后,硅片最外端的Si幾乎都以H為終端, 故硅片呈疏水性。
SPM(H2SO4/H2O2100-130℃)是一種由硫酸和過氧化氫組成的混合溶液。這是一種去除有機(jī)污染物的常用清洗液。由于工藝上的不同,DHF或被用于SPM后、或SC-1后、或SC-2后,甚至多道DHF被引入RCA清洗中。大部分公司將RCA清洗中的DHF設(shè)置于SPM后。標(biāo)準(zhǔn)的RCA清洗流程如圖3所示。
圖3:標(biāo)準(zhǔn)的RCA清洗流程
02
2
臭氧清洗
臭氧清洗技術(shù)主要利用其極強(qiáng)的氧化性。該氧化性可以破壞和去除晶圓表面的有機(jī)和無機(jī)污染物,它也常用于對(duì)表面進(jìn)行氧化處理。向超純水中加入臭氧可以有效去除Cu,Ag等金屬,甚至一些輕有機(jī)物,是其他晶圓清洗手段的一種輔助。這種方法不需要使用昂貴的化學(xué)試劑,并且對(duì)環(huán)境污染較小,因此逐漸成為晶圓清洗領(lǐng)域的一種新興技術(shù)。
圖4:臭氧清洗原理示意圖
3
超聲波清洗
超聲波清洗是在超聲波作用下,機(jī)械振動(dòng)傳到液體中時(shí),迫使液體內(nèi)部產(chǎn)生疏密相間的振動(dòng),液體不斷被拉伸和壓縮。疏的區(qū)域形成微小的空穴氣泡,密的區(qū)域受到壓縮,在不斷拉伸和壓縮的環(huán)境下,空穴氣泡不斷破裂,對(duì)晶片表面的顆粒連續(xù)施加短暫且強(qiáng)烈的作用力,迫使顆粒從晶片表面脫落,從而達(dá)到清洗效果。一般用于大于0.5微米的顆粒清洗。
4
兆聲波清洗
在兆聲波清洗中,很少形成超聲波那樣的氣泡,主要以高速的流體沖擊晶片表面,強(qiáng)制除去細(xì)小的污染物,使之進(jìn)入到清洗液中。一般可以去除0.1-0.3微米的顆粒清洗。
圖5:兆聲波清洗示意圖
晶圓清洗技術(shù)作為半導(dǎo)體制造中的關(guān)鍵環(huán)節(jié),其重要性不言而喻。通過多種清洗方法的組合使用,能夠有效去除晶圓表面的各種污染物,為后續(xù)工藝提供潔凈的基底表面。隨著技術(shù)的不斷進(jìn)步,清洗工藝也在不斷優(yōu)化,以適應(yīng)更高精度、更低缺陷率的半導(dǎo)體制造需求。
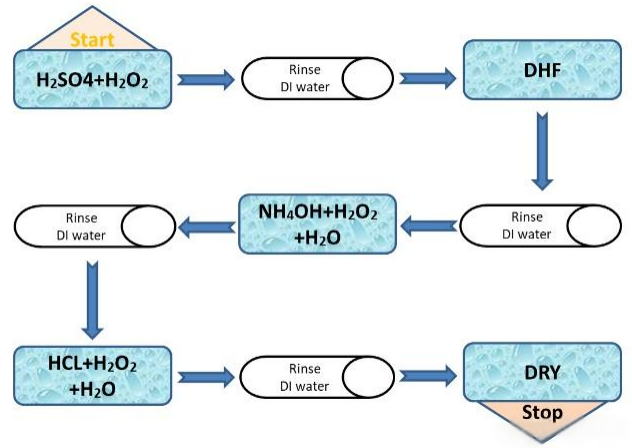

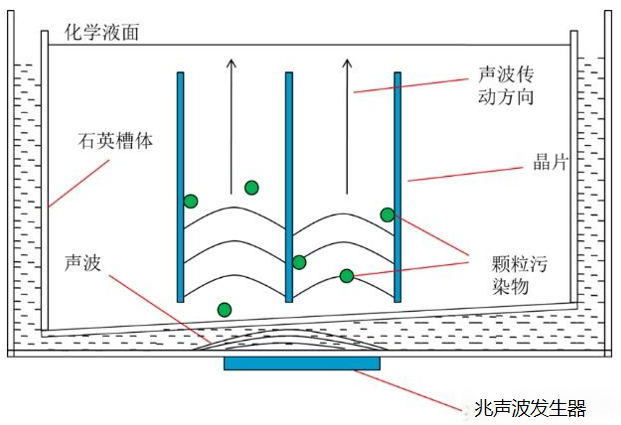
-
濕法
+關(guān)注
關(guān)注
0文章
19瀏覽量
7174 -
半導(dǎo)體制造
+關(guān)注
關(guān)注
8文章
448瀏覽量
24773
原文標(biāo)題:半導(dǎo)體濕法清洗工藝
文章出處:【微信號(hào):wc_ysj,微信公眾號(hào):旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
最全最詳盡的半導(dǎo)體制造技術(shù)資料,涵蓋晶圓工藝到后端封測(cè)
半導(dǎo)體制造
半導(dǎo)體清洗設(shè)備
半導(dǎo)體制造的難點(diǎn)匯總
《炬豐科技-半導(dǎo)體工藝》DI-O3水在晶圓表面制備中的應(yīng)用
半導(dǎo)體清洗工藝全集
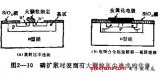
半導(dǎo)體制造CMP工藝后的清洗技術(shù)
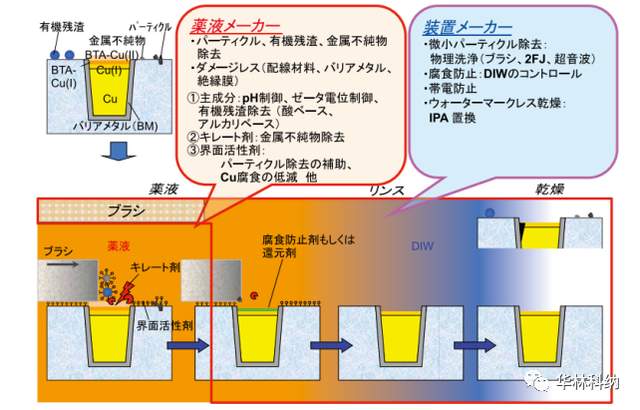
半導(dǎo)體制造中有效的濕法清洗工藝
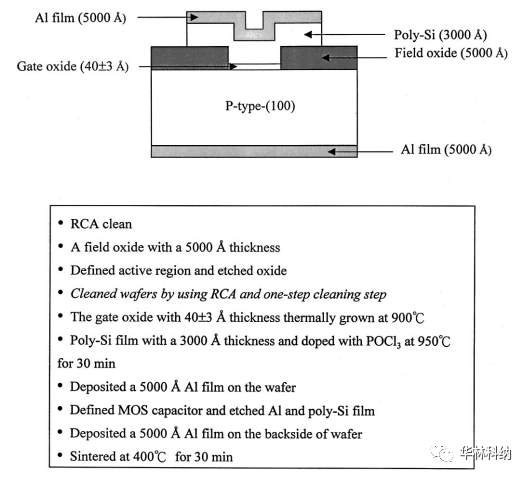
半導(dǎo)體制造CMP工藝后的清洗技術(shù)
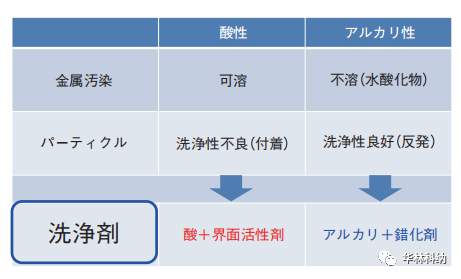
探秘半導(dǎo)體制造中單片式清洗設(shè)備
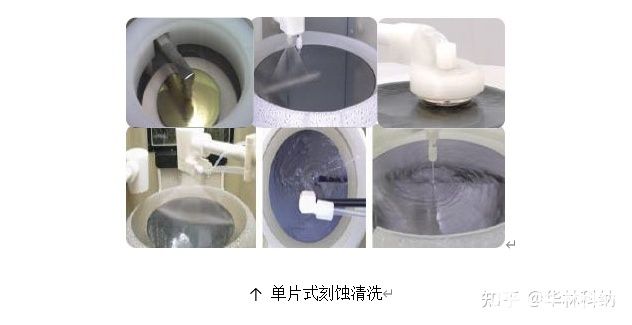





 半導(dǎo)體制造中的濕法清洗工藝解析
半導(dǎo)體制造中的濕法清洗工藝解析

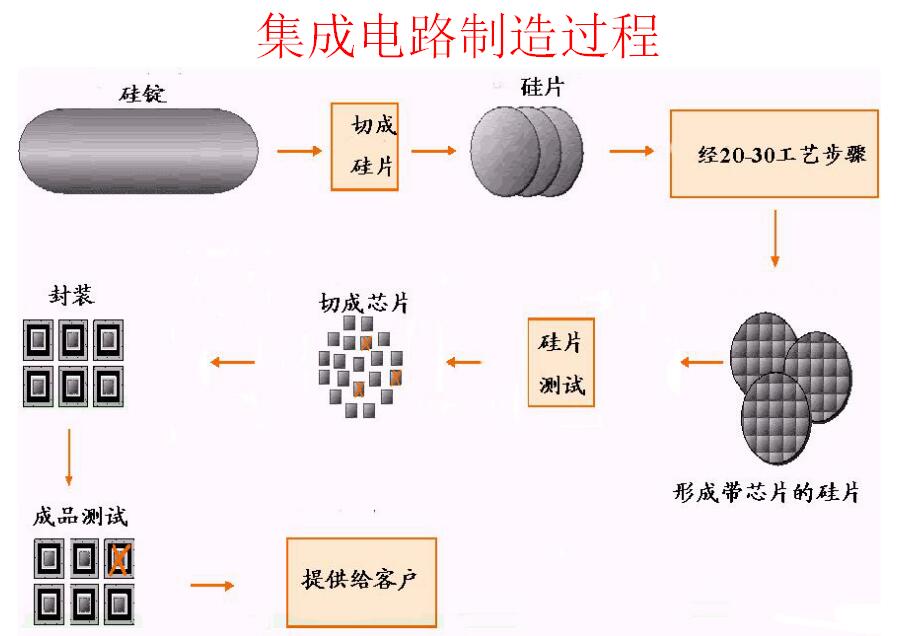












評(píng)論