一、引言
半導體塑封工藝是半導體產業中不可或缺的一環,它通過將芯片、焊線、框架等封裝在塑料外殼中,實現對半導體器件的保護、固定、連接和散熱等功能。隨著半導體技術的不斷發展,塑封工藝也在不斷演進,以適應更高性能、更小尺寸、更高可靠性的半導體器件的需求。
二、半導體塑封工藝概述
半導體塑封工藝是一種將半導體器件封裝在塑料外殼中的制造過程。其主要目的是保護器件免受環境影響和機械損傷,同時提供電氣連接和散熱等功能。塑封工藝具有成本低、生產效率高、保護性能好等優點,因此在半導體產業中得到了廣泛應用。
三、塑封材料的選擇與性能
塑封材料的選擇對半導體器件的性能和可靠性至關重要。常用的半導體塑封材料主要包括環氧樹脂、硅橡膠、聚氨酯等。其中,環氧樹脂因其優良的絕緣性能、耐溫性能和力學性能,成為半導體塑封工藝中最常用的材料。
環氧樹脂塑封料是一種熱固性化學材料,主要由環氧樹脂、固化劑、填料和多種助劑混配而成。環氧樹脂分子中的環氧基團在固化劑的作用下發生交聯反應,形成具有穩定結構的化合物。固化后的環氧樹脂塑封料具有優良的耐熱性、較高的機械強度、電氣絕緣性、可靠性和力學性能及較小的收縮率、耐化學性。
在選擇塑封材料時,需要考慮多個因素,包括材料的耐溫性能、強度、韌性、抗化學腐蝕能力、成本等。例如,對于在高溫環境下工作的半導體器件,需要選擇具有良好耐溫性能的塑封材料;對于需要承受較大機械應力的半導體器件,需要選擇具有較高強度和韌性的塑封材料。
四、塑封工藝流程
半導體塑封工藝流程通常包括模具準備、材料預熱、注塑、固化、后處理等步驟。以下是詳細的工藝流程介紹:
模具準備
- 模具清模:在使用模具之前,需要對模具進行清潔,以去除殘留的塑封料和其他雜質。這可以通過機械清洗、化學清洗或超聲波清洗等方法實現。
- 模具脫模:為了確保塑封料能夠順利脫模,需要在模具表面涂覆脫模劑。同時,在正式塑封前,還需要對模具進行預熱,以降低模具與塑封料間的黏結力。
材料預熱
- 塑封料預熱:將環氧樹脂塑封料從低溫存儲環境中取出,進行回溫處理,使其達到適合注塑的溫度。預熱溫度和時間根據塑封料的種類和規格而定。
- 框架預熱:將待封裝的芯片和引線框架裝入模具的模腔中,并進行預熱。預熱溫度和時間根據框架的材料和尺寸而定。
- 注塑
- 注塑壓力:通過注塑機構將預熱后的液態環氧樹脂注入模具的模腔中。注塑壓力的大小需要根據塑封料的流動性、模具的結構和產品的尺寸等因素進行調整。
- 注塑時間:注塑時間的長短需要根據塑封料的固化速度、模具的溫度和產品的尺寸等因素進行調整。為了確保塑封料能夠充分填充模腔并形成良好的封裝效果,注塑時間需要控制在合適的范圍內。
固化
- 模具保壓:在注塑完成后,需要對模具進行保壓處理。保壓時間和壓力的大小需要根據塑封料的固化速度、模具的溫度和產品的尺寸等因素進行調整。保壓處理可以確保塑封料在固化過程中不會因為收縮而產生裂紋或空洞等缺陷。
- 固化爐固化:將注塑并保壓處理后的模具放入固化爐中進行進一步固化處理。固化爐的溫度和時間需要根據塑封料的種類和規格進行調整。固化處理可以確保塑封料完全固化并形成穩定的結構。
后處理
- 去除毛邊:在固化完成后,需要對塑封體周邊多余的環氧樹脂進行去除處理。這可以通過機械切割、化學腐蝕或超聲波清洗等方法實現。
- 檢驗與測試:對塑封后的半導體器件進行外觀檢驗和性能測試。外觀檢驗主要包括檢查塑封體是否有裂紋、空洞、針孔等缺陷;性能測試主要包括測試器件的電性能、熱性能和可靠性等指標。
五、塑封工藝中的關鍵參數與設備
半導體塑封工藝中的關鍵參數和設備對塑封效果和產品質量具有重要影響。以下是一些關鍵的參數和設備介紹:
關鍵參數
- 合模壓力:上下模具壓合的壓力。合模壓力過小會導致塑封料有溢料的情況發生;合模壓力過大會對模具的使用壽命造成一定的影響。
- 模具溫度:模具溫度用于保證熱固性塑封料在加熱過程中軟化、液化,以便能流動。模具溫度需要根據塑封料的種類和規格進行調整。
- 注塑時間:塑封料注塑過程的整體時間。針對一些結構復雜的產品,可以分段注塑,每段注塑單獨控制時間。
- 固化時間:塑封料從固化開始到形成一定的硬度,以至于能用頂桿頂出的時間(從產品注塑的時間開始算起,包含注塑時間)。固化時間需要根據塑封料的種類和規格進行調整。
關鍵設備
- 塑封壓機:為塑封模具提供合適的溫度、注塑壓力、合模壓力等作業條件。塑封壓機又可以分為自動壓機和手動壓機。自動壓機可自動實現塑封過程,無須人員手動上模,但設備費用較高;手動壓機需要人員輔助上塑封料、上框架,設備相對廉價。
- 塑封模具:塑封模具是塑封設備的核心部件。不同的產品有不同的封裝形式,對應不同的模具。塑封模具根據注塑頭的數量,又分為多注塑頭模具、傳統模具。多注塑頭模具里有多個注塑頭進行注塑,傳統模具只通過一個注塑頭進行注塑。從產品的品質及材料的成本來看,多注塑頭模具的優勢很大,應用也比較多。
- 預熱設備:用于對塑封料和框架進行預熱處理。常見的預熱設備包括高頻預熱爐和預熱平臺等。
六、塑封工藝中的常見問題與對策
在半導體塑封工藝中,可能會出現一些常見問題,如分層、開裂、氣泡、針孔等。這些問題會嚴重影響半導體器件的性能和可靠性。以下是一些常見問題的原因和對策:
分層與開裂
- 原因:分層與開裂通常是由于塑封料與芯片、基島、導電膠或框架之間的應力過高或溫度沖擊過大引起的。此外,塑封料性能參數的差異、塑封模具注膠口位置和流道設計不同、塑封工藝差異以及塑封產品結構設計(包括引線框架結構)的不同也可能導致分層與開裂問題。
- 對策:通過優化塑封料的配方和工藝參數來降低應力水平;改進塑封模具的設計和制造質量;加強塑封過程中的溫度控制等。
- 氣泡與針孔
- 原因:氣泡與針孔通常是由于塑封料中的氣體未能完全排出或模具中的空氣被卷入塑封料中引起的。此外,塑封料預熱不充分或注塑速度過快也可能導致氣泡與針孔問題。
- 對策:通過優化塑封料的脫泡預攪拌等預處理工藝來減少氣體含量;改進模具的設計和制造質量以減少空氣被卷入的可能性;調整注塑速度和壓力等參數以確保塑封料能夠充分填充模腔并排出氣體。
七、塑封工藝的發展趨勢與挑戰
隨著半導體技術的不斷發展,塑封工藝也面臨著新的發展趨勢和挑戰。以下是一些主要的發展趨勢和挑戰:
發展趨勢
- 微型化與高密度封裝:隨著半導體器件的不斷微型化和集成度的提高,塑封工藝也需要向微型化和高密度封裝方向發展。這要求塑封材料具有更高的流動性和更好的填充性能;同時要求塑封設備具有更高的精度和穩定性。
- 環保與可持續發展:隨著環保意識的提高和可持續發展理念的普及,塑封工藝也需要向環保和可持續發展方向發展。這要求塑封材料具有更低的揮發性有機化合物(VOC)排放和更好的可回收性;同時要求塑封設備具有更低的能耗和更少的廢棄物產生。
- 智能化與自動化:隨著智能化和自動化技術的不斷發展,塑封工藝也需要向智能化和自動化方向發展。這要求塑封設備具有更高的自動化程度和更好的智能化控制功能;同時要求塑封工藝具有更高的生產效率和更好的產品質量。
- 挑戰
- 技術難度提升:隨著半導體器件的不斷微型化和集成度的提高,塑封工藝的技術難度也在不斷提升。這要求塑封材料具有更高的性能和更好的穩定性;同時要求塑封設備具有更高的精度和更好的可靠性。
- 成本控制壓力增大:隨著半導體市場競爭的加劇和成本控制的壓力增大,塑封工藝也需要向低成本和高效益方向發展。這要求塑封材料具有更低的成本和更好的性能;同時要求塑封設備具有更高的生產效率和更好的維護性能。
- 環保法規限制增強:隨著環保法規的限制增強和環保要求的提高,塑封工藝也需要向環保和可持續發展方向發展。這要求塑封材料具有更低的揮發性有機化合物(VOC)排放和更好的可回收性;同時要求塑封設備具有更低的能耗和更少的廢棄物產生。
八、結論
半導體塑封工藝是半導體產業中不可或缺的一環,它通過將芯片、焊線、框架等封裝在塑料外殼中,實現對半導體器件的保護、固定、連接和散熱等功能。塑封工藝具有成本低、生產效率高、保護性能好等優點,因此在半導體產業中得到了廣泛應用。隨著半導體技術的不斷發展,塑封工藝也在不斷演進,以適應更高性能、更小尺寸、更高可靠性的半導體器件的需求。未來,
-
半導體
+關注
關注
335文章
28702瀏覽量
234242 -
半導體器件
+關注
關注
12文章
777瀏覽量
32845 -
塑封
+關注
關注
0文章
9瀏覽量
8322
發布評論請先 登錄
半導體工藝講座
新冠病毒對世界半導體影響
半導體工藝幾種工藝制程介紹
世界著名半導體公司及其官網 精選資料分享
半導體塑封設備
半導體生產封裝工藝簡介
一文講清芯片封裝中的塑封材料:環氧塑封料(EMC)成分與作用
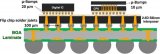





 走進半導體塑封世界:探索工藝奧秘
走進半導體塑封世界:探索工藝奧秘










評論