文章來(lái)源:Tom聊芯片智造
原文作者:芯片智造
本文介紹了Cu-Cu混合鍵合主要用在哪方面以及原理是什么。
什么是Cu-Cu混合鍵合?
Cu-Cu混合鍵合英文名為Cu-Cu Hybrid Bonding。
傳統(tǒng)的錫球倒裝鍵合通常需要金屬熔化又凝固的過(guò)程,但銅一銅混合鍵合采用固態(tài)接合,在高溫下,銅金屬的原子在固態(tài)下發(fā)生擴(kuò)散,形成牢固的連接,避免了金屬熔化帶來(lái)的“bridging”問(wèn)題,確保接合的可靠性。
Cu-Cu混合鍵合原理

1,選擇兩片均含有SiO?介質(zhì)和銅觸點(diǎn)的晶圓,銅觸點(diǎn)通常略低于SiO?的厚度。通常會(huì)使用等離子體來(lái)清潔表面,增強(qiáng)材料之間的粘附力。
2,處理后的兩片晶圓將在室溫下進(jìn)行對(duì)位接合。由于氧化硅之間的范德華力的作用,兩片晶圓已經(jīng)形成了一定的接合強(qiáng)度。這種接合力雖不高,但足夠讓兩片晶圓保持初步接觸。
3,接合后的晶圓在100℃下加熱,形成了較強(qiáng)的共價(jià)鍵,共價(jià)鍵的形成使得氧化硅接合面之間的結(jié)合更加牢固。
4,接下來(lái),溫度升高至300℃至400℃,由于銅的熱膨脹系數(shù)大于SiO?,銅的體積會(huì)劇烈膨脹,最終使兩片晶圓上位置低于氧化硅的銅相互接觸,并在高溫下擴(kuò)散進(jìn)入對(duì)方,從而實(shí)現(xiàn)銅與銅之間的鍵合。
Cu-Cu混合鍵合問(wèn)題的來(lái)源
晶圓的平坦化不足,晶圓表面未清洗干凈有粒子殘留,對(duì)齊誤差,Cu金屬界面有孔洞等。
wafer to wafer Cu-Cu混合鍵合用在哪些芯片產(chǎn)品上?
可以用在CIS、3D NAND等產(chǎn)品上。
-
芯片
+關(guān)注
關(guān)注
459文章
52308瀏覽量
437987 -
晶圓
+關(guān)注
關(guān)注
52文章
5131瀏覽量
129308 -
鍵合
+關(guān)注
關(guān)注
0文章
79瀏覽量
8067
原文標(biāo)題:Cu-Cu混合鍵合原理
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
銅線鍵合IMC生長(zhǎng)分析

請(qǐng)教如何查看CU320卡里存貯的CU組態(tài)數(shù)據(jù)?
CU1641-000 CU1641-000 纜到纜接續(xù)
CU1647-000 CU1647-000 纜到纜接續(xù)
CU1639-000 CU1639-000 纜到纜接續(xù)
CU3031-000 CU3031-000 接頭
BOE濕蝕對(duì)三維集成中銅模式直接鍵界面特性的影響
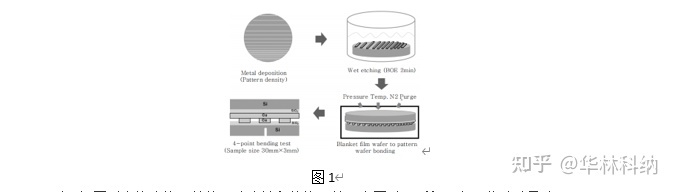
先進(jìn)封裝之熱壓鍵合工藝的基本原理

CU4000?和CU4000 LoPro?銅箔Rogers
先進(jìn)封裝中銅-銅低溫鍵合技術(shù)研究進(jìn)展

3D Cu-Cu混合鍵合技術(shù)的優(yōu)點(diǎn)和未來(lái)發(fā)展
化解先進(jìn)半導(dǎo)體封裝挑戰(zhàn),有一個(gè)工藝不能不說(shuō)
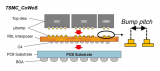
先進(jìn)封裝中銅-銅低溫鍵合技術(shù)研究進(jìn)展

Cu-Cu Hybrid Bonding技術(shù)在先進(jìn)3D集成中的應(yīng)用

微電子封裝用Cu鍵合絲,挑戰(zhàn)與機(jī)遇并存






 Cu-Cu混合鍵合的原理是什么
Cu-Cu混合鍵合的原理是什么










評(píng)論