我們先設(shè)定一下場景:假設(shè)某一系統(tǒng)運行溫度過高,需要評估冷卻解決方案,如使用風(fēng)扇或液體冷卻。所有冷卻解決方案均可在仿真中進行評估,但如何在仿真模型中定義熱源和邊界條件?
要獲取熱仿真的輸入數(shù)據(jù),需要了解系統(tǒng)中的主要熱源。這意味著要使用原型進行一些測量,以便在仿真模型中定義熱源和邊界條件。在測試電子系統(tǒng)時,有幾種測量方法(例如熱電偶或紅外攝像機)都可以確定主要熱源。
在確定主要熱源后,只要正確使用測量數(shù)據(jù),便可進行系統(tǒng)仿真。為了解仿真過程,我們將探討在設(shè)計中收集哪些測量數(shù)據(jù),以及如何使用它們來設(shè)置熱仿真。
從熱測量開始
為了確保熱仿真的精確性,首先需要進行精確的測量,定義想要在仿真中重現(xiàn)的情況。在熱仿真中,最終目標是計算系統(tǒng)中一組給定源的溫度分布。此外,我們還要確定系統(tǒng)在受到干擾(例如氣流干擾)后發(fā)生變化所需的時間。然后可以使用此初始溫度分布仿真來評估新設(shè)計,例如在系統(tǒng)中添加風(fēng)扇。
從定義要求開始
在測量溫度之前,首先要明確您想要與測量結(jié)果進行比較的具體場景。例如,您需要確定測試用例的以下方面:
重要器件的功耗是多少?
是否包括導(dǎo)熱墊或散熱器等特殊材料?
更改后,系統(tǒng)中的測量結(jié)果是否可重復(fù)?
這些都是為產(chǎn)品設(shè)置熱測試用例時的基本任務(wù)。設(shè)置熱測試時有兩個最常見的場景:分析標準作業(yè)條件和壓力作業(yè)條件。前者展示產(chǎn)品的典型使用場景,后者用于確定產(chǎn)品可能容易出現(xiàn)故障的額定工作范圍上限。
測量位置
為了確定產(chǎn)品內(nèi)部的溫度分布,應(yīng)在系統(tǒng)的幾個關(guān)鍵區(qū)域進行測量。以下是幾種常見的溫度測量方法:
使用熱電偶進行點測量
使用紅外熱傳感器進行點測量
使用熱像儀進行全系統(tǒng)測量
使用紅外點傳感器進行的熱測量是一種瞄準式解決方案,能夠提供系統(tǒng)中特定點的溫度讀數(shù)。然而,就像熱像儀一樣,這種測量需要將外殼完全打開,才能從 PCB 上獲取讀數(shù)。使用熱電偶進行點測量是最理想的選擇,因為它們可以接入封閉的封裝中,并直接連接到集成電路封裝進行溫度測量。

使用手持式紅外傳感器進行點測量
當使用一組熱電偶時,應(yīng)直接測量所有熱集成電路封裝,因為這些封裝是系統(tǒng)中的主要熱源。隨后將使用這些直接測量數(shù)據(jù)來確定熱仿真中所需的一些材料參數(shù)。
此外,還應(yīng)獲取外殼內(nèi)部空隙的溫度讀數(shù)。這也可測量設(shè)計中的停滯空氣,因此將成為仿真模型評估的一部分。最后,將熱電偶連接到外殼表面或使用熱像儀測量外殼溫度。
這些直接測量值可以通過現(xiàn)成的數(shù)據(jù)采集(Data Acquisition,DAQ)單元捕獲,例如下圖所示的測量計算單元。

用于捕獲熱電偶測量值的 DAQ 單元。
連接熱電偶后,應(yīng)持續(xù)監(jiān)測設(shè)計,觀察其是否達到熱平衡。一旦系統(tǒng)達到平衡溫度,DAQ 將記錄每個測量點的連續(xù)溫度數(shù)據(jù)。
在某些情況下,如果外殼體積較小且沒有開放的熱電偶接入點,可能很難獲取所有這些測量值。在這些系統(tǒng)中,更合理的做法可能是打開外殼并將 PCB 放置在較大的盒子中,以便為熱電偶留出空間。另一種選擇是使用熱像儀直接成像,而不是使用熱電偶進行點測量,因為這可以直接從主要產(chǎn)熱器件獲取表面溫度測量值。
在仿真中重現(xiàn)測量值
在仿真中分析更改的設(shè)計之前,需要使用現(xiàn)有數(shù)據(jù)在仿真中重現(xiàn)現(xiàn)有的測量值。在仿真中重現(xiàn)測試用例,可以驗證仿真模型——用物理測試用例作為參考,可以評估仿真結(jié)果的準確性。
熱仿真需要求解封閉系統(tǒng)中的熱方程,這要求掌握系統(tǒng)中各個點的熱導(dǎo)率。就集成電路封裝而言,這些數(shù)據(jù)不像外殼材料或 PCB 材料那樣以表格形式提供,但可以根據(jù)數(shù)據(jù)表中的封裝熱阻值和操作過程中直接測量的溫度值來確定。
熱仿真需要熱源(S)的值,以便預(yù)測產(chǎn)品中的穩(wěn)態(tài)溫度分布。下圖展示了集成電路仿真包計算源熱通量(S)所需的輸入?yún)?shù):
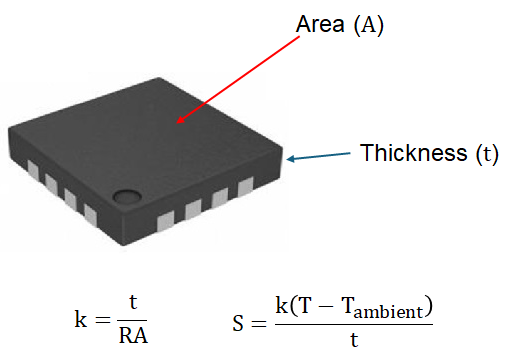
根據(jù)封裝熱阻、封裝尺寸和溫度測量值來計算熱通量。
Tambient(即環(huán)境溫度)的值將作為外殼內(nèi)部停滯空氣的初始條件。為了在仿真中定義熱源,可以將另一個溫度值(T)視為靜態(tài)值。為簡單起見,可以將 T 設(shè)置為平衡狀態(tài)下的封裝溫度測量值。
確定封裝熱導(dǎo)率(k)和靜態(tài)封裝溫度(T)的值之后,可以使用以下設(shè)置進行瞬態(tài)熱仿真:
初始條件:
Tambient已知,可調(diào)整
外殼主體溫度(可設(shè)置為Tambient)
邊界條件:
T 從測量中獲得,設(shè)置為靜態(tài)值
外殼外部溫度(可設(shè)置為室溫)
您也可以通過將 Tambient設(shè)為系統(tǒng)達到熱平衡時測量的停滯空氣溫度和外殼溫度,進行穩(wěn)態(tài)熱仿真。這種仿真方法速度更快,并且能夠有效驗證系統(tǒng)仿真模型。
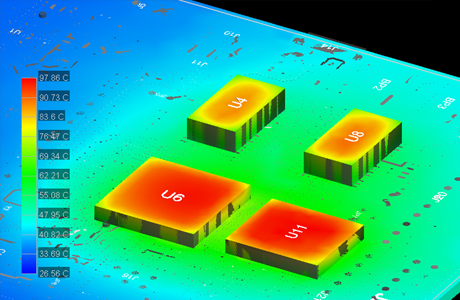
初始熱仿真結(jié)果可用于評估對系統(tǒng)的修改。
修改系統(tǒng)并重新仿真
一旦系統(tǒng)經(jīng)過仿真并獲得參考數(shù)據(jù),便可實施擬定的修改并重新檢查系統(tǒng)。如果條件允許,可以同時進行新的測量,盡管并非所有系統(tǒng)都支持此類修改。無論如何,仿真是確定設(shè)計更改以減少熱負荷的最快方法。
例如,您可以使用合格仿真模型來重現(xiàn)熱電偶的測量值,然后對其進行修改以添加風(fēng)扇。通過 CFD 熱協(xié)同仿真,可以添加氣流源并運行瞬態(tài)仿真,檢查不同流速對運行期間平衡溫度的影響。通過這種方法,您可以快速識別出一些在測量中難以發(fā)現(xiàn)的潛在問題,例如:
存在停滯空氣的重點區(qū)域
流量較低的區(qū)域
進氣口和排氣口位置對氣流的影響
上述因素對外殼表面溫度的影響
溫度下降與氣流之間的關(guān)系
排氣溫度
在典型的熱仿真中,部分上述參數(shù)會直接顯示在電路板上,但會疊加流線來展示氣流的位置和流量。在這些仿真中,還會檢查其他冷卻措施,例如使用散熱器、將熱界面材料附著到外殼或使用尺寸較大的外殼。

帶有流線的熱感知 CFD 仿真。
雖然為仿真收集熱數(shù)據(jù)的前期工作較為耗時,但設(shè)計團隊能夠更快地驗證與熱控制和管理相關(guān)的設(shè)計更改。最終減少原型迭代次數(shù),從而節(jié)省時間和成本,并且隨著新原型的構(gòu)建和測試,可以不斷更新仿真模型。Cadence 的 Celsius EC Solver 可以對復(fù)雜設(shè)計進行建模和分析、對復(fù)雜電子系統(tǒng)的流動和傳熱進行分析,不僅可以降低產(chǎn)品失效風(fēng)險,還可以優(yōu)化熱管理解決方案,最大程度地提升性能。
-
仿真
+關(guān)注
關(guān)注
51文章
4250瀏覽量
135453 -
仿真模型
+關(guān)注
關(guān)注
1文章
30瀏覽量
12510 -
熱測量
+關(guān)注
關(guān)注
0文章
3瀏覽量
5060
發(fā)布評論請先 登錄
數(shù)據(jù)總線寬度:對齊的含義和怎樣去對齊以及帶來的效率差異
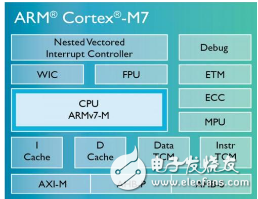
功率器件熱設(shè)計基礎(chǔ)(六)——瞬態(tài)熱測量

PCB熱仿真
基于設(shè)計數(shù)據(jù)共享的板級熱仿真技術(shù)研究(一)
連接器的熱設(shè)計與熱仿真和熱測試
POL的熱阻測量及SOA評估方法
ThermaSim在線MOSFET熱仿真工具改進設(shè)計
基于ARM程序的字節(jié)對齊的分析
DC-DC轉(zhuǎn)換器熱仿真電路






 對齊熱測量與仿真
對齊熱測量與仿真












評論