離子束掃描電子顯微鏡(FIB-SEM)是將聚焦離子束(FIB)技術與掃描電子顯微鏡(SEM)技術有機結合的高端設備。
什么是FIB-SEM?
FIB-SEM系統通過聚焦離子束(FIB)和掃描電子顯微鏡(SEM)兩種互補技術,實現了材料的高精度成像與加工。FIB技術利用電透鏡將液態金屬離子源產生的離子束加速并聚焦,作用于樣品表面,可實現納米級的銑削、沉積、注入和成像操作。這種技術能夠對樣品進行精確的微觀加工,為后續的分析提供理想的樣品形態。
與此同時,SEM通過電子槍發射電子束,經電磁透鏡加速和聚焦后與樣品相互作用,產生多種信號,如二次電子和背散射電子。這些信號能夠揭示樣品的物理和化學特性,包括形貌、成分和晶體結構等。
在FIB-SEM系統中,SEM能夠實時監控FIB的操作過程,確保加工的精度和效果。這種協同工作模式使FIB-SEM具備了“觀察-加工-分析”的全鏈條能力。
FIB-SEM的用途
1.截面分析
截面分析是FIB-SEM的典型應用之一。通過在樣品表面挖出一個垂直于表面的截面,研究人員可以詳細研究樣品的內部結構。這種技術廣泛應用于分析多層結構的厚度、夾角和組成成分。
例如,在半導體制造領域,FIB-SEM被用于檢測光刻膠層的厚度和均勻性。隨著集成電路從中小規模向大規模、超大規模甚至系統級芯片發展,失效分析對技術精度的要求日益提高,而FIB-SEM憑借其納米級別的分析能力,能夠滿足這一需求。
2.FIB-TEM樣品制備
透射電子顯微鏡(TEM)是一種能夠觀察材料微觀結構的高分辨率工具,但對樣品厚度要求極高,通常在100納米以下。然而,絕大多數固體樣品無法直接滿足TEM的要求,此時FIB-SEM的精準加工能力便顯得尤為重要。
其典型步驟包括:首先在樣品的關鍵區域進行保護性涂層沉積,以避免制樣過程中高能離子束引起的表面損傷;然后使用FIB技術對樣品進行初步銑削;最后通過精細銑削將樣品厚度進一步降低至TEM可用的標準。例如,磷酸鐵鋰正極材料經過FIB制備后的SEM圖片顯示,通過TEM表征可以對其內部微觀結構進行詳細分析。
結語
FIB-SEM作為一種高端的微觀分析與加工設備,憑借其獨特的雙束協同工作模式和強大的功能,在材料科學、電子工業、生命科學以及納米技術等領域發揮著重要作用。隨著技術的不斷進步,FIB-SEM將在微觀世界的研究中發揮更加重要的作用。
-
fib
+關注
關注
1文章
94瀏覽量
11345 -
電子顯微鏡
+關注
關注
1文章
115瀏覽量
10108 -
離子束
+關注
關注
0文章
86瀏覽量
7745
發布評論請先 登錄
Dual Beam FIB(雙束聚焦離子束)
聚焦離子束應用介紹
聚焦離子束掃描電鏡(FIB-SEM)技術原理、樣品制備要點及常見問題解答






 聚焦離子束掃描電子顯微鏡(FIB-SEM)的用途
聚焦離子束掃描電子顯微鏡(FIB-SEM)的用途


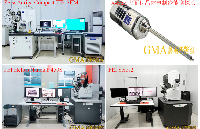
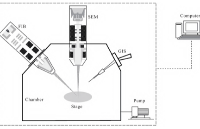

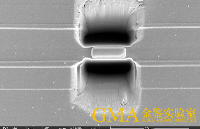
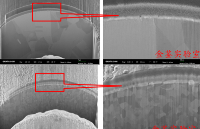
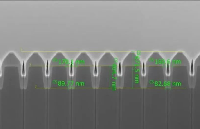
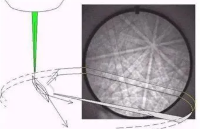










評論