詳細分析如何將GaN Systems的GaNPX? 和PDFN封裝下的E-HEMT器件焊接到PCB。
概括:
? 焊錫模板的設計
? 焊錫與助焊劑
? 回流焊的溫度曲線
? 手工焊接和拆焊、
好的焊錫模板設計可以有效改善焊錫空洞、多余焊錫球等焊接問題。以下是GaN Systems的建議:
? 設計焊錫模板時,盡量避免對一個焊盤使用一個大的網孔。應該使用幾個小的網孔,從而使得焊錫分小
方塊狀覆蓋焊盤。
? 焊錫小塊之間的距離對形成焊錫空洞與否起著決定作用。相對大的距離會容許回流焊中焊錫里的揮發物
有效溢出,從而降低焊錫空洞的概率。
? 合理范圍內,焊錫量越少,越會抑制焊錫空洞和多余焊錫球的形成。建議如下: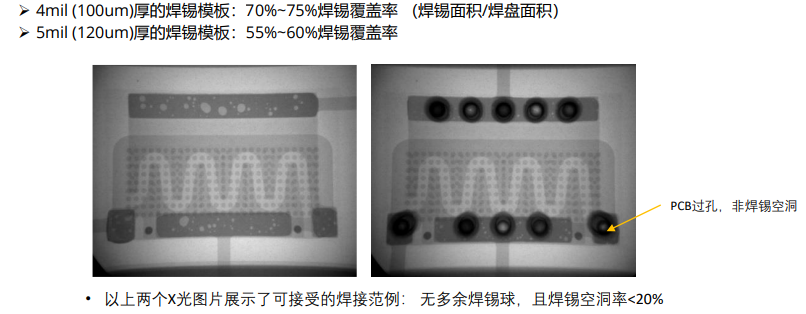
詳細文檔免費下載:GaNPX?和PDFN封裝器件的焊接建議
*附件:GaNPX?和PDFN封裝器件的焊接建議.pdf
GaNPX?和PDFN封裝器件的焊接建議總結
一、簡介
本文檔提供了GaN Systems的GaNPX?和PDFN封裝下E-HEMT器件焊接到PCB的詳細建議,涵蓋焊錫模板設計、焊錫與助焊劑選擇、回流焊溫度曲線以及手工焊接和拆焊方法。
二、焊錫模板設計
- ?避免大網孔?:設計焊錫模板時,避免使用大的網孔覆蓋整個焊盤,建議采用多個小網孔,使焊錫分小方塊狀覆蓋焊盤。
- ?焊錫小塊距離?:焊錫小塊之間的距離對減少焊錫空洞至關重要,較大的距離有助于焊錫中的揮發物溢出。
- ?焊錫覆蓋率?:建議4mil(100um)厚的焊錫模板使用70%~75%焊錫覆蓋率,5mil(120um)厚的焊錫模板使用55%~60%焊錫覆蓋率。
三、焊錫與助焊劑
- ?焊錫選擇?:推薦使用空洞率低、揮發性低的焊錫,如Indium 6.4 water soluble SAC 305。
- ?助焊劑殘留?:GaNPX?封裝器件焊接后需保持清潔,助焊劑殘留可能導致漏電,影響電性測試。高溫或高濕度環境下,即使使用免洗焊錫也建議清洗。
- ?助焊劑類型?:避免使用活性或酸性助焊劑,以防腐蝕影響焊點可靠性。
- ?布線建議?:建議在布線時避免在GaNPX? Top Cooled(頂部散熱)封裝器件下方布高壓電路,以防短路。
四、回流焊溫度曲線
- ?推薦溫度曲線?:提供了詳細的回流焊溫度曲線,確保焊錫空洞率<20%,并保證較長時間的高溫浸泡,以揮發助焊劑和焊錫中的水汽。
五、手工焊接與拆焊
- ?手工焊接步驟?:
- 將熱電偶貼到器件表面監控溫度。
- 在PCB焊盤上涂焊錫和助焊劑(如焊盤已鋪錫并含助焊劑,可省略此步)。
- 對準并放置器件。
- 預熱PCB至100-120°C,用熱風槍吹器件表面至260-280°C,保持20-30秒。
- 撤掉熱風槍和按壓力,待器件冷卻后清洗多余助焊劑。
- ?拆焊步驟?:
- 預熱PCB至100-120°C。
- 用熱風槍吹器件表面至260-280°C,待器件松動后用鑷子取下。
通過以上詳細的焊接建議,可以確保GaNPX?和PDFN封裝器件在焊接過程中獲得最佳的焊接質量和可靠性。
-
GaN
+關注
關注
19文章
2190瀏覽量
76459 -
PCB焊接
+關注
關注
0文章
16瀏覽量
8128
發布評論請先 登錄

[原創]專業經營電子元器件(以集成電路為主)
焊接技術-貼片元器件(密引腳IC)焊接教程
PCB LAYOUT(1):元器件布局與焊接工藝
從官網下載的元器件封裝可以直接用嗎?
請問器件封裝焊接工藝邊緣有損壞對器件有什么影響嗎?
VS2508AE -20V -55A P管 PDFN3*3封裝 MOS管 場效應管
新潔能車規級PDFN 5x6雙面散熱功率器件介紹
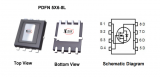
GaNPX?和PDFN封裝器件的熱設計
基于RC熱阻SPICE模型的GaNPX?和PDFN封裝的熱特性建模

實測案例:如何用推拉力測試機進行SMT元器件焊接強度測試?






 GaNPX?和PDFN封裝器件的焊接專業經驗
GaNPX?和PDFN封裝器件的焊接專業經驗












評論