早期的翻蓋手機功能雖然簡單,僅能實現(xiàn)撥打電話,但在當時已然代表了一項重要的技術突破。如今,這種對技術的期待并未消退,反而愈發(fā)強烈——人們期待手機具有更強大的功能組合:更高分辨率的屏幕、更長的電池壽命、更快的處理速度,尤其是更小的外形尺寸。
擁有這樣想法的人不在少數(shù)。無論是手機、耳機、智能手表,還是日常家電如吹風機,消費者都期望它們在功能和尺寸上不斷優(yōu)化。如果成本、尺寸或功能沒有改進,大多數(shù)消費者就不太可能購置已擁有產品的升級款。
縮小體積,增強功能的趨勢也影響了嵌入式系統(tǒng)設計人員,他們專注于提高系統(tǒng)功能和性能,同時降低整體系統(tǒng)尺寸和成本。
為了幫助嵌入式系統(tǒng)設計人員,包括TI 在內的半導體制造商正在開發(fā)功能豐富、體積更小的微控制器 (MCU)和嵌入式處理器。這些器件采用經過優(yōu)化的封裝,在印刷電路板 (PCB) 上占用的空間更小,從而能夠為更多元件和更大電池提供更多空間,以延長使用壽命。在封裝內部,這些器件的設計也在不斷發(fā)展,集成了大量模擬元件以擴展功能,同時減少對分立式元件的需求。
本文將探討封裝和模擬元件集成如何在保障嵌入式處理器功能的情況下幫助減小其尺寸,以及優(yōu)化封裝對制造工藝的影響。
封裝
封裝創(chuàng)新是半導體領域少數(shù)肉眼可見的改進之一。為了幫助減小封裝尺寸,半導體制造商將傳統(tǒng)引線選項改為先進的封裝選項,以此去除不必要的塑料外殼和引線。這些封裝選項的尺寸與芯片尺寸直接相關,可以減少實現(xiàn)預期功能所需的面積。
TI 在其嵌入式處理產品系列中提供了多種微型封裝:
四方扁平無引線封裝 (QFN)QFN 封裝不使用傳統(tǒng)的引線,而是由塑料外殼邊緣周圍的扁平觸點和底部的裸露導熱墊組成,以提高導熱性能。圖 1 顯示了 MSPM0C1104 的封裝圖,這是一款 20 引腳微控制器,尺寸僅為9mm2。
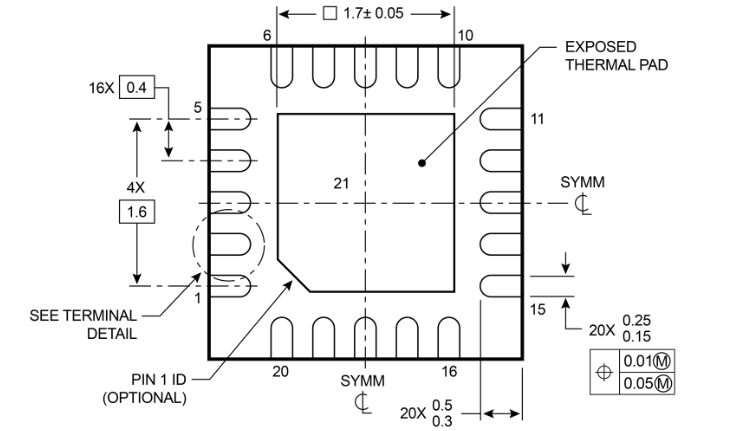
圖 1:采用 20 引腳 0.8mm QFN 封裝的 MSPM0C1104 圖紙
晶圓芯片級封裝 (WCSP)與其他封裝類型相比,這些封裝的外形尺寸更小。焊球陣列直接連接到硅片,使封裝尺寸等于硅片尺寸(請參見圖 2)。這一封裝在1.38mm2的空間內裝入了 8 個焊球,使每平方毫米區(qū)域集成更多功能。此外、MSPM0C1104 還采用比同類器件小 38% 的 WCSP 封裝,使其成為全球超小型 MCU。
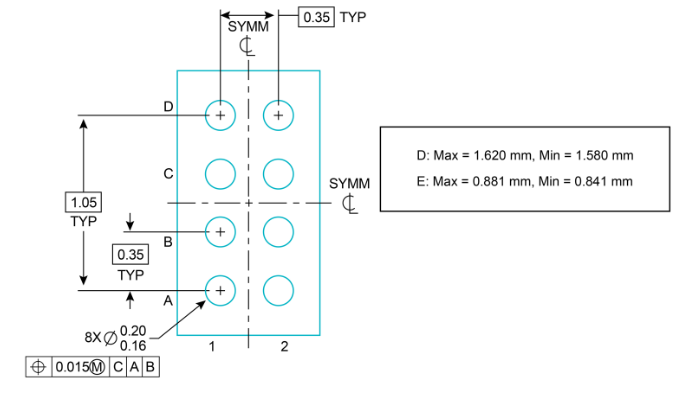
圖 2:MSPM0C1104 八球 WCSP 封裝圖紙(標稱值為 1.50 x 0.86mm,厚度為 0.35mm)
集成
解決電路板空間有限問題的另一種方法是優(yōu)化設備中的功能集成。每個元件都有自己的塑料封裝、引線和所需的布局空間,與具有集成功能的單個芯片相比,它們會占用更多的電路板空間。
在推動小型化的過程中,集成模擬和數(shù)字外設的 MCU 和處理器將發(fā)揮重要作用。以脈動式血氧計為例。與 圖 3 所示的離散設計方法相比,將模數(shù)轉換器 (ADC)、比較器和電壓基準集成到 MCU 中可以減少所需元件的數(shù)量,從而縮小 PCB 尺寸,如圖 4 所示。
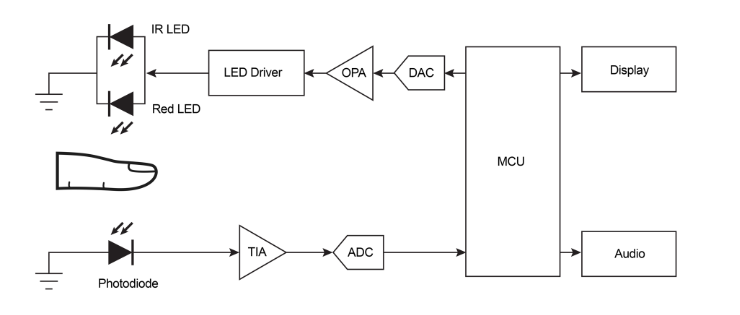
圖 3:采用分立式模擬元件的脈動式血氧計設計
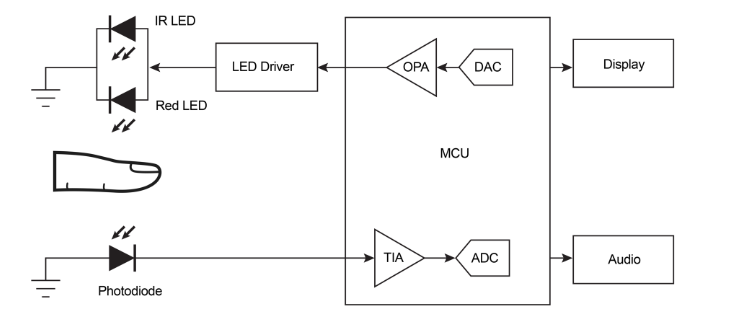
圖 4:采用集成元件的脈動式血氧計設計
選擇在 MCU 中集成哪些功能需要做出一些權衡。功能集成可以減少設計中的元件數(shù)量,但包含不必要的功能可能會違背意圖并增加單芯片解決方案的尺寸。
這就是功能優(yōu)化如此重要的原因。添加的外設與裸片尺寸和器件成本直接相關。未利用的功能可能會浪費空間和金錢,并降低空間受限設計的效率。了解市場的真實需求可打造出具有成本和尺寸優(yōu)勢的嵌入式解決方案。例如,8 焊球 MSPM0C1104 WCSP不僅體積小巧,而且具有眾多集成功能和元件。它采用 1.38 mm2 封裝,搭載 16KB 的閃存存儲器,具有三通道的 12 位 ADC 和三個計時器。通過使用 MSPM0C1104 等器件來優(yōu)化每平方毫米的功能數(shù)量,工程師可以在設計中提升空間利用效率。

圖 5:MSPM0C1104 與無線耳機之間的尺寸對比
隨著物理集成電路變得越來越小,設計和生產方法也在不斷發(fā)展。雖然采用更小的電氣元件有助于充分減小 PCB 尺寸,但還需要考慮布局、處理和生產流程。
采用芯片級封裝進行設計時,有兩種類型的 PCB 焊盤圖案十分有用:阻焊層限定 (SMD)和非阻焊層限定 (NSMD),如圖 6 所示。SMD 類型包含與基板重疊的較大銅焊盤,而 NSMD 類型包含較小且更具精度的銅焊盤。NSMD 類型焊盤可在芯片級封裝中提供更高的均勻覆蓋能力、更好的布線性能和更低的應力。

圖 6:NSMD 和 SMD PCB 焊盤圖案
元件放置和處理可能也并非易事。對于半導體和產品制造商而言,制造過程中使用的拾取和放置機器以及真空筆可充分降低損壞 WCSP 和 BGA 封裝裸片的風險。為了提高放置精度,拾取和放置機器中的視覺系統(tǒng)可以定位封裝輪廓或單個凸點。焊錫凸點幾何形狀可實現(xiàn) PCB 焊盤的自定心和校正。隨著電氣元件尺寸的減小,制造機械也在不斷發(fā)展以適應變化。
結語
創(chuàng)新是一個循環(huán)的過程。消費者一直期待功能豐富的輕量級產品。工程師們正在進行設計以平衡利益沖突。半導體行業(yè)正在不斷發(fā)展,以優(yōu)化封裝和功能選項。在當前一代產品上市后,團隊就會開會來集思廣益,以尋找下一個最佳產品,然后這個重復這一循環(huán)。
TI在半導體小型化方面所做的努力包括選擇性功能集成、封裝優(yōu)化和制造工藝進步,為工程師在微型世界中設計產品提供更多選擇和可能性。
-
mcu
+關注
關注
146文章
17893瀏覽量
361858 -
嵌入式
+關注
關注
5144文章
19575瀏覽量
315787 -
德州儀器
+關注
關注
123文章
1786瀏覽量
142122 -
封裝
+關注
關注
128文章
8598瀏覽量
144991
原文標題:技術干貨 | 超小卻強大:MCU 的小尺寸封裝和集成如何幫助優(yōu)化空間受限的設計
文章出處:【微信號:tisemi,微信公眾號:德州儀器】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
德州儀器推出全球超小型 MCU

《電子發(fā)燒友電子設計周報》聚焦硬科技領域核心價值 第4期:2025.03.17--2025.03.21
德州儀器CC2640無線MCU應用方向,與集成電路ESD放電警告!
德州儀器CC2640無線MCU應用方向,與集成電路ESD放電警告!
基于德州儀器GaN產品實現(xiàn)更高功率密度
德州儀器(TI)
德州儀器推出新款步進電機驅動器DRV8818
德州儀器WEBENCH PCB導出 快速創(chuàng)建電源電路板布局

德州儀器推出業(yè)內最小的降壓電源模塊縮小電路板空間達58%
德州儀器裁撤中國區(qū)MCU團隊 原MCU產品線遷往印度
突發(fā),德州儀器被證實已裁撤中國MCU團隊!
德州儀器推出電源模塊全新磁性封裝技術






 德州儀器MCU的小尺寸封裝和集成如何解決電路板空間有限問題
德州儀器MCU的小尺寸封裝和集成如何解決電路板空間有限問題











評論