使用反向并聯的肖特基勢壘二極管(SBD)可以提高碳化硅MOSFET在電力轉換應用中的性能和可靠性。本文將展示兩家SiC器件制造商在集成SBD與MOSFET為單芯片解決方案方面所取得的進展。
SiC肖特基二極管
SiC肖特基二極管相較于標準的硅p/n二極管提供了許多優勢。一個關鍵優勢是缺乏反向恢復損失,這種損失在p/n二極管中尤為顯著,特別是在高溫、快速切換和高電流應用中。除了增加的切換損失之外,反向恢復還會因為結中存在多余的少數載流子而導致電壓過沖,這對雜散電感和電磁干擾(EMI)濾波造成限制。
這些二極管的結構基本上是一個輕摻雜的n–層位于一個重摻雜的n+層之上。施加在n–層上的陽極金屬接觸用于形成肖特基結,典型的開啟正向電壓降約為1伏。商業上可獲得的SiC肖特基二極管的電壓等級高達3.3千伏,可以成為高壓電力轉換應用中硅IGBT充電二極管的首選。
SiC MOSFET的體二極管在典型情況下開啟電壓超過2.5伏,多個制造商的數據表列出了在額定的第三象限電流下正向電壓降接近4伏。這種高電壓降直接導致在自由輪回操作期間的導通損失增加。此外,雖然SiC MOSFET的體二極管得益于較小的載流子壽命,因而相較于硅p/n二極管具有更低的反向恢復電荷,但這些反向恢復損失在高溫快速切換操作下可能占總切換損失的顯著部分。
存在于SiC基片和外延層中的基面缺陷可能導致體二極管導通時出現堆垛缺陷。這可能隨著時間的推移降低二極管的性能,最終導致器件失效。這一潛在的可靠性失效機制在厚外延層的高壓器件中可能會被放大。
SiC MOSFET的體二極管開啟時具有負溫度系數,即在高溫下導通更強。這可能對第三象限導通下的并行操作產生限制,因為熱失控的風險更高。
使用反向并聯的SiC肖特基二極管克服了上述SiC MOSFET體二極管的限制。其使用的好處通常體現在導通和切換損失的減少。由于SBD的低開啟電壓,死區時間控制也可以更優化、更容易地完成,而開啟導通的正溫度系數使其更容易并聯。切換損失的改善伴隨著警告,在某些條件下,SBD的附加非線性電容實際上可能增加切換損失,尤其是在輕負載條件下。
在使用SiC MOSFET的轉換器中,反向并聯SBD的一個主要限制是這些器件的突發電流能力較低。這是由于這些單極器件的差動導通電阻顯著較高。相比之下,體二極管中的導電調制導致在高電流下的差動電阻較低。這種效應在高溫下可能被放大。雖然使用與SBD結合的p/n結(例如在合并的PiN肖特基二極管中)可以緩解這個問題,但額外的芯片、封裝和組裝成本則是另一個缺點。
接下來,我們將討論兩家SiC制造商提出的集成MOSFET/SBD器件的解決方案,以應對上述限制。
集成MOSFET/SBD
東京電子(Toshiba)最近宣布正在進行帶有嵌入式SBD的1200V SiC MOSFET的芯片采樣。新的X5M007E120器件針對的是電動汽車牽引逆變器應用。該器件在25°C時的典型導通電阻為7.2毫歐。在175°C、50A電流下,由于SBD的存在,第三象限電壓降僅為1.40V。可用于容納SBD的寶貴MOSFET通道面積可能會降低器件的特定導通電阻指標(RDS(on) × 芯片面積)。通過將SBD以交錯模式排列,該指標改善了20%至30%。該模式如圖1所示。
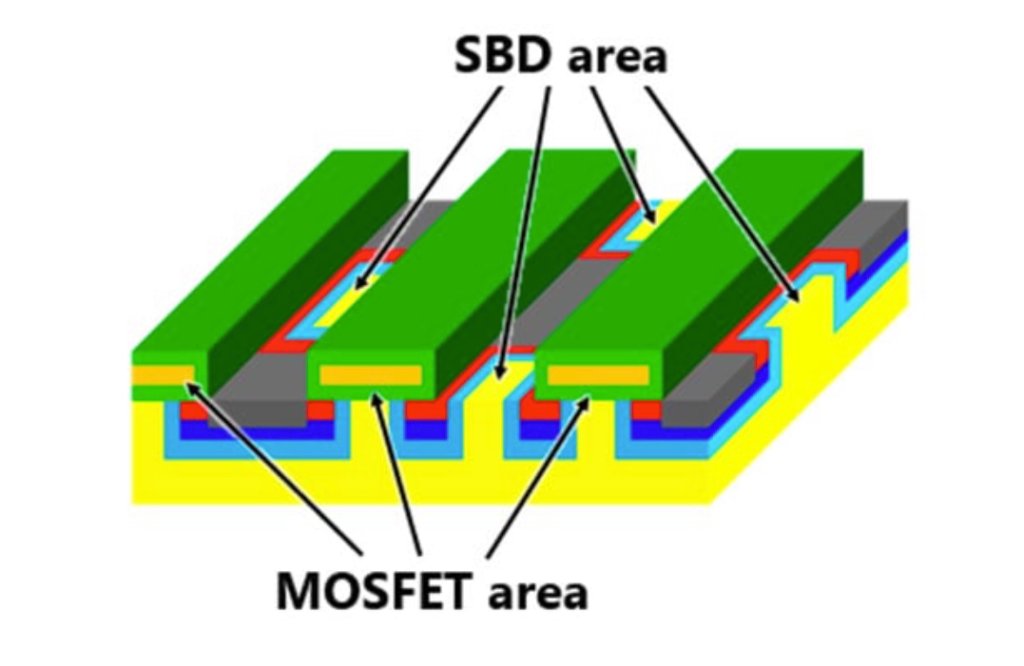 圖1
圖1這種交錯模式的通道密度提高允許在MOSFET內部嵌入的SBD中達到約兩倍于條紋版本的單極反向電流密度。如圖2所示,所實現的特定電阻為0.27Ω-mm2,甚至在標準的1200V(即非嵌入SBD的)平面SiC MOSFET中也是一個具有競爭力的數字。
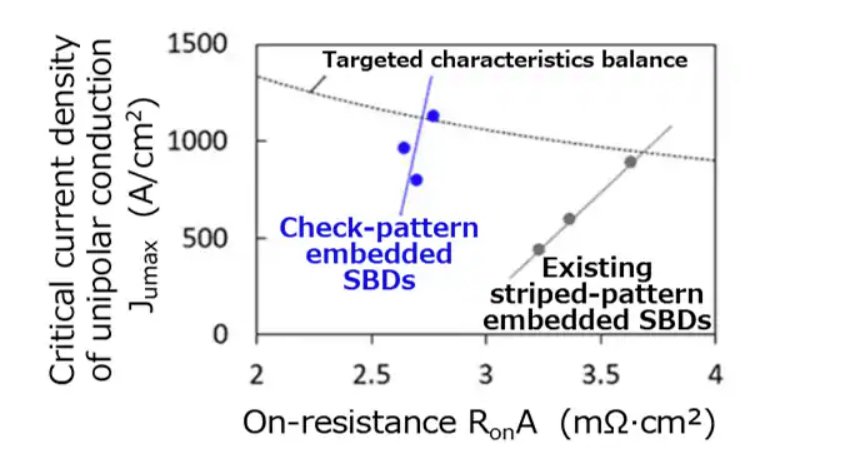 圖2
圖2短路耐受能力是驅動電動機的電力電子的關鍵指標。硅IGBT具有非常強的短路耐受時間(SCWT),在10微秒范圍內。SiC MOSFET在過去幾年已經在SCWT方面取得了許多改進。東京電子采用了深p井結構來改善這一指標。SCWT與器件的特定導通電阻成反比,低阻抗結構可能需要快速感應以在活躍功率器件的短SCWT時間之前觸發柵極驅動器。如圖3所示,使用深p井屏障改善了這一權衡。
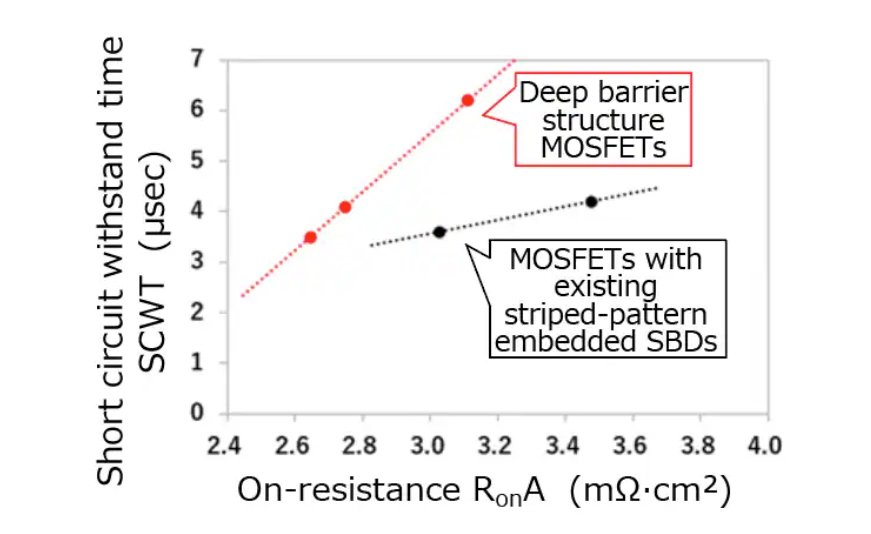 圖3
圖3現在讓我們來看一下在嵌入式SiC SBD-MOSFET器件中的突發行為的改善。2023年,三菱電機公司宣布了一款3.3 kV/800 A的SiC半橋功率模塊FMF800DC-66 BEW。今年還推出了400 A和200 A版本。Unifull系列產品包括嵌入式SBD器件,以提高性能。這些模塊針對大型工業設備、鐵路牽引系統、電力生產和分配基礎設施等。對這些模塊的一個關鍵改進是即使在存在SBD結構的情況下也能處理突發電流。
在一個含有SBD的并聯芯片連接模塊中,制造過程中的輕微尺寸變化可能導致突發電流集中在特定芯片上。這些小變化在制造過程中是不可避免的。例如,如果圍繞SBD n–陽極層的p層寬度在一個芯片上稍大于其他芯片,可能導致p/n體二極管的突發電流優先發生在該芯片上。這可能造成熱失控并損壞該特定芯片,從而影響整個模塊。三菱實施的一個解決方案是從每個芯片內的單元格中移除SBD。這個單元格可以占據總芯片的非常小的百分比——例如1%。因此,對整體第三象限SBD導通的影響并不大。每個芯片上的這個特定單元格允許優先的突發起始電流在所有芯片的位置同時發生。由于突發的開始減少了周圍SiC單元格的電阻(載流子擴散降低了漂移電阻,而更高的溫度導致p/n二極管導通的負溫度系數),它也觸發了這些相鄰單元格的突發,形成了連鎖反應。
新的芯片結構使突發能力比標準SiC嵌入結構提高了5倍,達到了傳統硅功率模塊所獲得的水平。
-
MOSFET
+關注
關注
150文章
8384瀏覽量
219070 -
SiC
+關注
關注
31文章
3187瀏覽量
64597 -
肖特基勢壘二極管
+關注
關注
0文章
34瀏覽量
9442
發布評論請先 登錄
肖特基勢壘二極管的特征
SiC肖特基勢壘二極管更新換代步履不停
淺析肖特基勢壘二極管
肖特基勢壘二極管的特點
碳化硅SiC MOSFET:低導通電阻和高可靠性的肖特基勢壘二極管
肖特基勢壘二極管,肖特基勢壘二極管是什么意思
什么是肖特基勢壘二極管
SiC肖特基勢壘二極管和Si肖特基勢壘二極管的比較
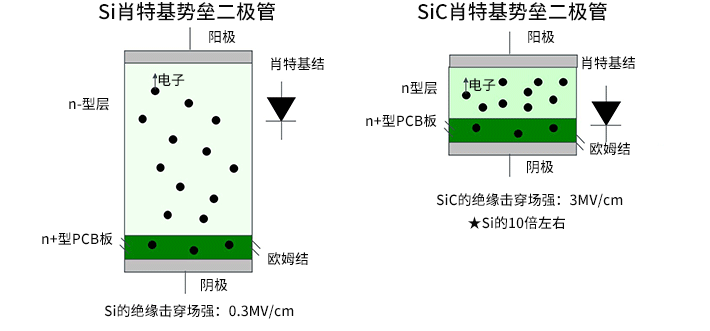
SiC產品和Si產品的兩點比較 SiC肖特基勢壘二極管的特征
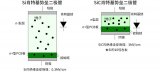





 SiC MOSFET與肖特基勢壘二極管的完美結合,提升電力轉換性能
SiC MOSFET與肖特基勢壘二極管的完美結合,提升電力轉換性能

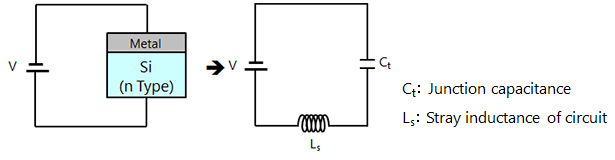










評論