引言
通信、雷達(dá)和微波測(cè)量等領(lǐng)域電子信息裝備迅速發(fā)展, 對(duì)射頻系統(tǒng)提出了微型化、集成化和多樣化等迫切需求。先進(jìn)封裝技術(shù)可以將不同材料、不同工藝和不同功能的器件進(jìn)行異質(zhì)集成, 極大提升了電子產(chǎn)品的功能、集成度和可靠性等方面, 成為推動(dòng)射頻系統(tǒng)發(fā)展的關(guān)鍵引擎。
本文轉(zhuǎn)發(fā)中國(guó)電子科技集團(tuán)公司第十研究所吳磊博士發(fā)表在《電子元件與材料》上的“射頻系統(tǒng)先進(jìn)封裝技術(shù)研究進(jìn)展”一文,概述了芯片倒裝、扇出封裝、2.5D 封裝和三維堆疊這四種先進(jìn)封裝互聯(lián)技術(shù)在射頻系統(tǒng)封裝中的最新研究進(jìn)展, 并從結(jié)構(gòu)集成度、工藝實(shí)現(xiàn)性和信號(hào)傳輸?shù)冉嵌葘?duì)不同封裝結(jié)構(gòu)進(jìn)行了剖析。最后, 分析了當(dāng)前射頻系統(tǒng)先進(jìn)封裝技術(shù)發(fā)展所面臨的挑戰(zhàn), 并從協(xié)同設(shè)計(jì)、高效散熱和新封裝技術(shù)等方面探討了未來(lái)的發(fā)展方向。
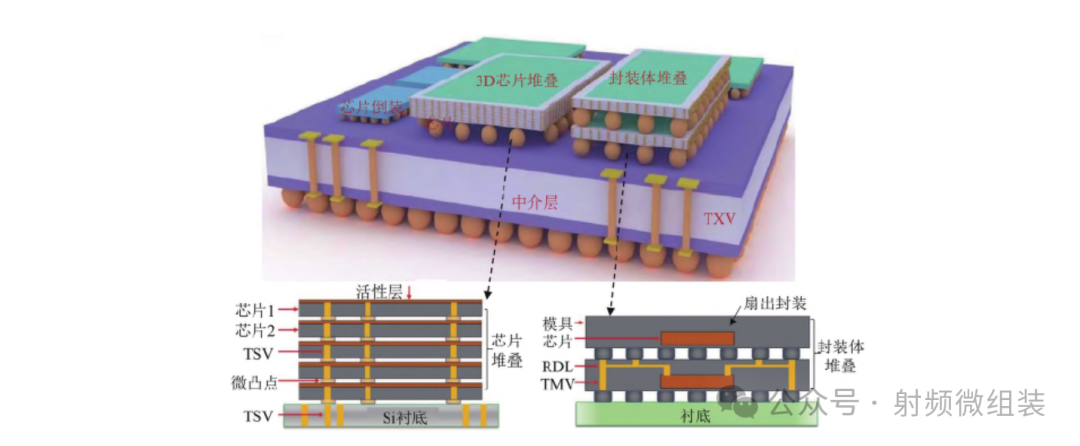
先進(jìn)封裝之倒裝封裝
倒裝封裝是將正面帶有微凸點(diǎn)的芯片朝下組裝到基板焊盤上。倒裝封裝的優(yōu)勢(shì)是短的互聯(lián)距離減小了寄生電感、電容和電阻, 顯著提升了封裝系統(tǒng)的電氣性能。此外, 由于倒裝封裝過程沒有進(jìn)行塑封, 可以確保芯片有效散熱。
倒裝封裝包括熱超聲、回流焊和熱壓三種鍵合工藝, 其凸點(diǎn)分別使用金球、錫球和銅柱。熱超聲鍵合是在超聲鍵合力和溫度的共同作用下, 將金凸點(diǎn)組裝在基板焊盤上, 其適用于I/O密度較小的芯片, 如聲表面波濾波器。回流焊是目前主流的倒裝鍵合工藝, 其是在錫凸點(diǎn)表面涂覆助焊劑, 再通過熱回流進(jìn)行焊接。熱壓工藝采用高深寬比、小尺寸銅柱凸點(diǎn), 能夠?qū)崿F(xiàn)高密度互聯(lián), 適用于I/O密度較大的芯片。
文中舉例國(guó)外的Kimura 等提出了一種低剖面相控陣?yán)走_(dá)的T/R 組件, 其中的射頻芯片, 如低噪聲放大器(GaAs)、核心芯片(SiGe)和功率放大器/ 射頻開關(guān)(GaN), 均采用倒裝技術(shù)與封裝載板上的金凸點(diǎn)集成互聯(lián)(如圖(b)), 但是在該組件量產(chǎn)時(shí)會(huì)采用銅凸點(diǎn)以提高生產(chǎn)力。性能測(cè)試表明,該TR 組件發(fā)射功率達(dá)到20 W, 并且在X 波段的噪聲系數(shù)低至2.8dB。該研究提出的多芯片倒裝技術(shù)所封裝的TR 組件將有利于實(shí)現(xiàn)高性能、低剖面和高緊湊的相控陣?yán)走_(dá), 因此有望在射頻系統(tǒng)封裝領(lǐng)域得到廣泛應(yīng)用。
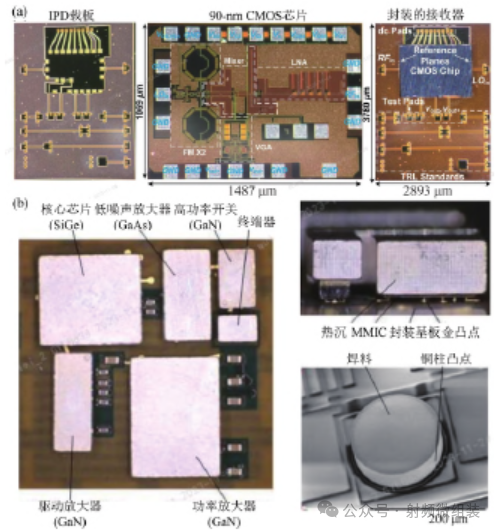
先進(jìn)封裝之扇出封裝
扇出封裝是將芯片嵌入到環(huán)氧模塑料中, 并通過再布線層(RDL)對(duì)焊點(diǎn)重新進(jìn)行分配, 再裝配到基板焊盤上。該技術(shù)可以實(shí)現(xiàn)高密度引腳集成, 進(jìn)而提高封裝系統(tǒng)數(shù)據(jù)交互和存儲(chǔ)能力, 并且短的互聯(lián)距離保證了其優(yōu)異的電氣性能 。此外,層RDL 有助于解決芯片散熱問題。
文中提到較多扇出封裝在天線、射頻模塊上的研究,請(qǐng)閱讀下方原文。
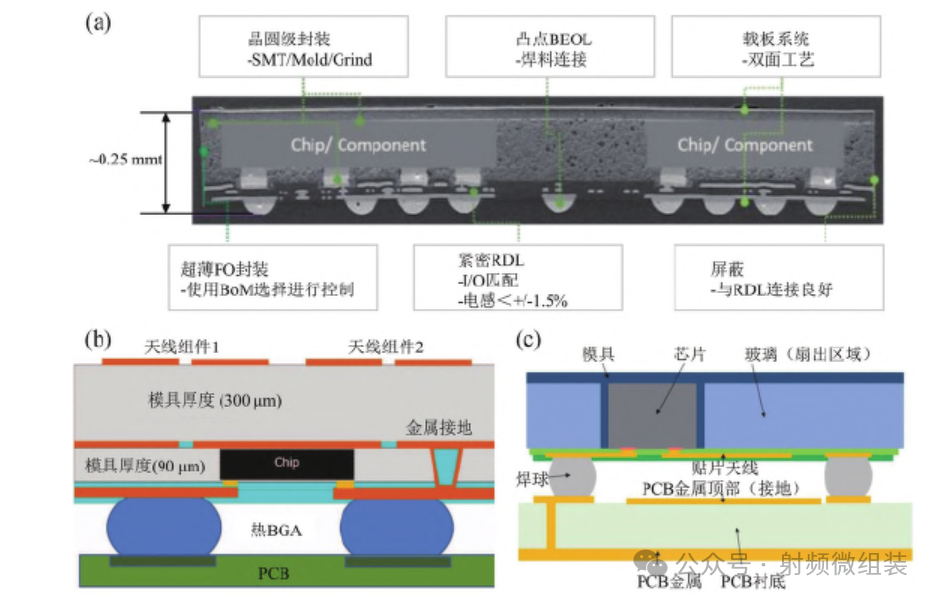
先進(jìn)封裝之2.5D封裝
2.5D 封裝是指把不同材料、工藝和功能的器件連接到由RDL 和通孔兩部分組成的中介層上, 并通過RDL 實(shí)現(xiàn)不同器件之間信號(hào)的互聯(lián)。2.5D 封裝方案適用于芯片引腳密度大的情況。中介層的材料主要有硅、玻璃和有機(jī)材料三種。
硅中介層在高頻條件下信號(hào)串?dāng)_和損耗較大,玻璃中介層具有高頻電學(xué)性能優(yōu)異、成本低和機(jī)械穩(wěn)定性強(qiáng)等優(yōu)點(diǎn), 在射頻系統(tǒng)封裝領(lǐng)域極具應(yīng)用前景。
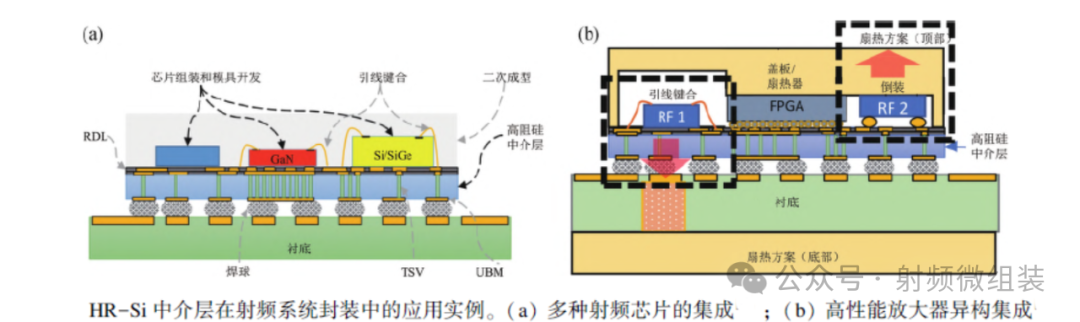
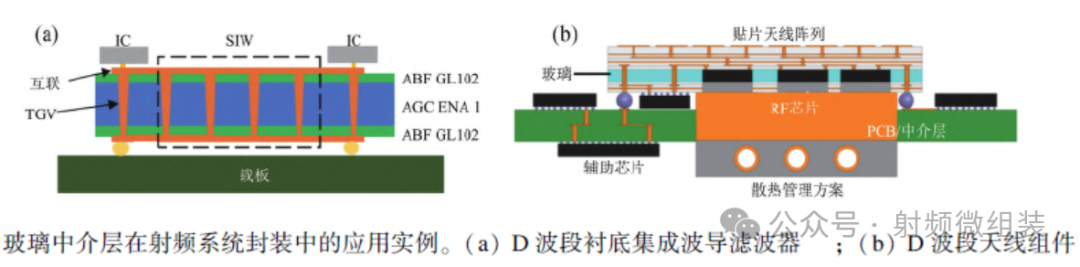
先進(jìn)封裝之三維堆疊封裝
三維堆疊封裝是將多個(gè)芯片/ 晶圓/ 封裝體在垂直方向上堆疊鍵合, 進(jìn)而實(shí)現(xiàn)高速信號(hào)傳輸?shù)囊环N互聯(lián)技術(shù)。其具有超高帶寬、短的互聯(lián)距離、低功耗、高集成和高傳輸速率等優(yōu)點(diǎn)。三維堆疊鍵合主要有三種技術(shù)形式:引線鍵合堆疊、封裝體堆疊(PoP)和芯片堆疊(3D-IC) 。
鍵合引線會(huì)影響射頻系統(tǒng)傳輸線的阻抗匹配, 并且會(huì)產(chǎn)生寄生電容和寄生電感, 因而較少應(yīng)用于射頻系統(tǒng)的封裝。文中舉了較多堆疊封裝的案例,請(qǐng)大家閱讀下方原文。
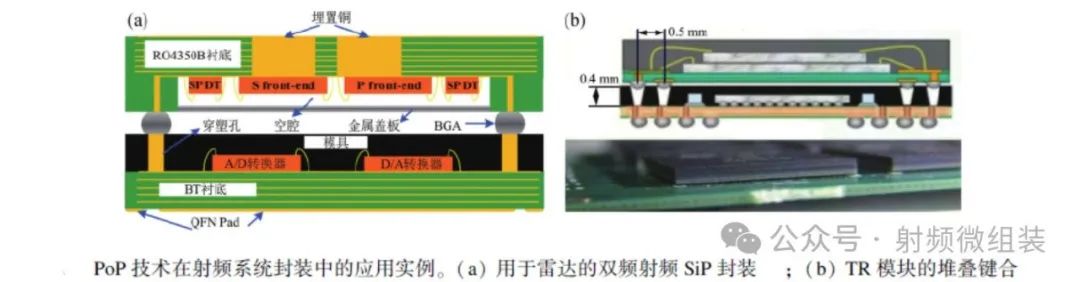
芯片堆疊技術(shù)是采用晶圓上的通孔作為互聯(lián)通道,將多個(gè)芯片在垂直方向上進(jìn)行堆疊鍵合, 其相對(duì)引線鍵合堆疊具有更短的互聯(lián)距離和更高的互聯(lián)密度。廖龍忠等通過面對(duì)背的方式實(shí)現(xiàn)了高成品率GaAs 微波電路的3D 集成,制備的Ka 波段幅相多功能芯片在32~38 GHz 頻段內(nèi)的接收端和發(fā)射端增益分別優(yōu)于21.5dB 和23dB。
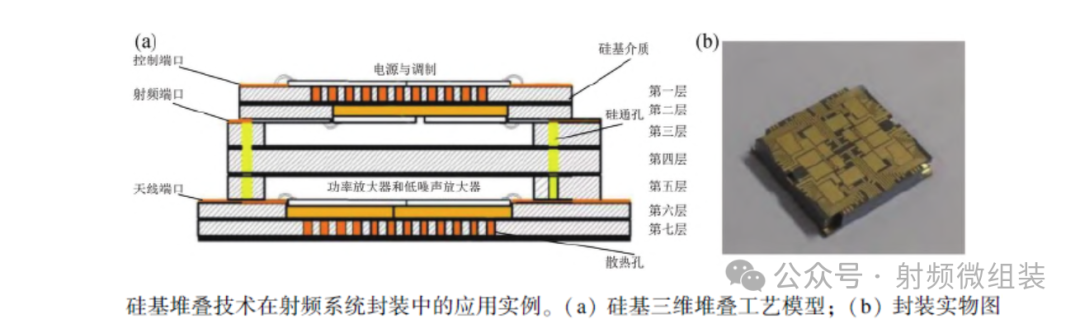
先進(jìn)封裝面臨的挑戰(zhàn)及發(fā)展方向
芯片-封裝-系統(tǒng)的協(xié)同優(yōu)化設(shè)計(jì)勢(shì)在必行。
SoC 技術(shù)的集成度已接近極限,Chiplet 技術(shù)有望實(shí)現(xiàn)集成度更高的射頻芯片, 其是將射頻芯片按需求分成較小的裸片(Die), 并選擇最優(yōu)的工藝制程進(jìn)行制造, 再利用先進(jìn)封裝技術(shù)將這些小的裸片封裝互聯(lián)在一起, 從而形成一個(gè)異構(gòu)集成的芯片。
銅柱凸塊技術(shù)可以有效解決焊點(diǎn)節(jié)距受限問題,有望在射頻系統(tǒng)封裝過程中得到廣泛應(yīng)用。
混合鍵合有望成為未來(lái)高性能射頻系統(tǒng)的關(guān)鍵封裝技術(shù)。
3D堆疊技術(shù)面臨散熱問題。
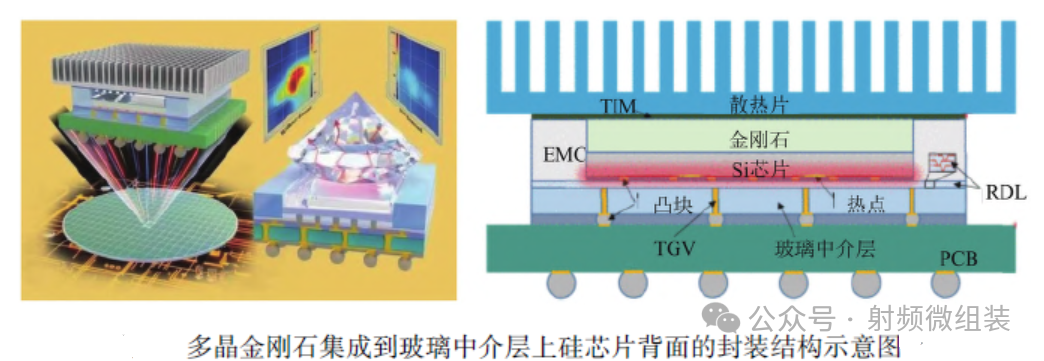
-
封裝技術(shù)
+關(guān)注
關(guān)注
12文章
578瀏覽量
68567 -
射頻系統(tǒng)
+關(guān)注
關(guān)注
0文章
125瀏覽量
13548 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
472瀏覽量
612
原文標(biāo)題:射頻系統(tǒng)先進(jìn)封裝技術(shù)研究進(jìn)展
文章出處:【微信號(hào):深圳市賽姆烯金科技有限公司,微信公眾號(hào):深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
先進(jìn)封裝RDL-first工藝研究進(jìn)展

新型銅互連方法—電化學(xué)機(jī)械拋光技術(shù)研究進(jìn)展
薄膜鋰電池的研究進(jìn)展
傳感器EMC的重要性與研究進(jìn)展
太赫茲量子級(jí)聯(lián)激光器等THz源的工作原理及其研究進(jìn)展
先進(jìn)的集成微型傳感器的研究進(jìn)展
中藥提取技術(shù)的研究進(jìn)展
廢舊鎳氫電池回收處理技術(shù)研究進(jìn)展
農(nóng)業(yè)機(jī)械自動(dòng)導(dǎo)航技術(shù)研究進(jìn)展

先進(jìn)封裝中銅-銅低溫鍵合技術(shù)研究進(jìn)展

量子計(jì)算關(guān)鍵技術(shù)研究進(jìn)展

先進(jìn)激光雷達(dá)探測(cè)技術(shù)研究進(jìn)展

先進(jìn)封裝中銅-銅低溫鍵合技術(shù)研究進(jìn)展






 射頻系統(tǒng)先進(jìn)封裝技術(shù)研究進(jìn)展
射頻系統(tǒng)先進(jìn)封裝技術(shù)研究進(jìn)展












評(píng)論