聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點(diǎn)僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報(bào)投訴
-
封裝
+關(guān)注
關(guān)注
127文章
8011瀏覽量
143465 -
電鍍
+關(guān)注
關(guān)注
16文章
459瀏覽量
24241 -
TSV
+關(guān)注
關(guān)注
4文章
115瀏覽量
81578 -
硅通孔
+關(guān)注
關(guān)注
2文章
24瀏覽量
11881 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
430瀏覽量
287
原文標(biāo)題:先進(jìn)封裝中硅通孔(TSV)銅互連電鍍研究進(jìn)展
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
一文詳解硅通孔技術(shù)(TSV)
硅通孔技術(shù)(TSV,Through Silicon Via)是通過在芯片和芯片之間、晶圓和晶圓之間制作垂直導(dǎo)通,實(shí)現(xiàn)芯片之間互連的技術(shù),是2.5D/3D

新型銅互連方法—電化學(xué)機(jī)械拋光技術(shù)研究進(jìn)展
新型銅互連方法—電化學(xué)機(jī)械拋光技術(shù)研究進(jìn)展多孔低介電常數(shù)的介質(zhì)引入硅半導(dǎo)體器件給傳統(tǒng)的化學(xué)機(jī)械拋光(CMP)技術(shù)帶來了巨大的挑戰(zhàn),低k 介質(zhì)的脆弱性難以承受傳統(tǒng)CMP 技術(shù)所施加的機(jī)械
發(fā)表于 10-06 10:08
硅通孔(TSV)電鍍
硅通孔(TSV)電鍍的高可靠性是高密度集成電路封裝應(yīng)用中的一個(gè)有吸引力的熱點(diǎn)。本文介紹了通過優(yōu)化
發(fā)表于 01-09 10:19
銅電車線材料的研究進(jìn)展
對目前銅電車線材料的研究進(jìn)展做了述評,并闡述了用定向凝固方法制備高度強(qiáng)度高導(dǎo)電率銅車線的可行性,同時(shí)報(bào)道了記者近期在這方面的一些研究結(jié)果。
發(fā)表于 07-06 13:37
?22次下載
中孔分子篩研究進(jìn)展
綜述了中孔分子篩在合成和應(yīng)用等方面的最新研究進(jìn)展。歸納了不同中孔分子篩合成體系,比較各自的優(yōu)缺點(diǎn),指出不同體系
發(fā)表于 12-10 11:25
?4次下載
3D IC集成與硅通孔TSV互連
重點(diǎn)討論了垂直互連的硅通孔(TSV)互連工藝的關(guān)鍵技術(shù)及其加工設(shè)備面臨的挑戰(zhàn).提出了工藝和設(shè)備開發(fā)商的應(yīng)對措施并探討了3DTSV
發(fā)表于 12-07 10:59
?89次下載

詳解TSV(硅通孔技術(shù))封裝技術(shù)
硅通孔技術(shù)(Through Silicon Via, TSV)技術(shù)是一項(xiàng)高密度封裝技術(shù),正在逐漸取代目前工藝比較成熟的引線鍵合技術(shù),被認(rèn)為是第四代封
發(fā)表于 10-12 18:30
?1.7w次閱讀

什么是TSV封裝?TSV封裝有哪些應(yīng)用領(lǐng)域?
硅通孔技術(shù)(Through Silicon Via, TSV)技術(shù)是一項(xiàng)高密度封裝技術(shù),正在逐漸取代目前工藝比較成熟的引線鍵合技術(shù),被認(rèn)為是第四代封
發(fā)表于 08-14 15:39
?9.1w次閱讀
硅通孔TSV-Through-Silicon Via
編者注:TSV是通過在芯片與芯片之間、晶圓和晶圓之間制作垂直導(dǎo)通;TSV技術(shù)通過銅、鎢、多晶硅等導(dǎo)電物質(zhì)的填充,實(shí)現(xiàn)硅通

先進(jìn)封裝中銅-銅低溫鍵合技術(shù)研究進(jìn)展
用于先進(jìn)封裝領(lǐng)域的 Cu-Cu 低溫鍵合技術(shù)進(jìn)行了綜述,首先從工藝流程、連接機(jī)理、性能表征等方面較系統(tǒng)地總結(jié)了熱壓工藝、混合鍵合工藝實(shí)現(xiàn) Cu-Cu 低溫鍵合的研究進(jìn)展與存在問題,進(jìn)一步地闡述了新型納米材料燒結(jié)工藝在實(shí)現(xiàn)低溫連接

先進(jìn)封裝中的TSV/硅通孔技術(shù)介紹
注入導(dǎo)電物質(zhì),將相同類別芯片或不同類別的芯片進(jìn)行互連,達(dá)到芯片級集成的先進(jìn)封裝技術(shù)。 TSV技術(shù)中的這個(gè)通道





 先進(jìn)封裝中硅通孔(TSV)銅互連電鍍研究進(jìn)展
先進(jìn)封裝中硅通孔(TSV)銅互連電鍍研究進(jìn)展

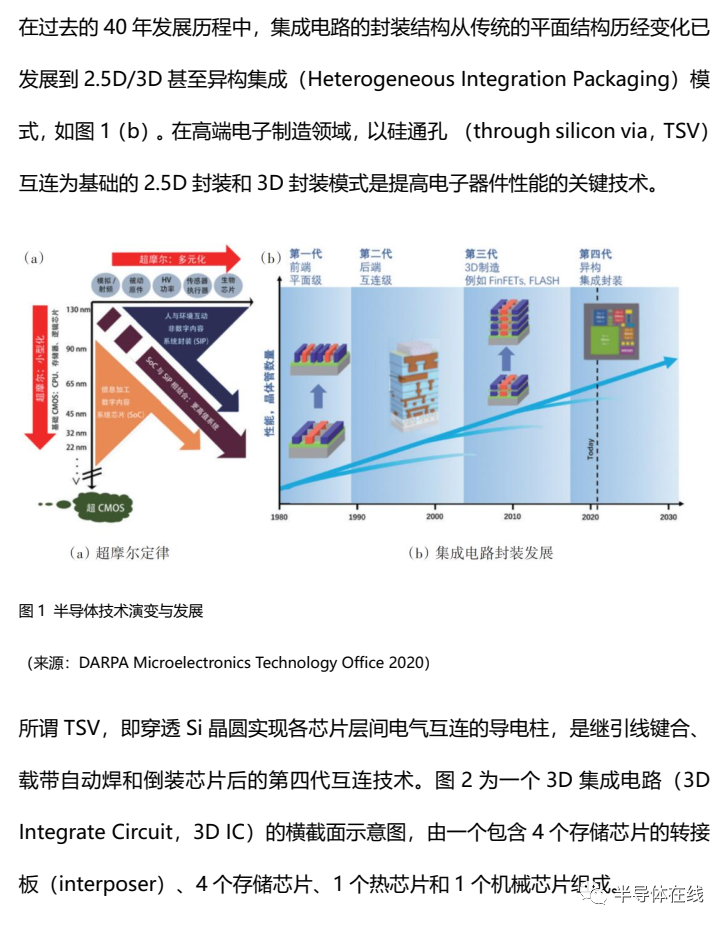
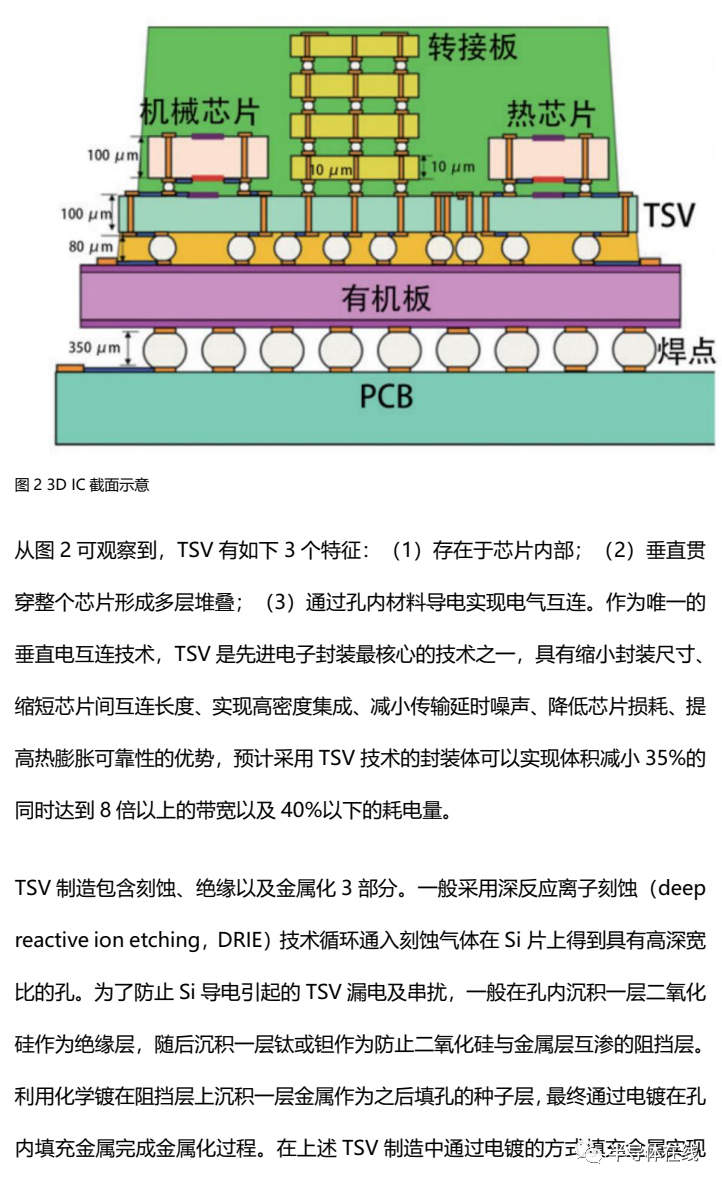


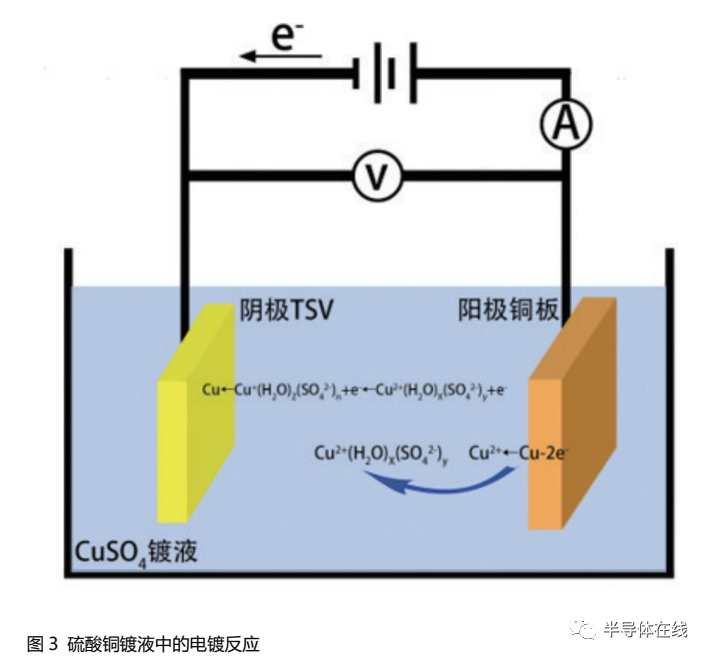




























評論