隨著電子產品向輕薄短小、高性能及多功能化方向發展,作為電子產品元器件支撐體的印制線路板(PCB)也需要向布線高密度化、輕薄化方向發展。高密度布線、高接點數的高密度互連(HDI)技術和可實現立體三維組裝的剛柔結合技術,是目前業內實現高密度布線、輕薄化的兩項重要技術。隨著這類訂單市場需求的增多,眾陽電路將HDI技術導入剛柔結合板正是順應此發展潮流,經過多年的研發和發展,目前眾陽電路已積累豐富的HDI剛柔板加工經驗,產品受到廣大客戶的一致好評。
眾陽HDI剛柔板發展歷程
1、2018年,開始研發,并生產出一階HDI剛柔板樣品
2、2020年,研發出二階HDI剛柔板樣品
3、2021年,研發并生產各種不同結構的二階HDI剛柔板
4、2023年,研發出三階HDI剛柔板樣品
目前,可承接制作各種結構的一階、二階HDI剛柔板樣板和批量板,三階HDI剛柔板樣品和小批量。
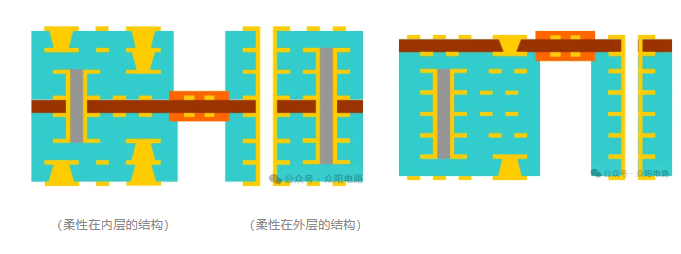
HDI剛柔板的基本特點及應用
1、疊層上,同時存在剛性和柔性層,采用No-flow PP壓合
2、微導通孔(包括由激光鉆或者機械鉆形成的盲孔、埋孔)的孔徑:Φ≤0.15mm,孔環≤0.35mm;盲孔穿過FR-4材料層,或PI材料層
3、一般線寬/間距≤4mil,焊盤密度>130點/in2
HDI剛柔板一般布線較密,焊盤較小,并需激光打孔和電鍍填孔或樹脂塞孔,工藝較復雜,難度大,成本也相對比較高。因此,產品
空間較小,需要立體安裝,才會設計成HDI剛柔板。其應該領域有手機、PDA、藍牙耳機、專業數碼相機、數碼攝像機、車載導航儀、掌上閱讀器、手持式播放器、便攜式醫療器材等等。

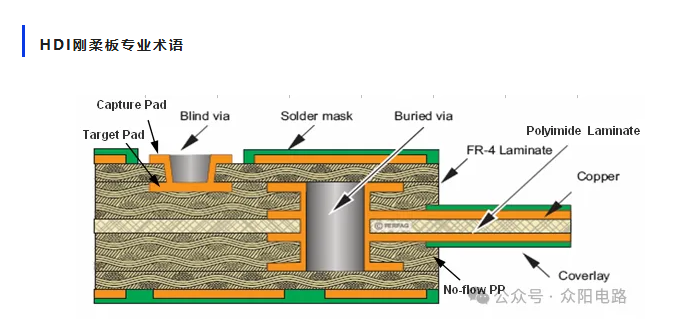
1、Polyimide laminate:內層柔性PI芯板。
2、FR-4 laminate:外層剛性FR-4芯板。
3、No-Flow PP:不流動(低流動)半固化片。
4、Build-up Layer:積層,疊積于芯層表面的高密互連層,通常采用微孔技術。
5、Microvia:微孔,用機械或者激光形成的孔直徑≤0.15mm的盲孔或埋孔。
6、Target Pad:微孔底部對應Pad。
7、Capture Pad:微孔頂部對應Pad。
8、Buried via:機械埋孔,沒有延伸到PCB表面的導通孔。
9、POFV (Plating Over Filled Via):對過孔先樹脂塞孔再鍍銅覆蓋樹脂層 。
10、Dimple:填孔凹陷。
11、Cap plating:樹脂塞孔電鍍銅。
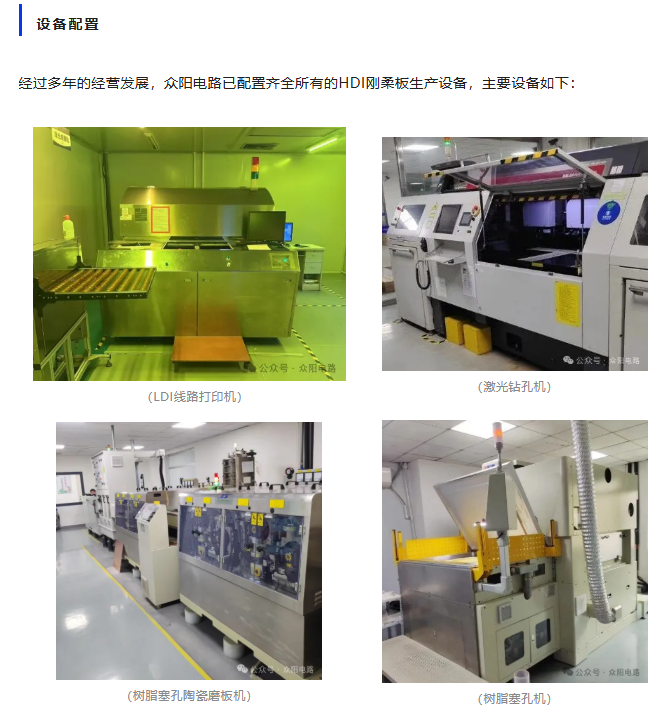

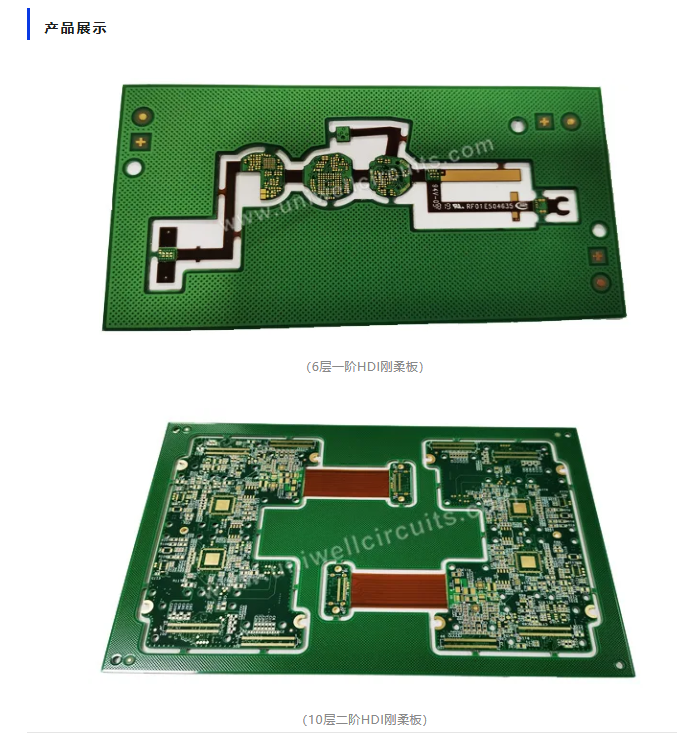
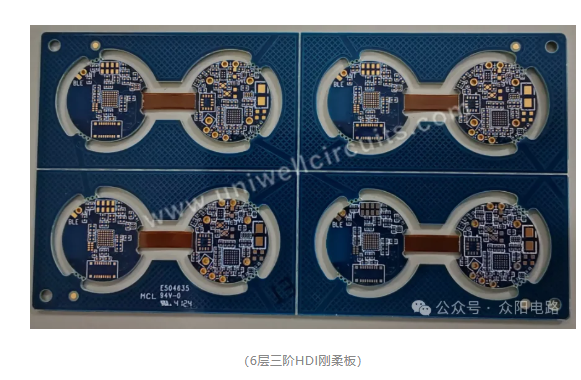
審核編輯 黃宇
-
PCB板
+關注
關注
27文章
1472瀏覽量
53202 -
HDI
+關注
關注
7文章
212瀏覽量
21780
發布評論請先 登錄
HDI線路板和多層線路板的五大區別
生產HDI線路板需要解決的主要問題
HDI板在5G技術中的應用
HDI線路板盤中孔處理工藝
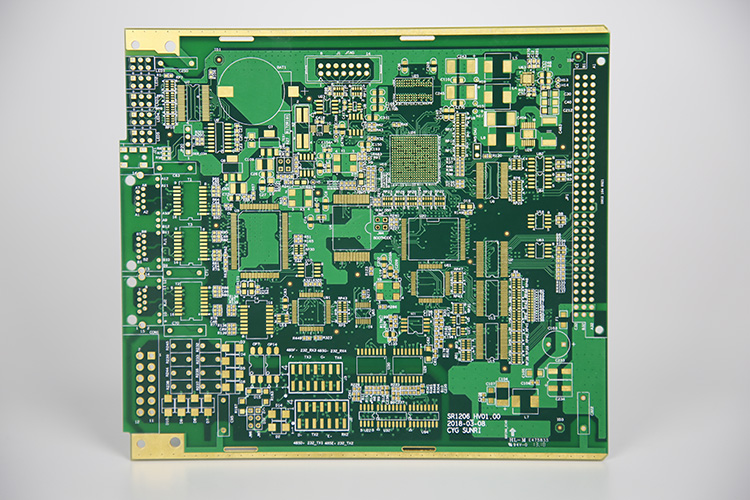
什么是HDI?PCB設計基礎與HDI PCB制造工藝






 眾陽電路HDI剛柔板介紹(一)
眾陽電路HDI剛柔板介紹(一)
















評論