葉淳懿 鄔學賢 張志彬 丁萍 駱靜利 符顯珠
(深圳大學材料學院)
摘要
芯片制造中大量使用物理氣相沉積、化學氣相沉積、電鍍、熱壓鍵合等技術來實現(xiàn)芯片導電互連.與這些技術相比,化學鍍因具有均鍍保形能力強、工藝條件溫和、設備成本低、操作簡單等優(yōu)點,被人們期望應用于芯片制造中,從而在近年來得到大量的研究.本綜述首先簡介了芯片制造中導電互連包括芯片內互連、芯片3D封裝硅通孔(TSV)、重布線層、凸點、鍵合、封裝載板孔金屬化等制程中傳統(tǒng)制造技術與化學鍍技術的對比,說明了化學鍍用于芯片制造中的優(yōu)勢;然后總結了芯片化學鍍的原理與種類、接枝與活化前處理方法和關鍵材料;并詳細介紹了芯片內互連和TSV互連化學鍍阻擋層、種子層、互連孔填充、化學鍍凸點、再布線層、封裝載板孔互連種子層以及凸點間鍵合的研究進展;且討論了化學鍍液組成及作用,超級化學鍍填孔添加劑及機理等.最后對化學鍍技術未來應用于新一代芯片制造中進行了展望.
1引言
芯片指內含集成電路而體積很小的硅片,是電子設備的“大腦”.在信息時代,芯片是各行業(yè)的核心基石,電腦、手機、家電、汽車、高鐵、電網、醫(yī)療儀器、機器人、工業(yè)控制等各種電子產品和系統(tǒng)都離不開芯片[1].芯片產業(yè)是一個國家高端制造能力的綜合體現(xiàn),是全球高科技國力競爭的戰(zhàn)略必爭制高點.目前我國已有華為、龍芯、歐加、阿里巴巴、寒武紀等公司能夠設計出先進芯片,但在高端芯片制造領域還薄弱,芯片為我國第一大宗進口商品.在三星、臺積電已能量產5 nm制程芯片的當下,我國大陸也僅有中芯國際能夠量產14 nm制程的芯片.倘若西方國家進行技術封鎖,我國有可能面臨無芯可用的窘境.因此,對芯片制造技術的研究就顯得尤為重要.
如圖1所示,芯片的制造可分為前段工藝(FEOL,Front End of Line)、后段工藝(BEOL, Back End of Line)及后繼的芯片封裝等.前段工藝就是在單晶硅片上制造出晶體管.而后段工藝則是在一層層的絕緣材料上進行穿孔(Via)和金屬布線,將前段工藝中的晶體管進行導電互連[2].此外,后續(xù)封裝中將會涉及TSV、芯片封裝載板盲孔與通孔、重布線層(RDL)、凸點(bump)、凸點下金屬過渡層(UBM)及凸點間的鍵合等關鍵工藝,主要目的也是實現(xiàn)高效導電互連.目前, BEOL及TSV中的阻擋層、種子層主要使用物理氣相沉積(PVD)或化學氣相沉積(CVD)方法制造,金屬的填充使用電鍍銅制備[3-5].芯片級細凸點通常使用電沉積技術制造,凸點間的鍵合則可通過熱壓實現(xiàn)[6].但是隨著芯片線寬的不斷縮小,上述技術會面臨著一些難以克服的缺點.且不談PVD、CVD技術所要求的昂貴設備,使用它們制造的阻擋層和種子層,在面對高縱橫比的通孔時難以保證完美覆蓋率,最終可能導致金屬填充的失敗.對于銅柱凸點間的鍵合,如果使用熱壓方式則需要較高的溫度和較大的壓力,這對于芯片導電互連長效服役是不利的[7].
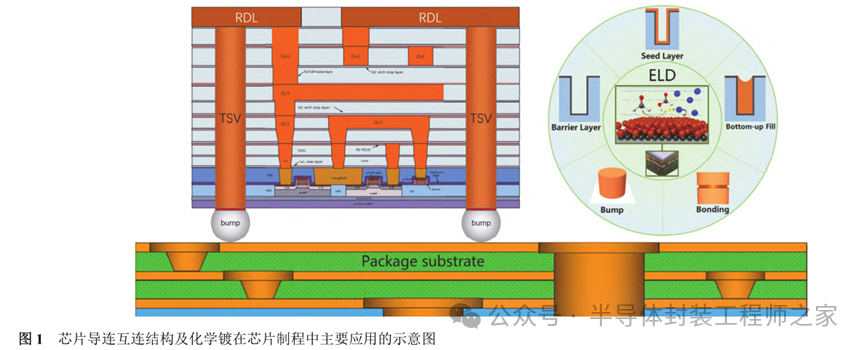
化學鍍作為一種金屬沉積工藝,它可以不需高成本設備、不需要電流及導電基體就能夠在復雜形狀的基體包括含有細孔徑的深孔基體上均勻沉積金屬層,并且工藝成本低、實施簡單方便,已被廣泛應用于印制線路板[8]、芯片封裝載板、UBM中阻擋層、柔性電路[9-14]、集流體[15]、傳感器[16]、電磁屏蔽[17]、導熱散熱[18]、防腐裝飾及多種功能性涂層等制造上.化學鍍被許多研究者積極研究用于芯片制造中的阻擋層、種子層、孔填充金屬互連、銅柱凸點之間的金屬低溫濕制程鍵合等.本綜述將對比傳統(tǒng)芯片制造導電互連工藝技術與化學鍍技術,介紹用于芯片制造中的化學鍍技術研究進展,并對它們進行總結與展望,為今后芯片制造領域中的化學鍍應用提供參考.
2芯片化學鍍原理與制程
2.1芯片化學鍍原理及常用鍍種
化學鍍就是溶液中的金屬離子在還原劑的催化還原作用下只在需要進行鍍覆的基體上形成金屬鍍層的一種技術[19].化學鍍總反應式如式(1):

其中, Ox是還原劑Red的氧化產物.該反應又可分為陰極部分和陽極部分:

式(2)、(3)中z和m表示電子數(shù).上述反應發(fā)生在同一電極、同一溶液金屬界面上,因此需要讓還原劑的平衡電位比金屬電極的平衡電位更負才能保證反應的持續(xù)發(fā)生.以芯片化學鍍工藝中常見的甲醛還原銅離子的化學鍍銅工藝為例,討論其機理(圖2).以甲醛作為化學鍍銅的還原劑時,其總反應如式(4):

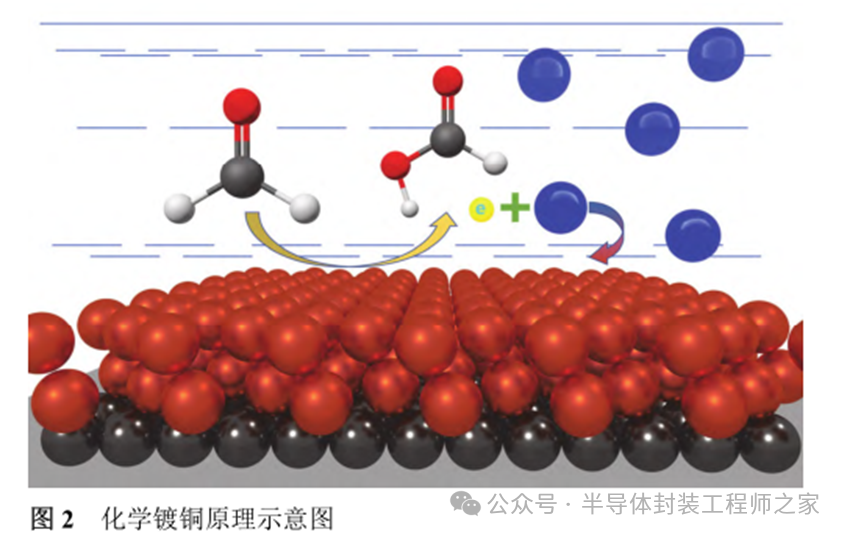
可分為陽極反應式(5)與陰極反應式(6):

上述反應可細分為幾個步驟:甲醛在水合后解離(式(7)、式(8)),與氫氧化物離子反應生成亞甲二醇陰離子(式(9)).亞甲二醇陰離子隨后繼續(xù)在催化劑金屬表面反應(式(10)、式(11)).

最后在催化劑金屬表面發(fā)生析氫反應:

上述反應機理表明化學鍍反應離不開催化劑的存在.芯片化學鍍工藝中,催化劑緊密地吸附在基體上,化學鍍反應在催化劑表面進行,保證了工藝的選擇性和保形性,同時也是化學鍍工藝應用于芯片制造的優(yōu)勢.表1列出了芯片制造中常見單金屬化學鍍種類,在此基礎上可以添加錸鹽酸、鉬酸鹽、鎢酸鹽等金屬鹽以及次磷酸鹽、二甲胺硼烷(DMAB)等非金屬鹽來實現(xiàn)NiP、CoB、NiReP、CoWP等二元、多元合金的沉積.
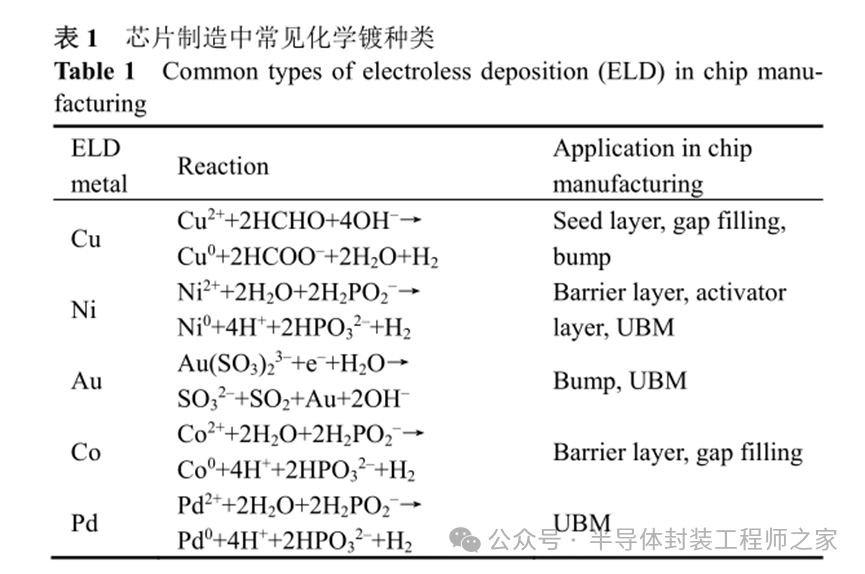
提升反應溫度可以促進化學鍍的進行,但溫度太高也可能導致鍍液分解.鍍液的自發(fā)分解取決于以下因素:溶液中成核的概率和速率,以及核生長與溶解的關系.臨界核半徑的方程式為:

其中 γ 為金屬溶液界面的表面張力,ν 為金屬的摩爾體積, EMe和ERed是金屬和還原劑在溶液中的電動勢.當r的實際值大于理論值時,發(fā)生自發(fā)分解.通過使用添加劑和絡合劑,同時調節(jié)溶液的pH值,可以使沉積過程的(EMe-ERed)值盡可能地小.添加劑還可以通過吸附在晶核上并阻止晶核生長來毒化催化劑表面,從而導致晶核溶解.此外,使用表面活性劑可以降低鍍液的表面張力,有利于去除鍍層表面產生的氫氣泡[20].
2.2芯片化學鍍前接枝與接枝劑
化學鍍金屬層要在芯片基體上高效催化沉積并與基體具有良好的結合力,這主要通過對化學鍍前基體的處理來保障[21].由于芯片化學鍍工藝的特殊性,常用的前處理關鍵步驟為接枝改性和活化.自組裝單分子層(SAM)已被證明可在微電子和生物醫(yī)學工程等各種應用領域中用作偶聯(lián)劑、催化劑捕獲層、擴散屏障、腐蝕抑制劑和黏附促進劑等[22].在芯片化學鍍工藝中,接枝處理后可以在基底表面形成SAM,用于捕獲催化劑離子或催化劑顆粒.使用SAM的一個關鍵理由在于它能起到增強基底對鍍層黏附強度的作用,以支持鍍層經過后續(xù)化學機械拋光(CMP)而不脫落.常見的接枝步驟如下: (1)使用清潔溶液(通常包含過氧化氫、硫酸或氨水)清洗基底并干燥,實現(xiàn)基底表面的羥基化; (2)在一定溫度下,將基底浸入含有接枝劑的甲苯或乙醇溶液一定時間后取出清洗并干燥,在基底上得到SAM; (3)用標準清洗液(SC-1,包含過氧化氫及氨水)對SAM進行功能化或是對樣品進行烘烤使SAM致密化(可選)[22-24].以Si為基底, 3-[2-(2-氨基乙基氨基)乙基氨基]丙基-三甲氧基硅烷(ETAS)為接枝劑為例,如圖3a所示,使用微蝕刻溶液對基底表面處理后會帶上羥基基團. ETAS的分子結構以Si原子為中心,連接著三個含甲氧基(-OCH3)的頭部基團和一個烷基鏈,烷基鏈尾部有一個游離氨基(-NH2).由于頭部基團與基底表面羥基之間氫鍵的作用力, ETAS在基底上組裝成SAM, ETAS尾部的氨基會捕獲Pd催化劑從而起到活化的作用.此外,經過退火處理, ETAS分子與Si襯底之間、兩個相鄰ETAS分子之間均會發(fā)生脫水反應,從而大幅提高黏附強度,黏附強度與退火溫度之間的關系如圖3b所示[25].使用SAM捕獲催化劑,相比于直接活化,可以獲得粒徑更小、密度更高的催化劑.如圖3c、3d所示,由SAM捕獲的不論是Pd還是Au催化劑,其催化劑粒徑及密度都要比直接使用Sn/Pd膠體活化更加優(yōu)秀[26-27].表2列舉了芯片化學鍍工藝中常用的接枝劑.

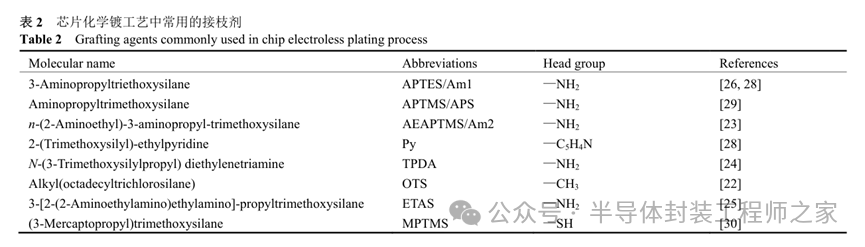
2.3芯片化學鍍前活化及活化劑
活化的目的在于讓基材表面附著上具有催化活性的Pd、Ag、Au、Ru等催化劑促使金屬離子還原的化學鍍反應能夠進行,活性顆粒自身的催化活性以及在基材表面上的分布形態(tài)等均會影響后續(xù)化學鍍性能.化學鍍中最為常用的活化方式為Sn/Pd膠體活化. Pd是貴金屬,成本高.作者所在課題組為降低化學鍍活化劑成本,開發(fā)了空心多孔Pd納米球[31]、多孔空心PdCu納米框[32-34]、納米Sn棒載Ag[9]、納米Cu、Ag膠水[15]、銀離子油墨[35]等多種催化劑,能夠實現(xiàn)良好的化學鍍銅導電互連.相比于直接吸附催化劑納米顆粒的一步活化法,敏化-活化法先使用二氯化錫(SnCl2)對基材進行敏化,吸附在基底上的Sn離子可以有效降低樣品表面張力并改善潤濕性能,降低表面能,并為金屬催化劑離子還原提供了均勻分布的位點,從而增加催化劑納米顆粒的覆蓋率.此外,敏化后吸附在基底上的Sn離子會與Pd離子發(fā)生如下反應:

將Pd離子還原為Pd納米顆粒[36-37].如圖4所示,經過敏化處理的基底吸附的Pd納米顆粒密度更高,粒徑更小.原子力顯微鏡(AFM)測試結果表明,敏化活化法相比起直接活化,表面粗糙度降低了約40%,說明吸附的Pd納米顆粒更傾向于平面覆蓋.
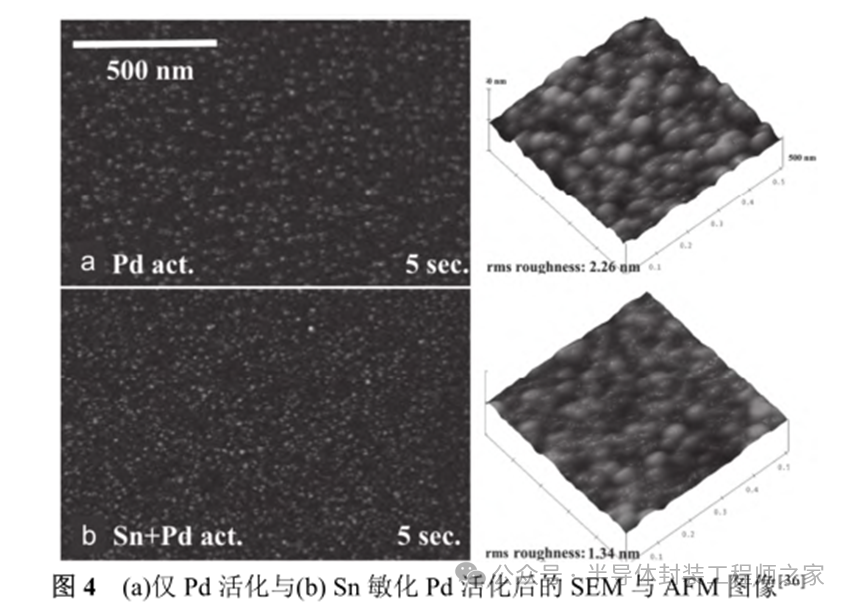
SAM可以捕獲金屬離子,直接將帶有SAM的基底浸入含鹽酸的氯化鈀溶液中,基底便會吸附Pd離子.在后續(xù)化學鍍時,鍍液中的還原劑會將Pd離子還原成有催化活性的Pd納米顆粒[38],從而催化化學鍍金屬層沉積[23,39].將氯化鈀溶液換成硝酸鎳溶液, SAM同樣可以吸附Ni離子.與Pd不同的是, Ni離子較不容易被還原,因此在化學鍍前需要將基底先浸入強還原劑硼氫化鈉溶液中將Ni離子還原為Ni納米顆粒,之后再進行化學鍍[29].如圖5a、5b所示,除金屬離子外, SAM也能直接從鈀納米顆粒(PdNP)、金納米顆粒(AuNP)活化劑中捕獲Pd、Au等納米顆粒用于活化[24,26-27,40-41]. Inoue等[27,40]認為AuNP所帶的電荷使它們之間存在靜電斥力,在活化時可以保證高密度吸附而不團聚,但在硅工藝中使用Au可能帶來嚴重的金屬污染,因此后續(xù)的實驗中棄用了AuNP轉而使用PdNP. Shingubara等[42]用電離簇束(ICB)沉積1 nm超薄Pd作為化學鍍催化層. Lim等[43]將Ta基底浸入六氯鈀酸鉀溶液中,超聲使水聲解產生H?自由基還原Pd(IV),從而實現(xiàn)Ta基底的活化(圖5c). Lin等[44]使用濺射沉積的銅膜代替鋅作為化學鍍UBM的活化層. Inoue等[45]在原子層沉積(ALD)的10 nm厚釕層上化學鍍Cu種子層,納米金屬釕層起到了催化作用.因為直接在Pd活化的SAM上化學鍍CoWP會成長為不連續(xù)的島狀, Osaka等[46]先化學鍍NiB層,將其作為催化層再化學鍍連續(xù)的CoWP阻擋層.化學鍍中的活化劑可謂是多種多樣,表3列舉了一些芯片化學鍍制程中的常見活化劑.
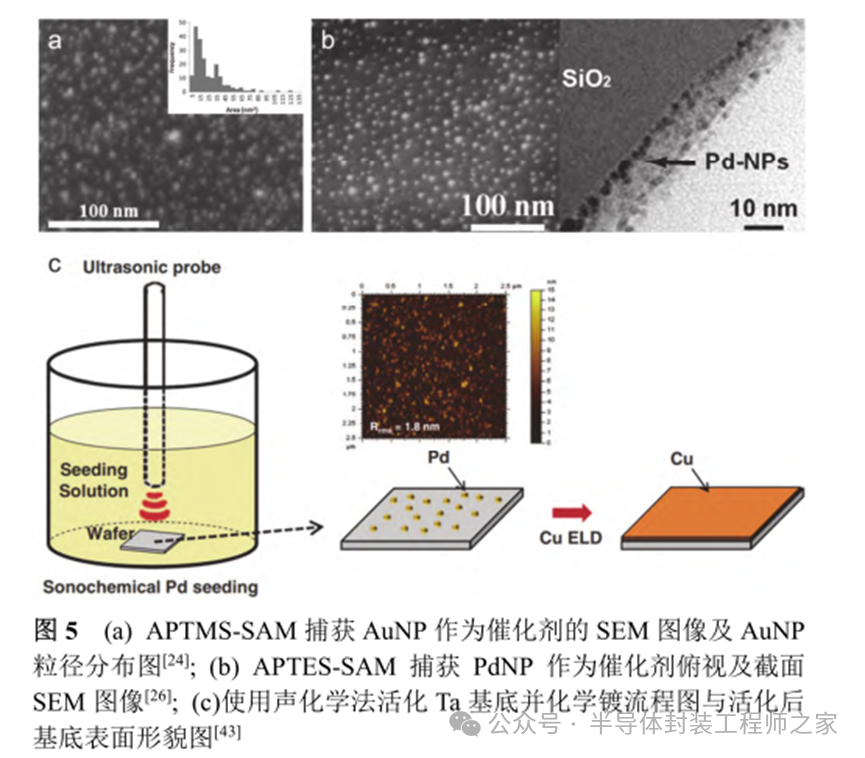
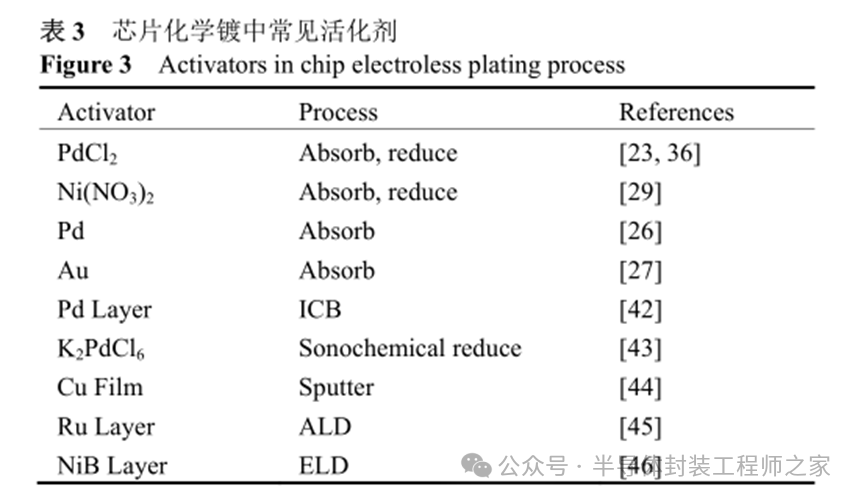
3芯片導電互連制程
3.1芯片內互連制程
早期,在芯片制造的后段工藝中人們使用鋁(Al)作為導電互連金屬.但隨著芯片中晶體管數(shù)量增加和線寬縮小, RC延遲(R為芯片中互連線的電阻, C為基板的電容)成為影響芯片速率的重要因素[47].為了解決這個問題, IBM于1997年提出用導電性更好的Cu代替Al作為芯片的互連材料.與Al相比, Cu的電阻率更低,可以有效降低延遲.但是Cu易腐蝕,且容易向二氧化硅(SiO2)或硅(Si)基材擴散,從而影響絕緣體或半導體的特性.應用于Al的工藝技術無法直接應用于Cu,因此雙大馬士革互連線工藝應運而生[48].如圖6所示,先在Si基材表面形成一層SiO2介電層,然后在介電層上刻蝕出溝槽(trench)和穿孔.緊接著使用PVD或CVD沉積一層擴散阻擋層,用于防止填充的Cu金屬向介電層擴散.隨著晶圓尺寸的增大,傳統(tǒng)阻擋層過大的電阻導致的IR壓降會讓后續(xù)使用大馬士革工藝電鍍填充Cu時出現(xiàn)Cu沉積不均勻的情況,因此必須在填充Cu之前使用PVD或CVD沉積一層導電的種子層.隨后在各種添加劑的作用下,實現(xiàn)自下而上的電鍍Cu填充[49].電鍍完成后還需要進行CMP去除多余的Cu,實現(xiàn)平坦化.最后可以覆蓋一層阻擋層,并繼續(xù)進行下一層的大馬士革工藝[50].
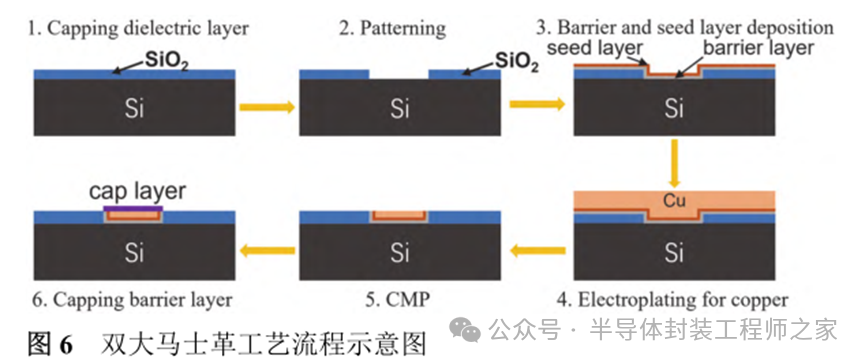
但正如前述, PVD、CVD技術不僅設備昂貴,而且面對線寬逐漸縮小的制程,無法保證完整覆蓋溝槽和穿孔,或是引起“倒垂”現(xiàn)象(圖7a),導致后續(xù)電鍍填充金屬的步驟失敗.而化學鍍優(yōu)秀的均勻鍍覆保形能力不僅可用于制作阻擋層或種子層(圖7b),還能在添加劑的配合下直接進行孔填充金屬(圖7c). Osaka等[46]使用3-氨基 丙 基 三 乙 氧 基 硅 烷(APTES)對已 刻 蝕 出 溝 槽 的SiO2/Si晶圓進行硅烷化,隨后將其浸入PdCl2溶液中吸附Pd離子.在含有硫酸鎳、檸檬酸和DMAB的溶液中,Pd離子會被還原成Pd納米顆粒并催化化學鍍鎳,得到NiB層.在含有硫酸鈷、鎢酸鈉、檸檬酸鈉、次磷酸鈉及硼酸的溶液中, Ni層會作為化學鍍CoWP的催化劑,獲得CoWP/NiB阻擋層(圖8a).最后,他們在聚乙二醇(PEG)添加劑的配合下,使用乙醛酸還原硫酸銅超級化學鍍銅填孔,實現(xiàn)了溝槽內的自下而上填充(圖8b).在500℃下退火30 min,未觀察到Cu的擴散,說明該阻擋層能較好地發(fā)揮阻擋作用.使用超級化學鍍填孔可以減少種子層沉積和電沉積工序,在不導電的絕緣層或阻擋層上直接一步化學鍍填充導電互連金屬.
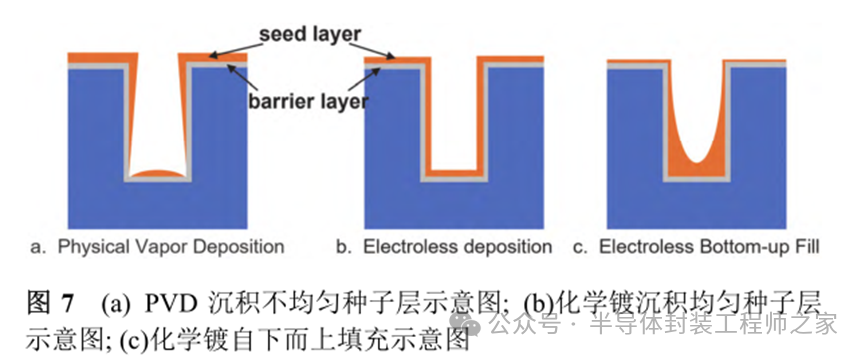
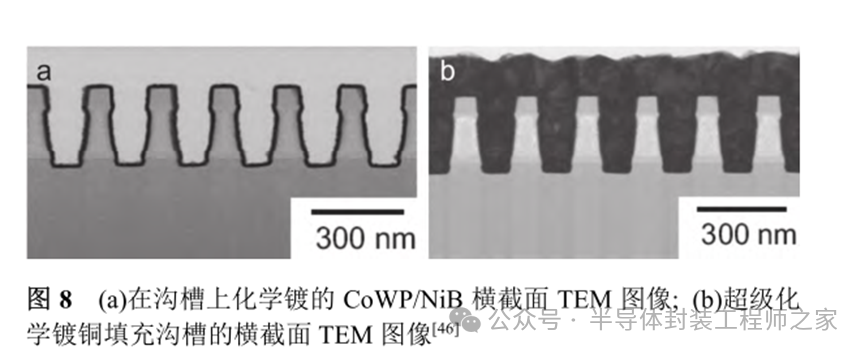
3.2三維封裝TSV制程
在芯片制程發(fā)展逐漸遇到瓶頸的今天,芯片的3D封裝是人們能夠繼續(xù)追趕摩爾定律的有效手段.將芯片堆疊并用TSV連接是如今最常使用的芯片3D封裝方法. TSV的制造在某種程度上與芯片內互連大馬士革工藝非常相近.如圖9所示,對基材進行垂直刻蝕后,用PVD技術沉積擴散阻擋層與種子層,用于防止填充的銅擴散至基材中及電鍍填充金屬.在電鍍填充銅后,通過CMP去除多余的金屬[51].
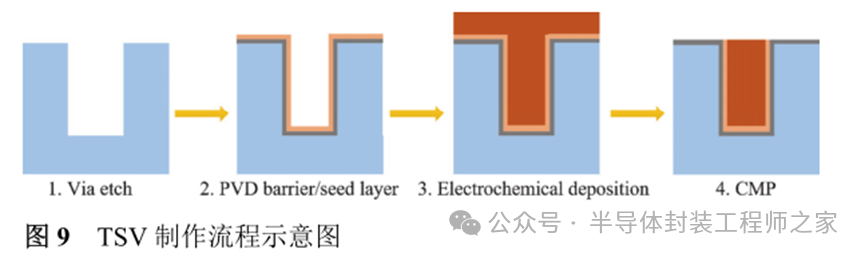
芯片內部空間“寸土寸金”, TSV孔徑面積如果過大勢必會造成浪費,因此隨著人們對芯片要求的提高,TSV所占用的面積不斷縮小.孔徑面積的縮小意味著縱橫比的提高, PVD技術在面對較大縱橫比的TSV時,無法做到完整覆蓋阻擋層或種子層,最終造成金屬填充失敗[52].如圖10a所示, Inoue等[53-54]提出了使用化學鍍全濕工藝制作TSV的方法.使用APTES在TSV內形成SAM,用于吸附高密度的Pd納米顆粒作為催化劑(圖10b),化學鍍Co-W-B阻擋層(圖10c).當化學鍍Co-W-B阻擋層厚度小于40 nm時,黏附強度與濺射制備的Co膜相當.在該阻擋層上,使用乙醛酸作為還原劑可以在無需催化劑的情況下通過置換反應激活化學鍍銅.此外,通過在鍍液中添加PEG及聚二硫二丙烷磺酸鈉(SPS),經過二次化學鍍銅,實現(xiàn)了高縱橫比TSV的超級化學鍍銅填充(圖10d、10e).通過化學鍍工藝制作的TSV,過鍍的銅層較少,節(jié)約了后續(xù)CMP的時間及成本,而且實現(xiàn)了阻擋層沉積與TSV填孔的全化學鍍工藝,不再需電沉積填孔步驟.
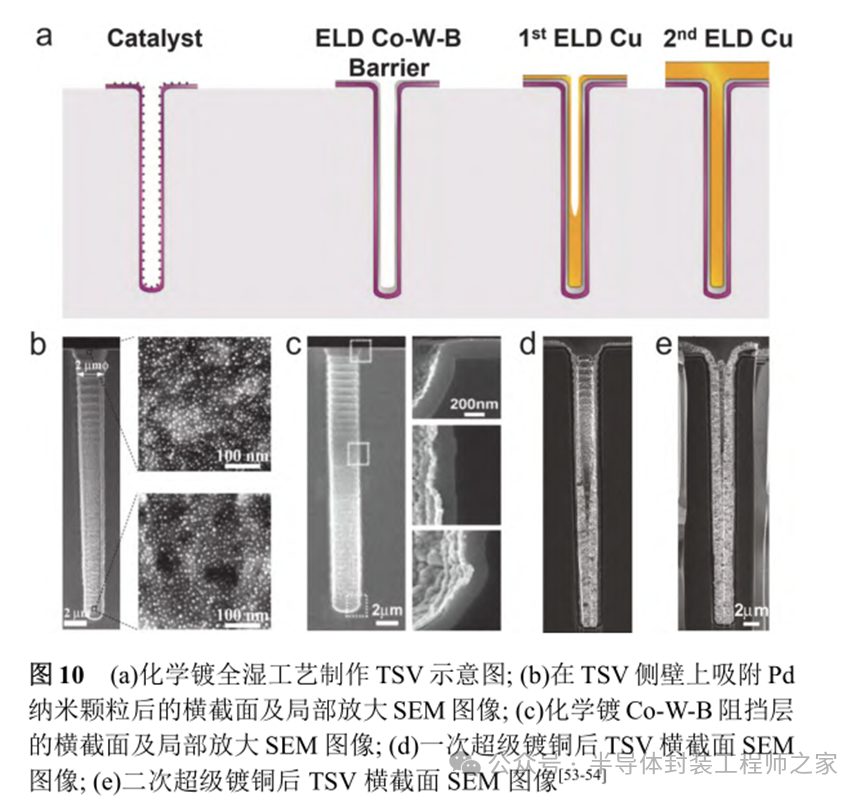
3.3RDL、凸點及鍵合
當輸入/輸出(I/O)焊盤太小或太密集而導致無法進行可靠的焊料連接時,便需要RDL將I/O焊盤分布到其他位置,降低基板與元件之間的應力,提高可靠性.典型的RDL如圖11a所示,制作時步驟如下: (1)在芯片表面已有的焊盤及鈍化層上覆蓋聚合物介電層,并通過光刻技術去除焊盤上方的覆蓋使其暴露; (2)覆蓋一層TiW或Cu種子層,并用臨時抗蝕劑創(chuàng)建“電鍍模板”,進行電鍍沉積銅引線,最后去除抗蝕劑和種子層; (3)繼續(xù)覆蓋介電層,用于保護銅引線并通過光刻技術使其暴露在新焊盤位; (4)用臨時抗蝕劑創(chuàng)建“電鍍模板”或“蝕刻模板”,通過電鍍或濺射沉積來制作UBM層,用于連接焊盤與凸點,提供擴散阻擋性能; (5)通過電鍍或放置焊球在UBM上制作凸點.凸點間的連接通常采用熱壓鍵合.步驟(1)至(4)均需要采用高成本光刻技術,兩次使用臨時抗蝕劑,兩次覆蓋介電層,如果能夠優(yōu)化其中的步驟,降低成本,即可提高RDL技術的競爭力[55].使用氧等離子處理聚酰亞胺(PI)介電層可使其表面變得粗糙,增大后續(xù)金屬層的黏附強度.選用化學鍍鎳作為阻擋層,并通過堿性溶液處理PI使酰亞胺環(huán)發(fā)生裂解反應來進一步增大對Ni層的粘附力.在化學鍍鎳后,進行化學鍍銅制備種子層(圖11b).相比濺射等工藝,化學鍍阻擋層與種子層對設備要求低、成本低,且實現(xiàn)了全濕工藝[56],芯片封裝載板孔金屬化及半加成工藝中銅種子層也是使用化學鍍工藝制備.臭氧處理具有可擴展性,適用于大面板的晶圓工藝,對化學鍍銅種子層進行處理后可以提升后續(xù)電鍍的質量[57].用硝酸溶液對新的銅焊盤進行刻蝕處理,可以使用次磷酸鈉作為還原劑,在酸性硫酸鎳溶液中化學鍍鎳制作UBM[44]. Yeoh等[55]提出了如圖11c所示的步驟,在銅UBM上沉積Pd活化層進行化學鍍鎳,然后通過置換反應在Ni表層覆蓋Au,以此來保護Cu UBM,并增加對焊料的潤濕性和可焊性.使用經過優(yōu)化的無氰鍍金浴,能夠化學鍍Au凸點[58],在進行凸點間鍵合時也可以使用化學鍍工藝[7].
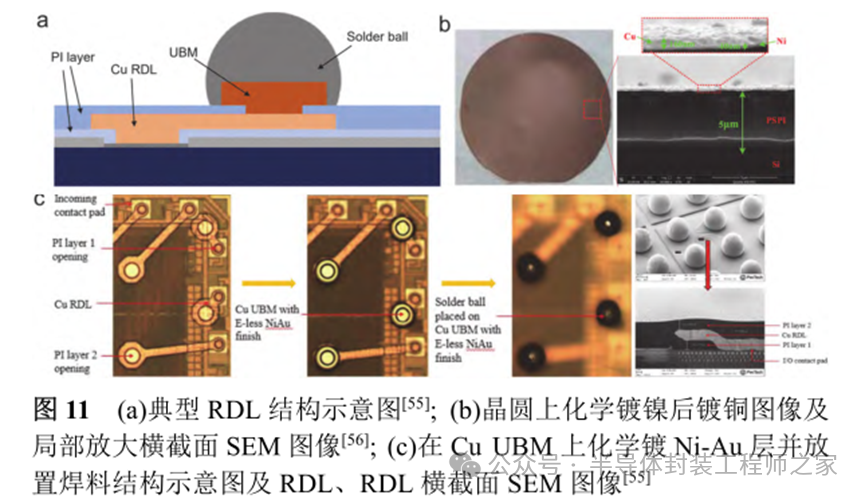
4芯片互連化學鍍阻擋層
4.1芯片阻擋層作用及材料
目前, Cu已成為使用最為廣泛的芯片導電互連材料.相比于上一代互連材料Al, Cu在Si或SiO2中遷移率高,在加熱條件下會向Si或SiO2基材中擴散,影響它們的電性質,因此不論是芯片內互連的溝槽、穿孔,還是三維封裝的TSV、凸點,都需要阻擋層來防止Cu的擴散[50,59].阻擋層與Cu的反應程度應在一個合理的范圍內,以保證擁有優(yōu)秀阻擋性能的同時,還有良好的粘附性[60].傳統(tǒng)的阻擋層材料通常是鈦(Ti)、鉭(Ta)、鎢(W)等高熔點金屬或其合金,并通過PVD、CVD等技術制備阻擋層.近年來成本更低的化學鍍Co、Ni等金屬及其合金作為阻擋層得到了積極研究[61].
4.2化學鍍鎳基阻擋層
化學鍍鎳層擁有與基底的結合力較高、硬度大、耐磨性好等優(yōu)點,只需較為廉價的金屬即可催化沉積的進行[62],有利于成本的降低,且因其較好的阻擋性能和較高的電導率,成為芯片互連制程中阻擋層的重要候選材料,得到了研究者們的廣泛關注[63]. Shingubara與其合作者[27,64-65]使用SAM吸附AuNP或PdNP作為催化劑,在TSV內化學鍍Ni-W-P、NiP和NiB阻擋層.他們制備的NiB阻擋層橫截面SEM圖像如圖12a,電阻率為410μΩ?cm,且能直接作為化學鍍銅種子層的活化層,但阻擋性能一般,在300℃退火后便已出現(xiàn)Cu的擴散.Ikeda等[39]通過氣相沉積APTES形成SAM.氣相沉積可以減少APTES分子聚集,進而增加阻擋層的黏附強度.如圖12b所示,他們制得的NiB阻擋層黏附強度為13.07N?cm2,電阻率僅為37~42μΩ?cm,低于傳統(tǒng)Ta或TaN阻擋層,可在400℃退火的條件下阻擋Cu的擴散.Zhang等[66]在TSV中使用了特殊的絕緣層,無需SAM即可直接捕獲Pd離子用于活化,最終得到的化學鍍NiB阻擋層經過500℃退火仍未觀察到Cu的擴散.Xiong等[67]提出了一種新型偏心旋涂技術,可大大提高均勻性,并采用該技術旋涂聚酰亞胺作為絕緣層.在該絕緣層上化學鍍鎳作為阻擋層,可在400℃下提供阻擋性能. Hu等[68]使用聚合物聚甲基丙烯酸膜(PMAA)作為絕緣層,降低TSV的電容及殘余應力.如圖12c所示,通過4-乙烯基吡啶的改性, PMAA能夠吸附Pd離子用于催化化學鍍NiP阻擋層.對于116 nm厚的NiP阻擋層,四探針測定的方阻為26 Ω?sq?1,黏附強度達到了5B等級,已經可用于TSV. Bernasconi等[23]在化學鍍液中同時使用DMAB與次磷酸鈉作為還原劑,得到了NiPB阻擋層(圖12d),方阻可低至20 Ω?sq?1. Cai等[69]探究了化學鍍Ni、Mo、P三元合金的鍍液配方,最終得到的NiMoP阻擋層可在400℃退火后正常發(fā)揮阻擋性能.Lee等[70]制造并評估了化學鍍鎳作為阻擋層兼種子層用于高可靠且低成本Cu TSV的效果,相比PVD沉積的阻擋層,化學鍍鎳阻擋層具有更好的阻擋性能, 400℃下退火后在能量色散X射線光譜(EDX)分析中未觀察到Cu的擴散(圖12e).
Osaka與其合作者[28,71]為了能夠在堿性條件下化學鍍芯片內互連NiReP阻擋層,先化學沉積了一層NiP用于保護SAM免受堿性溶液的危害,此后再沉積NiReP阻擋層(圖13a).在400℃退火后, NiReP/Cu界面區(qū)域仍然完好無損,阻擋層電阻隨退火溫度變化如圖13b所示.因為鈉與鉀離子會影響到金屬氧化物硅晶體管,他們進一步探究了無堿金屬的鍍液,使用氫氧化四甲基銨(TMAH)代替NaOH或KOH作為pH調節(jié)劑.通過SAM吸附Pd離子進行活化,在優(yōu)化后的鍍液中成功化學鍍NiB阻擋層.與含鈉離子的化學鍍液相比,使用無鈉溶液沉積的NiB膜表面更光滑,膜厚更均勻(圖13c).經過剖面分析(圖13d), 400℃退火后并未發(fā)現(xiàn)Cu的擴散.傳統(tǒng)的化學鍍NiP UBM阻擋層不足以長期保護底層金屬化層免受熔融焊料的侵蝕, Chen等[72]對鍍液進行改良,添加了鎢酸鈉作為鎢源.結果表明具有較高W含量的NiWP阻擋層的使用壽命比普通NiP層長得多.表4列舉了芯片中化學鍍鎳基阻擋層鍍液配方.
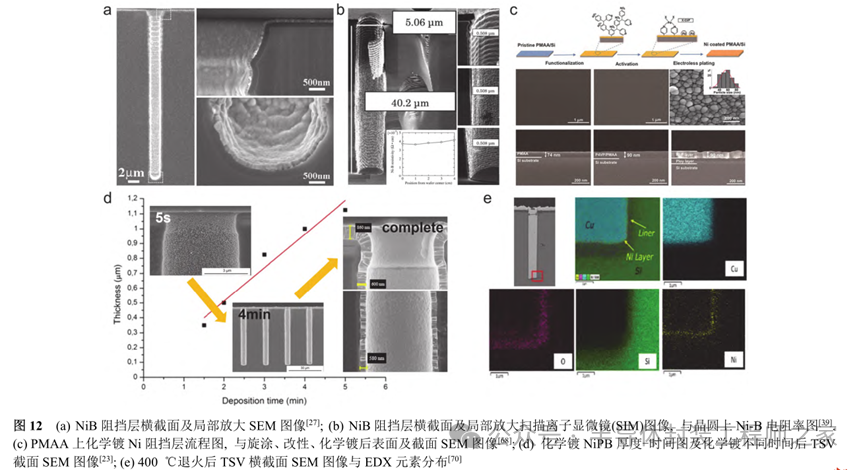

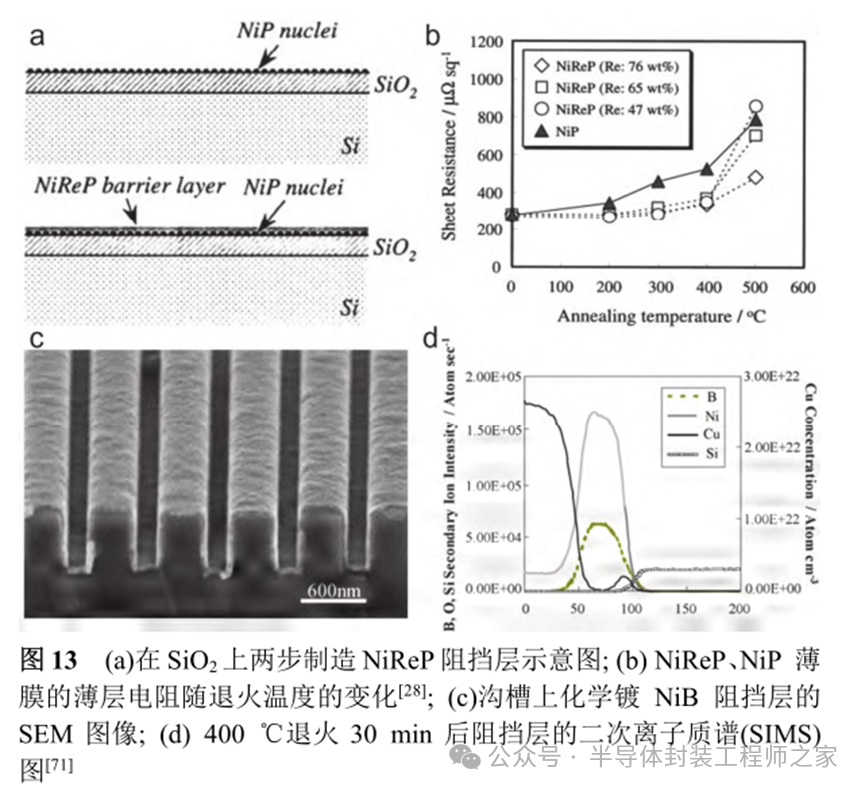
4.3化學鍍鈷基阻擋層
Shingubara與其合作者[41,73]在TSV內化學鍍制備了NiB與CoB阻擋層.通過分析不同阻擋層上銅種子層退火后的電阻變化(圖14a),他們認為CoB具有更優(yōu)的熱穩(wěn)定性.在300℃退火后, CoB黏附強度為51.3 MPa.Inoue等[26,40,53-54,74]使用SAM吸附納米顆粒作為催化劑,鍍液中添加鎢酸作為鎢源,在TSV內化學鍍制備了Co的三元合金CoWB阻擋層.表5列舉了芯片中化學鍍鈷基阻擋層鍍液配方.如圖14b所示,在300℃退火30min后未觀察到Cu的擴散.通過控制退火溫度, 60 nm厚的CoWB阻擋層黏附強度高達70.2 MPa, 40 nm厚的可超過80 MPa. Arima等[75]發(fā)現(xiàn)在鍍液中添加SPS可使CoWB在TSV內沉積得更加均勻. Iseri與Matsudaira等[76-77]在上述基礎上進一步研究后認為Co的三元合金CoWB具有比CoB更好的擴散阻擋性能(圖14c).當化學鍍CoWB阻擋層的W質量分數(shù)大于15%時,在350℃退火后仍可保證阻擋性能;當W質量分數(shù)大于20%, 400℃退火后阻擋層仍具有優(yōu)異的抑制Cu擴散的效果. Tanaka等[78]使用化學鍍工藝在TSV內沉積了CoWB阻擋層和Cu種子層, 420℃退火后也未發(fā)生Cu的擴散.如圖14d,他們對比了化學鍍工藝與PVD工藝制備阻擋層與種子層,化學鍍CoWB的臺階覆蓋率可達85%以上,優(yōu)于PVD制備的Ta阻擋層與Cu種子層,化學鍍CoWB對化學鍍銅種子層的粘附強度與PVD-Ta對化學鍍銅相當,在電鍍填充銅之后也未觀察到空隙或接縫.經過粗略的成本計算,他們認為通過對鍍液進行合理的回收利用,化學鍍工藝的成本對比PVD可降低40%至50%. Sandjaja等[79]開發(fā)了一種基于熒光的TSV內官能團可視化技術用于表征SAM.他們利用此技術使Pd催化劑在TSV內的高密度吸附,實現(xiàn)了化學鍍均勻CoReP阻擋層(圖14e).


Shacham-Diamand與其合作者[24,46,80]最初選擇在Co二元合金中添加鉬形成化學鍍CoMoP三元合金用于改善其作為芯片內互連阻擋層的性能,可承受350℃退火.后續(xù)更換為CoWP三元合金(圖15a),在500℃退火后未觀察到Cu的擴散.兩種Co合金在200℃退火后均可降低電阻.此外,他們認為活化時使用不同的SAM可能會影響化學鍍CoWP阻擋層的性質.不同的SAM對阻擋層成核、生長過程中形態(tài)演變有不同程度的影響,最終將導致孵化時間、覆蓋率及電氣性能的不同.隨著芯片制程的縮小,對阻擋層厚度提出了更高的要求,為了化學鍍超薄Co阻擋層, Chen等[81]在使用SC-1對基底表面進行處理后,增加了等離子體處理的步驟,使Co離子可高密度地吸附在表面,進而獲得了8 nm的超薄CoP阻擋層(圖15b),能夠在至少550℃的溫度下保持整個金屬化層的完整性.
覆蓋阻擋層對于芯片內互連也很重要,用于防止下層的銅擴散至上層的介電材料中.根據(jù)對活化的需求,化學鍍覆蓋阻擋層可分為兩大類,需要額外催化劑活化和無需額外催化劑活化.需要額外催化劑的化學鍍覆蓋層流程如圖15c所示, Decorps等[82]使用酸性溶液去除65 nm節(jié)點銅互連導線表面的氧化層,并通過噴霧方式用Pd活化銅表面,最后浸泡在鍍液中得到12 nm厚CoWP覆蓋層(圖15d). Pd催化劑可能會導致電阻的上升并成為器件雜質,因此研究者們也在關注無額外催化劑化學鍍覆蓋層.次磷酸鈉作為還原劑時,銅并不能催化Co離子的還原. Aal等[83]將鐵線或鋁線浸入鍍液發(fā)生置換反應,用于啟動化學鍍.使用DMAB作為還原劑,可直接在銅的催化下還原Co離子. Itabashi與其合作者[84-85]借助DMAB實現(xiàn)了在銅互連導線表面自對準化學鍍CoWB覆蓋層(圖15e). Almog等[86]將次磷酸鈉與DMAB聯(lián)用,做到了自對準化學鍍CoWPB四元合金覆蓋層,能夠在550℃下阻擋Cu的擴散,且電阻僅為1.8Ω?sq?1.

根據(jù)擴散阻擋機理,擴散阻擋層分為犧牲型、填充型、被動復合型和非晶型. Pan與Hsieh[87-88]使用敏化-活化法化學鍍CoWP作為UBM阻擋層,并用固態(tài)時效與液態(tài)時效老化探究它們在面對不同焊料時的擴散阻擋特性.α-CoWP在作為SnAgCu焊料的阻擋層時,會提供犧牲型、填充型和非晶型的阻擋機理; poly-CoWP能提供犧牲型和填充型.在面對SnBi焊料時,無定形CoWP能作為犧牲型及填充型阻擋層,多晶CoWP表現(xiàn)為犧牲型.
5芯片互連化學鍍銅種子層
阻擋層電阻一般較大,這對于芯片內及TSV內傳統(tǒng)電鍍填充銅互連材料的工藝是不利的.比如,在使用大馬士革工藝電鍍填充銅時,對于大尺寸的晶圓,阻擋層過大的電阻會使電鍍接觸點(通常為邊緣)到晶圓中心出現(xiàn)IR壓降,導致銅沉積不均勻,因此必須在填充銅之前覆蓋一層導電的銅種子層.通常采用PVD或CVD的方式制備銅種子層,但正如前述,這兩種工藝不僅成本高,而且可能出現(xiàn)“倒垂”現(xiàn)象,導致后續(xù)電鍍銅填充的失敗[50].化學鍍優(yōu)秀的保形能力及低成本引起了研究人員的關注.
5.1芯片化學鍍銅鍍液組成及作用
表6列舉了常見的銅種子層鍍液配方.鍍液中通常使用硫酸銅作為銅源,乙二胺四乙酸(EDTA)與酒石酸鉀鈉則被廣泛地用作絡合劑,可防止銅離子在堿性條件下沉淀[37,89-90].除絡合劑外,研究者們還會加入一些添加劑改善鍍銅質量[91].例如加入表面活性劑可以增加鍍液的潤濕能力,有利于氫氣的排出[92-93]; 5,5-二甲基乙內酰脲可避免鍍液中產生銅與氧化亞銅的微小顆粒[94];硫代硫酸鈉可增強鍍液穩(wěn)定性[95]; PEG可以控制鍍銅速率[96]; Inoue等[45,97-100]在鍍液中添加PEG-硫醇體系使銅種子層在大縱橫比的TSV內均勻沉積,他們還發(fā)現(xiàn)2,2'-聯(lián)吡啶添加劑能夠發(fā)揮穩(wěn)定劑及光亮劑的作用,可提升沉積的銅膜純度,降低粗糙度.
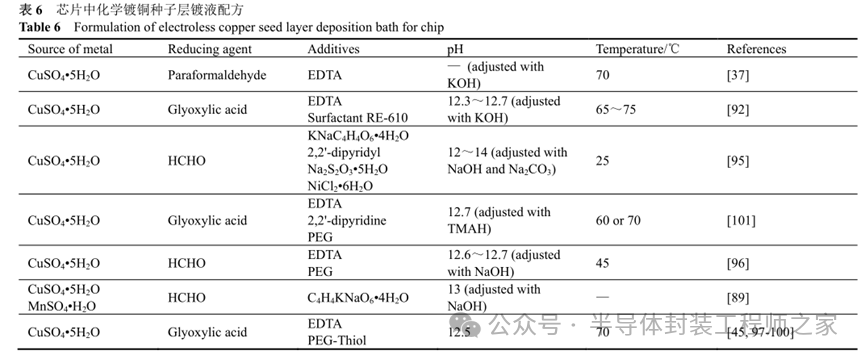
化學鍍液大多使用甲醛作為還原劑,但甲醛作為1類致癌物,對人們的身體健康有重大威脅,為此研究者們開發(fā)了其他一些還原劑作為替代品.在銅種子層鍍液中,乙醛酸得到了廣泛研究.早在1999年, Shacham‐Diamand等[92]就將乙醛酸用于化學鍍芯片內互連銅種子層.但當時的工藝并不成熟, Shacham‐Diamand認為此方案只適用于修補PVD沉積的銅種子層. 2003年Wang等[101]配制的乙醛酸鍍液便已可以在TaN或WN阻擋層上沉積銅種子層. Inoue等[97,99]以乙醛酸為還原劑繼續(xù)研究鍍液配方,探究了EDTA、2,2'-聯(lián)吡啶等添加劑的作用.化學鍍銅液需要在堿性下工作,由于堿金屬離子對芯片器件不友好,研究者們也開發(fā)了TMAH作為NaOH、KOH等pH調節(jié)劑的替代品[101].
5.2化學鍍芯片內銅種子層
化學鍍銅種子層既可選用活化工藝,也可以通過置換法引發(fā)化學鍍. Wang等[101]用濕法刻蝕去除了TaN或WN阻擋層表面的氧化物,在乙醛酸為還原劑的鍍液中,TaN或WN的氧化還原電位低于Cu的氧化還原電位,因此可置換出銅,從而驅動無需活化的化學鍍銅種子層.退火后鍍層黏附強度可達0.11 kgf/cm,足以支持CMP.但應用更為廣泛的還是活化鍍銅的制備方式. Lee等[37]使用敏化-活化法制備了銅種子層.經過對比,化學鍍方式制備的銅種子層無論是側壁還是底部臺階的覆蓋率都要優(yōu)于PVD制備的銅種子層(圖16a). Lim等[102]利用Pd存在時DMAB的氧化電流,引入了一種電化學監(jiān)測方法,用于表征敏化-活化后阻擋層表面吸附的Pd納米顆粒數(shù)量與面積(圖16b),并以此優(yōu)化催化過程.

除敏化-活化法,使用SAM捕獲催化劑離子并活化也是常見手段. Chen與其合作者[22,103]經過對比發(fā)現(xiàn),在Ta、TaN阻擋層上使用OTS-SAM吸附Ni離子、Pd離子并 還 原 得 到 的 納 米 顆 粒 尺 寸 要 遠 小 于 直 接 通 過Ta-OH基團吸附并還原的(圖16c),且吸附密度提高了至少一個數(shù)量級,能夠沉積更好的鍍層(圖16d). Wu等[25]使用ETAS在SiO2/Si襯底上制備SAM,用于吸附Pd納米顆粒活化基底.退火后, ETAS分子層表現(xiàn)出了很強的束縛能力,黏附強度可達5.6 MPa.此外,通過對比有無SAM的鍍銅后橫截面圖像(圖16e),發(fā)現(xiàn)ETAS分子層很可能發(fā)揮著阻擋層的作用. Yu等[89,104]使用Ru層作為活化層,化學鍍Cu-Mn種子層, Mn會以氧化物或氫氧化物的形式沉積.經過退火, Mn會在Cu-基底界面處偏析,從而形成阻擋層.他們還利用在Cu與Ru上欠電位沉積鉛的起始電位差異,獲得了Cu種子層在Ru上的覆蓋數(shù)據(jù),研究了Cu種子層的生長模式.
5.3化學鍍TSV銅種子層
在Ta/TaN和Ti/TiN阻擋層上沉積金屬銅較為困難,而Ru、W、Co等金屬雖然對于沉積工藝較為友好,但它們 的 阻 擋 效 率 可 能 不 如Ta/TaN和Ti/TiN. Inoue等[45,97-99,105-106]認為,使用原子層沉積或化學氣相沉積將Ru、W、Co等金屬沉積至Ta/TaN、Ti/TiN等良好的阻擋層上,則可以結合兩者的優(yōu)勢.他們使用ALD在TiN阻擋層上分別沉積了Ru、W層,使用CVD在TiN阻擋層上沉積了Co層,并實現(xiàn)了在TSV阻擋層上無催化劑化學鍍銅種子層,但它們的原理并不相同. W會與鍍液中的銅離子發(fā)生置換反應,使Cu在W層表面析出,自催化化學鍍.但是該方式化學鍍的銅種子層與W層黏附強度很低,這可能是因為置換反應發(fā)生時還會生成W的氧化物種,殘留在Cu與W的界面處,導致黏附強度的下降. Co同樣會與銅離子發(fā)生置換反應從而使化學鍍銅進行,但置換反應對Co層的腐蝕對于制作工藝是不利的.在化學鍍初期,置換反應與沉積反應是競爭關系,可以通過調整鍍液中EDTA與銅離子的濃度使化學鍍銅種子層的過程中Co的置換反應達到最少,使用該方案化學鍍銅種子層的TEM圖像如圖17a所示.而Ru層對化學鍍銅種子層起的是催化作用,沒有氧化物種的生成,所以黏附強度較高.使用乙醛酸作為鍍液的還原劑可以縮短化學鍍銅時Cu核在Ru層表面生成的時間,2,2'-聯(lián)吡啶的加入可以獲得更光滑、純度更高的銅種子層.該技術可在3μm×50μm的TSV內化學鍍銅種子層(圖17b),并應用于30 mm的晶圓上.無獨有偶, Seo等[96]同樣使用Ru層作為催化層化學鍍銅種子層.但不同的是,他們在Ta阻擋層上使用化學鍍的方式沉積Ru層,相比于ALD方法設備成本更低,實現(xiàn)了沉積Ru層到電鍍銅填充TSV的全濕工藝(圖17c). Ho等[107]為嵌入式晶圓級封裝開發(fā)了模內通孔互連,使用化學鍍方式沉積銅種子層.
Inoue等[100]在鍍液中添加PEG-硫醇添加劑,在縱橫比高達10的TSV中成功制備了共形的銅種子層.Zhang等[108]在化學鍍銅種子層前引入Cu濺射,增強了種子層的連續(xù)性. Xiao等[109]提出脈沖超聲輔助化學鍍方法,成功在580μm深的TSV中沉積了連續(xù)且致密的銅種子層.
5.4芯片封裝載板化學鍍種子層
在目前的大規(guī)模生產制造中,芯片封裝載板和印制電路板(PCB)的孔金屬化種子層主要是通過化學鍍銅來實現(xiàn).芯片封裝載板通常使用半加成工藝(SAP)或改良半加成工藝(mSAP)制造(圖18a).在鉆孔之后,需要使用化學鍍銅技術在積層裸材表面覆蓋一層銅種子層(圖18b),以便后續(xù)的電鍍填充圖形[110].芯片封裝載板的化學鍍工藝已較為成熟,商業(yè)上通常選用化學鍍含鎳的銅膜來提高沉積速率和黏附強度.但是含鎳的銅膜不容易被刻蝕,這可能影響精細圖案的設計制造. Hakiri等[111]使用新開發(fā)的不含鎳鍍液鍍銅,獲得了優(yōu)異的黏附強度和保形能力. Chao等[112]開發(fā)了一種選擇性全加成工藝(SFA)用于替代SAP.如圖18c所示, SFA采用了抗鍍層以實現(xiàn)選擇性化學鍍,在化學鍍銅時間達到40 min時可填上3μm線寬的溝槽(圖18d、18e).與SAP相比, SFA可以摒棄CMP等步驟,其更少的流程步驟顯著降低了總體成本. Beyer等[113]開發(fā)了膠體銅活化劑取代鈀基活化劑,可降低SAP工藝中化學鍍成本.后續(xù)的測試結果也表明其覆蓋率、沉積速率、黏附強度和電氣可靠性性能與鈀基活化劑相當.
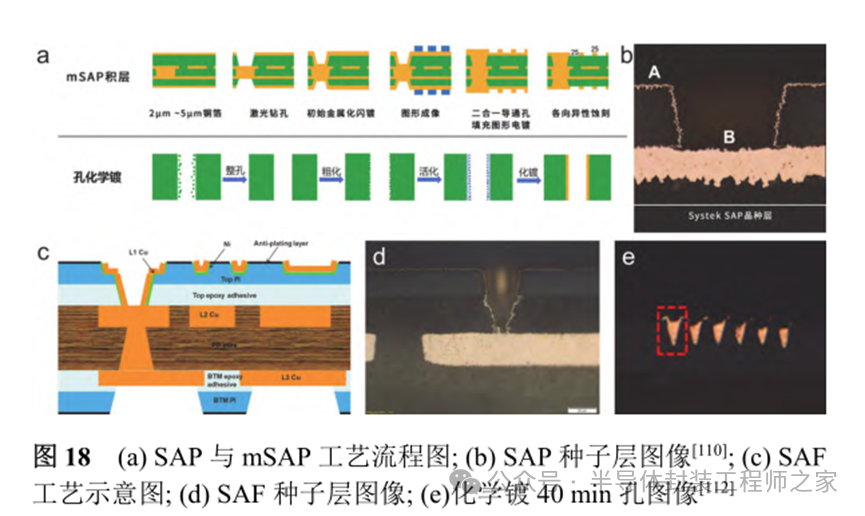
6芯片互連化學鍍孔填充
雙大馬士革工藝以及TSV填充工藝中,由于阻擋層電阻較大,想要進行電鍍填充Cu必須要有種子層的存在.而化學鍍能夠在不導電基材上鍍銅的特性可以減少工序、降低成本,化學鍍直接進行孔填充實現(xiàn)互連的研究得到關注.
6.1超填孔互連化學鍍添加劑及機理
在傳統(tǒng)的電鍍填孔中,由于孔口位置銅離子濃度高,想要對溝槽、過孔和TSV進行自下而上的超級填充,添加劑必不可少[114].超級化學鍍孔填充與電鍍孔填充相似,同樣需要添加劑的輔助,添加劑體系可分為單添加劑體系與雙添加劑體系[115].常見的添加劑體系有SPS、PEG、巰基烷基羧酸(MACA)、三嵌段共聚物、3-N,N-二甲氨基二硫代氨基甲酰基-1-丙磺酸(DPS)和2-巰基-5-苯并咪唑磺酸(MBIS)等. 2004年, Shingubara與其合作者[116-117]使用SPS單添加劑首次實現(xiàn)了超級化學鍍孔填充,并探究其中機理.如圖19a所示,他們認為SPS吸附在沉積的銅膜表面時降低了Cu自催化沉積的活性面積,從而降低Cu的沉積速率.在Cu沉積過程中,SPS會被消耗(結合到銅膜內),溝槽及過孔頂部的SPS會及時補充,繼續(xù)抑制沉積速率,而中部及底部由于擴散的影響,消耗掉的SPS無法被及時補充,形成了濃度梯度,因此沉積速率也形成梯度,從而實現(xiàn)了自下而上的化學鍍銅沉積.楊等[118-119]探究了不同濃度、不同分子量PEG以及相同分子量PEG、聚丙二醇和三嵌段共聚物EPE對超級化學鍍的影響.結果表明PEG濃度與分子量越大,對化學鍍銅沉積速率的抑制越明顯,在相同分子量的情況下則是EPE對化學鍍銅的抑制作用最強.此外, MACA[120]、三 嵌 段 共 聚 物EPE-8000[121]和PEP-3100[122]均使用抑制機理實現(xiàn)了超級化學鍍孔填充.Lee等[123]使用石英晶體微天平、混合電位分析等方法也對SPS添加劑的機理進行了探究,認為SPS并不是一直表現(xiàn)出抑制作用,在低濃度時SPS起到了加速沉積的效果.此外, DPS[124]與MBIS[125]也具有低濃度時加速沉積、高濃度時抑制沉積的特性,均可用于超級化學鍍填孔.
雙添加劑體系通常包含加速劑與抑制劑.研究者們開發(fā)的抑制劑-加速劑體系有:聚乙二醇與8-羥基-7-碘-5-喹啉磺酸(PEG-HIQSA)體系[126]、聚乙二醇與聚二硫二丙烷磺酸鈉(PEG-SPS)體系[127-128]、聚醚與2-巰基苯并噻唑(PE-3650-2-MBT)體系[129]和三嵌段共聚物與健那綠B(PEP-3100-JGB和RPE-2520-JGB)體系[130-131].雙添加劑體系通常有三個特性:一是加速劑的分子一般較小,擴散速度快;抑制劑的分子量一般比加速劑大,擴散速度慢.二是僅加速劑存在時沉積速率會被加快;僅抑制劑存在時沉積速率會被減慢.三是加速劑與抑制劑同時存在時,沉積速率會被更強烈地抑制.綜上所述,雙添加劑體系實現(xiàn)超級化學鍍孔填充的機理為:抑制劑擴散速度慢,在需要填充的孔內會形成濃度梯度,頂部濃度高,底部濃度低.加速劑因為分子量較小,可視為不存在濃度梯度.在底部加速劑能夠加快沉積速率,而中部與頂部由于抑制劑濃度的增大,沉積逐漸被抑制,從而實現(xiàn)了自下而上的超級化學鍍填孔(圖19b).
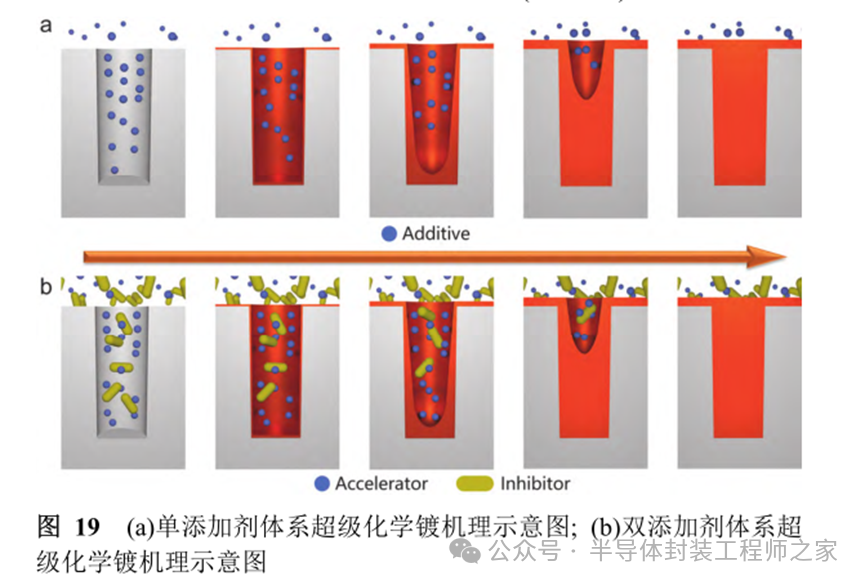
6.2芯片內互連化學鍍填孔
早些年,研究者們對于超級化學鍍填孔的研究重點在于添加劑. Shingubara與其合作者[42,116-117]開發(fā)了SPS與PEG-SPS體系在超級化學鍍填孔中的應用; Hasegawa等[126]使用HIQSA替代SPS; Wang與其合作者[121-122,129]開發(fā)了三嵌段共聚物作為抑制劑; Lee等[124-125,132]開發(fā)了MBIS、DPS等添加劑,并使用2,2'-聯(lián)吡啶提高沉積的銅質量,避免退火后產生空隙; Wang等[130-131]則更加關注以JGB為加速劑的體系,開發(fā)三嵌段共聚物作為抑制劑. Lee等探究了鍍液中添加劑和鍍銅條件的影響,在優(yōu)化后實現(xiàn)了30 nm線寬溝槽的填孔(圖20a).后續(xù)研究者們的關注點轉向了工藝優(yōu)化及超級化學鍍填充Co的可能性. Lim等[43]采用聲化學法,利用超聲將Pd納米顆粒均勻地還原在Ta阻擋層上,并實現(xiàn)了溝槽內的超級化學鍍銅填孔.隨著工藝制程(線寬)的縮小,芯片內銅互連線的電阻上升,將會對芯片性能造成影響. Chen等[30,133-134]認為應該縮小阻擋層厚度,為最大限度增加銅線寬留出空間.他們給出的解決方案是用于捕獲金屬離子的SAM兼作阻擋層.經過實驗,他們發(fā)現(xiàn)脂肪族NH2-SAM、APTMS-SAM和MPTMS-SAM都可以發(fā)揮阻擋層的作用,且成功利用它們捕獲金屬離子并還原,催化超級化學鍍填孔(圖20b).這將簡化工藝,降低填充Cu的電阻.研究者們提出的另一種解決方案為使用Co代替Cu作為互連線材料[135],因為在線寬很小時,不需阻擋層的Co互連線比需阻擋層的Cu互連線總電阻更低[136]. Veen等[137]提出并實現(xiàn)了BEOL中過孔的Co超級化學鍍填充.在W基底上使用Pd催化化學鍍鈷;在填充Cu的溝槽上可以無需催化劑直接化學鍍鈷(圖20c、20d).無獨有偶, Yu等[138]在28 nm技術節(jié)點實現(xiàn)了超級化學鍍鈷填充BEOL過孔,且電遷移失效分析表明其壽命要長于Cu.
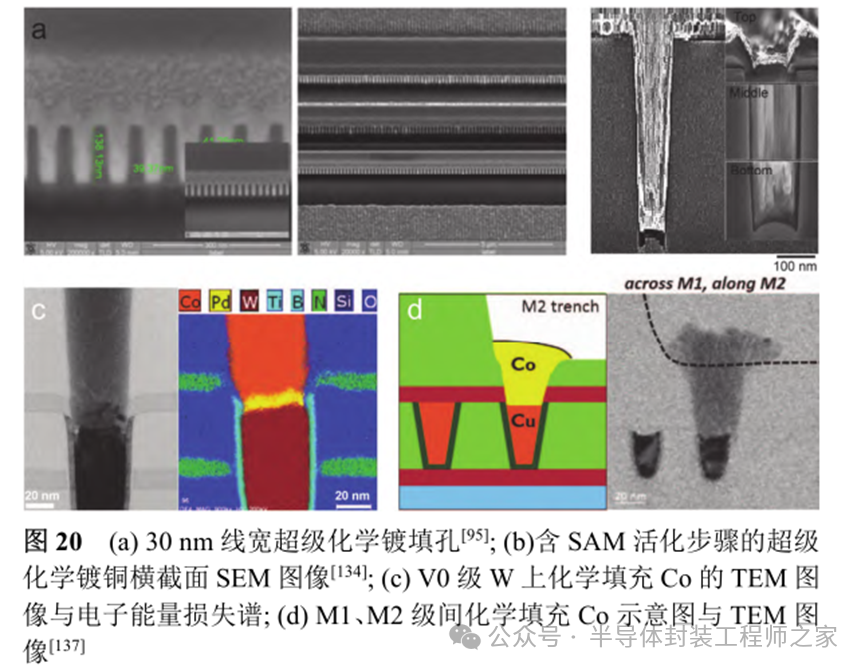
在面對孔徑與深度都遠大于芯片內互連的三維封裝TSV時,化學鍍填充TSV更為困難,但隨著3D封裝互連線寬的不斷變小,化學鍍填充TSV也變得更具可行性. Inoue等[53,139]在覆蓋有W層的TSV內,使用含SPS與氯離子的鍍液成功地在開口為2μm×8μm、縱橫比為18.5的TSV內完成了保形化學鍍銅.但如圖21a所示,初始填充的Cu并沒有完全閉合, TSV中心仍有一條空隙存在.后續(xù)經過二次鍍銅,成功地填充了該TSV.Mariappan等[140]使用PVD在孔徑為11μm、縱橫比為5.5的TSV內沉積WNi阻擋層/活化層,并成功地使用化學鍍銅填充了TSV(圖21b).化學鍍填充TSV研究得更多的是Ni填充,因為Ni不需要額外的擴散阻擋層.Kawano等[141]開發(fā)了能夠在以W層為底的TSV內化學鍍填充Ni并形成背凸的工藝,在W上使用Pd催化化學鍍鎳,形成背凸后進行化學鍍鈀浸金.該化學鍍工藝將電鍍需要的10道工序縮減至2道(圖21c),并使用該工藝制 造 了 堆 疊 式 動 態(tài) 隨 機 存 取 存 儲 器(DRAM). Du等[142]發(fā)現(xiàn),在鍍液中當活性金屬與金焊盤接近而不是直接接觸時也會發(fā)生化學鍍鎳,稱為非接觸感應化學鍍鎳.他們將此技術與晶圓轉移技術相結合,根據(jù)圖21d流程,制造了微機電系統(tǒng)通孔(TMV),用于連接CMOS與微機電系統(tǒng). Murugesan等[143]在12英寸晶圓上制造了孔徑為500 nm、縱橫比20的TSV,并使用改進過的化學鍍鎳工藝進行了填充(圖21e).該工藝與CMOS BEOL相兼容,可用于未來制造小孔徑TSV 3D互連.
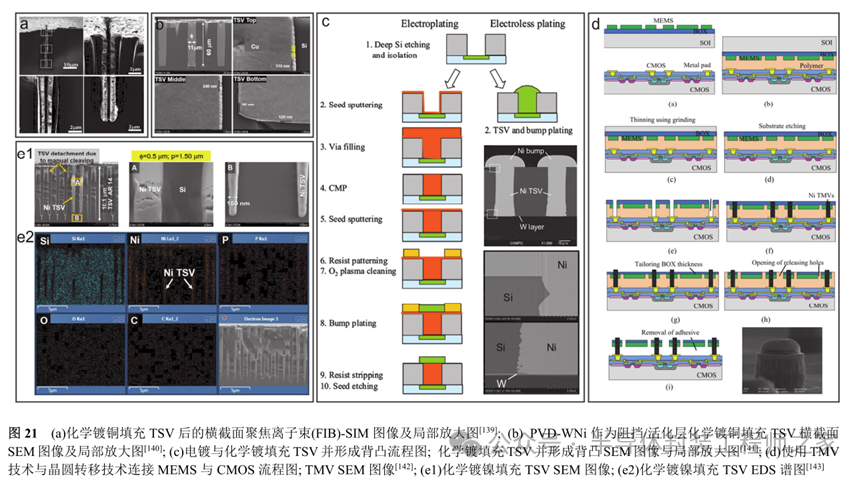
6.3RDL和凸點鍵合化學鍍填孔
芯片封裝中凸點通常使用電沉積方式制造.但由于電流密度分布不均勻,難以制造小間距的均勻凸點.此外,為電沉積提供電流的引線也有可能干擾高速信號的傳輸.因此,化學鍍制造凸點也得到了廣泛關注. Kim等[144-145]探究了化學鍍鎳形成凸點鍍鎳浴參數(shù)的影響,包括穩(wěn)定劑濃度、溫度、pH值和焊盤尺寸等,并提出了其最佳工藝條件.化學鍍金體系通常含有氰化物[146],對環(huán)境不友好, Yokoshima等[58]開發(fā)了一種無氰鍍金浴,克服了傳統(tǒng)化學鍍金沉積速率低、凸點高度無法超過5μm的缺點,成功地在Cu線上制造了高度與直徑均為10μm、間距為20μm的Au微凸點陣列(圖22a). Watanabe等[147]在上述工作的基礎上,繼續(xù)對金凸點進行高度測量、剪切測試、X射線光電子能譜分析,并在鍵合后進行SIM觀察、剪切測試和四端測量等(圖22b、22c).最終結果表明金凸點具有良好的機械性能和電學性能.化學鍍的必要條件是有活性的活化物種, Koo等[148]利用該特性實現(xiàn)了在填充Cu的TSV上自對準化學鍍Cu/Sn凸點,并使用2,2'-聯(lián)吡啶增強銅的選擇性沉積.相比于電鍍制造,化學鍍工藝有效地降低了總過程成本和時間(圖22d~22h).
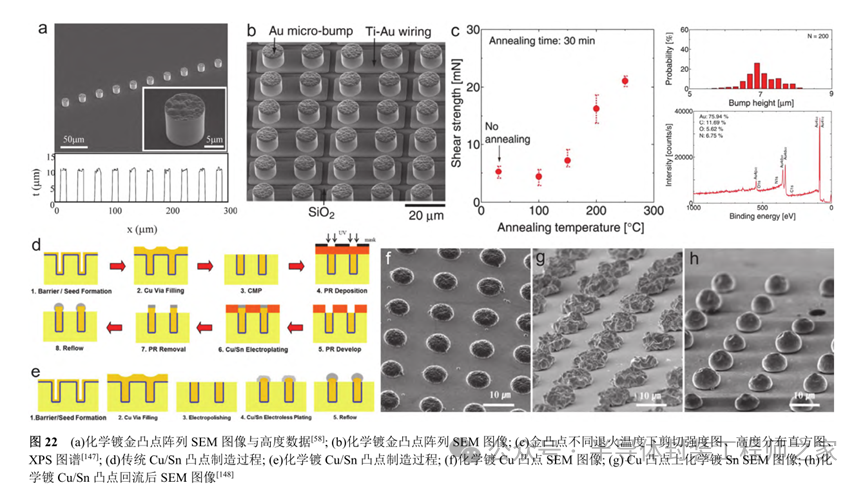
在芯片制程不斷進步的今天,基于傳統(tǒng)焊料的凸點互連可能面臨電氣連接、熱穩(wěn)定性和機械可靠性問題,包括抗電遷移能力差或形成脆性金屬間化合物.與傳統(tǒng)焊接技術相比,銅柱凸點能夠提供更高的I/O密度以及更低的熱阻、電阻和出色的電遷移電阻[149].目前使用最為廣泛的銅柱鍵合技術是熱壓,然而其高溫高壓的條件可能會對芯片產生不良影響.因此,研究者們探究了條件溫和的化學鍍工藝在銅柱凸點鍵合上的應用. Koo等[150]使用SPS作為添加劑,在兩個銅柱凸點間形成的縫隙內實現(xiàn)了超級化學鍍填孔,成功地將銅柱凸點相連. Chen等[151]通過使用一種結晶改進劑,使銅層的生長達到高度各向異性,形成尖銳而快速生長的微錐,沉積速率可達15 μm?h?1.如圖23a所示,兩個銅柱凸點之間相向生長的微錐最終將會閉合,使凸點相連.失效分析表明,微錐閉合處黏附強度優(yōu)秀,失效主要發(fā)生在凸點與基底之間的斷裂以及化學鍍銅連接層與凸點之間的斷裂(圖23b). Kao與其合作者[7,152-154]開發(fā)了微流控化學鍍互連工藝(MELI). MELI工藝流程與器件如圖23c所示,對芯片上的銅柱凸點進行清洗、刻蝕、活化(可選)之后,將兩個芯片對齊,使用UV樹脂使它們能夠堆疊放置.隨后,將堆疊的芯片放置在由聚二甲基硅氧烷(PDMS)和玻璃板組成的微流控夾具中,兩根玻璃管分別作為微流控通道的入口和出口連接到PDMS夾具上.借助MELI,可以通過化學鍍鎳、化學鍍銅和化學鍍金來鍵合銅柱凸點.在使用化學鍍鎳與化學鍍銅鍵合時,可能產生凸點陣列鍵合不均勻的現(xiàn)象(圖23d),其原因有二:一是原子氫的流動.原子氫是鍍鎳與鍍銅時還原反應產生的中間體, MELI施加的鍍液流動可能會將原子氫從Ni或Cu表面帶走,導致微流道入口處的凸點跳鍍,出口處凸點過鍍.二是氫氣泡的產生.化學鍍過程中產生的氫氣泡可能困在需要連接的凸點間,阻擋化學鍍的進行,導致銅柱凸點無法鍵合.為了解決鍵合不均勻的問題, Hung等[7]采用定期停止流動和定期逆流的方式,稱為間歇振蕩流.在使用該方式后,雖然化學鍍鎳仍會出現(xiàn)部分過鍍柱,但化學鍍銅已經能均勻鍵合了.間歇振蕩流除可以讓化學鍍銅與化學鍍金的方式均勻鍵合外(圖23e~23g),還可以大幅縮短工藝時間.圖23h展示了使用3種MELI工藝鍵合銅柱的SEM圖片.Zhang等[155]對MELI工藝進行建模計算與實際實驗驗證.結果表明該技術的主要局限是微通道中傳質不足,他們通過探究流速與逆流對傳質的影響,調節(jié)參數(shù)顯著增強了化學鍍鍵合的均勻性.
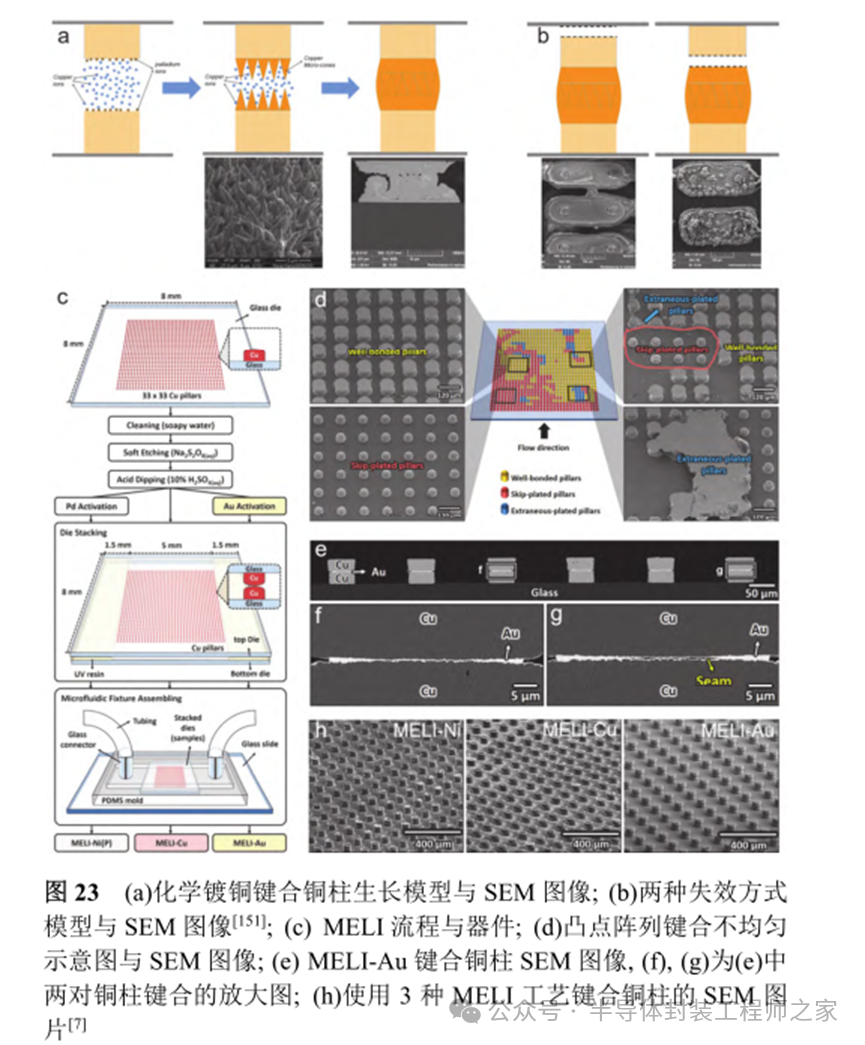
7總結與展望
在芯片工藝制程不斷縮小的今天,不僅僅是芯片內互連線,包括TSV、UBM、凸點等的制造工藝面臨著挑戰(zhàn).互連線與TSV尺寸的縮小使得傳統(tǒng)的PVD、CVD工藝制備阻擋層、種子層時容易形成“倒垂”現(xiàn)象,化學鍍因其優(yōu)秀的均鍍保形能力恰好滿足了芯片內互連與3D封裝TSV中阻擋層、種子層均勻沉積的需求,被研究人員寄予厚望.此外,化學鍍因其工藝簡單、設備成本低和條件溫和等優(yōu)點,還被研究用于填充芯片互連線、填充TSV、UBM、凸點及鍵合等.例如,傳統(tǒng)電沉積方式在制造小尺寸凸點時,可能會由于電流密度不均勻導致凸點陣列不均勻;傳統(tǒng)熱壓鍵合銅柱凸點的方式可能會破壞芯片.使用化學鍍工藝替代將會大幅降低成本,并解決上述問題.但目前化學鍍仍存在一些問題,例如傳統(tǒng)化學鍍預處理工藝復雜;較慢的沉積速率在制造凸點、填充TSV時耗時較長,在TSV粗孔時甚至可能出現(xiàn)不能完全填充的情況;傳統(tǒng)化學鍍銅液中使用甲醛造成的污染等.目前對于芯片化學鍍預處理工藝常用接枝活化,不再需要粗化、敏化等工序,復雜度已大幅降低.更重要的是,選用化學鍍工藝所導致的整體工序簡化將帶來更高的收益.例如SAM將有可能發(fā)揮阻擋層的作用從而不再需要沉積阻擋層,化學鍍技術填充互連線或TSV將不再需要種子層,且與電鍍相比過鍍現(xiàn)象不易發(fā)生從而減少后續(xù)CMP的時間與成本.化學鍍鍍速慢的缺點也被逐漸解決,已有部分研究者對鍍液進行改進以提升沉積速率,如高速鍍銅浴[156]、高速鍍鎳浴以及上文中提到的高速鍍金浴等[58].雖然部分研究并非針對芯片化學鍍,但其鍍液添加劑與體系均可活用于芯片化學鍍中.此外,隨著新一代芯片工藝制程的線寬不斷縮小, TSV孔徑與深度、凸點尺寸都會相對應縮小以適應需求,使得對于化學鍍的鍍速不需很高.而關于鍍液中甲醛的污染,也已有乙醛酸、次磷酸鹽作為替代[157],污染問題將被解決.因此雖然目前介紹的多數(shù)研究成果尚停留在實驗室階段,還沒有在工業(yè)生產中普遍應用,但隨著技術的不斷進步,且近年來隨著芯片工藝制程節(jié)點線寬進一步不斷縮小至3 nm及以下,對于芯片內及封裝導電互連也提出更小孔徑金屬化的要求,如TSV孔徑與深度、凸點尺寸都需對應縮小以適應更小制程節(jié)點,化學鍍因其獨特的優(yōu)勢很有希望在未來更低線寬芯片制造中得到廣泛的使用.
-
集成電路
+關注
關注
5420文章
11991瀏覽量
367579 -
半導體
+關注
關注
335文章
28703瀏覽量
234369 -
芯片制造
+關注
關注
10文章
681瀏覽量
29599
原文標題:芯片制造中的化學鍍技術研究進展
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
新型銅互連方法—電化學機械拋光技術研究進展
印制電路板用化學鍍鎳金工藝探討-悌末源
FPC的電鍍,化學鍍及熱風整平
《炬豐科技-半導體工藝》用于半導體封裝基板的化學鍍 Ni-P/Pd/Au
廢舊鎳氫電池回收處理技術研究進展
化學鍍鎳金板問題及解決措施
化學鍍的特點優(yōu)勢及應用介紹
化學鍍的原理及具有哪些應用特性
量子計算關鍵技術研究進展






 芯片制造中的化學鍍技術研究進展
芯片制造中的化學鍍技術研究進展














評論