光模塊、oDSP與交換機(jī)交換芯片是數(shù)據(jù)中心光互連的核心組件,而LPO(線性驅(qū)動可插拔光學(xué))和CPO(共封裝光學(xué))的出現(xiàn)正推動行業(yè)向更低功耗、更高密度演進(jìn)。
一、核心組件功能解析
1.光模塊:光電轉(zhuǎn)換的橋梁
光模塊是實(shí)現(xiàn)電信號與光信號相互轉(zhuǎn)換的關(guān)鍵器件,廣泛應(yīng)用于數(shù)據(jù)中心、電信網(wǎng)絡(luò)等場景。其核心功能包括:
光電轉(zhuǎn)換:發(fā)射端通過激光器將電信號調(diào)制為光信號,接收端通過探測器將光信號轉(zhuǎn)換為電信號。
速率適配:支持從100G到1.6T的多速率標(biāo)準(zhǔn)(如QSFP-DD、OSFP等),滿足不同距離(50m至2km)的傳輸需求。
信號處理:傳統(tǒng)光模塊依賴DSP芯片進(jìn)行信號均衡、糾錯(cuò)和色散補(bǔ)償,例如400G光模塊中DSP功耗占比約50%。
2.oDSP:光模塊的“大腦”
oDSP(光數(shù)字信號處理器)是光模塊內(nèi)價(jià)值量最高的電芯片(占BOM成本20%-30%),其核心作用包括:
調(diào)制與解調(diào):在數(shù)通場景中,PAM4oDSP通過4電平調(diào)制提升單通道速率(如50G/100G),并補(bǔ)償信號失真;在電信長距場景中,CoherentoDSP采用相干調(diào)制(如QPSK)實(shí)現(xiàn)高靈敏度傳輸。
信號再生:通過數(shù)字信號處理(如前向糾錯(cuò)FEC)恢復(fù)受損信號,確保長距離傳輸?shù)目煽啃浴?/p>
功耗痛點(diǎn):800G光模塊中oDSP功耗約6-8W,成為光模塊功耗的主要來源。
3.交換機(jī)交換芯片:數(shù)據(jù)轉(zhuǎn)發(fā)的中樞交換芯片是交換機(jī)的核心,負(fù)責(zé)高速數(shù)據(jù)幀的路由與轉(zhuǎn)發(fā),其功能包括:
端口互聯(lián):支持多端口高速連接(如112GSerDes),實(shí)現(xiàn)服務(wù)器、存儲設(shè)備間的低延遲數(shù)據(jù)交換。
協(xié)議處理:集成PAM4調(diào)制、CDR(時(shí)鐘數(shù)據(jù)恢復(fù))和流量控制功能,確保信號完整性。
協(xié)同優(yōu)化:在LPO方案中,交換芯片需承擔(dān)部分原由oDSP實(shí)現(xiàn)的信號補(bǔ)償功能,如線性均衡和時(shí)鐘恢復(fù)。
二、LPO與CPO的技術(shù)突破及影響
1.LPO:可插拔架構(gòu)的降本增效
技術(shù)特點(diǎn):
去DSP化:通過高線性度Driver/TIA芯片替代DSP,取消CDR和復(fù)雜數(shù)字處理,使800G LPO模塊功耗成本以及延遲大大降低。
兼容性:保留QSFP-DD/OSFP等可插拔封裝,支持熱插拔維護(hù),適合短距(<2km)AI算力集群和成本敏感場景。
標(biāo)準(zhǔn)進(jìn)展:基于OIFCEI-112G-Linear-PAM4協(xié)議,已支持800G部分產(chǎn)品商用,但224GSerDes仍需進(jìn)一步驗(yàn)證和探索。
行業(yè)影響:
功耗革命:單機(jī)柜100個(gè)400GLPO模塊年省電費(fèi)超2000元(PUE1.5),散熱成本同步降低。
供應(yīng)鏈重構(gòu):減少對Marvell/Broadcom等DSP廠商的依賴,推動Driver/TIA芯片國產(chǎn)化。
場景局限:依賴交換機(jī)ASIC的信號補(bǔ)償能力,適合同構(gòu)網(wǎng)絡(luò),在異構(gòu)復(fù)雜網(wǎng)絡(luò)中競爭力較弱。
2.CPO:共封裝架構(gòu)的性能躍升
技術(shù)路徑:
近封裝演進(jìn):從NPO(光學(xué)引擎與芯片同板)到CPO(芯片與光引擎共封裝),信號傳輸距離從10cm縮短至毫米級,功耗降低30%-50%。
集成形態(tài):分為A型(2.5D封裝)、B型(Chiplet封裝)和C型(3D封裝),逐步實(shí)現(xiàn)硅光芯片與交換ASIC的深度融合。
硅光核心:CPO依賴硅光技術(shù)實(shí)現(xiàn)高密度光器件集成,預(yù)計(jì)2030年硅光市場份額將達(dá)60%。
行業(yè)影響:
性能提升:1.6TCPO系統(tǒng)可支持51.2T總帶寬,延遲降至亞納秒級,滿足AI訓(xùn)練集群的超高帶寬需求。
生態(tài)挑戰(zhàn):初期依賴專有設(shè)計(jì)(如NVIDIAQuantum-X),缺乏統(tǒng)一標(biāo)準(zhǔn),且光引擎故障需整機(jī)更換,運(yùn)維成本高。
市場分化:CPO主要用于縱向擴(kuò)展(scale-up)網(wǎng)絡(luò)(如多機(jī)柜AI集群),而橫向擴(kuò)展(scale-out)仍依賴可插拔模塊。
三、未來趨勢與技術(shù)博弈
1.多技術(shù)共存:
LPO主導(dǎo)中短期:2025-2027年,LPO在AI算力集群和中小數(shù)據(jù)中心快速滲透,預(yù)計(jì)2027年新增超800萬個(gè)1.6TLPO端口。
CPO長期潛力:2030年后,隨著硅光工藝成熟和生態(tài)完善,CPO在超大規(guī)模數(shù)據(jù)中心逐步商用,尤其在100T+速率場景。
傳統(tǒng)模塊延續(xù):DSP方案仍將在長距、異構(gòu)網(wǎng)絡(luò)中占據(jù)主流,且通過Link Optimized-DSP優(yōu)化功耗。
2.技術(shù)協(xié)同創(chuàng)新:
硅光融合:硅光技術(shù)同時(shí)支撐LPO(降低Driver/TIA成本)和CPO(實(shí)現(xiàn)高密度集成),成為兩者的底層技術(shù)基礎(chǔ)。
封裝突破:3D封裝和TSV(硅通孔)技術(shù)推動CPO向C型演進(jìn),進(jìn)一步縮小體積并提升散熱效率。
標(biāo)準(zhǔn)統(tǒng)一:IEEE802.3和OIF的推進(jìn),將加速LPO的互聯(lián)互通;而CPO需建立開放生態(tài)以解決兼容性問題。
3.產(chǎn)業(yè)鏈重構(gòu):
芯片廠商:Marvell/Broadcom在DSP領(lǐng)域仍具優(yōu)勢,但需應(yīng)對LPO的沖擊;NVIDIA/Intel通過CPO整合硅光與ASIC,強(qiáng)化系統(tǒng)級競爭力。
光模塊廠商:中際旭創(chuàng)、新易盛等積極布局LPO/CPO,但需平衡技術(shù)投入與市場需求,避免過早押注單一方案。
代工廠:臺積電、意法半導(dǎo)體等加大硅光產(chǎn)能,推動CPO規(guī)模化生產(chǎn)。
四、總結(jié)
LPO和CPO的出現(xiàn)標(biāo)志著光互連技術(shù)從“可插拔主導(dǎo)”向“集成化演進(jìn)”的轉(zhuǎn)折。LPO以低功耗、易部署的特點(diǎn)成為中短期主流,而CPO憑借極致性能代表長期方向。兩者的博弈將推動數(shù)據(jù)中心架構(gòu)向更高效、更智能的方向發(fā)展,同時(shí)也為硅光、先進(jìn)封裝等底層技術(shù)帶來新的機(jī)遇與挑戰(zhàn)。未來,多技術(shù)路線的協(xié)同發(fā)展將成為行業(yè)常態(tài),而標(biāo)準(zhǔn)統(tǒng)一與生態(tài)合作將是決定技術(shù)落地速度的關(guān)鍵。
審核編輯 黃宇
-
CPO
+關(guān)注
關(guān)注
0文章
32瀏覽量
347
發(fā)布評論請先 登錄
CPO光電共封裝如何破解數(shù)據(jù)中心“功耗-帶寬”困局?
AMD收購硅光子初創(chuàng)企業(yè)Enosemi AMD意在CPO技術(shù)
硅光方案崛起之高帶寬光通信領(lǐng)域的變革力量
LPO 光模塊:下一代數(shù)據(jù)中心網(wǎng)絡(luò)的節(jié)能高效新選擇
華工科技出席綠色智能船舶區(qū)域協(xié)同發(fā)展座談會
CPO相對LPO的優(yōu)勢剖析
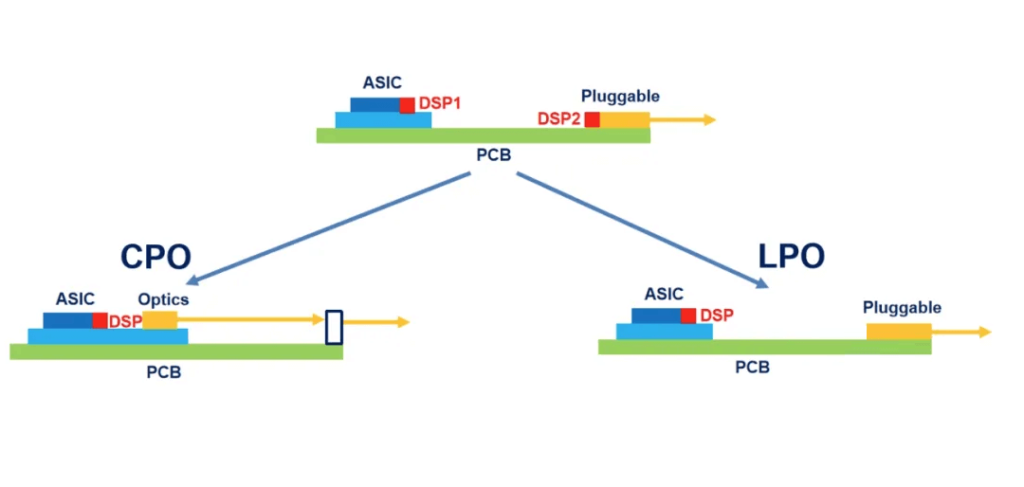
剖析CPO相較于LPO的優(yōu)勢

英偉達(dá)將推出CPO交換機(jī),CPO應(yīng)用落地提速

光電共封裝技術(shù)CPO的演變與優(yōu)勢

Marvell發(fā)布突破性CPO架構(gòu),淺析互連產(chǎn)品的利弊得失






 LPO與CPO:光互連技術(shù)的轉(zhuǎn)折與協(xié)同發(fā)展
LPO與CPO:光互連技術(shù)的轉(zhuǎn)折與協(xié)同發(fā)展










評論