半導體參數(shù)測試需結合器件類型及應用場景選擇相應方法,核心測試技術及流程如下:
?一、基礎電學參數(shù)測試?
?電流-電壓(IV)測試?
?設備?:源測量單元(SMU)或專用IV測試儀,支持fA級電流和kV級電壓精度。
?關鍵參數(shù)?:
?靜態(tài)特性?:閾值電壓(Vth)、導通電阻(Ron)、擊穿電壓(BV)、漏電流(Leakage)。
?測試步驟?:
施加階梯電壓掃描,同步記錄電流響應;
通過V-I曲線提取參數(shù)(如Ron = ΔV/ΔI)。
?應用范圍?:二極管、MOSFET、IGBT等分立器件及集成電路。
?電容-電壓(CV)測試?
?設備?:電容測量單元(CMU),配備四端對(4TP)屏蔽電纜減少寄生效應。
?關鍵參數(shù)?:
輸入電容(Ciss)、輸出電容(Coss)、柵極電荷(Qg)。
?測試步驟?:
施加交流偏壓信號,測量電容隨電壓變化曲線;
通過C-V曲線分析摻雜濃度或界面特性。
?二、動態(tài)參數(shù)測試?
?開關特性測試?
?設備?:高速示波器+電流探頭,需校準通道延遲(小于1ns)。
?關鍵參數(shù)?:
開啟損耗(Eon)、關斷損耗(Eoff)、瞬態(tài)響應時間。
?測試規(guī)范?:
?Eon計算區(qū)間?:電流上升至10%到電壓下降至10%;
?Eoff計算區(qū)間?:電壓上升至10%到電流下降至10%。
?脈沖式IV測試?
?作用?:避免器件自熱效應,精準測量動態(tài)電阻。
?設備?:脈沖發(fā)生器+高速數(shù)字化儀,脈寬低至微秒級。
?三、材料特性測試?
?霍爾效應測試?
?參數(shù)?:載流子濃度、遷移率(μ)、電阻率(ρ)。
?方法?:范德堡法,結合磁場與電流掃描。
?低頻噪聲測試?
?設備?:具備1/f噪聲分析功能的參數(shù)分析儀。
?應用?:評估器件界面缺陷及可靠性。
?四、可靠性測試?
| ?測試類型? | ?關鍵參數(shù)? | ?條件與標準? |
|---|---|---|
| 高溫存儲壽命測試 | 電參數(shù)漂移 | 125°C/150°C,時長500-1000小時 |
| 溫度循環(huán)測試 | 結構疲勞失效 | -40°C?+150°C,循環(huán)≥500次 |
| 高加速應力測試(HAST) | 濕度敏感性失效 | 130°C+85%RH,96-168小時 |
?五、特殊器件測試方案?
?功率器件(IGBT/SiC/GaN)?:
需支持3kV高壓、千安級脈沖電流;
測試項目包括雪崩能量(Ear)、電流崩塌效應。
?納米材料/二維材料?:
采用非接觸式拉曼光譜法測試載流子濃度(誤差<1%)。
TH521系列半導體參數(shù)分析儀是一款用于電路設計的綜合解方案,可幫助電力電子電路設計人員選擇適合自身應用的功率件,讓其電力電子產品發(fā)揮最大價值。它可以評測器件在不同工條件下的所有相關參數(shù),包括IV參數(shù)(擊穿電壓和導通電阻)、三端FET電容、柵極電荷和功率損耗。用于電路設計的TH521系列導體參數(shù)分析儀具有完整的曲線追蹤儀功能以及其他功能。

審核編輯 黃宇
-
半導體
+關注
關注
335文章
28771瀏覽量
235114
發(fā)布評論請先 登錄
半導體測試可靠性測試設備

提供半導體工藝可靠性測試-WLR晶圓可靠性測試
SC2020晶體管參數(shù)測試儀/?半導體分立器件測試系統(tǒng)介紹
有沒有一種能測試90%以上半導體分立器件靜態(tài)參數(shù)的設備,精度及測試范圍寬,可與分選機、探針臺聯(lián)機測試?
半導體測試的種類與技巧

半導體在熱測試中遇到的問題
半導體熱測試常見問題

高壓低漏電開關矩陣RM1013-HV,滿足功率半導體參數(shù)測試應用!


模塊化儀器的技術原理和應用場景
半導體器件測試的理想型解決方案
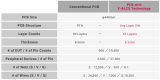
功率半導體雙脈沖測試方案

ATA-5420前置微小信號放大器如何進行半導體測試






 如何測試半導體參數(shù)?
如何測試半導體參數(shù)?












評論