文章來源:半導體全解
原文作者:圓圓De圓
本文主要講述芯片化學機械拋光(CMP)技術(shù)。
一、化學機械拋光(CMP)簡介
化學機械拋光(Chemical Mechanical Polishing,簡稱CMP)技術(shù)是一種依靠化學和機械的協(xié)同作用實現(xiàn)工件表面材料去除的超精密加工技術(shù)。下圖是一個典型的CMP系統(tǒng)示意圖:
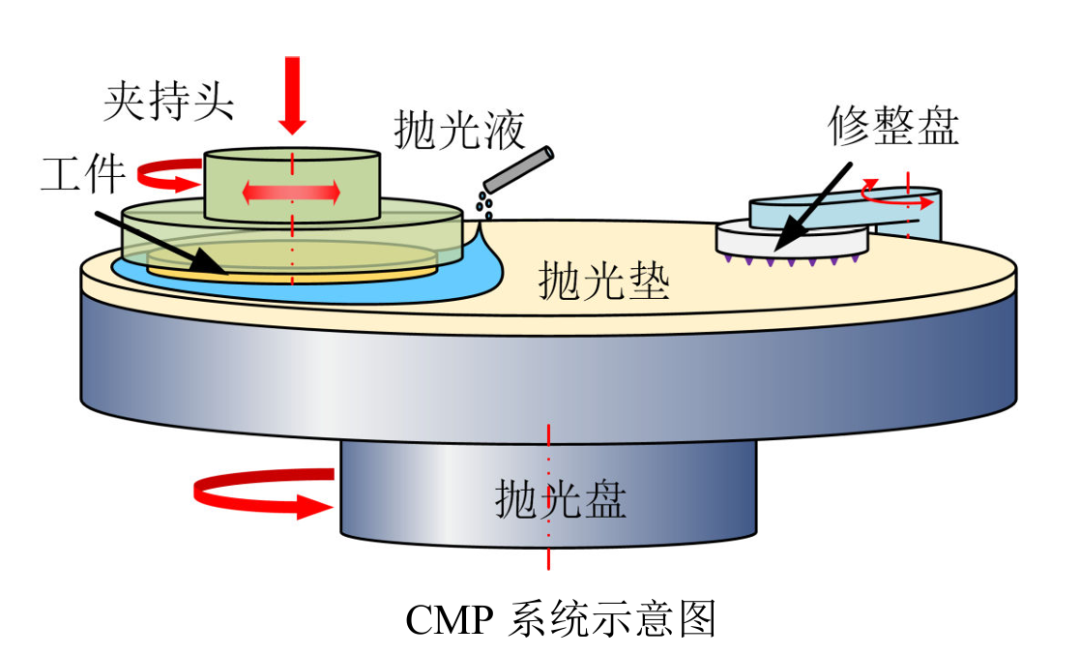
主要包括:夾持工件的拋光頭、承載拋光墊的拋光盤、修整拋光墊表面的修整器和拋光液供給系統(tǒng)四大部分。
在拋光過程中,工件通過拋光頭,按照給定壓力作用在貼有拋光墊的旋轉(zhuǎn)拋光盤上,同時相對自身軸線做旋轉(zhuǎn)運動以及相對拋光盤做往復擺動運動。拋光液輸送在工件和拋光墊之間的接觸界面內(nèi),不斷和工件表面發(fā)生化學反應,通過磨粒的機械作用以及拋光液的化學作用,實現(xiàn)表面材料的去除。
二、化學機械拋光(CMP)發(fā)展歷程
CMP技術(shù)起源于古典拋光技術(shù),在早期主要用于玻璃的拋光。在當時的工藝條件下,復雜的影響因素導致拋光結(jié)果不穩(wěn)定和不可控。在很長一段時間內(nèi),拋光工藝都被當作是一種藝術(shù),而不是一種科學看待。
直到上個世紀八十年代初期,美國IBM公司率先開發(fā)出應用于半導體晶圓拋光的CMP技術(shù)。
CMP在去除上道工序引起的損傷和缺陷的同時,能夠兼顧全局和局部平坦化要求,這使得半導體晶圓表面平坦化程度獲得大幅提高,克服了當時遇到的“深亞微米壁壘”。
進入二十一世紀以來,集成電路 (Integrated Circuit,簡稱IC)制造在“摩爾定律”的指引以及資本的推動下飛速發(fā)展, 已經(jīng)深入到計算機,通信,電子,軍事等各個領域。如今,IC制造儼然成為現(xiàn)代高科技的核心與先導,成為大國之間博弈的重要籌碼。
CMP作為公認的能夠為晶圓表面提供優(yōu)異局部和全局平坦化的唯一技術(shù),在IC制造對人類制造極限的一次次沖擊中獲得了極大的發(fā)展。
目前,CMP技術(shù)遠遠超越了早先在IBM試驗室達到的水平,尤其是在IC制造領域,CMP技術(shù)已經(jīng)能夠?qū)崿F(xiàn)原子水平上的材料去除。
CMP技術(shù)多樣化挑戰(zhàn)IC制造領域?qū)τ贑MP技術(shù)的推動和開發(fā),也促進了CMP技術(shù)在其他制造領域的應用,如光學玻璃加工,強激光元件制造等領域。
三、化學機械拋光(CMP)原理
CMP原子級材料去除過程是在拋光液的化學作用下,拋光墊/磨粒/工件三者之間原子級的摩擦磨損過程是CMP技術(shù)最底層的材料去除過程。
Preston作為拋光技術(shù)的先驅(qū)者,在1926年關(guān)于玻璃拋光的文獻中就提出以下論述:不同于研磨這種依靠機械磨損導致玻璃表面破碎的材料去除方式,玻璃的拋光更像是一種連續(xù)的,在“分子或近似分子”量級的材料去除。
然而,在過去的很長一段時間內(nèi),由于難以確定CMP過程中的化學作用機理,相關(guān)理論研究更多的注重于CMP過程中機械作用,并將材料去除歸因于磨粒和工件之間的“固固”磨損。其中最具代表性的為1991年Kaufman等人的研究,他們提出CMP的材料去除過程是一種化學輔助的機械劃擦過程,具體過程如圖所示:
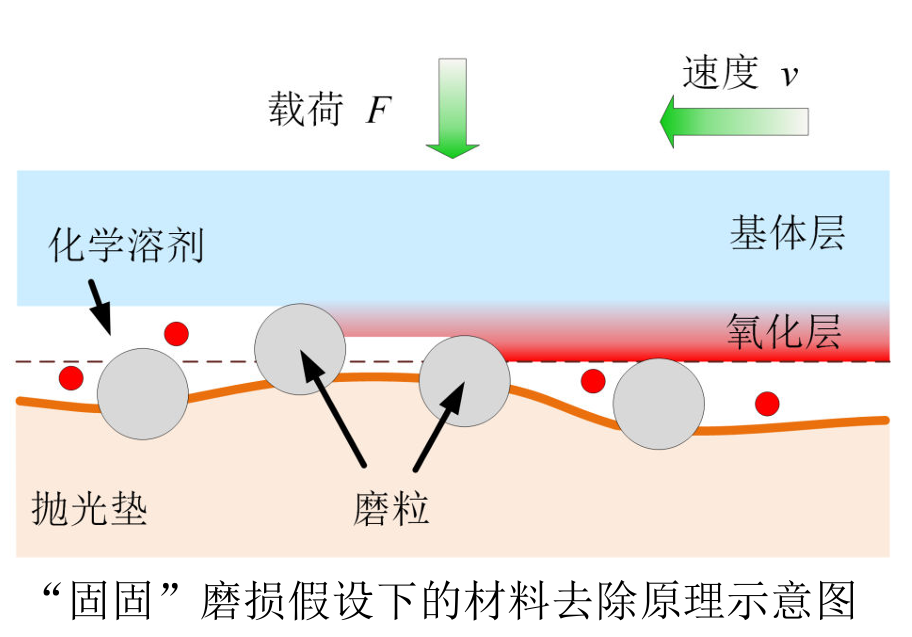
首先,拋光液中的化學溶劑和工件表面發(fā)生化學反應,在工件表面生成一種軟質(zhì)的反應層。磨粒在拋光墊的擠壓下劃擦表面反應層,產(chǎn)生材料去除。反應層被去除之后,底層的新鮮表面重新裸露在拋光液中并生成新的反應層,之后再被磨粒去除,如此循環(huán)往復。
當機械去除和化學反應兩種過程處于平衡時,材料去除效率將達到最佳,并且任何影響這兩個過程的參數(shù)都將對最終的材料去除率以及表面質(zhì)量產(chǎn)生影響。
然而,這種基于機械劃擦理論的材料去除機理的認知在如今面臨很大的局限性。首先,目前CMP技術(shù)可以實現(xiàn)超光滑表面的加工,在拋光GaN,藍寶石等晶體材料時會觀測到原子臺階現(xiàn)象。
原子臺階是由于晶向偏角或者晶格缺陷的存在,導致表面裸露的晶格結(jié)構(gòu)呈現(xiàn)穩(wěn)定的周期性臺階,是表面加工所能達到的理論光滑極限。
顯然,基于磨粒壓入-塑性耕犁的材料去除模式無法解釋CMP這種原子級的極限加工能力。另外,在典型的CMP工況下,拋光液中的納米磨粒壓入工件表面的深度甚至小于一個原子直徑,在這種原子級別的壓入深度下,基于連續(xù)介質(zhì)理論的壓入-耕犁去除模式將不再適用于CMP原子級材料去除機理的解釋。
分子動力學(Molecular Dynamics,簡稱MD)由于可在原子尺度展示所研究系統(tǒng)的動態(tài)運動過程,目前已經(jīng)成為研究CMP在原子尺度上的化學機械協(xié)同作用以及材料去除過程的主要途徑之一。
基于拋光過程的MD仿真模型主要包括磨粒磨損模型和磨粒沖擊模型。兩者均利用MD來模擬磨粒對工件表面的材料去除機制和損傷機理,而前者主要基于納米切削或者納米壓痕過程的仿真。
然而,傳統(tǒng)MD方法基于牛頓力學運動方程,無法考慮化學作用的影響,因此,模擬結(jié)果具有很大的局限性。 基于反應力場的分子動力學(Reactive Force Field-Molecular Dynamics,簡稱ReaxFF MD)方法是MD方法的一種延伸,其突破了MD基于傳統(tǒng)的牛頓運動定律的力場體系,而采用第一性原理的計算方法計算原子級別的動態(tài)過程。另外,通過建立勢能函數(shù)和鍵級的關(guān)系,ReaxFF-MD可以進一步用來描述體系中原子尺度的化學反應。
下圖展示了SiO2磨粒在閾值壓力下劃擦Si表面發(fā)生的單層原子去除過程。
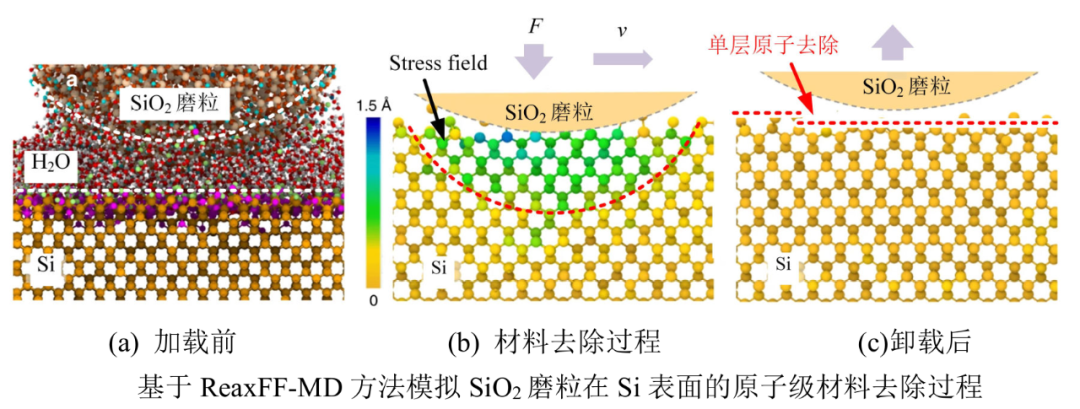
在初始階段,如圖(a)所示,Si工件和SiO2磨粒表面分別和H2O發(fā)生化學反應,生成Si–H和Si– OH官能團。接著,Si和SiO2磨粒在載荷的作用下發(fā)生接觸,表面官能團重組形成Si– O–Si界面橋鍵,如圖(b)所示,其中顏色云圖表示Si原子在載荷作用下的Z向位移。 在滑動過程中,界面Si–O–Si鍵將拉應力傳遞給Si基體,促進Si基體中Si–Si鍵的斷 裂,并發(fā)生表面單層Si原子的去除,如圖(c)所示。
基于原子力顯微鏡(Atomic Force Microscope,簡稱AFM)技術(shù)的AFM探針試驗,是研究原子尺度上材料去除過程的重要試驗方法。
研究發(fā)現(xiàn),金剛石針尖在劃擦Si表面時,只有在大載荷條件下才會造成材料去除,而SiO2針尖卻可以在更小的載荷條件下產(chǎn)生更大的材料去除,并且SiO2針尖的材料去除率和環(huán)境濕度密切相關(guān)。將這種現(xiàn)象歸因于SiO2和Si在H2O環(huán)境中的表面羥基化。當外載荷作用時,SiO2和Si表面的羥基脫水縮合形成Si–O–Si界面橋鍵。
這種原子尺度的機械化學反應,降低了材料去除的能量閾值,使得SiO2針尖可以在更小的載荷下去除材料,并進一步建立了單顆磨粒的材料去除率和最大接觸壓力Pmax以及相對劃擦速度v之間的關(guān)系。
基于上述原子尺度的機械化學反應,科研人員利用直徑為250 μm的SiO2探針,在單晶硅Si(100)面上實現(xiàn)了Si原子的單層去除,并通過高分辨透射電鏡(High Resolution Transmission Electron Microscope,簡稱HRTEM),證實了Si原子的單層去除現(xiàn)象。
盡管上述研究取得了一系列的成果,然而,真實CMP過程中的拋光環(huán)境更加復雜,涉及各類參數(shù),各類材料在拋光過程中的動態(tài)變化等等。
以目前的數(shù)值模擬技術(shù)和試驗技術(shù),要準確建立真實CMP過程中的原子級材料去除模型仍舊存在困難。
四、CMP納/微/宏跨尺度材料去除
化學機械協(xié)同作用下的原子級材料去除過程是CMP技術(shù)最底層的物理過程。然而,這種從原子級的材料去除過程到宏觀材料去除過程的映射,是一個復雜的動態(tài)跨尺度問題。如下圖(a)所示,拋光過程中,工件以給定載荷作用在拋光墊表面并發(fā)生相對運動。與此同時,拋光液在離心力的作用下,流入工件和拋光墊之間的接觸界面,提供供材料去除的納米磨粒以及化學溶劑環(huán)境。
拋光墊作為一種拋光工具,其表面存在大量的微觀粗糙結(jié)構(gòu),因此,粗糙的拋光墊表面只有一些局部高點才會和工件發(fā)生真實接觸,如圖(b)所示。
在CMP過程中,納米磨粒嵌入在一個個接觸點內(nèi),并跟隨拋光墊一起,相對工件表面運動,如圖(c)所示。
最后,在機械載荷以及拋光液的化學作用下,磨粒和工件之間發(fā)生原子級的材料去除,如圖(d)所示。
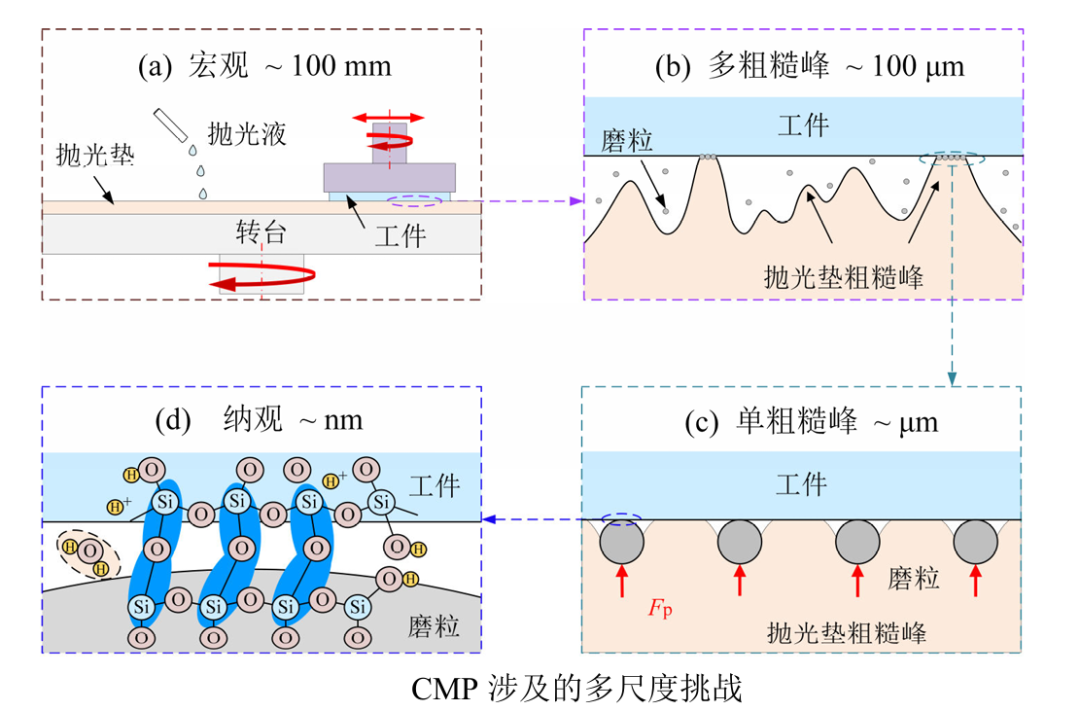
五、拋光墊作用及分類
拋光墊的微觀接觸狀態(tài),指的是拋光墊粗糙表面的高點和工件表面形成的接觸區(qū)域。
一般來說,拋光墊/工件之間接觸點尺寸在1~100 μm范圍內(nèi)。拋光墊的微觀接觸狀態(tài)是拋光墊力學特性和表面微觀形貌的綜合體現(xiàn)。
拋光過程中,任何導致拋光墊表面力學特性以及微觀形貌變化的的因素都會對拋光墊的微觀接觸狀態(tài)產(chǎn)生影響。
以下是拋光墊微觀接觸狀態(tài)的影響因素的詳細討論:
(1)微觀接觸狀態(tài)主要取決于拋光墊的材料力學特性和結(jié)構(gòu)特點
拋光墊一般是由聚氨酯材料制作而成,具有優(yōu)良的機械性能,耐磨損性,以及良好的化學穩(wěn)定性。另外,聚氨酯材料具有很好的可設計性和可加工性,可以滿足不同的工藝需求。這種設計和制造工藝的不同,導致不同拋光墊之間的力學特性和結(jié)構(gòu)特點差異明顯。基于拋光墊的結(jié)構(gòu)特點,將主流的商用拋光墊分為以下四類,如表所示。
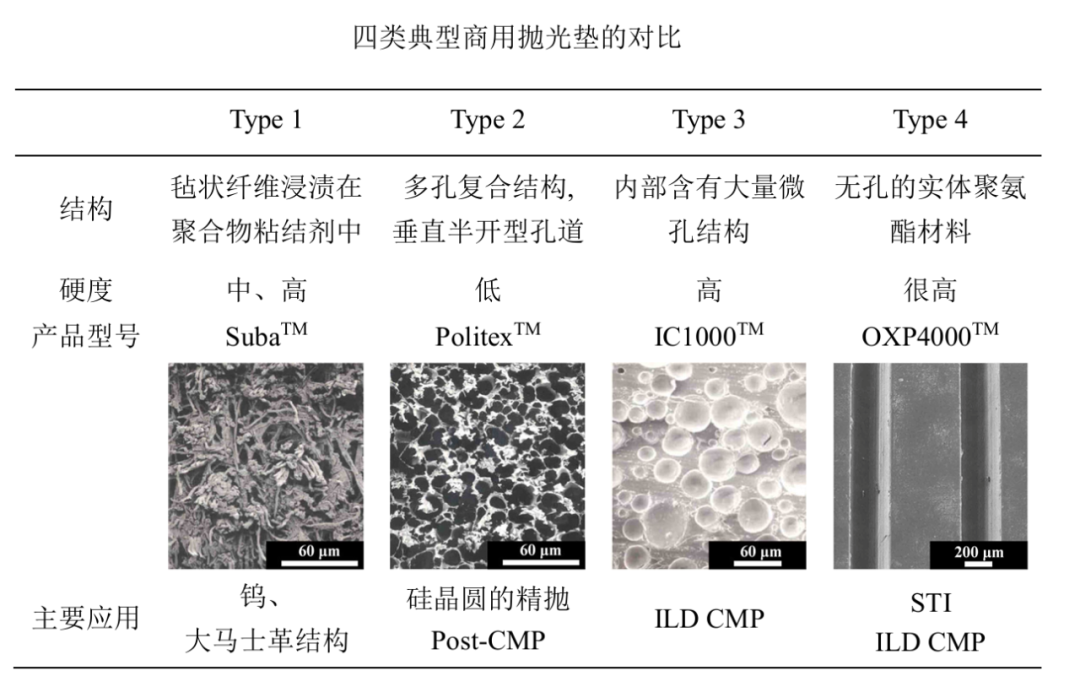
可見,每種類型的拋光墊都有獨特的表面微觀結(jié)構(gòu),表面微觀結(jié)構(gòu)決定了拋光墊的真實接觸狀態(tài),決定了磨粒在接觸界面內(nèi)的承載狀態(tài)以及工件表面的化學反應時間,從而對最終的材料去除率產(chǎn)生影響。
另外,拋光墊的力學特性表現(xiàn)出明顯的非線性特點,首先,為了保證拋光液在接觸界面的存儲和運輸,大部分拋光墊都含有微孔或者間隙結(jié)構(gòu)。
以IC1000系列拋光墊為例,其在制備過程中會填充一定比例的空心聚合物微球,混合固化后在內(nèi)部形成大量半徑10~50 μm的封閉微孔,這種多孔結(jié)構(gòu)導致拋光墊表現(xiàn)出明顯的材料非線性特點。并且,由于拋光機械載荷的作用以及化學溶劑帶來的聚氨酯水解現(xiàn)象,拋光墊表層的力學特性和基體層也將存在很大差異,同樣會帶來顯著的非線性問題。復雜的力學特性導致拋光墊的微觀接觸狀態(tài)變得更加復雜。
(2)微觀接觸狀態(tài)很容易受到拋光過程和修整過程的影響
一方面,CMP的運動特征導致拋光墊粗糙峰不斷經(jīng)歷拋光載荷以及剪切力的循環(huán)作用,從而誘發(fā)粗糙峰發(fā)生塑性流動并趨于平面化,這種拋光墊表面平面化的現(xiàn)象也被稱為釉化現(xiàn)象,如圖(b)所示。
另一方面,拋光液中的磨粒很容易積累在表面微孔結(jié)構(gòu)中,并導致材料去除效率的惡化以及劃痕的產(chǎn)生。因此,實際的CMP過程中大多會引入修整工藝來保證加工質(zhì)量以及加工過程的穩(wěn)定性。
修整是對拋光墊表面進行機械加工的過程,如圖(c)所示。
嵌有金剛石顆粒的修整盤在一定的修整載荷下劃擦拋光墊表面,通過金剛石顆粒的切割作用,重新生成具有一定粗糙度的表面,如圖(d)所示。修整過程直接決定拋光墊表面的微觀形貌,從而影響拋光墊/工件之間的微觀接觸狀態(tài)。然而修整過程是一種隨機過程,如何表征隨機修整過程中的微觀接觸特征,是導致拋光墊微觀接觸狀態(tài)研究復雜的另外一個重要因素。
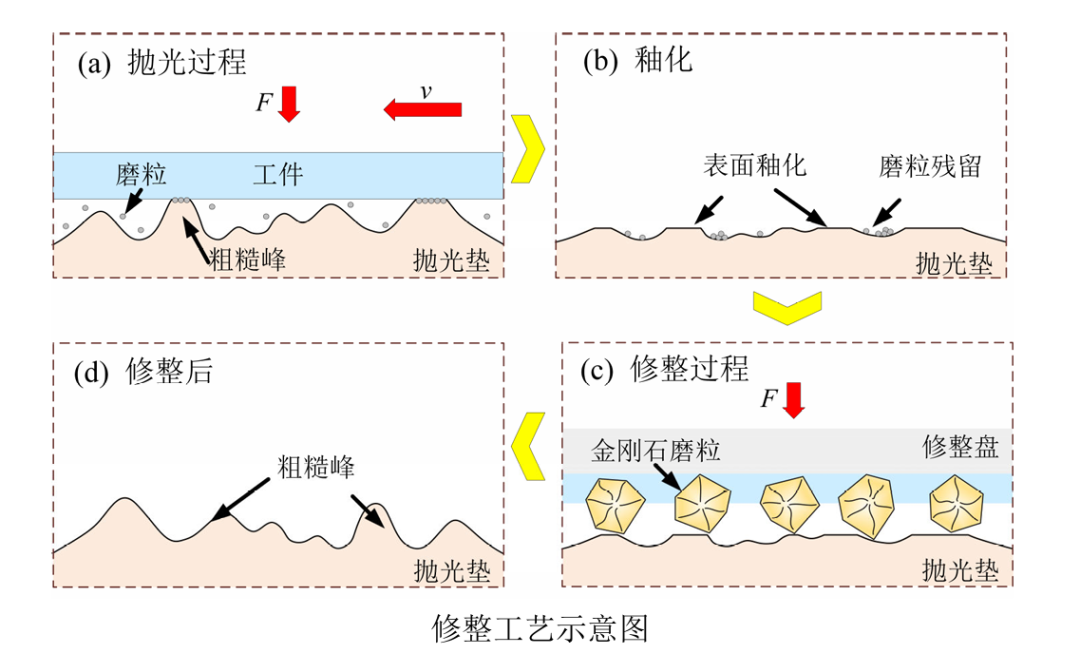
六、CMP面臨的挑戰(zhàn)
多行業(yè)的應用導致CMP技術(shù)面臨多樣化的材料以及加工工藝需求。CMP技術(shù)所面臨的多樣化挑戰(zhàn)包括以下幾部分:
(1)材料多樣化挑戰(zhàn)
CMP工藝所涉及的材料越來越多,包括玻璃、單晶硅、砷化鎵、碳化硅、氮化硅、氮化鎵、硅鍺化合物、銅、鋁、鎢、金、藍寶石、金剛石和各種陶瓷等。
根據(jù)易磨損(Easy to Abrade,簡稱ETA),難磨損(Difficult to Abrade,簡稱DTA)兩類機械特性和易反應(Easy to React,簡稱ETR),難反應(Difficult to React,簡稱DTR)兩類化學特性,將材料分為以下四個大類:
(a)ETA–ETR材料,Cu,Al這種質(zhì)軟、化學特性活潑的金屬材料一般屬于這一類,其在CMP過程中很容易產(chǎn)生劃痕以及化學腐蝕現(xiàn)象。
(b)DTA–ETR材料,SiO2等氧化物阻擋層一般屬于這一類,雖然表面很難被劃擦,但是比較容易發(fā)生化學反應。
(c)ETA–DTR材料,IC領域中的Low k材料和MEMS領域中SU-8光刻膠就屬于這一類。
(d)DTA–DTR材料,一些新型的寬禁帶半導體材料如SiC和GaN一般屬于這一類,材料本身比較硬且有具有很強的化學反應惰性。
可見,不同的材料具有不同的物理化學特性,而CMP技術(shù)本身又是一種依靠化學和機械協(xié)同作用實現(xiàn)材料去除的加工方式,材料多樣化的挑戰(zhàn)對CMP過程中化學和機械協(xié)同作用的理解和控制提出新的要求。
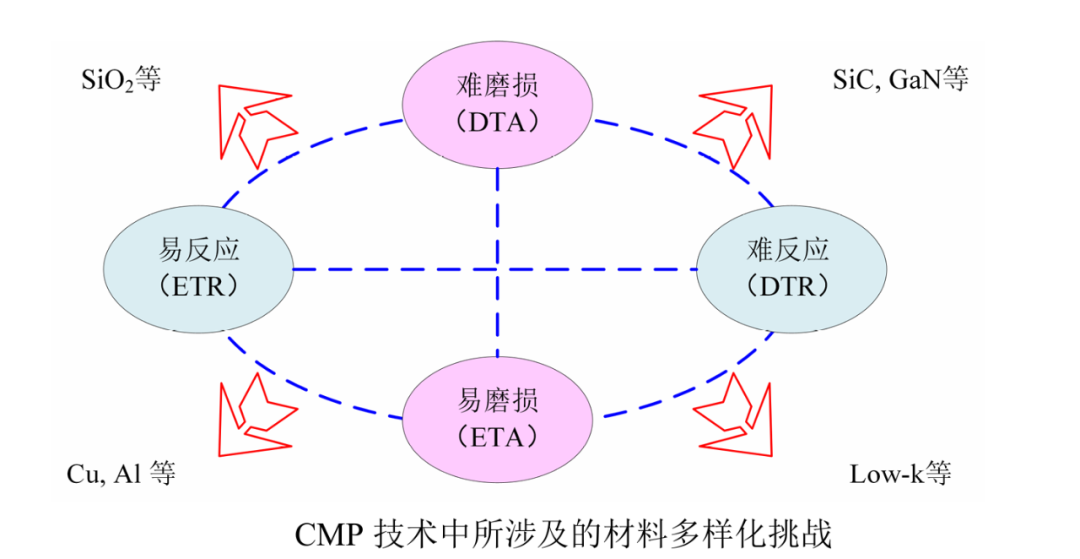
(2)加工技術(shù)指標的多樣化挑戰(zhàn)
不同領域?qū)MP的加工要求和精度指標有所差異,即使是相同領域,不同工藝路線和流程下的加工指標也有所不同。多樣化的加工技術(shù)指標是CMP技術(shù)面臨的另一個挑戰(zhàn)。以IC制造為例,鰭式場效應晶體管(Fin Field-effect Transistor,簡稱FinFET)是7nm制程下廣泛使用的工藝設計。FinFET制造中對CMP技術(shù)提出的技術(shù)指標是在SiN和SiO2層上實現(xiàn)Poly-Si層的選擇性去除,即要求CMP在平坦化過程中具有較高的選擇性去除能力,滿足Poly-Si的高去除率又保證作為襯底材料的SiN,SiO2不被去除。
而3D-NAND是一種將存儲單元在垂直方向進行堆疊從而提高芯片存儲容量的技術(shù)。為了滿足存儲單元在垂直方向堆疊,就需要一些大的溝道結(jié)構(gòu),導致阻擋層和隔離層材料如SiN,SiO2以及poly-Si在沉積時,出現(xiàn)明顯的高度差,如下圖(a)所示。
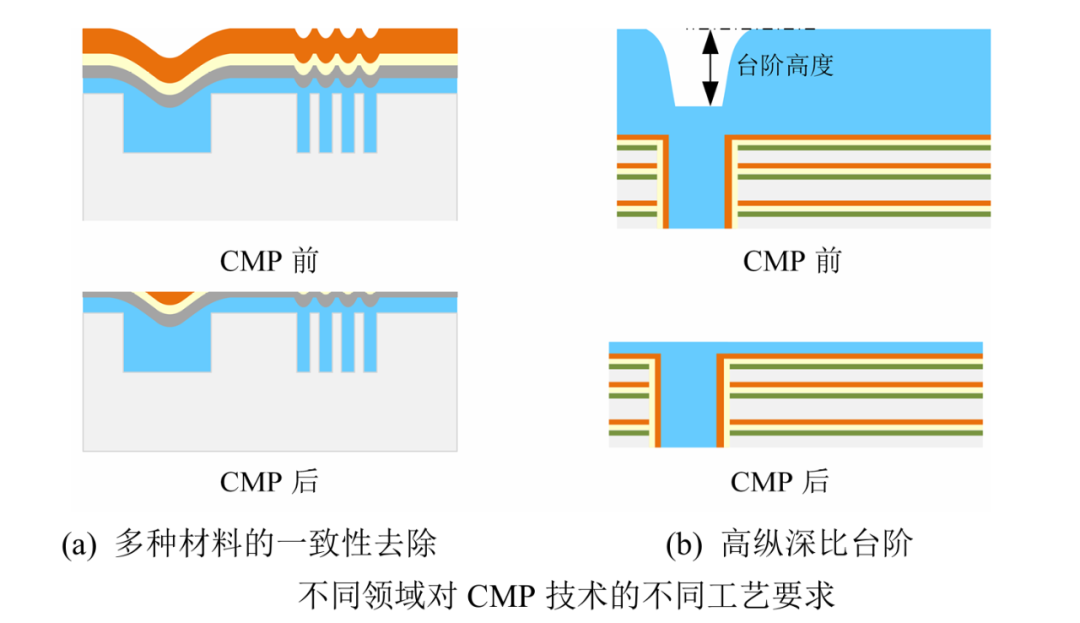
為了保證全局和局部的平坦化的要求,就要在一次CMP過程中實現(xiàn)SiN,SiO2以及Poly Si這幾種不同材料的同時去除,這提出了和FinFET制造中不同的工藝需求。
另外,半導體制造流程在前段制程(Front End of Line)以及后段制程(Back End of Line)中經(jīng)常遇到一些高縱深比的三維結(jié)構(gòu)。這些高縱深比的三維結(jié)構(gòu)在填充后,很容易產(chǎn)生一些大的臺階高度,如上圖(b)所示,這些高縱深比結(jié)構(gòu)的存在,則對CMP的去除效率提出新的要求。
(3)各產(chǎn)業(yè)未來發(fā)展的挑戰(zhàn)
隨著各領域的發(fā)展,各種新型材料會被不斷的開發(fā)出來,一些傳統(tǒng)材料也在新的背景需求下得到新的應用。
同時,各個領域的不斷的發(fā)展又會不斷提出新的加工工藝指標和技術(shù)要求,這就需要CMP技術(shù)具有很強的適應能力和調(diào)控能力,能夠快速滿足產(chǎn)業(yè)化需求。如何快速開發(fā)針對特定材料和加工性能要求的CMP工藝,是決定未來市場競爭力和產(chǎn)業(yè)化速度的關(guān)鍵問題之一,同樣也是CMP技術(shù)面臨的新的挑戰(zhàn)。
以IC領域為例,集成電路正繼續(xù)遵循摩爾定律向著更小線寬、更多互連層數(shù)、更大晶圓尺寸的方向發(fā)展,對晶圓平坦化工藝的平整度和缺陷控制的要求越來越苛刻,可以預見,CMP技術(shù)將成為未來IC制造的瓶頸之一。
下表列舉了IC領域中新的發(fā)展趨勢對于CMP技術(shù)的影響。
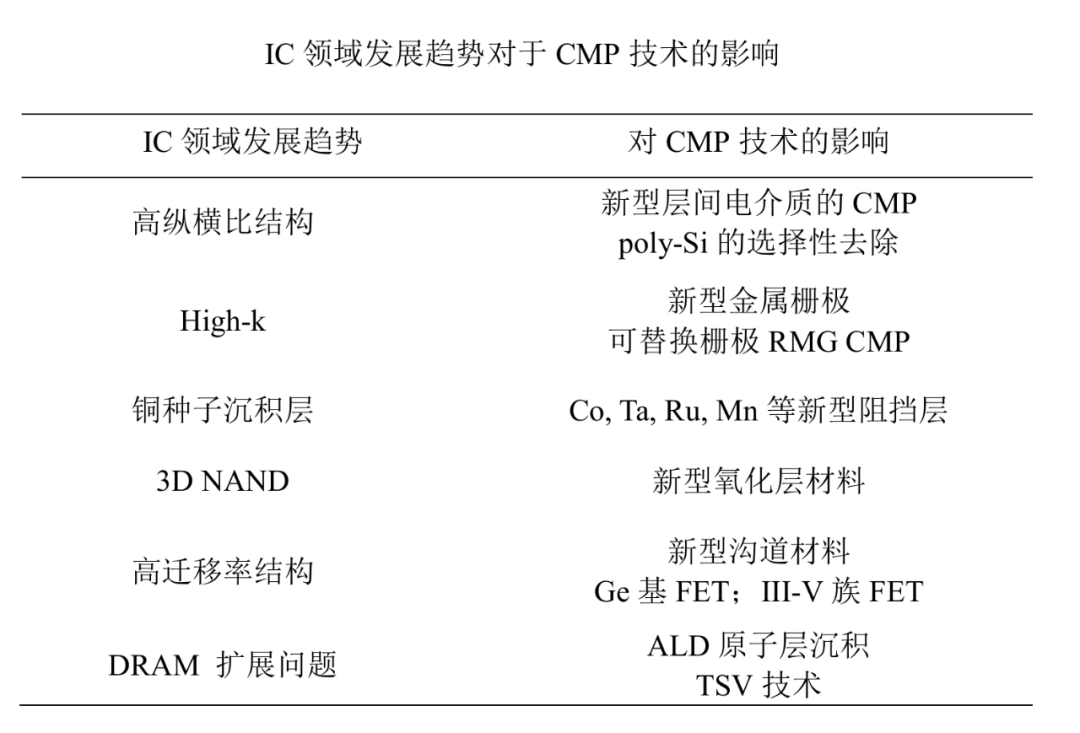
對于晶體管來說,為了提高晶體管柵極結(jié)構(gòu)的電子遷移率,提出利用Ge、III-V族半導體和石墨烯以及碳納米管等碳類材料作為溝道材料的MOSFET結(jié)構(gòu)。
這種新型三維結(jié)構(gòu)和柵極材料的使用,導致CMP技術(shù)的開發(fā)難度急劇增加。對于互連來說, 隨著互連線寬縮小,互連溝槽深寬比增大,傳統(tǒng)的鉭基阻擋層無法實現(xiàn)均勻沉積,容易出現(xiàn)縮口現(xiàn)象。因此,提出新的銅/釕(鈷)亞10nm結(jié)構(gòu)來替代傳統(tǒng)的銅/鉭結(jié)構(gòu)。
然而,銅、釕之間的電化學性能差異極大,如果機械力和化學的耦合作用控制不當,極易導致界面電偶腐蝕,造成芯片斷路。因此,這種新型結(jié)構(gòu)的使用對CMP過程中機械和化學作用的調(diào)控提出了更嚴格的要求。
七、總結(jié)
可以預見,在未來幾年,隨著不同物理化學響應的拋光材料的增加,再加上面形精度、表面粗糙度、材料去除均勻性、材料選擇去除性等不同加工結(jié)果的要求,CMP技術(shù)面臨越來越多樣化的挑戰(zhàn)。然而,由于影響CMP加工質(zhì)量和效率的因素眾多,且各因素的影響間存在復雜的耦合關(guān)系,人們依舊需要提高對CMP技術(shù)機理的認知。
-
芯片
+關(guān)注
關(guān)注
459文章
52404瀏覽量
439252 -
半導體
+關(guān)注
關(guān)注
335文章
28812瀏覽量
235936 -
晶圓
+關(guān)注
關(guān)注
53文章
5140瀏覽量
129599 -
機械拋光
+關(guān)注
關(guān)注
0文章
7瀏覽量
1877
原文標題:一文了解芯片化學機械拋光(CMP)技術(shù)
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
基于白光干涉測量的非接觸光學測量方法評估化學機械拋光面
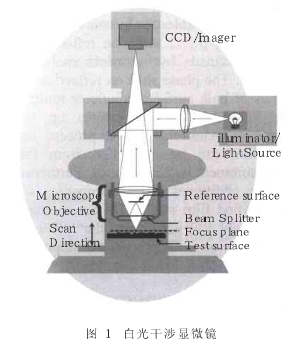
半導體行業(yè)中的化學機械拋光技術(shù)

碳化硅晶片的化學機械拋光技術(shù)研究

新型銅互連方法—電化學機械拋光技術(shù)研究進展
化學機械拋光技術(shù)的研究進展
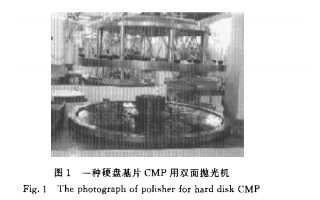
化學機械拋光CMP技術(shù)的發(fā)展應用及存在問題
化學機械拋光(CMP)技術(shù)的發(fā)展、應用及存在問題
多晶硅薄膜后化學機械拋光的新型清洗解決方案

CMP后化學機械拋光清洗中的納米顆粒去除報告
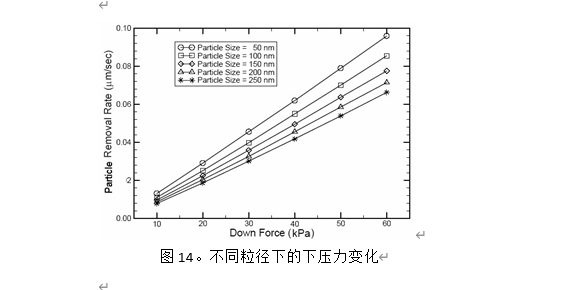
化學機械拋光(CMP)的現(xiàn)狀和未來
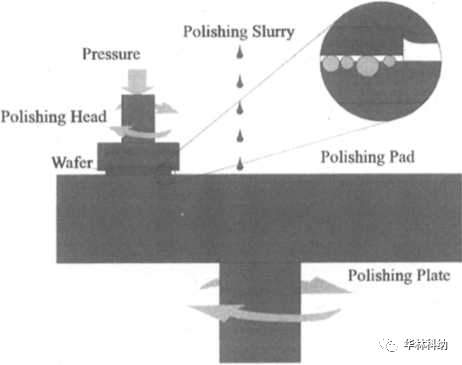
半導體行業(yè)中的化學機械拋光(CMP)技術(shù)詳解
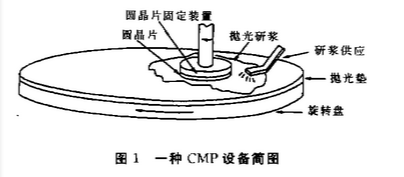





 深度解析芯片化學機械拋光技術(shù)
深度解析芯片化學機械拋光技術(shù)

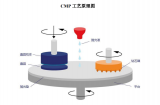










評論