掃描電鏡(SEM)把細束電子像畫筆一樣在樣品表面來回掃描,電子與表層原子短暫碰撞后,釋放出二次電子或背散射電子。探測器把這些信號逐點收集、放大,最后在屏幕上拼成一幅二維強度圖。因為作用深度只有幾納米,SEM 的圖像顆粒輪廓、裂紋走向、元素襯度一目了然。
透射電鏡(TEM)則讓高能電子直接“穿墻而過”。只有當樣品被削到百納米以下,電子才能帶著晶格間距、厚度、缺陷密度的信息抵達下端的透鏡系統。經過衍射、干涉、放大,最終得到的是原子尺度的二維投影。若想再往前走一步,選區衍射(SAED)或高分辨像(HRTEM)可以把晶體結構、位錯、甚至單原子缺陷一并呈現出來。
設備參數與操作差異
1.加速電壓和放大倍數是最直觀的差別:SEM 通常工作在 5–30 kV,放大 10 倍到兩百萬倍;TEM 則運行在 60–300 kV,放大倍數可輕松突破五千萬倍。
2.景深方面,SEM 的毫米級景深讓粗糙三維樣品也能整體清晰;TEM 的景深極短,只能聚焦亞微米薄片,但換來的是原子級細節。
3.真空要求:SEM 可以在高真空、可變壓力或環境模式下切換,含水或不導電樣品也能觀察;TEM 必須維持高真空,機械振動、磁場漂移都得嚴格控制。
4.樣品制備:SEM 樣品要求相對低,尺寸可較大,制樣簡單耗時短;TEM 樣品需制成薄片,尺寸小,制樣復雜耗時久。
5.成像原理與圖像觀察:
SEM 的常規成像包括:二次電子像(SEI)看表面形貌,背散射像(BSE)看成分襯度,再配上能譜(EDS)就能做元素面分布;加裝電子背散射衍射(EBSD)還可繪制晶粒取向圖。
TEM 的成像包括:明場像(BF)提供質量-厚度襯度,暗場像(DF)突出衍射襯度,高分辨像(HRTEM)直接顯示晶格條紋,掃描透射像(STEM)給出 Z 對比度,電子能量損失譜(EELS)則能揭示元素、化學態乃至電子結構。

如何選擇?兩者有什么優勢?
如果任務只是觀察裂紋、腐蝕、鍍層厚度、顆粒分布,或者快速篩查缺陷、污染,而樣品尺寸大、無需超薄化,那么成本低、時間短的 SEM 就是首選。
如果需要研究晶界、位錯、層錯、析出相,或者測量原子尺度缺陷、界面結構,甚至做選區衍射,則需要用到TEM。
在復雜項目中,兩者可以串聯:先用 SEM 快速定位感興趣區域,再用 FIB 精準制樣轉 TEM;SEM 可做連續切片成像(SBF-SEM),TEM 可做電子斷層掃描(ET),實現從宏觀到原子尺度的全鏈條表征。
掃描電鏡(SEM):
優勢:主要用于觀察樣品的表面形貌和成分分析。樣品制備相對簡單,對樣品的尺寸要求較寬松。可以在較低的真空度下工作,甚至可以觀察經過處理的含水或不導電的樣品。
應用場景:在材料科學、地質學、生物學等領域中,用于觀察樣品的表面特征、顆粒大小、形狀等。結合能譜分析技術,可以確定樣品表面的元素組成。
透射電鏡(TEM):
優勢:能夠提供高分辨率的樣品內部結構信息,如晶體結構、位錯、納米尺度的缺陷等。可以進行選區電子衍射等分析,確定晶體結構和取向。
應用場景:在材料科學研究、納米技術、生物學等領域中,用于觀察材料的微觀結構、納米材料的形態和結構、細胞的內部細胞器等。
成本與易用性對比
掃描電鏡(SEM)相對較為便宜,操作也比較簡單,對樣品的制備要求相對較低。而透射電鏡(TEM)價格昂貴,操作復雜,樣品制備也需要較高的技術水平——透射電鏡(TEM)的樣品需要非常薄,目前已經開發了許多方法,包括電拋光,機械拋光和聚焦離子束刻蝕。 對于預算有限或常規檢測任務,SEM 是性價比首選;若深入研究材料的內部結構和微觀特性,則 TEM更加合適。
-
SEM
+關注
關注
0文章
260瀏覽量
14940 -
TEM
+關注
關注
0文章
104瀏覽量
10799
發布評論請先 登錄
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構
TEM制樣、FIB切割、Pt沉積和三維重構
TEM制樣、FIB切割、Pt沉積和三維重構
TEM制樣、FIB切割、Pt沉積和三維重構
聚焦離子束顯微鏡(FIB-SEM)
超寬帶TEM天線的數值模擬
超逼真20張動圖,秒懂四大電鏡原理(SEM, TEM, AFM, STM)!
【尋材問料】超逼真20張動圖,秒懂四大電鏡原理(SEM, TEM, AFM, STM)!
FIB-SEM雙束技術及應用介紹
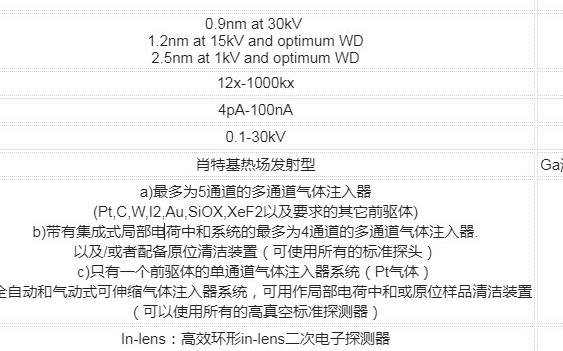
FIB-SEM的常用分析方法
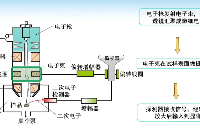





 SEM與TEM該如何選擇?
SEM與TEM該如何選擇?


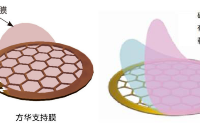










評論