設備、材料和封裝技術的進步都會導致問題。
汽車供應鏈上的企業遍布全球,越來越多的企業將自身的非核心業務外包給第三方企業,因而汽車供應鏈的結構也更加復雜化。但是,汽車供應鏈日益全球化,復雜化,多級化,精益化的特點,以及車企和供應鏈對精益生產的追求和運營的精細化,導致供應鏈本身的彈性不足,這增加了汽車供應鏈網絡運營環境的不確定性。
對于每個新節點,都必須考慮額外的物理影響,但并非所有這些影響都具有相同的關鍵級別。這些影響里被更頻繁提及的一種是自熱。
所有設備都會消耗電力,當它們這樣做時,它就會變成熱量。“本質上,所有有源器件都會在載流子移動時產生熱量,從而為電流通過柵極創造通道,”西門子 EDA Calibre 設計解決方案集團 DRC 應用營銷總監 John Ferguson 說。“在歷史悠久的 CMOS 時代,這些影響在很大程度上是可控的,因為在柵極捕獲的熱量有一條相對簡單的路徑可以通過硅襯底消散。不幸的是,CMOS 方法最終遇到了物理限制,在這種情況下它無法繼續在可靠運行的同時持續縮小尺寸。”
縮放比例也有影響。“直到 20 世紀 90 年代,這個問題還不是問題,”Synopsys TCAD 產品組的研究員 Victor Moroz 說。“那是因為人們能夠降低電源電壓,這確實有助于降低功耗。但一旦人們發現技術的局限性,就無法將電源電壓降低到遠低于 0.7V 左右。”
自熱與活動有關。Cadence 產品管理總監 Jay Madiraju 表示:“芯片最活躍部分的自熱效應最高,這給設計人員帶來了額外的瓶頸。”“當電路運行時,設備和互連的溫度會根據活動量增加。當設備在運行過程中消耗功率時,它會產生熱量。類似地,對于金屬互連,溫度升高將由在互連中流動的電流通過電阻損耗產生熱量(即焦耳熱)引起。這兩個因素都會導致產生熱量。”
收縮使事情變得更糟。“隨著設備和電線的幾何尺寸減小,電流密度增加,”Lightelligence 的物理設計負責人 Rob Kuhn 說。“這加劇了自熱及其對性能和可靠性的相關影響。同樣在高級節點中,finFET 和納米線器件會進一步增加自熱,因為導熱性會降低并且熱量會長時間滯留在器件附近。”
材料有影響。“制造器件所用材料的變化導致熱效應進一步增加,”Cadence 的 Madiraju 說。“例如,低 K 電介質比以前的金屬間電介質具有更高的熱阻。自熱開始成為 65nm 以下傳統節點設計的一個問題,并且隨著特征尺寸的縮小而變得更具挑戰性,特別是對于先進節點工藝,即 finFET 設計。”
形狀也會產生問題。Ansys 研發總監 Tianhao Zhang 表示:“FinFET 新型三維結構的自熱效應比平面器件更為顯著。”“此外,finFET 結構中使用的材料的導熱性差,以及難以從被介電材料包圍的隔離鰭片散熱到基板,導致 finFET 器件的溫度更高。反過來,這會對互連線造成更高的熱耦合效應。”
雖然縮放有助于解決一些問題,但其他問題會變得更糟。Synopsys 的 Moroz 說:“自 finFET 推出以來,功率密度變得足夠大,人們注意到并開始擔心它。”“晶體管密度每年增加大約 10% 到 15%。一個晶體管的功耗降低很慢,因為人們在一點一點地改進技術。當你減少幾何形狀時,電容也會減少。功耗主要與電容有關,因為所有電路都在切換。無論何時切換,都必須為電容充電,而該電容來自你要切換的下一個晶體管。每次給它充電或放電時,能量都會沿著其他組件(電線)傳遞。因此,當你減小晶體管尺寸時,晶體管電容會減小,從而幫助降低功耗。而且因為它們更小,它們之間的電線變得更短,這也有幫助。但它跟不上密度的提高,總的來說你會看到你的功率密度在不斷增加。”
當設備產生熱量時,熱量會通過封裝、電路板和散熱器散發出去。西門子的 Ferguson 說:“新材料和與硅散熱器直接相互作用最少的非常薄的層增加了熱阻。”“這使得散熱變得更加困難。因此,設備被迫在更高且可能增加的溫度負載下工作。這些高溫會影響器件的閾值電壓和性能,最終導致可靠性挑戰。3D-IC 設計的趨勢可能會進一步加劇這個問題,進一步增加總散熱路徑。”
熱量的產生和散熱必須平衡。“考慮圖 1(下圖),”Moroz說。“在某個時候,你開始操作設備,溫度會上升,直到它飽和并在這個平衡點變得穩定。這是因為你必須管理芯片的功率預算,以免整個芯片過熱。如果查看單個開關,并從一個平面晶體管(在左側)開始,它會打開然后關閉。在局部,晶體管溫度會先高后低,再高又低。當人們改用 finFET(中)時,總體上沒有任何變化,因為它仍然取決于你的功率預算和電路活動以及封裝的散熱能力。但是finFET有一個窄鰭,與平面相比,它的導熱和散熱能力不如平面,因此局部溫度會升高。現在人們正在改用環柵(右),熱量更難從它們中逸出,因為它們很小并且被不導電的東西包圍著。所以在本地,有一個更大的問題。但對于芯片規模,沒有任何改變。”

圖 1:芯片溫度和自熱。
熱量是芯片的殺手。即使溫度沒有高到足以毀壞設備,該設備也會受到長期影響。“對于設備而言,自熱會影響遷移率和閾值電壓,這反過來會限制設備性能并增加功耗,”Lightelligence的 Kuhn 說。“熱載流子注入、隨時間變化的電介質擊穿 (TDDB) 和負偏置溫度不穩定性 (NBTI) 會降低設備的長期可靠性。電線的固有電阻隨著溫度的升高而增加,這會通過減慢數據傳輸來影響芯片性能。隨著時間的推移,自熱還會加速電遷移效應,從而導致芯片故障。隨著技術的進步,這兩種趨勢都會惡化。”
行動計劃
與所有問題一樣,越早了解問題,處理起來就越容易,成本也就越低。過早老化設備的問題不僅需要對設計采取糾正措施,還需要成本更高的現場更換有缺陷的部件。
Ferguson概述了三個總體原則:
對設備行為的熱影響進行建模,以準確模擬預制造
使用任何和所有方法來減少總熱影響
尋找替代的消散路徑
“由于對芯片可靠性和性能的高度不利影響,對任何芯片或系統級封裝 (SiP) 的熱流進行建模至關重要,”Kuhn 說。“Ansys 和 Cadence 等公司提供的工具在這一領域變得越來越重要,因為它們使設計人員能夠識別可靠性和性能問題,并通過增加導線尺寸(降低電阻)和提高基板導熱性等技術來緩解這些問題”
所有分析都從模型開始。Cadence 高級產品經理 Art Schaldenbrand 表示:“設備建模[CMC] 已經認識到考慮自熱的必要性,最近的設備模型 BSIM-C 和 BSIM-I 包括自熱效應。”“這些模型連同模擬器的增強功能,可以計算設備和互連中消耗的功率。代工廠通常會為高級節點工藝提供具有自加熱功能的模型。設計人員在使用 SPICE 仿真時可以考慮自熱對其設計的影響,從而深入了解電路性能由于其操作而發生的變化。雖然設計人員可以在仿真中包含自熱效應,但存在仿真性能成本,因此他們需要在如何分析熱效應方面具有戰略意義。
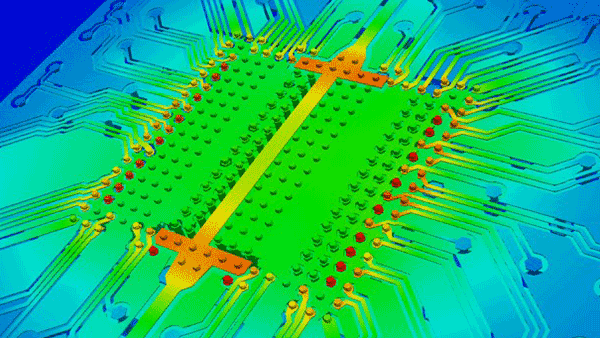
圖 2:IC 封裝互連結構的溫度曲線。來源:Cadence
其他簡化可能導致悲觀的結果。“芯片上均勻的最壞情況環境溫度通常過于悲觀,”Ansys 的 Zhang 說。“要獲得準確、高分辨率的結果,甚至基于金屬層的環境溫度,以及自熱是分析電路可靠性所必需的。”
模擬晶體管自熱是否足夠?“你產生的熱量與阻力成正比,”Moroz說。“對于電線,每微米會有幾十歐姆。如果查看信號網,它就是將開關連接到下一個開關的電線。這通常是幾微米長,而該網的電阻將是幾百歐姆。一個晶體管,它有兩種狀態。兩個階段之間有一個瞬態,但兩個狀態是開和關。在關閉狀態下,它具有兆歐姆電阻。在開啟狀態下,通常它具有幾千歐姆的電阻。它支配著導線電阻。所以,如果一根電線是 100 歐姆,而你的開關是 10 千歐姆,那么電線會產生熱量,但要少 100 倍。”
雖然信號線的自熱本身可能不是問題,但熱耦合會增加這些溫度。Ansys 的 Zhang 表示:“電線的更高溫度對可靠性構成了挑戰,因為為這些電線定義了更小的允許電流以滿足預期的平均無故障時間 (MTTF)。”“這是電遷移造成的故障,隨著時間的推移會產生不希望的開路或短路。”
電力網絡中的電線有不同的問題。“電源網絡比信號網絡復雜得多,”Ansys 產品營銷總監 Marc Swinnen 說。“信號線是點對點或多點的,但電力網是網格。你無法使用相同的求解器來求解它。你必須使用類似SPICE 的電路模擬器。網絡很大。在一個有 500 億個晶體管的芯片上,你有 500 億個電源和接地點需要連接。這比整個美國的電網還要復雜。每一小段電線都必須建模為一個電阻器,所以有數千億個電阻器,必須減少數量才能模擬它。只有這樣才能準確判斷電流流向何處以及每個點的電壓。EM 分析是免費的——這是一個可靠性問題,但你需要知道流過所有電線的電流。這也與溫度有關,因此需要了解全球溫度,而這取決于散熱器和環境。但是整個芯片的溫度各不相同。過去它被認為是整個芯片的單一溫度,但現在我們需要進行熱建模并包括焦耳自熱。”
減少供暖影響的最直接方法是減少活動。這通常被稱為暗硅。“高端服務器封裝每平方厘米可耗散約 50 瓦,”Moroz說。“關鍵是你在芯片上使用一小部分開關,不要超過它。否則,它會過熱。如果你看看今天的技術,你可以用大約 1% 的活動因子來實現這種功耗。這聽起來可能很糟糕,但它正在變得更糟,并且在一點一點地下降,每年下降 5% 或 10%。”
這一切都始于早期的系統分析。“了解你的功率預算始于復雜的芯片-封裝-電路板協同設計,”Zhang 說。“后期的熱問題會導致大的 ECO 循環、難以解決的問題,甚至是設計失敗。為了克服這個問題,應在早期設計階段考慮熱效應,包括熱感知功能塊放置和熱熱點評估。這種考慮不僅有助于產生最佳設計,還有助于降低自熱影響并提高整體設計可靠性。”
散熱變得越來越困難,尤其是對于多芯片系統。“你有一些凸點將芯片連接到電路板,”Moroz說。“然后有一些散熱器可以幫助你散熱。中間有硅,它是一個很好的導熱體,所以各處的熱量會很均勻,你就等著封裝散熱。現在,如果拿起那塊芯片,開始在上面堆東西,這種材料的熱導率是多少?如果它是電介質,那就是個問題,因為它是熱逃逸的額外屏障,所以必須確保電介質沒有那么糟糕。”
結論
自熱可能不是當今電路設計人員面臨的最大問題,但問題已經增長到足以引起人們的關注,而且它們在未來只會變得更糟。新設備、新材料和新封裝技術都在加速這個問題,如果最大活性因子繼續下降,任何封裝中都會面臨這個問題。
編輯:黃飛
?
 電子發燒友App
電子發燒友App














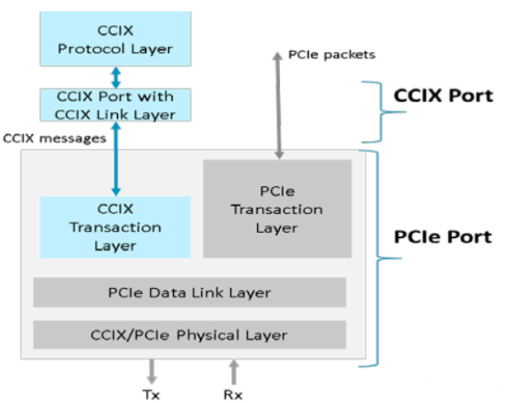


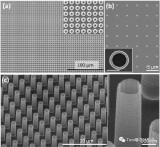
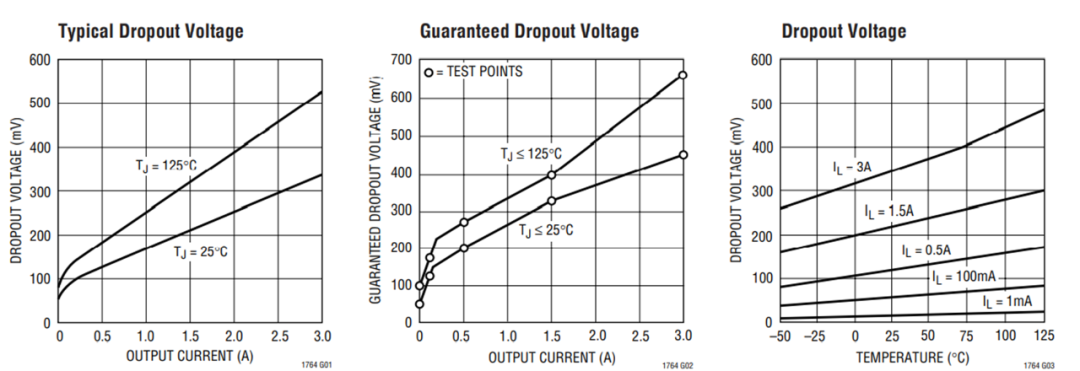
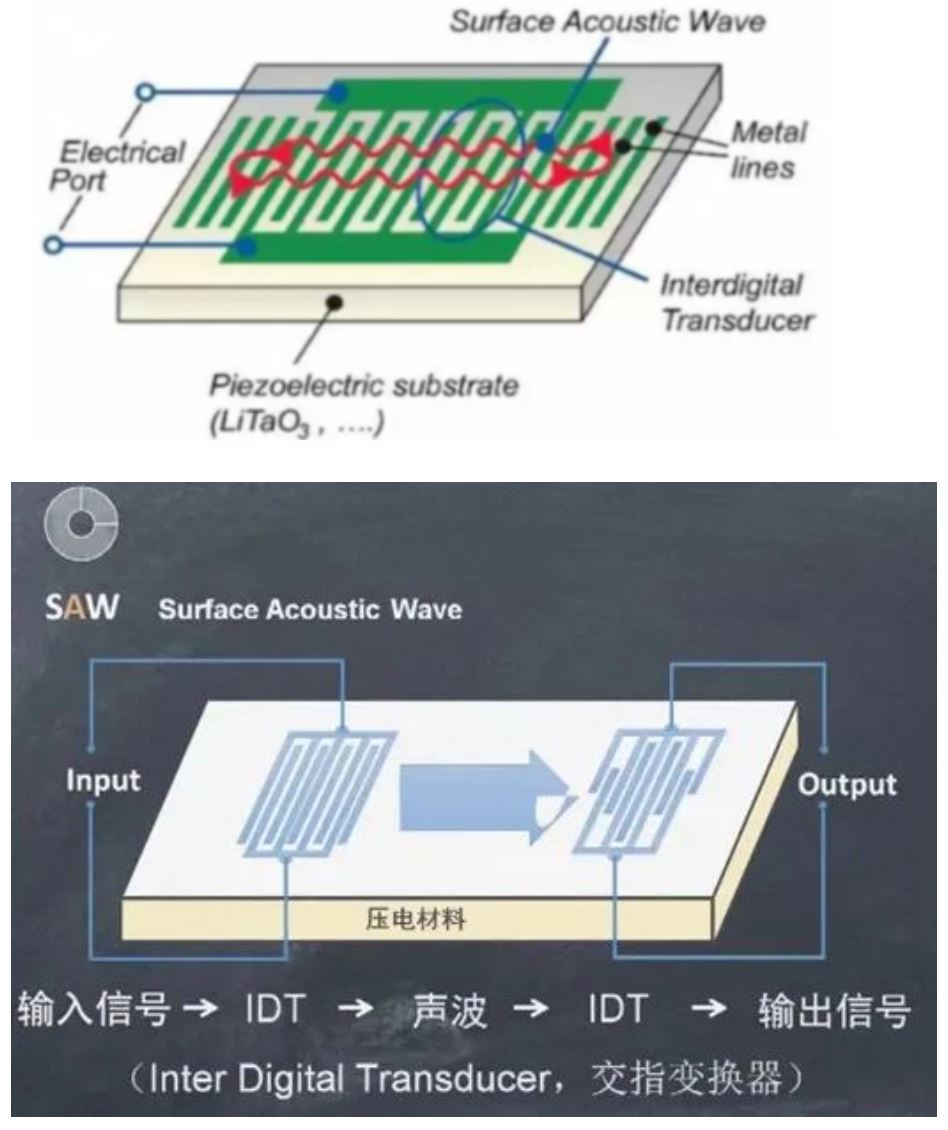
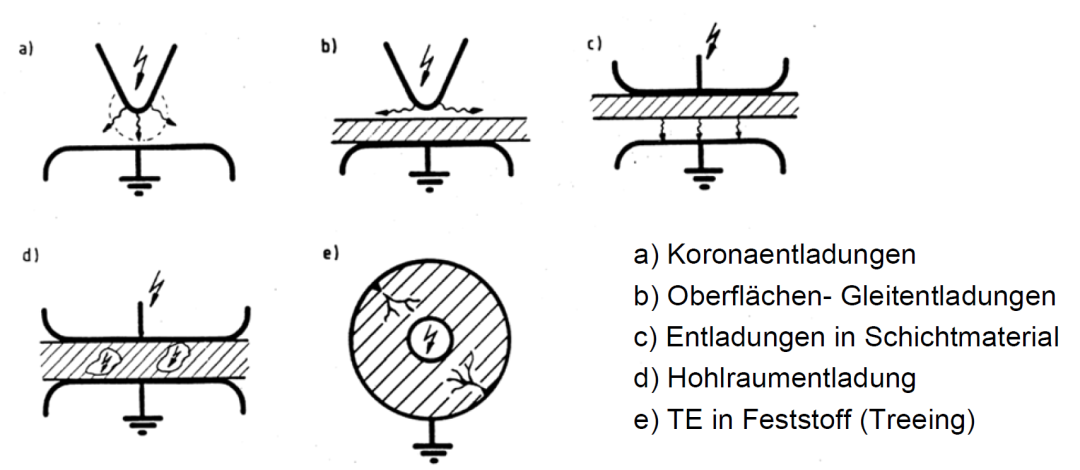










評論