隨著物聯(lián)網(wǎng)時(shí)代來(lái)臨,全球終端電子產(chǎn)品漸漸走向多功能整合及低功耗設(shè)計(jì),因而使得可將多顆裸晶整合在單一封裝中的SiP技術(shù)日益受到關(guān)注。除了既有的封測(cè)大廠積極擴(kuò)大SiP制造產(chǎn)能外,晶圓代工業(yè)者與IC基板廠也競(jìng)相投入此一技術(shù),以滿足市場(chǎng)需求。
全球終端電子產(chǎn)品不斷朝輕薄短小、多功能、低功耗的發(fā)展趨勢(shì)下,能夠整合上述特性的系統(tǒng)級(jí)封裝(SiP)技術(shù)逐漸受到重視。尤其,近幾年在行動(dòng)裝置與穿戴裝置等輕巧型產(chǎn)品興起后,SiP需求日益顯現(xiàn)。
未來(lái)隨著物聯(lián)網(wǎng)時(shí)代即將來(lái)臨,多功能整合與低功耗將是重要趨勢(shì),SiP也將在封裝技術(shù)中扮演重要角色。因此本文將從技術(shù)發(fā)展、市場(chǎng)應(yīng)用及產(chǎn)業(yè)趨勢(shì)等三個(gè)構(gòu)面,對(duì)全球SiP發(fā)展進(jìn)行深入剖析。
全球SiP技術(shù)發(fā)展分析
全球IC封裝技術(shù)發(fā)展,最早是以打線封裝(Wire Bond)技術(shù)為主,采用此方式連接晶片與基板上的連接點(diǎn),使用導(dǎo)線以金線為主,因?yàn)榻鸬难诱埂⒎€(wěn)定與導(dǎo)電性能極佳(圖1)。
圖1 因金線導(dǎo)電性佳,故打線封裝技術(shù)以金線為主要材料。資料來(lái)源:WireBondDemo.com
而在打線技術(shù)后,逐步發(fā)展到凸塊技術(shù)(Bumping),利用薄膜、黃光、電鍍等主要制程在基板的連接點(diǎn)上長(zhǎng)出鉛錫凸塊、金凸塊或銅凸塊,目前常見(jiàn)的覆晶封裝(Flip Chip)即為凸塊技術(shù)的應(yīng)用,將晶片與基板用凸塊接合,不僅比打線技術(shù)穩(wěn)固,又可縮短晶片與基板距離,降低電??阻,并節(jié)省空間。
隨著封裝技術(shù)持續(xù)演進(jìn),加上終端電子產(chǎn)品朝向輕薄短小趨勢(shì),因此,對(duì)SiP需求亦逐漸提升。
SiP生產(chǎn)線須由基板、晶片、模組、封裝、測(cè)試、系統(tǒng)整合等生態(tài)系共同組成,才能夠順利發(fā)展。反之,若缺乏完整生態(tài)系,便難以推動(dòng)SiP技術(shù)具體實(shí)現(xiàn)。
由于SiP技術(shù)可將多種晶片封裝于單一封裝體內(nèi)而自成系統(tǒng),因此具有高整合性與微型化特色,適合應(yīng)用于體積小、多功能、低功耗等特性的電子產(chǎn)品。
以各種應(yīng)用來(lái)看,若將原本各自獨(dú)立的封裝元件改成以SiP技術(shù)整合,便能縮小封裝體積以節(jié)省空間,并縮短元件間的連接線路而使電阻降低,提升電性效果,最終呈現(xiàn)微小封裝體取代大片電路載板的優(yōu)勢(shì),又仍可維持各別晶片原有功能。因此,高整合性與微型化特色,使SiP成為近年來(lái)封裝技術(shù)發(fā)展趨勢(shì)。
此外,因SiP是將相關(guān)電路以封裝體完整包覆,因此可增加電路載板的抗化學(xué)腐蝕與抗應(yīng)力(Anti-stress)能力,可提高產(chǎn)品整體可靠性,對(duì)產(chǎn)品壽命亦能提升。
SiP搭配模組設(shè)計(jì)朝多元發(fā)展
相較于SoC來(lái)說(shuō),SiP毋須進(jìn)行新型態(tài)晶片設(shè)計(jì)與驗(yàn)證,而是將現(xiàn)有不同功能的晶片,以封裝技術(shù)進(jìn)行整合,達(dá)到小體積、多功能、低功耗等主要目標(biāo)。因此,SiP整體開發(fā)時(shí)程較短,可節(jié)省時(shí)間成本。至于封裝技術(shù)類型方面,依不同產(chǎn)品設(shè)計(jì)需求各有其對(duì)應(yīng)技術(shù)。
SiP所運(yùn)用的基本技術(shù)類型相當(dāng)廣泛,涵蓋2D、3D等領(lǐng)域,各種技術(shù)間亦可進(jìn)行搭配,再結(jié)合模組化便可進(jìn)行系統(tǒng)整合。大致上來(lái)說(shuō),現(xiàn)階段SiP常用的基本封裝技術(shù),包括普遍應(yīng)用于智慧型手機(jī)的Package on Package(PoP)技術(shù),將邏輯IC與記憶體IC進(jìn)行封裝體堆疊。將主動(dòng)與被動(dòng)元件內(nèi)埋于基板的嵌入式技術(shù)(Embedded),以及多晶片封裝(MCP)、多晶片模組(MCM)、Stacking Die、PiP、TSV 2.5D IC、TSV 3D IC等,也屬于SiP技術(shù)范疇。
在封裝技術(shù)類型外,模組設(shè)計(jì)能力亦扮演舉足輕重角色;各種基本封裝類型須結(jié)合不同模組設(shè)計(jì),所有環(huán)節(jié)緊密配合,最后將整個(gè)系統(tǒng)進(jìn)行整合,便能成為完整的SiP。因此,因應(yīng)終端產(chǎn)品不同需求,所使用的封裝技術(shù)與搭配的模組設(shè)計(jì)亦不盡相同,使SiP逐漸朝向多元發(fā)展。
SiP存在許多進(jìn)入門檻
SiP封裝雖然比重逐漸提升,并有多樣類型,但至今仍存在跨入門檻。由于SiP是高度整合性技術(shù),牽涉層面廣,涵蓋IC基板材料、封裝堆疊技術(shù)、模組設(shè)計(jì)、系統(tǒng)整合及多晶片測(cè)試等領(lǐng)域,因此,須將分屬不同領(lǐng)域的知識(shí)與技術(shù)整合,才能順利推展。若無(wú)法縝密串連相關(guān)領(lǐng)域,將導(dǎo)致部分環(huán)節(jié)難以突破而無(wú)法順?biāo)臁?/p>
在封裝技術(shù)門檻方面,晶片堆疊所遇到的散熱問(wèn)題是不易解決的技術(shù)瓶頸,而晶片與IC基板面積微小化與柔軟度需求、晶片薄化時(shí)可能出現(xiàn)的龜裂與形變等問(wèn)題,也是技術(shù)上的考驗(yàn)。
在測(cè)試方面,由于SiP會(huì)增加多晶片測(cè)試與晶片功能檢測(cè)需求,不但測(cè)試難度與晶片功能檢測(cè)難度都將提升,整體測(cè)試與檢測(cè)流程復(fù)雜度亦會(huì)增加。至于在模組方面,SiP模組常用的是表面黏著技術(shù)(SMT)與模組設(shè)計(jì)。
不過(guò),SMT技術(shù)門檻較低,因此,比較高的門檻出現(xiàn)在模組設(shè)計(jì)能力方面,供應(yīng)商要能夠因應(yīng)不同需求??而設(shè)計(jì)出符合模組。
此外,高額的資本支出也是門檻之一。因?yàn)镾iP需要多種不同領(lǐng)域作為發(fā)展基礎(chǔ),因此需要較為龐大的資本支出,不具資本規(guī)模之廠商所受到的限制較大,不容易在SiP技術(shù)領(lǐng)域進(jìn)行全方位的發(fā)展。
因此,整體而言,SiP至今仍存在多種進(jìn)入門檻;包含封裝技術(shù)、測(cè)??試、模組設(shè)計(jì)與系統(tǒng)整合等難度,以及高額資本支出等。使得SiP至目前為止,雖然比重逐漸提高,但并非多數(shù)廠商都能順利進(jìn)入此一領(lǐng)域,仍存在各種進(jìn)入門檻待為克服。
智慧型手機(jī)扮演SiP成長(zhǎng)驅(qū)動(dòng)主力
與個(gè)人電腦時(shí)代相比,行動(dòng)裝置產(chǎn)品對(duì)SiP的需求較為普遍,主要是因?yàn)樾袆?dòng)裝置產(chǎn)品更為輕薄短小,對(duì)空間節(jié)省要求更高,在功能上也越來(lái)越多樣。就以智慧型手機(jī)來(lái)說(shuō),上網(wǎng)功能已是基本配備,因此與無(wú)線網(wǎng)路相關(guān)的Wi-Fi模組便會(huì)使用到SiP技術(shù)進(jìn)行整合。
基于安全性與保密性考量所發(fā)展出的指紋辨識(shí)功能,其相關(guān)晶片封裝亦需要SiP協(xié)助整合與縮小空間,使得指紋辨識(shí)模組開始成為SiP廣泛應(yīng)用的市場(chǎng);另外,壓力觸控也是智慧型手機(jī)新興功能之一,內(nèi)建的壓力觸控模組(Force Touch)更是需要SiP技術(shù)的協(xié)助。
除此之外,將應(yīng)用處理器(AP)與記憶體進(jìn)行整合的處理器模組,以及與感測(cè)相關(guān)的MEMS模組等,亦是SiP技術(shù)的應(yīng)用范疇。
因此,近年來(lái)智慧型手機(jī)為驅(qū)動(dòng)SiP技術(shù)廣泛應(yīng)用的最主要終端產(chǎn)品。自2007年蘋果(Apple)發(fā)表第一代iPhone以來(lái),智慧型手機(jī)逐漸成為一般民眾生活必備的電子產(chǎn)品。
一路發(fā)展至今,由于智慧型手機(jī)呈現(xiàn)高度成長(zhǎng),加上內(nèi)建功能越來(lái)越多,以及產(chǎn)品朝向微型化趨勢(shì)發(fā)展,因此,不但智慧型手機(jī)相關(guān)晶片需求成長(zhǎng),也刺激SiP技術(shù)需求大幅增加。使得智慧型手機(jī)成為近年來(lái)驅(qū)動(dòng)SiP成長(zhǎng)的主力產(chǎn)品。
穿戴裝置/物聯(lián)網(wǎng)驅(qū)動(dòng)SiP需求上揚(yáng)
全球終端電子產(chǎn)品的發(fā)展不斷地朝向輕薄短小、多功能、低功耗等趨勢(shì)邁進(jìn),對(duì)于空間節(jié)省、功能提升,以及功耗降低的要求越來(lái)越高,SiP的成長(zhǎng)潛力也越來(lái)越大。2015年Apple Watch等穿戴式產(chǎn)品問(wèn)世后,SiP技術(shù)擴(kuò)及應(yīng)用到穿戴式產(chǎn)品。
雖然,目前穿戴式產(chǎn)品的市場(chǎng)規(guī)模尚難與智慧型手機(jī)匹敵,但未來(lái)穿戴式產(chǎn)品預(yù)期仍將呈現(xiàn)成長(zhǎng),為SiP帶來(lái)成長(zhǎng)動(dòng)能。
此外,物聯(lián)網(wǎng)即將逐漸普及之際,在萬(wàn)物聯(lián)網(wǎng)的趨勢(shì)下,必然會(huì)串聯(lián)組合各種行動(dòng)裝置、穿戴裝置、智慧交通、智慧醫(yī)療,以及智慧家庭(圖2)等網(wǎng)路,多功能異質(zhì)晶片整合預(yù)估將有龐大需求,低功耗也會(huì)是重要趨勢(shì)。
圖2 IoT漸漸普及時(shí),在萬(wàn)物聯(lián)網(wǎng)的需求下,各式應(yīng)用的多功能晶片整合需求上揚(yáng)。資料來(lái)源:Philharmonic
因此,SiP預(yù)料仍將扮演重要的封裝技術(shù)。雖然,全球物聯(lián)網(wǎng)相關(guān)業(yè)者目前仍處于建立平臺(tái)與制定規(guī)格階段,尚未呈現(xiàn)具體商機(jī)。然而,若將來(lái)相關(guān)平臺(tái)建立完成,相關(guān)規(guī)格與配套措施皆完備后,物聯(lián)網(wǎng)亦成為SiP動(dòng)能成長(zhǎng)來(lái)源。
整體來(lái)說(shuō),未來(lái)智慧型手機(jī)等行動(dòng)裝置仍可呈現(xiàn)微幅成長(zhǎng)趨勢(shì),且內(nèi)建功能將越趨豐富,對(duì)SiP需求將會(huì)有所提升;而穿戴裝置產(chǎn)品朝向微小化發(fā)展,將更仰賴SiP技術(shù)協(xié)助;加上未來(lái)物聯(lián)網(wǎng)時(shí)代,多功能異質(zhì)整合與低功耗趨勢(shì),將以SiP技術(shù)作為重要解決方案。因此,SiP市場(chǎng)預(yù)期仍將持續(xù)成長(zhǎng)。
2014年全球SiP產(chǎn)值約為48.43億美元,較2013年成長(zhǎng)12.4%左右;2015年在智慧型手機(jī)仍持續(xù)成長(zhǎng),以及Apple Watch等穿戴式產(chǎn)品問(wèn)世下,全球SiP產(chǎn)值估計(jì)達(dá)到55.33億美元,較2014年成長(zhǎng)14.3%。
2016年,雖然智慧型手機(jī)可能逐步邁入成熟期階段,難有大幅成長(zhǎng)的表現(xiàn),但SiP在應(yīng)用越趨普及的趨勢(shì)下,仍可呈現(xiàn)成長(zhǎng)趨勢(shì),因此,預(yù)估2016年全球SiP產(chǎn)值仍將可較2015年成長(zhǎng)17.4%,來(lái)到64.94億美元(圖3)。

圖3 2013~2016年全球SiP產(chǎn)值與年成長(zhǎng)率資料來(lái)源:資策會(huì)MIC
全球主要封測(cè)大廠中,日月光早在2010年便購(gòu)并電子代工服務(wù)廠(EMS)--環(huán)電,以本身封裝技術(shù)搭配環(huán)電在模組設(shè)計(jì)與系統(tǒng)整合實(shí)力,發(fā)展SiP技術(shù)。使得日月光在SiP技術(shù)領(lǐng)域維持領(lǐng)先地位,并能夠陸續(xù)獲得手機(jī)大廠蘋果的訂單,如Wi-Fi、處理器、指紋辨識(shí)、壓力觸控、MEMS等模組,為日月光帶來(lái)后續(xù)成長(zhǎng)動(dòng)能。
此外,日月光也與DRAM制造大廠華亞科策略聯(lián)盟,共同發(fā)展SiP范疇的TSV 2.5D IC技術(shù);由華亞科提供日月光矽中介層(Silicon Interposer)的矽晶圓生產(chǎn)制造,結(jié)合日月光在高階封測(cè)的制程能力,擴(kuò)大日月光現(xiàn)有封裝產(chǎn)品線。
不僅如此,日月光也與日本基板廠商TDK合作,成立子公司日月旸,生產(chǎn)積體電路內(nèi)埋式基板,可將更多的感測(cè)器與射頻元件等晶片整合在尺寸更小的基板上,讓SiP電源耗能降低,體積更小,以因應(yīng)行動(dòng)裝置、穿戴裝置與物聯(lián)網(wǎng)之需求。
全球第二大封測(cè)廠Amkor則是將韓國(guó)廠區(qū)作為發(fā)展SiP的主要基地。除了2013年加碼投資韓國(guó),興建先進(jìn)廠房與全球研發(fā)中心之外;Amkor目前SiP技術(shù)主要應(yīng)用于影像感測(cè)器與動(dòng)作感測(cè)器等產(chǎn)品。
全球第三大暨***第二大封測(cè)廠矽品,則是布局IC整合型SiP,以扇出型疊層封裝(FO PoP)技術(shù)為主,其主要應(yīng)用于智慧型手機(jī),目前與兩岸部分手機(jī)晶片大廠合作中,2016年可望正式量產(chǎn)。
由于矽品在模組設(shè)計(jì)與系統(tǒng)整合方面較為欠缺,因此近期積極尋求與EMS大廠鴻海策略聯(lián)盟,以結(jié)合該公司在模組設(shè)計(jì)與系統(tǒng)整合能力,讓SiP技術(shù)領(lǐng)域發(fā)展更趨完整。
原本位居全球第四大封測(cè)廠的星科金朋也在韓國(guó)廠區(qū)積極開發(fā)SiP技術(shù),但因整體營(yíng)運(yùn)狀況不如前三大廠,因此難以投入大額資本以擴(kuò)充SiP規(guī)模。
不過(guò),隨著大陸封測(cè)廠江蘇長(zhǎng)電并購(gòu)星科金朋而帶來(lái)資金,將能夠結(jié)合原本星科金朋的技術(shù),預(yù)期在SiP領(lǐng)域有望成長(zhǎng)。擁有資金并進(jìn)一步取得技術(shù)之后的江蘇長(zhǎng)電,未來(lái)在SiP技術(shù)領(lǐng)域所帶來(lái)的競(jìng)爭(zhēng)力,特別值得臺(tái)廠留意。
IC基板廠投入SiP領(lǐng)域
由于封測(cè)廠商積極發(fā)展SiP技術(shù),因此吸引部分IC基板廠商開始聚焦SiP所帶來(lái)的潛在商機(jī)。IC基板埋入主被動(dòng)元件而成為SiP基板,在更薄的載板空間內(nèi)埋入IC,亦逐漸成為發(fā)展趨勢(shì)。未來(lái),在行動(dòng)裝置、穿戴式與物聯(lián)網(wǎng)等應(yīng)用下,SiP基板預(yù)料將為IC基板廠商帶來(lái)另一波成長(zhǎng)動(dòng)能。
在國(guó)外廠商部分,除日商TDK發(fā)展積體電路內(nèi)埋式基板,并與日月光結(jié)盟,共同朝SiP領(lǐng)域邁進(jìn)之外;另一家日系大廠Ibiden、韓廠Semco以及奧地利廠商AT&S等,也都積極投入發(fā)展SiP所需的IC基板。
國(guó)內(nèi)其他IC基板大廠也陸續(xù)展開布局,其中南電發(fā)展的系統(tǒng)級(jí)封裝產(chǎn)品已導(dǎo)入量產(chǎn),主要應(yīng)用于手機(jī)和網(wǎng)通產(chǎn)品,并積極開發(fā)中國(guó)大陸IC設(shè)計(jì)與封測(cè)客戶。
另一間IC基板大廠景碩的SiP產(chǎn)品所占營(yíng)收比重在2015年已經(jīng)超過(guò)一成,包括應(yīng)用于功率放大器、NAND Flash與網(wǎng)通等產(chǎn)品,并與國(guó)內(nèi)封測(cè)大廠建立供應(yīng)鏈關(guān)系,同時(shí)也是美系客戶供應(yīng)商。而欣興電子也積極開發(fā)新原料與新制程,以作為系統(tǒng)級(jí)封裝基板的技術(shù)基礎(chǔ)。
SiP技術(shù)不但是諸多封測(cè)廠發(fā)展的目標(biāo),也吸引部分EMS廠商與IC基板廠商投入。
近年來(lái),部分晶圓代工廠也在客戶一次購(gòu)足的服務(wù)需求下(Turnkey Service),開始擴(kuò)展業(yè)務(wù)至下游封測(cè)端,以發(fā)展SiP等先進(jìn)封裝技術(shù)來(lái)打造一條龍服務(wù)模式,滿足上游IC設(shè)計(jì)廠或系統(tǒng)廠。
然而,晶圓代工廠發(fā)展SiP等先進(jìn)封裝技術(shù),與現(xiàn)有封測(cè)廠商間將形成微妙的競(jìng)合關(guān)系。首先,晶圓代工廠基于晶圓制程優(yōu)勢(shì),擁有發(fā)展晶圓級(jí)封裝技術(shù)的基本條件,跨入門檻并不甚高。
因此,晶圓代工廠可依產(chǎn)品應(yīng)用趨勢(shì)與上游客戶需求,在完成晶圓代工相關(guān)制程后,持續(xù)朝晶圓級(jí)封裝等后段領(lǐng)域邁進(jìn),以完成客戶整體需求目標(biāo)。這對(duì)現(xiàn)有封測(cè)廠商來(lái)說(shuō),可能形成一定程度的競(jìng)爭(zhēng)。
由于封測(cè)廠幾乎難以向上游跨足晶圓代工領(lǐng)域,而晶圓代工廠卻能基于制程技術(shù)優(yōu)勢(shì)跨足下游封測(cè)代工,尤其是在高階SiP領(lǐng)域方面;因此,晶圓代工廠跨入SiP封裝業(yè)務(wù),將與封測(cè)廠從單純上下游合作關(guān)系,轉(zhuǎn)向微妙的競(jìng)合關(guān)系。
以晶圓代工龍頭臺(tái)積電量產(chǎn)在即的整合扇出型封裝(InFO)技術(shù)來(lái)說(shuō),2016年將可量產(chǎn)應(yīng)用于行動(dòng)裝置產(chǎn)品,再搭配前端晶圓代工先進(jìn)制程,打造出一條龍的服務(wù)。
InFO架構(gòu)是以邏輯晶片與記憶體晶片進(jìn)行整合,亦屬于SiP范疇,與過(guò)去TSV 2.5D IC技術(shù)層級(jí)的CoWoS技術(shù)相比,其亮點(diǎn)是無(wú)需矽中介層,因此成本更低,更輕薄且散熱程度更好。
目前臺(tái)積電跨入SiP業(yè)務(wù)多為因應(yīng)客戶需求,是否對(duì)于封測(cè)廠形成搶單效應(yīng),值得后續(xù)關(guān)注。不過(guò),封測(cè)廠面臨晶圓代工廠可能帶來(lái)的競(jìng)爭(zhēng),并非完全處于劣勢(shì)而毫無(wú)機(jī)會(huì)。
封測(cè)廠一方面可朝差異化發(fā)展以區(qū)隔市場(chǎng),另一方面也可選擇與晶圓代工廠進(jìn)行技術(shù)合作,或是以技術(shù)授權(quán)等方式,搭配封測(cè)廠龐大的產(chǎn)能基礎(chǔ)進(jìn)行接單量產(chǎn),共同擴(kuò)大市場(chǎng)。此外,晶圓代工廠所發(fā)展的高階異質(zhì)封裝,其部份制程步驟仍須專業(yè)封測(cè)廠以現(xiàn)有技術(shù)協(xié)助完成,因此雙方仍有合作立基點(diǎn)。
產(chǎn)業(yè)鏈結(jié)構(gòu)完整臺(tái)廠發(fā)展SiP最大優(yōu)勢(shì)
2007年第一代iPhone推出后,逐漸開啟行動(dòng)裝置產(chǎn)品的普及。隨著輕薄短小、多功能、低功耗等產(chǎn)品趨勢(shì)形成,SiP技術(shù)漸成封裝技術(shù)發(fā)展的目標(biāo);2015年,體積更小的Apple Watch等穿戴式產(chǎn)品開始興起,亦亟需使用SiP技術(shù)協(xié)助。
而在物聯(lián)網(wǎng)時(shí)代即將來(lái)臨之際,對(duì)多功能整合、低功耗與微型化等需求更將逐步增加,SiP技術(shù)將能提供較為理想的解決方案。因此,不但國(guó)內(nèi)外現(xiàn)有封測(cè)大廠極力發(fā)展SiP技術(shù),相關(guān)基板廠、EMS廠乃至于上游晶圓代工廠,皆有廠商跨入以搶食商機(jī)。
由于SiP須不同專業(yè)領(lǐng)域互相配合,包括IC基板、封裝技術(shù)、模組設(shè)計(jì)與系統(tǒng)整合能力等,這對(duì)相關(guān)***業(yè)者來(lái)說(shuō),是很好的發(fā)展機(jī)會(huì)。因?yàn)椋?**在半導(dǎo)體電子產(chǎn)業(yè)鏈結(jié)構(gòu)完整,廠商分布廣泛,具有發(fā)展SiP技術(shù)的先天條件。就以半導(dǎo)體產(chǎn)業(yè)結(jié)構(gòu)來(lái)分析,分布領(lǐng)域廣泛且完整,使***半導(dǎo)體業(yè)者具有上中下游合作的基礎(chǔ)條件。
尤其對(duì)封測(cè)業(yè)者來(lái)說(shuō),以技術(shù)為主的封裝廠可與IC設(shè)計(jì)廠緊密合作,以領(lǐng)先的封裝技術(shù)來(lái)滿足IC設(shè)計(jì)業(yè)者對(duì)產(chǎn)品的各種設(shè)計(jì)需求;也可與記憶體廠乃至晶圓代工廠技術(shù)合作,發(fā)展SiP異質(zhì)整合。
而對(duì)于專注在測(cè)試為主的后段測(cè)試廠而言,SiP對(duì)晶片功能檢測(cè)與多晶片測(cè)試的需求增加,也將帶給部分專業(yè)測(cè)試廠切入機(jī)會(huì),專業(yè)測(cè)試廠可積極爭(zhēng)取與封裝廠或晶圓代工廠垂直分工,以分食SiP所帶來(lái)的龐大商機(jī)。
不僅如此,***在IC基板廠商近年來(lái)開始走向類半導(dǎo)體領(lǐng)域,發(fā)展SiP所需的積體電路內(nèi)埋基板,提供相關(guān)材料。而在模組設(shè)計(jì)與系統(tǒng)整合方面,更是有鴻海等EMS大廠可進(jìn)行相關(guān)支援。因此,在整體產(chǎn)業(yè)鏈結(jié)構(gòu)完整的優(yōu)勢(shì)下,***廠商具有發(fā)展SiP技術(shù)的先天條件。
目前在高階封裝技術(shù)仍保有領(lǐng)先地位的臺(tái)廠,若能再?gòu)?qiáng)化廠商間合作與善用優(yōu)勢(shì),則***廠商在SiP領(lǐng)域?qū)⒖删S持技術(shù)領(lǐng)先并擁有更多發(fā)展商機(jī)。
 電子發(fā)燒友App
電子發(fā)燒友App











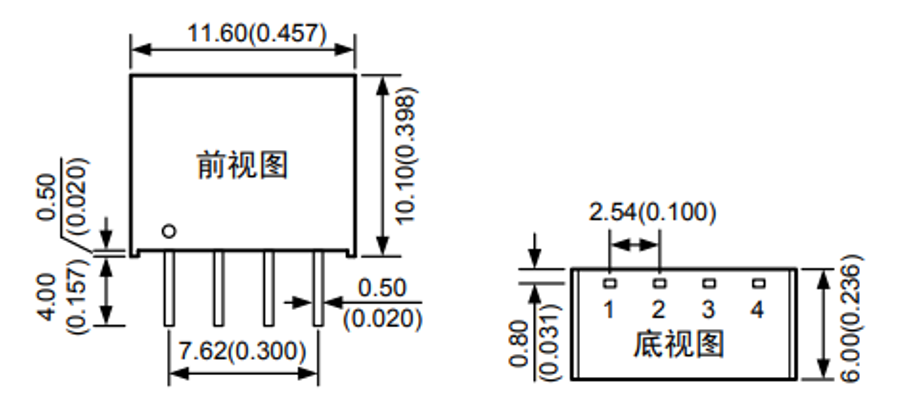












評(píng)論