生成測(cè)試序列
故障建模背景完成后,設(shè)計(jì)人員要明確測(cè)試的電壓、溫度和頻率要求。給定應(yīng)力角的序列與稱為測(cè)試算法發(fā)生器(TAG)的引擎結(jié)合。TAG 將與針對(duì)個(gè)別故障類型的小測(cè)試序列組合在一起,產(chǎn)生使測(cè)試時(shí)間和測(cè)試成本最小化的最小測(cè)試算法。
圖9展示了針對(duì)FinFET的TAG。圖中的過程是全自動(dòng)的,從故障注入到測(cè)試序列識(shí)別再到TAG本身。不同的算法片段可以分割以應(yīng)對(duì)不同的應(yīng)力角和不同的故障檢測(cè)級(jí)別。分割形成了一個(gè)針對(duì)不同條件的測(cè)試序列池,這是由于不同用戶和應(yīng)用具有不同的要求。比如,生產(chǎn)測(cè)試期間,設(shè)計(jì)人員必須識(shí)別故障,以便他們能夠糾錯(cuò),但是確定每個(gè)故障根源的完整分析可能十分耗時(shí)。然而,如果某種錯(cuò)誤經(jīng)常發(fā)生,設(shè)計(jì)人員會(huì)執(zhí)行更加復(fù)雜而昂貴的測(cè)試,以縮小故障范圍,從而能采取相應(yīng)的糾錯(cuò)措施。
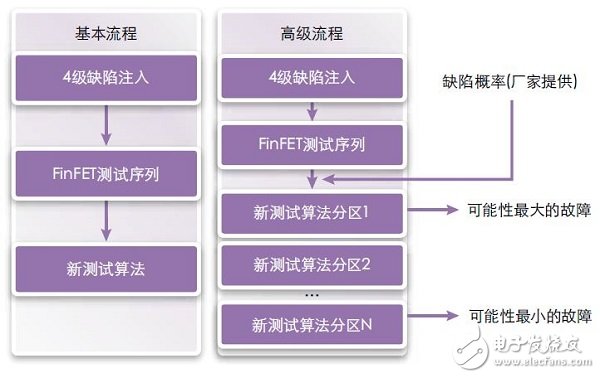
圖9:FinFETs測(cè)試算法綜合
這些過程和測(cè)試全部在STAR存儲(chǔ)器系統(tǒng)中得以實(shí)現(xiàn),考慮了來自大多數(shù)FinFET提供商的故障,這些故障在不同提供商之間具有很大的共性,盡管位單元彼此相差很大。
STAR存儲(chǔ)器系統(tǒng)還將可編程能力納入其中。可以通過JTAG端口和TAP控制器更新算法,修改測(cè)試序列本身或?yàn)檎{(diào)試和診斷而升級(jí)算法,或者就是簡(jiǎn)單的算法升級(jí),甚至是在現(xiàn)場(chǎng)。
使用STAR存儲(chǔ)器系統(tǒng)檢測(cè)并修復(fù)故障
Synopsys對(duì)FinFET潛在故障和缺陷的深入而徹底的分析內(nèi)建在了STAR存儲(chǔ)器系統(tǒng)之中,使得該系統(tǒng)可以在很多層次上使用,如圖10所示。最高層次是了解哪個(gè)存儲(chǔ)器例化單元出現(xiàn)失效,這對(duì)于生產(chǎn)測(cè)試和糾錯(cuò)可能就足夠了。下一個(gè)層次是故障的邏輯地址和物理地址。STAR存儲(chǔ)器系統(tǒng)可以確定故障位的物理X、Y坐標(biāo)。缺陷可以分類(單個(gè)位、成對(duì)位、整列等),故障可以分類并最終精確定位到故障部位。注意,所有這些都由芯片外面的STAR存儲(chǔ)器系統(tǒng)確定,而不是使用電子顯微鏡或其他更精細(xì)/昂貴的方式。

圖10:DesignWare STAR存儲(chǔ)器系統(tǒng):多層次精密診斷
開發(fā)為SoC用戶(或存儲(chǔ)器IP設(shè)計(jì)人員)帶來高質(zhì)量結(jié)果的工具和IP是一個(gè)漫長(zhǎng)而持續(xù)的過程。從深入的存儲(chǔ)器設(shè)計(jì)知識(shí)開始,早期接觸多家代工廠的制程參數(shù)、大量的故障注入模擬、硅芯片特征化和精確的行為和結(jié)構(gòu)模型,該過程可能需要三年以上。深入理解FinFET特有缺陷得到了對(duì)面積影響更小和測(cè)試時(shí)間更少的優(yōu)化測(cè)試算法,外加對(duì)使缺陷易于顯現(xiàn)的應(yīng)力條件的認(rèn)識(shí)。最后,所有這些知識(shí)全部結(jié)合在STAR存儲(chǔ)器系統(tǒng)中用于創(chuàng)建自動(dòng)插入、快速測(cè)試和使產(chǎn)出最大化。
FinFET為使用預(yù)先插入的一組可調(diào)度的存儲(chǔ)器優(yōu)化時(shí)序提供了更多的可能性。BIST多路復(fù)用器可隨共享測(cè)試總線落實(shí)到位。這些測(cè)試總線可由定制數(shù)據(jù)通路創(chuàng)建者和處理器內(nèi)核進(jìn)行復(fù)用。Synopsys創(chuàng)立了多存儲(chǔ)器總線(MMB)處理器來充分利用FinFET提供的可能性。MMB與映射到該總線上的所有緩存共享BIST/BISR邏輯,因此不再需要存儲(chǔ)器包裝器,減小了面積占用和功率消耗(圖11)。
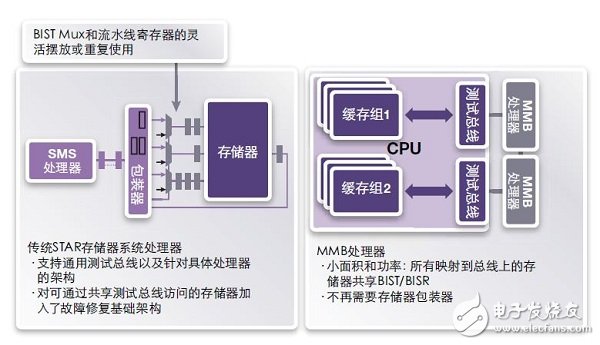
圖11:搭建在傳統(tǒng)STAR存儲(chǔ)器系統(tǒng)處理器上的MMB處理器獲得更高FinFET性能及更小面積
圖12展示了一個(gè)SoC實(shí)例,其中部分存儲(chǔ)器傳統(tǒng)地使用STAR存儲(chǔ)器系統(tǒng),而CPU內(nèi)核中的存儲(chǔ)器則通過MMB處理器訪問。MMB處理器不直接處理包裝器,而是訪問圖12中紅色方框代表的總線端口。MMB處理器從CPU RTL中讀取信息,理解存儲(chǔ)器細(xì)節(jié)和寫入總線的配置,引起即時(shí)握手。
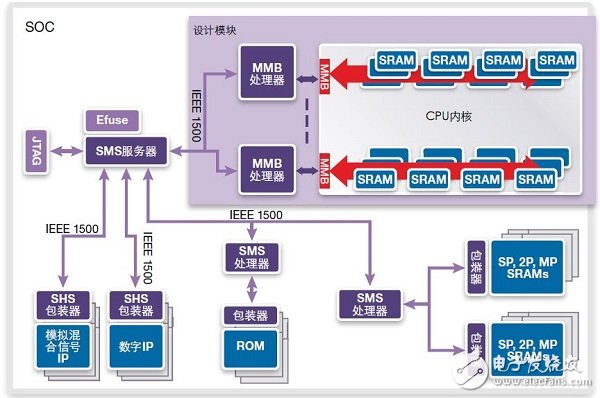
圖12:STAR存儲(chǔ)器系統(tǒng)MMB使用模型
維修故障
現(xiàn)代存儲(chǔ)器同時(shí)具有行和列冗余性(圖13)。檢測(cè)到故障時(shí),可以通過在非易失性存儲(chǔ)器中記錄問題和使用維修方案配置冗余列。STAR存儲(chǔ)器系統(tǒng)通過縮小故障范圍和確定置換出故障的方法來自動(dòng)進(jìn)行維修。這個(gè)過程可以對(duì)所有應(yīng)力角進(jìn)行優(yōu)化,故障在一個(gè)應(yīng)力角檢出并擴(kuò)大到下一個(gè)應(yīng)力角,以此類推。
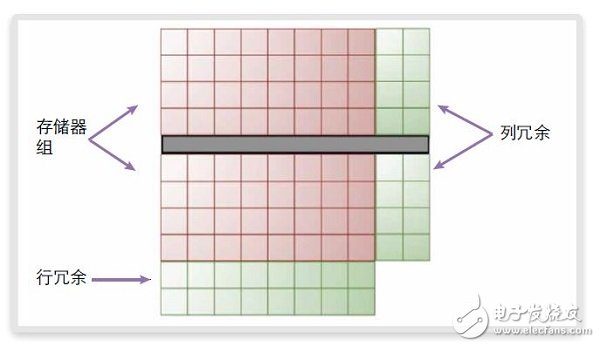
圖13:使用行、列修復(fù)維持FinFET高良率
由于STAR存儲(chǔ)器系統(tǒng)的自動(dòng)化程度如此之高,診斷和修復(fù)可以按預(yù)定間隔在現(xiàn)場(chǎng)重復(fù)進(jìn)行,比如系統(tǒng)上電時(shí)或按預(yù)定的時(shí)間長(zhǎng)度。這種重復(fù)可以通過內(nèi)建冗余性消除因老化而產(chǎn)生的故障。
負(fù)偏壓溫度不穩(wěn)定性(NBTI)是FinFET最令人頭痛的一個(gè)特殊老化問題(平面晶體管沒有這樣的問題)。NBTI主要與溫度有關(guān),會(huì)導(dǎo)致取決于 FinFET 工作溫度范圍的性能逐漸下降。
 電子發(fā)燒友App
電子發(fā)燒友App









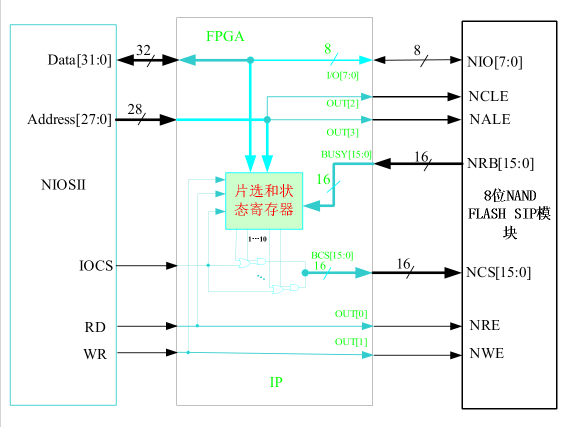
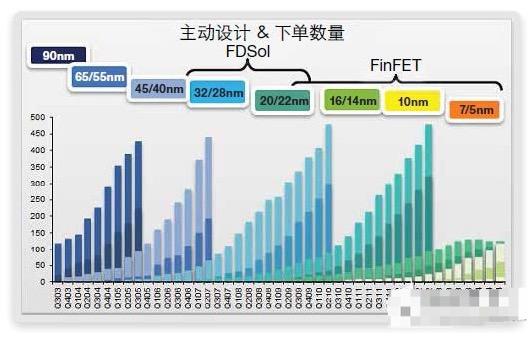


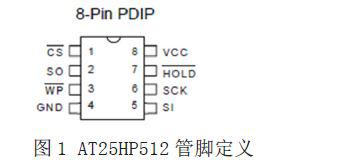

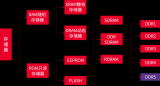










評(píng)論