對于芯片制造工藝,可能多數人更在意芯片是多少納米制程,但是對于封裝技術卻并不太在意。Intel去年提出了全新的六大戰略支柱,其中封裝(Package)也占據很重要的一個位置,足見其重要性。
作為芯片制造過程的最后一步,封裝在電子供應鏈中看似不起眼,卻一直發揮著極為關鍵的作用。作為處理器和主板之間的物理接口,封裝為芯片的電信號和電源提供著陸,尤其隨著行業的進步和變化,先進封裝的作用越來越凸顯。
另一方面,半導體工藝和芯片架構的日益復雜,制程工藝的推進也越來困難,傳統SoC二維單芯片思路已經逐漸行不通,chiplet多個小芯片組合或堆疊在一起的2.5D/3D封裝成為大勢所趨。
AMD剛發布的第三代銳龍以及即將發布的第二代霄龍,就是這種變化的一個典型代表,都用了chiplet小芯片設計,將原本一個單獨的大2D芯片拆分開來,不同模塊做成不同的小芯片,再整合堆疊到一起。
Intel此前也陸續推出了EMIB 2.5D、Foveros 3D封裝技術,前者的代表是去年集成了Vega GPU核心的Kaby Lake-G,后者則會在今年底有Lakefiled,融合10nm、22nm制程工藝。
近日,在本周舊金山舉辦的SEMICON West大會上,Intel介紹了三項全新的先進芯片封裝技術:Co-EMIB、ODI、MDIO。基本原則都是使用最優工藝制作不同IP模塊,然后借助不同的封裝方式、高帶寬低延遲的通信渠道,整合在一塊芯片上,構成一個異構計算平臺。此外,英特爾還推出了一系列全新基礎工具,包括EMIB、Foveros技術相結合的創新應用,新的全方位互連(ODI)技術等。
一、Co-EMIB
Foveros 3D封裝是Intel在今年初的CES上提出的全新技術,首次為CPU處理器引入3D堆疊設計,可以實現芯片上堆疊芯片,而且能整合不同工藝、結構、用途的芯片,相關產品將從2019年下半年開始陸續推出。而EMIB(嵌入式多芯片互連橋接)技術則是幾年前英特爾推出的2D封裝技術。
而Co-EMIB就是利用高密度的互連技術,將EMIB 2D封裝和Foveros 3D封裝技術結合在一起,實現高帶寬、低功耗,以及相當有競爭力的I/O密度。
Co-EMIB能連接更高的計算性能和能力,讓兩個或多個Foveros元件高速互連,從而基本達到接近SoC性能,還能以非常高的帶寬和非常低的功耗連接模擬器、內存和其他模塊。
Intel介紹的一個示例就包含四個Foveros堆棧,每一個都有八個小的計算芯片,通過TSV硅通孔與基底裸片相連,同時每個Foveros堆棧通過Co-EMIB連接兩個相鄰的堆棧,HBM顯存和收發器也是通過Co-EMIB組織在一起。

在現場,Intel還拿出了幾顆概念性的樣品,可以看出在一塊基板上都有很多個裸片(Die),且大小、功能各異,整合方式也不一樣。
二、ODI
ODI全稱是Omni-Directional Interconnect,也就是全方位互連技術,為封裝中小芯片之間的全方位互連通信提供了更大的靈活性。
Omni-Path正是Intel用在數據中心里的一種高效互連方式。Directional(方向性)所代表的,則是ODI既可以水平互連,也可以垂直互連。
ODI封裝架構中,頂部的芯片可以像EMIB下一樣,與其他小芯片進行水平通信,還可以像Foveros下一樣,通過硅通孔(TSV)與下面的底部裸片進行垂直通信。
ODI利用更大的垂直通孔,直接從封裝基板向頂部裸片供電,比傳統硅通孔更大、電阻更低,因而可提供更穩定的電力傳輸,同時通過堆疊實現更高的帶寬和更低的時延。
此外,這種方法減少了基底芯片所需的硅通孔數量,為有源晶體管釋放更多的面積,并優化了裸片的尺寸。




三、MDIO
MDIO意思是Multi-Die IO,也就是多裸片輸入輸出,是AIB(高級互連總線)的進化版,為EMIB提供一個標準化的SiP PHY級接口,可互連多個chiplet。
針腳帶寬從2Gbps提高到5.4Gbps,IO電壓從0.9V降低至0.5V,并且號稱比臺積電最近宣布的LIPNCON高級的多。

-
芯片
+關注
關注
459文章
52253瀏覽量
437093 -
半導體
+關注
關注
335文章
28669瀏覽量
233517
原文標題:詳解Intel三大全新封裝技術:繼續推動摩爾定律的新動力!
文章出處:【微信號:icsmart,微信公眾號:芯智訊】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
國星光電斬獲2025光亞展三項榮譽
安富利榮獲Bourns三項大獎
Future AIHER公司提交三項AI混增系統專利申請
深演智能斬獲三項國家級權威認證
長城汽車榮獲三項重量級大獎
華為MWC2025斬獲三項GLOMO大獎
科技為用戶而生!海爾智家大腦HomeGPT連獲三項大獎
松下電氣榮獲SGS三項服務認證






 詳細介紹Intel三項全新芯片封裝技術
詳細介紹Intel三項全新芯片封裝技術
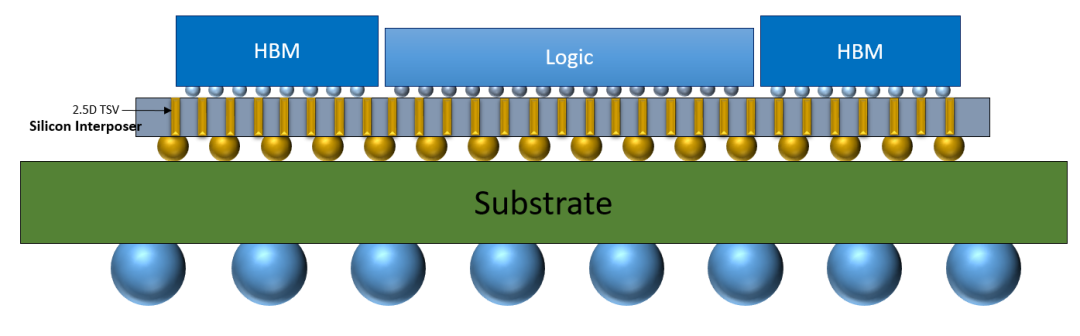











評論